基于機械剝離b-Ga2O3的Ni/Au垂直結構肖特基器件的溫度特性*
龍澤 夏曉川 石建軍 劉俊 耿昕蕾 張赫之 梁紅偉
(大連理工大學微電子學院,大連 116024)
本文制備了基于機械剝離b-Ga2O3的Ni/Au垂直結構肖特基器件,對該器件進行了溫度特性I-V曲線測試.器件表現出了良好的二極管特性,隨著溫度從300 K升高至473 K,勢壘高度從1.08 eV上升至1.35 eV,理想因子從1.32降低至1.19,二者表現出了較強的溫度依賴特性,這表明器件的肖特基勢壘存在勢壘高度不均勻的問題.串聯電阻隨溫度升高而降低,這主要是熱激發載流子濃度升高導致的.本文利用勢壘高度的高斯分布對器件的溫度特性進行了修正,修正后的勢壘高度為 1.54 eV,理查孫常數為 26.35 A·cm–2·K–2,更接近理論值,這表明利用高斯分布勢壘高度的熱電子發射模型能夠很好地解釋Au/Ni/b-Ga2O3肖特基二極管的I-V溫度特性問題,這種方法更適合用來測量b-Ga2O3肖特基二極管的電學參數.
1 引 言
b-氧化鎵(b-Ga2O3)材料是一種新興的超寬禁帶半導體材料,在最近幾年受到了科學界的極大關注.b-Ga2O3單晶屬于單斜晶系,晶格常數分別為:a=12.23 ?,b=3.04 ?,c=5.8 ?,a=b=90°,g=103.7°[1].因此 (100)與 (001)晶面為解理面,可以通過機械剝離的方法獲得薄層結構的氧化鎵材料[2,3].b-Ga2O3具有 4.9 eV的禁帶寬度、8 MV/cm的理論擊穿場強和較高的巴利伽優值[4,5],使得它相較于GaN,SiC等第三代半導體材料在高功率器件、日盲深紫外探測器、氣體傳感器等方面都有著獨特的優勢[5?7].除此之外,b-Ga2O3材料可以通過導模法、區熔法以及直拉法等方法制備質量較高的大尺寸單晶[8,9].這既為氧化鎵基器件的研究提供了幫助,同時也為這種單晶材料的大規模生產及商業化奠定了基礎.
在氧化鎵材料以及器件領域,人們已經對b-Ga2O3薄膜生長[10,11]、光電器件[12,13]、大功率器件制備及表征(如MOSFET,SBD)等方面進行了大量的研究[14,15].其中,氧化鎵的肖特基接觸特性可以說是研究的重點之一.迄今為止,人們已經采用Ni,Pt,Cu,Au 等多種金屬制作了不同的氧化鎵肖特基二極管(Ga2O3-SBD),并且對器件的電學特性進行了測試與分析,其中絕大多數的測試均為室溫條件下測試[16].然而,僅在單一工作溫度下對器件進行電學測試只能獲得勢壘高度、理想因子等信息,難以全面分析肖特基勢壘的特性.而電流-電壓溫度特性曲線測試能夠進一步分析器件的電學性質,通過不同溫度下的I-V曲線與Cheung和Norde的處理方法可以得到各項電學參數隨溫度的變化趨勢,從而分析器件內部的電流傳輸機制[17,18].同時采用激活能與高斯分布擬合的方法可以對器件的勢壘不均勻性進行評價,并且計算得到更精確的電學參數.
目前為止,有關氧化鎵肖特基二極管溫度特性的報道比較有限.2017 年,He 等[19]采用 (100) b-Ga2O3單晶襯底制備了 Pt/b-Ga2O3SBD,并對器件進行了溫度特性測試,得到器件的勢壘高度從294 K 時 的 1.39 eV 下 降 至 423 K 時 的 1.30 eV.Ahn等[20]制作了 Ni/Au和 Pt/Au的 b-Ga2O3SBD,發現二者具有相同的溫度特性變化趨勢,勢壘高度和理想因子分別隨溫度升高而升高和降低.2018 年,Jian 等[21]制備了 Pt/b-Ga2O3SBD,并且利用高斯分布的非均勻勢壘理論解釋了理查孫常數偏離理論值的問題.Fares等[22]制備了Au/W/b-Ga2O3SBD,該肖特基接觸具有更好的熱穩定性,更適合于在高溫下工作.2020 年,Reddy 等[23]在Si摻雜的b-Ga2O3外延層上制備了Au/Ni/b-Ga2O3SBD,并且在 100—400 K 的溫度范圍內進行了電學測試.利用多種方式提取了電學性質參數,采用高斯分布的勢壘模型解釋了勢壘高度、理想因子與串聯電阻的溫度依賴特性.
人們對肖特基器件的研究普遍基于熱電子發射模型(TE)來進行分析.然而這種理論模型的前提假設之一是肖特基勢壘在橫向上是均勻的,并且凈電流的存在不會影響這種平衡[24].對于硅基器件來說,由于材料生長與器件制備工藝成熟,肖特基勢壘相對均勻,可以采用TE模型來進行分析.但對于氧化鎵材料來說,生長工藝不夠成熟,單晶襯底存在界面質量差、界面層化學計量不均勻、電荷分布不均勻、界面層厚度不均勻以及摻雜原子的空間分布等原因,使得基于氧化鎵的肖特基器件存在著勢壘不均勻的現象,肖特基電極面積越大,不均勻程度也越高[23].因此采用TE模型來分析器件特性得到的結果不夠準確,需要將勢壘的不均勻考慮進來才能得到準確的電學參數.此外,在氧化鎵SBD溫度特性方面的工作幾乎全部都是基于單晶襯底或外延材料,而基于機械剝離的薄層氧化鎵肖特基二極管的溫度特性研究十分稀少[19?23].本文通過機械剝離方式獲得(001)晶向的氧化鎵單晶薄層材料,并且制作了垂直結構的Au/Ni/b-Ga2O3肖特基器件.在300—473 K的溫度范圍內對器件進行了I-V溫度特性測試,通過高斯分布模型對勢壘不均勻性進行了分析,最終得到了更可靠的電學參數.
2 實驗內容
本文采用的材料為直徑2英寸的非故意摻雜N型b-Ga2O3單晶晶圓,其載流子濃度為1.14 ×1017cm–3.原始單晶生長方法為 CZ 法 (Czochralski方法),氧化鎵單晶的晶向為 (01) 方向.本文采用機械剝離的方式獲得(001)晶向的條狀薄層材料,機械剝離過程在晶圓截面進行.首先用膠帶從晶圓截面撕下長約4 cm,厚度數百微米的條狀單晶.然后采用膠帶對撕的方法減薄材料厚度至100 μm以下,去除兩端損傷及表面不連續部分,最終獲得長度約為 2 cm,寬度約為 800 μm,厚度約為 100 μm的條狀單晶材料.機械剝離過程示意如圖1所示.在該材料上制作了垂直結構Au/Ni/b-Ga2O3肖特基二極管.歐姆接觸的制作采用Mg/Au疊層工藝,利用真空熱蒸發方式分別蒸鍍Mg (50 nm)和Au(300 nm)作為電極,蒸鍍后在 Ar環境下 400 ℃退火2 min[25].同樣采用真空熱蒸發的方法蒸鍍Ni(50 nm)和 Au (200 nm)作為肖特基電極,其中Ni與b-Ga2O3形成肖特基接觸,Au作為保護層覆蓋在Ni表面.為了避免Au與Ni和Ni與b-Ga2O3之間的熱擴散,蒸鍍完成后不進行退火處理.以上蒸鍍過程均在 5×10?4Pa 的真空中進行.采用物理掩膜的方法在氧化鎵表面蒸鍍直徑為600 μm的圓形電極,歐姆電極與肖特基電極尺寸及形狀相同,具體的器件結構示意圖如圖1所示.器件的電學及溫度特性測試使用可控溫度平臺(300—473 K)、Keithley 2611A 單通道系統數字原表和Keithley 4200-SCS參數分析儀進行測試.
3 結果與討論
3.1 電流-電壓溫度特性
圖2分別為Au/Ni/b-Ga2O3肖特基二極管在不同溫度下的正向和反向I-V特性曲線,測試溫度范圍 300—473 K,溫度步進 25 K.
由圖2可以看出,在正向偏壓條件下,器件的電流隨電壓的增大而指數增加,同時電流也隨著溫度的升高而增大.反向電流隨電壓變化程度很小,這是肖特基器件整流特性的良好體現.I-V曲線表現出了兩段線性區域,這主要是由于勢壘的不均勻導致的.出現雙勢壘表明整個勢壘平面有一些區域與其他區域存在明顯的勢壘高度差,等效為一小塊低勢壘區域嵌入到整個勢壘平面當中,所以體現出了雙勢壘的I-V曲線,這等效于兩塊肖特基勢壘并聯[26,27].低勢壘區域往往面積很小,對于器件的電學性能影響不大.這種現象主要由晶體自身的缺陷與晶體表面的表面態導致,而機械剝離的氧化鎵樣品表面往往會含有一定密度的表面態,正是這些因素導致測試的正向I-V曲線呈現為兩段線性區域[28,29].根據雙指數形式的TE模型給出器件的I-V理論表達式為[30]
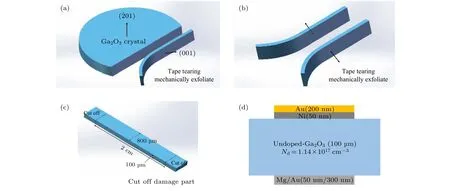
圖1 (a),(b),(c) 機械剝離氧化鎵單晶材料;(d) Au/Ni/b-Ga2O3 肖特基二極管結構示意圖Fig.1.(a),(b),(c) Mechanically exfoliated beta-Ga2O3 single crystal;(d) schematic cross section of Au/Ni/b-Ga2O3 Schottky barrier diode.

圖2 肖特基二極管的 I-V 溫度特性曲線 (a) 正向;(b) 反向Fig.2.Temperature dependent I-V characteristic curves of Schottky barrier diode: (a) Forward curves;(b) reverse curves.

其中A?為理查孫常數,φBn為勢壘高度,n為理想因子,RS為串聯電阻,Rsh為并聯電阻.T為器件的工作溫度,B1與B2分別為兩個不同高度的勢壘參數,等效電路如圖2(a)插圖所示.通過對正向IV曲線進行線性擬合可以提取器件的閾值電壓Vth,勢壘高度φBn和理想因子n等參數,得到圖3所示的結果.

圖3 I-V 溫度特性曲線提取的 (a) 勢壘高度;(b) 理想因子;(c) 閾值電壓Fig.3.The parameters from temperature dependent I-V characteristic curves: (a)Barrier height;(b) ideal factor;(c) threshold voltage.
首先,器件的正向I-V特性曲線存在兩段線性區域,這表明肖特基勢壘存在著不均勻的情況.分別對兩段區域進行數據處理,并且得到兩個不同的勢壘分布: Barrier 1 和 Barrier 2.兩部分勢壘的高度不同,但具有相似的隨溫度變化趨勢.隨著工作溫度的升高,勢壘高度分別從1.01和1.08 eV上升至 1.31和 1.35 eV,理想因子從1.32和 2.11降低至1.19和1.69,閾值電壓同樣隨溫度的升高而降低,具體的數據如表1所列.
圖4為勢壘高度φBn與理想因子n的依賴關系,可以看出器件的I-V特性隨溫度變化明顯且有規律,這表明器件具有較強的溫度依賴特性.理想因子和勢壘高度隨溫度的變化很可能是因為肖特基勢壘不均勻導致的.計算中采用的TE模型認為肖特基勢壘均勻,但通常情況下肖特基接觸勢壘高度是不均勻的.勢壘的不均勻性可能是多種物理原因造成的,如表面和體缺陷導致的界面質量差、界面層化學計量不均勻、界面電荷分布不均勻、界面層厚度不均勻以及摻雜原子的空間分布等原因.對于本文而言,勢壘的不均勻一方面是由氧化鎵單晶材料存在缺陷導致,另一方面也與機械剝離過程有關.通過機械剝離獲得的單晶材料表面存在大量懸掛鍵,這導致了表面態的存在.同時被束縛在表面的電荷會使能帶彎曲,而能帶的彎曲程度在橫向上很可能是不均勻的.除此之外,機械剝離后的單晶表面并不是完全連續的,一些島狀、層狀、裂紋狀結構也會導致勢壘的不均勻性.以上原因導致勢壘存在高低不同的部分,在較低的溫度下,電流會從較低的勢壘部分通過,因此通過I-V曲線得到的參數為低勢壘部分的平均值.而在較高的溫度下,電流則能夠流過勢壘高度較高的部分,導致理想因子的降低和勢壘高度的升高[31].但通過勢壘高度隨溫度的變化趨勢可以發現,肖特基接觸面上仍有更高的勢壘無法通過.而在較高溫度的條件下,器件的理想因子更趨近于理論值1,這表明在高溫時擴散電流可能在電流輸運中占據主導地位[32,33].

表1 I-V 溫度特性曲線提取數據表Table 1.The parameters from temperature dependent I-V characteristic curves.
I-V曲線提取的參數是基于正向小電壓下的電流曲線來進行計算的,這樣的處理方式對于勢壘不均勻的肖特基器件來說往往會使勢壘高度偏低.而電容-電壓(C-V)曲線分析則是工作在反向較大偏壓條件下,這樣可以一定程度上避免正向小電壓下電極未完全激活的問題.

圖4 不同溫度下勢壘高度與理想因子依賴關系 (a) Barrier 1;(b) Barrier 2Fig.4.Plot of barrier height as a function of ideal factor obtained at various temperatures: (a) Barrier 1;(b) Barrier 2.
圖5為器件在不同頻率下的C-V曲線,測試頻 率 范 圍 為 40 kHz至 1 MHz,電 壓 范 圍 為–30 至+30 V.在不同的頻率下,器件的C-V曲線基本一致,滿足肖特基器件的電容電壓關系式:

式中,ND為載流子濃度,ψbi為內建電勢.可以通過對C-V曲線的處理得到以上參數.勢壘高度與內建電勢的關系為

其中EC?EF為導帶與費米能級之間的距離,這里可以表示為


圖5 (a) C-V 特性曲線;(b) 頻率為 100 kHz 的 1/C 2-V 曲線Fig.5.(a) C-V characteristic curves;(b) 1/C 2-V characteristic curve of 100 kHz.
其中NC為導帶上的有效態密度,h為普朗克常數,m?為電子有效質量,這里取m?=0.34m0,而??為鏡像力導致的勢壘降低程度,可以表示為

采用100 kHz的C-V曲線進行計算,得到器件在300 K的溫度下載流子濃度為 1.14×1017cm?3,勢壘高度為1.88 eV.可以發現通過C-V曲線計算出的勢壘高度要明顯高于通過I-V曲線計算的到的值.主要原因是在室溫下,電流更容易從勢壘較低的部分流過,I-V測試小電壓下電極的實際激活面積很小,得到的參數基本反映了勢壘最低處的高度.而C-V測試得到的參數則可以看成是整個勢壘的平均值,由于勢壘的不均勻性導致了這種方法得出的勢壘高度更高.但同時也不能排除1/C2-V曲線的線性度不夠高帶來的計算誤差.從載流子濃度方面可以看出,非故意摻雜的氧化鎵單晶具有較高的載流子濃度,通過計算肖特基勢壘的特征能E00可以分析得到電流傳輸的主要機制,特征能E00的表示式為

特征能與kT的比值反映了器件滿足的電流傳輸機制,若E00/kT?1 則為熱電子發射模型(TE),若E00/kT≈1 則為熱場發射模型 (TFE),若E00/kT?1則為場發射模型(FE)[34].通過計算得出300 K時器件的特征能E00=3.40meV ,遠小于kT=25.85meV,表明器件的電流傳輸機制主要是TE模型,這與利用TE模型計算出的理想因子接近于1是相吻合的.
3.2 串聯電阻RS
對于SBD來說,串聯電阻RS是一個非常重要的性能參數.它直接影響了器件在較高的正向偏壓下的電流特性,同時對于導通截至電流比也有著一定的影響[23].分別采用Cheung的dV/dlnI-I曲線與H(I)-I曲線方法和Norde的F(V)-V曲線方法來提取器件的串聯電阻RS與勢壘高度φB等參數[17,18].如圖6所示,通過對300 K溫度下dV/dlnI-I曲線進行線性擬合可以得到器件的理想因子n為1.76,這與I-V曲線得到的值相吻合,串聯電阻為RS=285.76?.
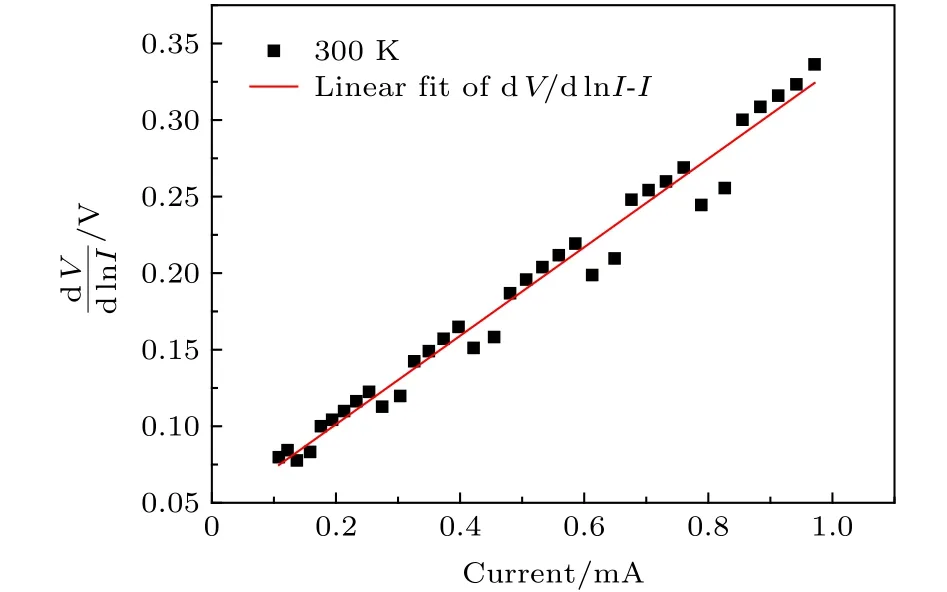
圖6 300 K 溫度下的 dV/dlnI-V 曲線Fig.6.dV/dlnI-V curve at the temperature of 300 K.
通過Cheung的方法,定義H(I)為[17]

在已知理想因子n隨溫度的變化量時,可以通過對曲線線性擬合后得到的斜率和截距來計算得出勢壘高度和串聯電阻值.器件的H(I)-I溫度特性曲線與對應的勢壘高度和串聯電阻變化如圖7所示.通過數據可以發現,隨著溫度的不斷增加,勢壘高度和串聯電阻發生了相應的變化,二者分別從 300 K 時的 0.97 eV 和 386.62 W 升高 和 降低至 473 K 時的 1.08 eV 和 189.04 W.在 300 K 時H(I)-I與dV/dlnI-I得到的串聯電阻值有一定的差距,這可能與H(I)-I曲線線性度較差有關,并且在較大正向偏壓下電流變化過快也會導致一定的擬合誤差.也正是因為以上原因,使得串聯電阻先隨溫度升高劇烈降低,然后緩慢升高,但總體表現為降低的趨勢.這主要是由于溫度升高使一些室溫下未激活的缺陷激活,導致載流子濃度增加從而降低了電阻值[20,35].

圖7 H(I)-I (a) 溫度特性曲線;(b) 不同溫度時的串聯電阻和勢壘高度Fig.7.H(I)-I (a) Temperature dependent curves;(b) the resistance and barrier height at various temperatures.
Norde提出可以通過偏置電壓V的經驗函數F(V),利用正向I-V曲線得到F(V)-V曲線,從而提取器件的勢壘高度和串聯電阻.其中經驗函數F(V)的表達式為[18]

則勢壘高度與串聯電阻可以表示為


其中Vmin為曲線最低點對應的正向偏壓,而F(Vmin)和I(Vmin) 則為相應的函數值.F(V)-V的溫度特性曲線與勢壘高度和串聯電阻的溫度變化如圖8所示,F(V)-V和H(I)-I的具體數據如表2所列.

圖8 (a) F(V)-V 溫度特性曲線;(b) 不同溫度時的串聯電阻和勢壘高度Fig.8.(a) F(V)-V temperature dependent curves;(b) the resistance and barrier height at various temperatures.

表2 H(I)-I與 F(V)-V 曲線提取數據表Table 2.The parameters from H(I)-I curves and F(V)-V curves.
Norde方法與Cheung方法之間的區別主要在于,Cheung方法更趨向于分析正向偏壓較高、電流趨于飽和階段的I-V曲線,而Norde更趨向于分析小電壓下的I-V曲線變化.對于本文而言,由于在較大正向偏壓下電流變化迅速,所以更適合采用Norde方法來對數據進行處理,得到的參數更接近于真實情況.Norde方法得到的勢壘高度隨溫度的升高從 1.07 eV 上升至 1.34 eV,這與I-V曲線Barrier 2得到的1.08至1.35 eV符合的非常好,側面印證了Norde方法的準確性.串聯電阻隨溫度的升高從 300 K時的 12.3 kW降低至 473 K時的 157.33 W,并且隨溫度的升高呈指數下降,下降原因與之前的分析相同.
3.3 勢壘的不均勻性
同樣,可以通過固定偏壓下激活能的溫度特性曲線來判斷在器件開啟時的面電極激活狀態.理想條件下,將(1)式進行一定處理得到如下關系:

式中,VF為開啟狀態下的正向偏置電壓,IF為對應的電流,q(φBn?VF) 則為激活能.通過構建圖像可以得到器件的勢壘高度φBn,同時也可以計算理論的理查孫常數A?的值,所以該圖像也稱為理查孫圖[36].在VF=1V時的理查孫圖如圖9所示.通過對圖像進行線性擬合可以得到器件勢壘高度為1.34 eV,這略高于300 K時I-V曲線得到的1.08 eV,但也明顯低于通過C-V曲線確定的1.88 eV.這表明肖特基勢壘的確存在不均勻的問題,正向偏壓為1 V時只有低勢壘部分被激活.而通過擬合直線的截距計算出的理查孫常數為1.6×10?3A·cm?2·K?2,遠遠低于理論值,如果按照理論值為 4 1.11A·cm?2·K?2來計算[37],則電極的電激活面積僅為 1.1×10?7cm2,不足實際電極面積的1%.

圖9 肖特基二極管的理查孫圖Fig.9.Richardson's plot of Schottky barrier diode.
由以上分析可知,肖特基勢壘在橫向上存在隨機的不均勻分布,而這種分布應滿足高斯分布的模型,所以本文利用高斯分布模型來對勢壘高度進行一定的修正[38].測試得到的勢壘高度應滿足如下公式:

其中φap為實際測試得到的勢壘高度,為平均勢壘高度,σ0為高斯分布的標準差.這里使用I-V曲線數據進行處理,繪制圖像如圖10(a)所示,可以得到標準差σ0的值分別為 0.211和0.189.再繪制圖像如圖10(b)所示,這樣就可以計算得到修正后的平均勢壘高度與理查孫常數值.

圖10 (a) 圖像;(b) 高斯分布修正后的理查孫圖Fig.10.(a) The plot of ;(b) Richardson's plot after Gaussian distribution processing.
通過對高斯分布模型修正后的理查孫圖進行線性擬合可以得到Barrier 1和Barrier 2勢壘高度分別為 1.52 eV 與 1.43 eV,理查孫常數也從1.6×10?3A·cm?2·K?2變為 2 6.38A·cm?2·K?2和0.35A·cm?2·K?2,相對來說更接近理論值41.11A·cm?2·K?2,這證明高斯型的勢壘分布模型能夠很好的解釋器件的肖特基勢壘不均勻問題.
4 結 論
本文制備了基于機械剝離薄層材料的Au/Ni/b-Ga2O3肖特基二極管,研究了器件的I-V溫度特性曲線.發現器件隨著工作溫度的升高,串聯電阻降低,這是由于額外的熱能激發淺能級缺陷形成新的載流子導致的.同時勢壘高度升高,理想因子降低,二者存在著較強的溫度依賴關系,這證明器件的肖特基勢壘存在不均勻的現象.利用高斯分布模型對勢壘的不均勻進行修正,得到實際的勢壘高度為 1.54 eV,理查孫常數為 2 6.38A·cm?2·K?2,較修正前更接近理論值.以上結論共同表明,利用高斯分布勢壘高度的熱電子發射模型能夠很好的解釋Au/Ni/b-Ga2O3肖特基二極管的I-V溫度特性問題.

