氮化鎵的干法刻蝕工藝研究
李 攀, 盧 宏
(華中科技大學武漢光電國家研究中心,武漢430074)
0 引 言
人類社會的進步越來越離不開電力,電力的使用過程不可避免地要進行直流交流轉換,在該過程中會產生損耗,而環保問題日益突出。直流交流轉換需要功率器件,而第一代硅功率器件正逐漸被更加節能、環保的,以GaN為代表的第3代半導體材料所替代[1]。Ⅲ-Ⅴ族化合物半導體以其特殊的材料特性廣泛應用于HEMT[2]、激光器[3-6]、調制器[7]、探測器[8-9]、LED[10-11]等各種光電子器件中。感應耦合等離子(ICP)干法刻蝕具有比反應離子刻蝕更高的等離子密度、更低的損傷,還具有更好的側壁形貌、更高的刻蝕速率和選擇比[12],可以進行各向異性刻蝕。
Shul等[14]采用ICP 通入Cl2、H2、Ar刻蝕GaN,得到了光滑的形貌和光滑陡直的側壁。Han等[15]采用Cl2、BCl3、Ar等氣體對GaN/AlGaN 進行刻蝕,提高了ICP刻蝕效果,得到了比刻蝕前更加光滑的刻蝕表面。
本文探索GaN等Ⅲ-Ⅴ族化合物半導體的刻蝕方法,分析刻蝕速率及刻蝕形貌。研究不同掩膜的刻蝕選擇比,為這些半導體材料的干法刻蝕提供參考。
1 GaN系材料的干法刻蝕
ICP干法刻蝕原理如圖1所示。本文采用英國Oxford公司的Plasmalab System 100(ICP 180)刻蝕機對GaN材料的刻蝕工藝進行探索,采用美國KLA公司KLA TENCOR P16+臺階儀測試刻蝕深度,采用荷蘭FEI公司的SIRION 200場發射掃描電鏡觀察刻蝕形貌。通常刻蝕采用的掩膜有光刻膠(Photo Resist,PR)、SiO2、金屬等,本文對PR和SiO2等掩膜分別進行刻蝕,并觀察形貌。
2 SiO2掩膜刻蝕GaN工藝
刻蝕參數見表1。表中:tPre指氣流穩定吹掃時間;t是刻蝕時間;PICP是電感射頻功率;PRF指下電極偏置射頻功率;Temp為腔體溫度;UDC,BIAS為自偏壓;vER為刻蝕速率;選擇比指材料刻蝕速率與掩膜刻蝕速率的比值。
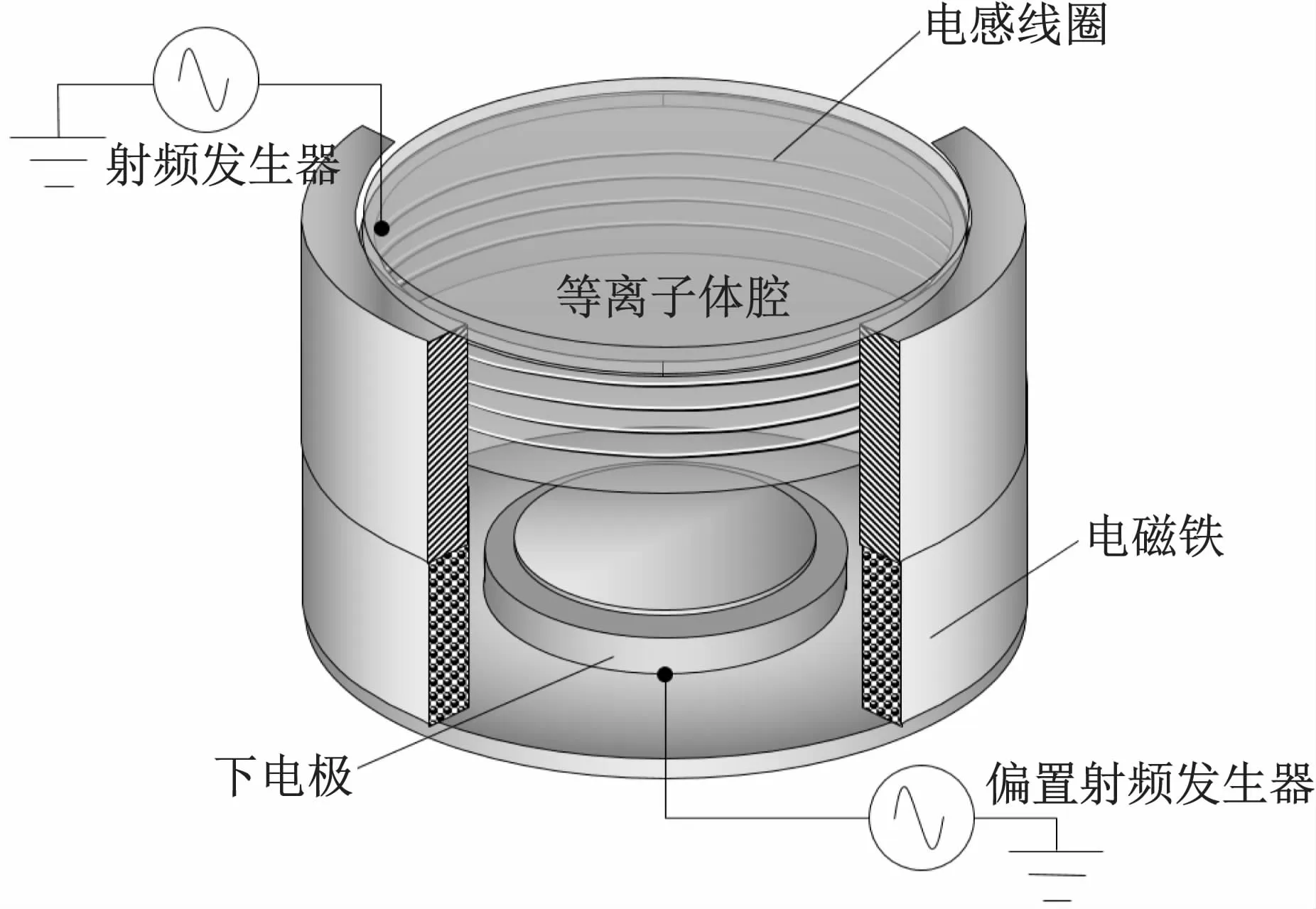
圖1 ICP體刻蝕原理圖[13]
使用直徑約5 cm小圓片放在石英盤上刻蝕,刻蝕SiO2掩膜厚度約480 nm,刻蝕后的GaN截面SEM形貌如圖2所示。由圖2可知,刻蝕效果較好,刻蝕側壁較垂直。根據測量結果,刻蝕速率約1 μm/min,選擇比為1∶7.8。

表1 ICP刻蝕SiO2掩膜GaN的主要參數

圖2 SiO2掩膜刻蝕GaN的截面形貌
3 PR掩膜刻蝕GaN
PR掩膜的刻蝕做了兩個試驗(PR厚度3 μm左右),使用PR為AZ6130,勻膠兩次,刻蝕參數見表2。

表2 ICP刻蝕PR掩膜GaN的主要參數
使用PR掩膜時,為了解決刻蝕時溫度過高,PR易碳化的問題,需要盡可能地降低刻蝕的ICP功率,而增大RF功率,即增大物理刻蝕的效果。其刻蝕效果見圖3。

圖3 PR掩膜刻蝕GaN的截面形貌
由圖3可見,使用PR掩膜時,刻蝕側壁較垂直,但是隨著刻蝕ICP功率的增大,兩層光刻膠由于烘干時間不足,產生了分層,導致刻蝕有臺階。因此使用PR掩膜進行刻蝕時,需要將光刻膠徹底烘干,且最好一次勻膠,保證光刻膠的均勻性。
4 GaN側邊傾斜角較大的刻蝕
有時需要刻蝕的側壁有一定的傾斜度,其刻蝕工藝見表3。為了得到刻蝕效果為側壁較傾斜,需要增大BCl3的比例,減小直流BIAS偏壓,使BCl3的側壁保護效果得到加強,其效果見圖4。

表3 ICP刻蝕傾斜側壁GaN的主要參數

圖4 傾斜側壁GaN的刻蝕截面形貌
由圖4可知,使用該程序可以達到要求,但是在刻蝕的時候會降低刻蝕的速率及刻蝕的選擇比。
5 刻蝕的均勻性及重復性
5.1 刻蝕均勻性
均勻性采用在相對極差的一半前面加上“±”來表示。刻蝕的均勻性的測試,晶圓片的測試是選擇兩個小片,放在直徑約10 cm晶圓托盤上刻蝕,然后測試兩片之間的均勻性。對于小片之間的均勻性,主要采取在4個位置每個位置放置1個小片,然后進行刻蝕,再測試其均勻性。其試驗工藝參數見表4。其中№8刻蝕目的是為了測試片內的均勻性,共放置片子為2個小片,刻蝕效果見圖5,均勻性測試結果數據見表5。

表4 ICP刻蝕GaN的主要參數

圖5 GaN的刻蝕截面形貌

表5 ICP刻蝕GaN的均勻性測試結果
№9刻蝕目的是為了測試4個小片之間的均勻性,共放置4個小片,均勻性測試數據見表6。刻蝕效果見圖6。

表6 ICP刻蝕GaN的均勻性測試結果
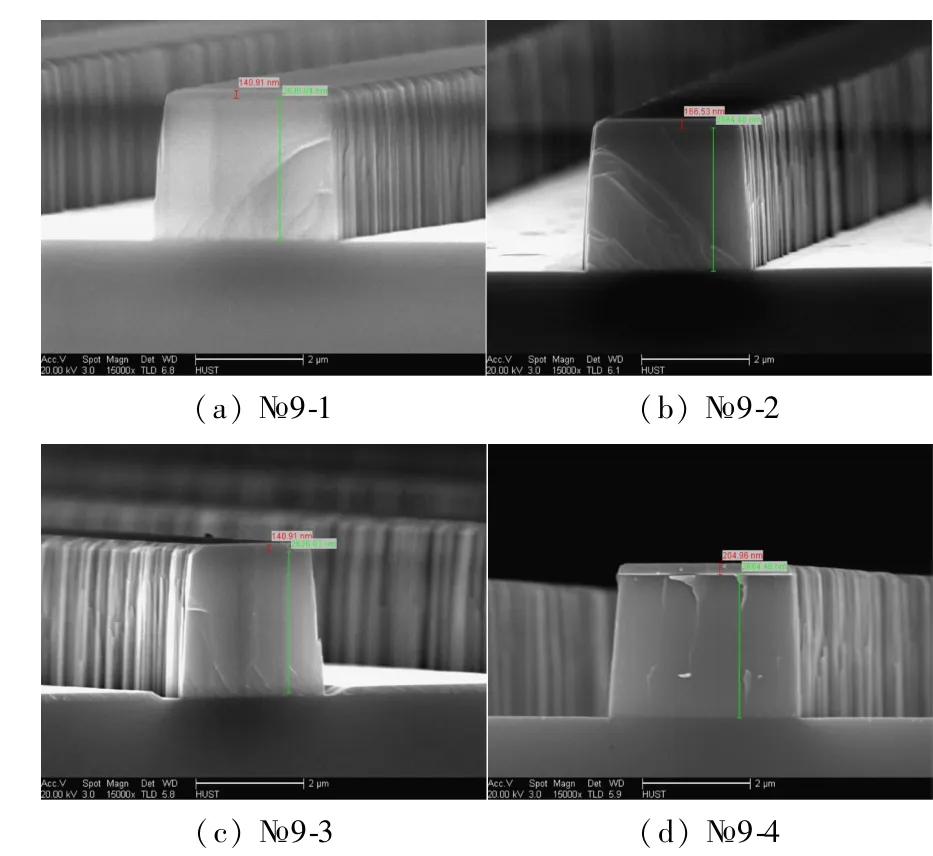
圖6 刻蝕均勻性測試截面形貌
5.2 刻蝕重復性測試
重復性采用在相對極差的一半前面加上“±”來表示[16]。重復性是短時間內由同一程序連續刻蝕后進行對比。由上面的試驗№8和№9的數據可以計算出兩次刻蝕的重復性為±2.51%。
6 結 語
研究了GaN刻蝕的刻蝕速率、選擇比、形貌,分別對金屬掩膜、SiO2掩膜和PR掩膜刻蝕形貌進行了對比。研究了工藝氣體對刻蝕形貌、刻蝕速率、選擇比的影響。實驗結果表明,采用Cl基氣體可以對GaN材料進行刻蝕,刻蝕側壁及底部形貌光滑。增大BCl3的比例可以獲得傾斜側壁的GaN刻蝕形貌。

