二氧化硅階梯狀薄膜熱阻層微納制備工藝研究*
周晨飛,楊明杰,梁軍生,2※
(1.大連理工大學遼寧省微納米技術及系統重點實驗室,遼寧大連 116024;2.大連理工大學精密與特種加工技術教育部重點實驗室,遼寧大連 116024)
0 引言
與傳統的熱流傳感器相比,薄膜熱流傳感器具有體積小、響應時間短等優點,能夠實現瞬態測量,能夠快速、準確地監控飛行器殼體和發動機組所在的熱環境。主要應用于航天器材料系統、發動機組件表面溫度和熱流的測量[1],還用于超聲速飛行器殼體材料的高溫力學性能分析,以選用合適的殼體材料[2],對保障飛行器的安全穩定運行具有重要意義。熱阻層是熱流傳感器的重要組成部分,不僅起到保護熱電偶組的作用,也直接影響到熱流傳感器的輸出值。傳感器組成示意圖如圖1所示。
熱流傳感器的傳熱原理可用傅里葉定律描述,公式如式(1)所示。

式中:λ為熱阻層材料的熱導率;ΔT 為兩層熱阻層底部的溫差;Δd 為兩熱阻層臺階的高度差。
從公式(1)中可以看出,熱阻層的高度差是影響傳感器輸出的重要因素,在工藝中要準確控制熱阻層臺階的厚度。
肖友文等[3]采用濺射-腐蝕-濺射的流程制備熱阻層臺階,王金鵬[4]通過濺射-腐蝕的流程制備。為確定更合適的制備方法,本文分別對這兩種方式進行了實踐,對兩種方法的優缺點進行了分析,對在工藝過程中出現的問題進行了分析解決,并提出了兩種工藝的適用條件。
1 薄膜的制備及臺階厚度的確定
1.1 薄膜的制備工藝
從公式(1)中可以看出,當薄膜厚度差ΔT 相同、熱流q 相同時,熱導率λ越小,ΔT 越大。熱電偶的輸出信號隨著ΔT 的增大而變強,因此常選用熱導率小的材料用作熱阻層。F.R.Brotzen 等[5]提到,塊狀SiO2的熱導率為1.4 W/(m·K),SiO2薄膜的熱導率比塊狀更低,甚至低于1 W/(m·K)。SiO2不僅熱導率低,還有電絕緣性高、硬度高等特點,常被用作高溫熱流傳感器熱阻層[6]。
目前SiO2薄膜的制造技術十分多樣,針對不同用途,SiO2薄膜的制作方式有多種,如物理氣相沉積法[7]、熱氧化法[8]、溶膠凝膠法[9]、射頻磁控濺射法[10]等。在非Si基底上制備較厚的薄膜時,常選用射頻磁控濺射法。本文選用射頻磁控反應濺射法制備SiO2薄膜。靶材為Si靶,射頻功率為300 W,靶基距為6.5 cm,氧氣流速為4.5 sccm,氬氣流速為21 sccm。實驗過程中,氬氣將Si 轟離靶材,在反應腔內與氧氣發生反應,生成的SiO2沉積在基底上形成SiO2薄膜,通過控制濺射的時間可控制薄膜厚度。
1.2 薄膜厚度的確定
Tsuneyuki Yamane等[11]在實驗中發現,用濺射方法制備的SiO2薄膜在厚度小于250 nm 時,熱導率呈指數上漲,在厚度大于250 nm以后趨于平緩,在500 nm以后基本保持不變。為保證高低臺階的熱導率一致,SiO2薄膜的低臺階厚度應大于500 nm,為更好地保護基底表面的結構,實驗時將低層臺階設置為1 μm。
由于基底與熱阻層薄膜的熱膨脹系數不同,在高低溫交替時,熱阻層薄膜與基底的變形不一致,產生內部應力,易出現熱失配的問題,造成薄膜開裂或脫落[12]。Teixeira[13-14]研究了熱應力對物理氣相沉積薄膜的影響,發現熱應力的大小與薄膜的高度相關。
為防止出現熱失配問題,確定合適的高臺階的高度,通過射頻磁控反應濺射法制備了6 μm、8 μm、10 μm 厚的SiO2薄膜后,將薄膜放在馬弗爐中以5 ℃/min 的速度升溫至1 250 ℃,保溫后隨爐冷卻,將樣片取出。通過掃描電子顯微鏡拍攝的樣片表面形貌如圖2 所示。從圖中可以看出,厚度為6 μm的薄膜表面完好,8 μm厚的薄膜表面出現裂痕,10 μm厚的薄膜脫落,因此薄膜的厚度不宜超過6 μm。
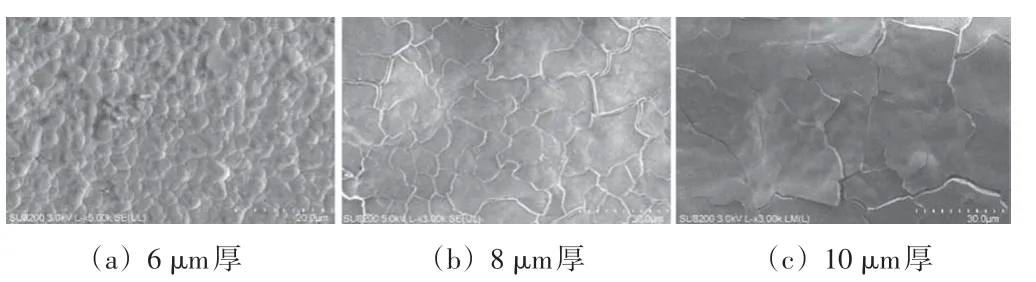
圖2 高溫處理后SiO2薄膜表面形貌
綜合考慮高低臺階的高度,在制備臺階時,以Ra40 nm、Ra280 nm 的Al2O3陶瓷片為基底,分別在基底上濺射了5 μm和6 μm厚的SiO2薄膜進行刻蝕實驗。
2 SiO2臺階的刻蝕
2.1 單次濺射
單次濺射即濺射-濕法腐蝕的方法,具體工藝流程如圖3所示。先濺射一層SiO2薄膜,厚度為高臺階的高度,再在SiO2薄膜的表面甩一層BP212 正性光刻膠,放在85 ℃的熱板上烘30 min,烘干后SiO2表面形成了固體膠膜。再通過曝光(SUSS MA6)、去膠的方法,將待腐蝕部分的膠膜去掉,僅留下無需腐蝕部分的膠膜。
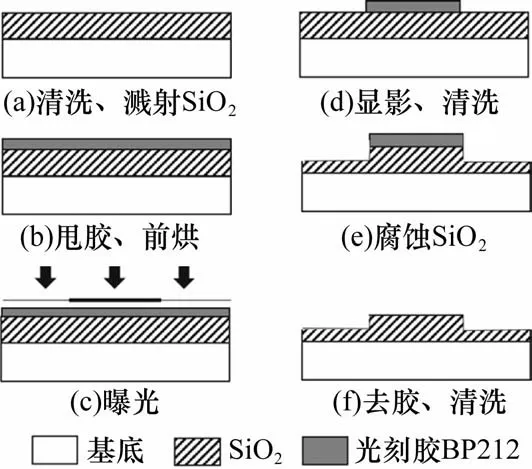
圖3 單次濺射濕法腐蝕工藝流程
腐蝕時,在40 ℃水浴條件下,將樣片放入氫氟酸緩沖液(氫氟酸緩沖液,HF、氟化銨、水比例為3∶6∶10)中,未被膠膜保護的部分與氫氟酸發生反應,化學反應方程式如式(2)所示。

被腐蝕的厚度即為高度差ΔT ,在實驗中,將厚度為6 μm,粗糙度為40 nm、280 nm 的樣片分別放入腐蝕液中80 s、90 s,取出烘干后,通過臺階儀測量臺階的厚度,得到的數據如表1所示,臺階橫截面如圖4所示。

表1 濕法腐蝕的腐蝕情況表
實驗發現,粗糙度為280 nm 的樣片腐蝕速度差距較大,且表面有不規則突起,腐蝕不均勻,臺階不明顯,無法用作傳感器的熱阻層,臺階測量結果如圖4(a)所示。粗糙度為40 nm 樣片的腐蝕速度相差不大,且不存在突起,臺階明顯,平面度高,如圖4(b)所示。這說明濕法腐蝕受到SiO2薄膜表面粗糙度的影響,當表面粗糙度較大時,表面各點的腐蝕速度不一致,在腐蝕的過程中凹點和凸點的腐蝕速度差異不斷增大,導致出現不規則突起。

圖4 腐蝕后的臺階橫截面
實驗證明,當薄膜表面粗糙度較低時,可通過單次濺射的方法進行腐蝕,但當粗糙度較大時,腐蝕后易出現突起等不均勻現象,無法進行實際應用。
2.2 二次濺射
二次濺射即濺射-濕法腐蝕-濺射的方法,具體工藝流程如圖5所示。先濺射一層SiO2薄膜,薄膜厚度為高低臺階的高度差。選取薄膜厚度為5 μm的樣片,在SiO2薄膜表面形成保護膠膜后,將樣片放在氫氟酸緩沖液中,放置足夠長的時間以保證未被膠膜保護的部分全部腐蝕,此次實驗腐蝕時間為240 s。清洗烘干后,再濺射一層薄的SiO2,第二次濺射的SiO2厚度為低臺階的高度。該方法的優點在于SiO2被全部腐蝕,既能保證臺階高度精確,也不受樣片粗糙度的限制,能避免因腐蝕引起的粗糙度增加導致的誤差。

圖5 二次濺射濕法腐蝕工藝流程圖
為保證熱電偶組均勻受熱,在制備掩膜板時,熱電偶兩端到臺階邊界的距離相等,但腐蝕后發現,臺階邊界向內收縮,這說明在腐蝕液中,腐蝕液不僅向下腐蝕,也向側邊腐蝕,出現了側蝕問題。腐蝕后的結果如圖6所示。
為保證SiO2被全部腐蝕,需要將樣片長時間放置在溶液中,導致薄膜側邊被腐蝕時間較長,側蝕示意圖如圖7 所示。為解決這一問題,在使用二次濺射的方法時,要先計算陪片腐蝕的速度,確定側蝕的寬度,在制作掩膜板時,將高臺階的半徑加寬,從而防止側蝕帶來的誤差。此外,該方法比單次濺射多一次濺射的工藝步驟,成本要比單次濺射高。

圖6 濕法腐蝕后高低臺階邊界圖
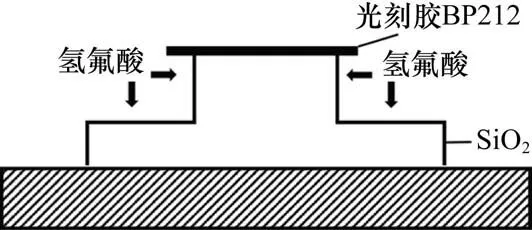
圖7 側蝕示意圖
3 結束語
經分析認為,為防止熱失配導致的薄膜開裂,SiO2薄膜的高臺階不宜超過6 μm;為保證高低臺階的薄膜熱導率相同,低臺階的高度不宜低于500 nm。
濕法腐蝕實驗證明,濕法腐蝕的均勻程度與樣品表面的粗糙度相關,粗糙度大時表面腐蝕不均勻,粗糙度小時,腐蝕均勻、腐蝕速度穩定。單次濺射的方法適用于粗糙度較小的樣片,具有工藝步驟簡單、成本低的優點,但對表面粗糙度要求較高。在樣片粗糙度較小時可選擇該方法。二次濺射的方法可避免粗糙度造成的腐蝕不均問題,對樣片表面的粗糙度要求低,可以保證臺階的高度和臺階的表面質量,但該方法側蝕更加嚴重,需要提前將側蝕造成的腐蝕寬度加在掩膜板上,以減少側蝕帶來的損害。并且與另一方法相比,該方法多一步濺射的步驟,這使該方法比單次濺射的方法成本高、操作更復雜。在樣片粗糙度較大或成本和工期允許的情況下,可選擇該方法。

