二維h-BN材料p型可摻雜性研究*
肖文君,劉天運,劉雪飛,羅子江
(1. 貴州師范大學 物理與電子科學學院,貴陽 550001;2. 貴州財經大學 信息學院,貴陽 550025)
0 引 言
二維材料由于具有優異的電學,光學,熱學和力學特性而受到廣泛關注。以sp2雜化形成的石墨烯單層結構于2004年被成功制備[1- 2],其展示出強烈的雙極性電場效應激發人們相繼成功制備出過渡金屬二硫化物[3-6],磷烯[7-8],碳氮化合物[9- 10]。實驗上,二維h-BN 被證明具有較好的力學、電學性能[11-13]。然而,在制備單層h-BN過程中不可避免的會引入各種點缺陷,因此對h-BN缺陷相關性質進行研究非常必要。在過去幾年來,關于二維h-BN缺陷計算的理論文章被大量報道[ 14-20]。在理論上,預測某種半導體材料是否容易實現n型或p型摻雜,比較有效的方法是對相關缺陷進行帶電缺陷計算[21],然而,據文獻調研表明,關于二維h-BN中引入各種替位雜質原子的帶電缺陷計算鮮有報道。因此,本文基于第一性原理方法,結合帶電缺陷計算理論及二維缺陷形成能校正理論,系統計算了在二維h-BN中引入多種潛在p型雜質的帶電缺陷體系,計算結果系統解釋了難以實現二維h-BN材料的p型摻雜的內在機制。
1 計算結構與方法
1.1 計算結構
計算所用結構如圖1所示。圖中較大原子為B, 較小原子為N, p-type替位點缺陷被標為XB, 缺陷附近的鍵長標為l′,遠離缺陷的鍵長被標為l,原始h-BN原胞對應菱形虛線框,正交化以后的原胞對應虛線長方形框,晶格常數被標注為a和b。對二維h-BN 體系摻入各種原子后,先進行結構優化,結果表明各體系在各價態下,遠離缺陷處的B-N鍵幾乎與完美h-BN中的鍵長一致,說明我們所選的超胞尺寸比較合理。除此之外,我們發現缺陷近鄰鍵長將會隨替位原子增大而增大,而幾乎不受缺陷所帶電荷態影響。
1.2 計算方法
本文基于第一性原理方法,使用(Vienna Ab initio Simulation Package,VASP)代碼完成計算。所有計算均考慮自旋極化,所選泛函為(Perdew John P., Burke Kieron, Ernzerhof Generalized gradient approximation,GGA-PBE)[22],并采用投影增強波(Projector Augmented Wave,PAW)贗勢[23-24]。

圖1 二維正交5×5 BN 超胞(100個原子)示意圖
為克服PBE方法低估帶隙的問題,我們用雜化泛函(Heyd-Scuseria-Ernzerhof,HSE06)[25]進行能帶計算。截斷能為450 eV,倒空間K點采樣密度為2×1×1,并使用Monkhorst-Pack方法。計算中部分結果后處理借助于VASPKIT代碼。在結構優化中,所有原子上的Hellman-Feynman受力均小于0.1 eV/nm,能量收斂判據為10-6eV。在計算過程中,為使用Freysoldt和Neugebaue (FN)提出的校正方法對缺陷形成能進行校正,我們將h-BN原胞晶格重新定義為正交形式,并在x-y平面內進行5×5擴胞,在z方向的真空層厚度為3.75 nm,體系包括100個原子。
在超胞中引入一個電荷態q的點缺陷形成能可由下式表達[26-27]
(1)

ΔV0/p=V0|far-Vp
(2)
ΔVd0/p為中性態缺陷遠離缺陷位置時的靜電勢V0|far與完美超胞中靜電勢Vp之差。μi(i=B,N,Be,Mg,Ca,Sr,C,Si,Ge)是穩定相原子化學勢,在平衡態BN體系中滿足:
EBN=μB+μN
(3)
其中,EBN表示一個BN原胞的能量。其它雜質原子化學窗口由Pymatgen進行確定[28]。研究表明,現實材料中缺陷數量是很低的,因此缺陷是近似孤立的,式(1)計算了一個有限大超胞的缺陷形成能,缺陷濃度顯著高于真實情況,從而引入誤差[29-30],因此有必要對形成能進行校正或外推,在本文中我們應用FN方法進行校正:
(4)
(5)


電荷轉移能級可表達為:
(7)
其中,Ef(q;Ef=0)和Ef(q′;Ef=0)分別表示q和q′價電態時的形成能。 在缺陷形成能關于電子化學勢函數圖像中表示斜率發生變化的拐點(見后文),轉移能級到CBM和VBM的能量差分別定義為施主和受主離子化能:
ID=CBM-E(q/q′)
(8)
IA=E(q/q′)-VBM
(9)
ID以及IA值越小,表示相應缺陷能級越淺。深能級將俘獲載流子,表現為復合中心,將影響半導體材料的摻雜效率。淺能級施主或受主可以為半導體材料提供電子或空穴,從而顯著提高半導體材料導電率。
2 結果與討論
2.1 XB體系缺陷形成能
圖2是在h-BN中摻入Be原子后,缺陷形成能(式1)隨費米能級(或電子化學勢)變化關系圖。為克服PBE泛函對帶隙(4.64 eV)的低估問題,我們計算了HSE雜化泛函下的h-BN能帶,得到其帶隙值為5.67 eV,PBE 和HSE 帶隙分別用箭頭標注在圖2中。基于式(1),在給定價態q時,其缺陷形成能隨電子化學勢變化的圖像應該是直線,直線的斜率對應所帶點荷價態。我們對各缺陷體系從-2價到+2價進行計算,得到5條類似的直線,所謂最穩定價態是指在給定電子化學勢(橫坐標)時,缺陷形成能最小的所有價態,如圖2 中粗實線所示。另外,由于熱力學生長過程中形成能將受到原子化學勢的影響,我們分別對富氮條件(a)和貧氮條件(b)進行計算,結果表明BeB體系在富氮體系具有更小的形成能,即在富氮條件下更容易將Be原子摻入h-BN中替換B原子。電荷轉移能級是指從某種價態變化到另一種價態所對應的費米能級,體現在圖中的直線斜率發生變化的拐點處。結果表明E(0/-1)轉移能級在HSE精度下處于價帶頂2.61 eV,表現為典型的深能級受主,從而很難為h-BN貢獻空穴導電率。相反,在靠近導帶底附近,BeB體系具有負的形成能,意味著BeB缺陷將自發的從導帶捕獲電子進而降低BN的n型摻雜效率,影響其n型導電率。
圖3~5分別對應MgB,CaB和SrB缺陷體系的形成能在富氮和貧氮條件下隨電子化學勢變化的圖形。對比可發現,由于替位雜質原子與Be具有類似價電子結構,因此其相應的最穩定價態以及電荷轉移能級的分布也都具有相似之處。即最穩定價態均為+1, 0和-1價,只是對應的缺陷形成能隨雜質原子半徑增大而增大,其原因是Be原子具有和B差異較小的原子半徑,因此用Be替換B時,將會引起更小的局部應力。從這個變化趨勢來看,我們的計算結果是比較合理的。需要指出的是,后三種缺陷體系在整個電子化學勢變化范圍內都具有相對較高的缺陷形成能,因此在實際摻雜過程中將很難將相應雜質與B 原子進行替換,因此不再進一步做深入討論。

圖2 BeB體系的缺陷形成能隨電子化學勢變化圖像
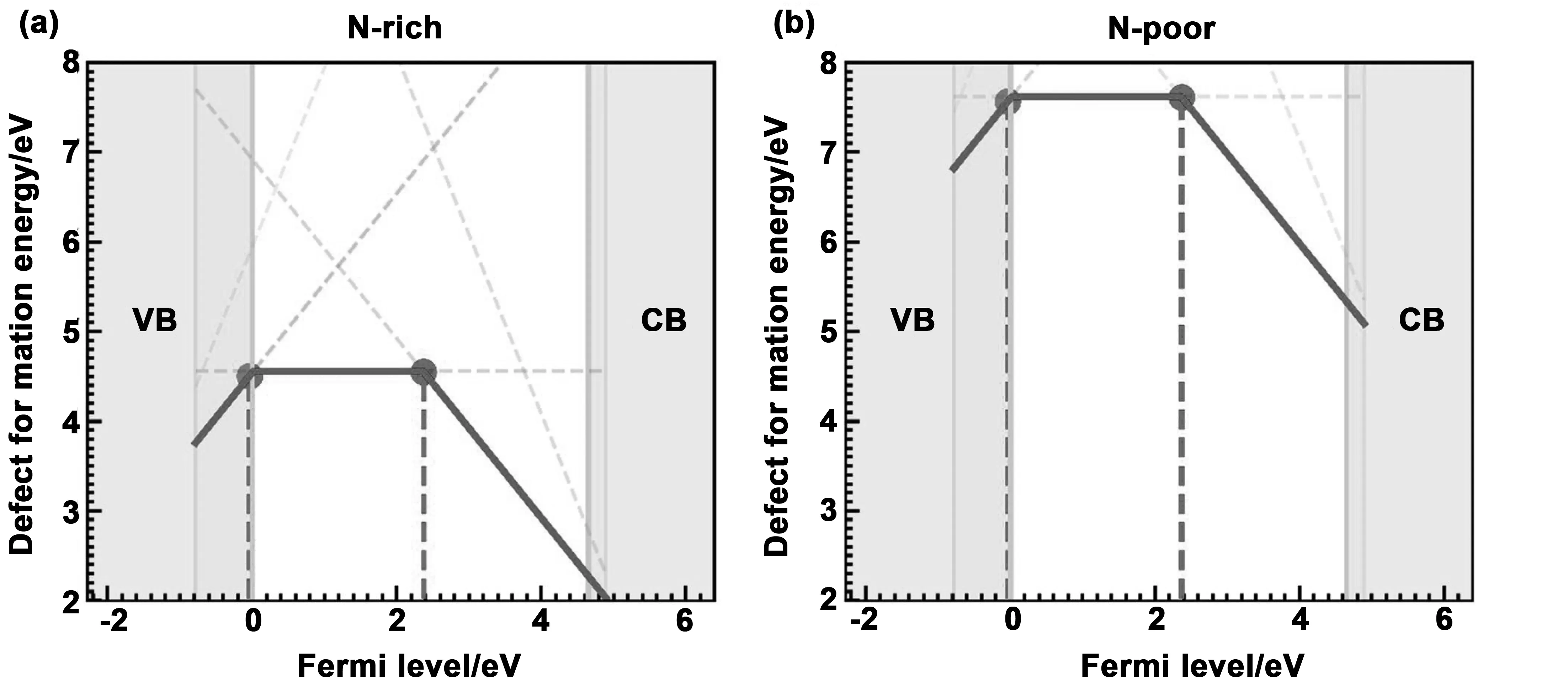
圖3 MgB體系的缺陷形成能隨電子化學勢變化圖像
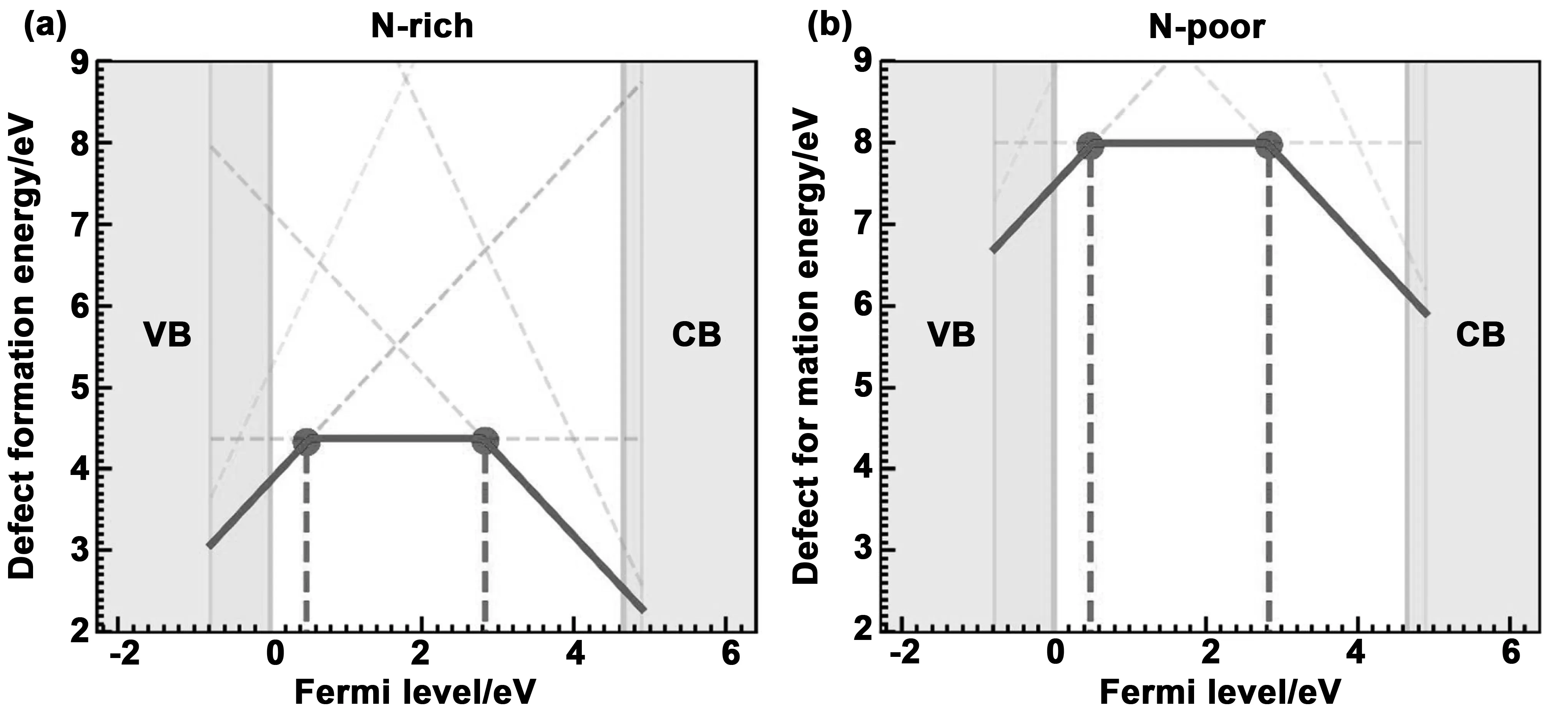
圖4 CaB體系的缺陷形成能隨電子化學勢變化圖像

圖5 SrB體系的缺陷形成能隨電子化學勢變化圖像
2.2 YN體系缺陷形成能
從原子的價電子排布來看,欲實現h-BN的p型摻雜,除了將II族原子(Be,Mg,Ca,Sr)去替換B引入空穴外,還可考慮將Ⅳ族原子(C, Si, Ge)去替換N原子產生空穴。因此,我們繼續計算YN(Y=C,Si,Ge)缺陷體系。其缺陷形成能隨費米能級變化的函數關系如圖6 到圖8所示。結果表明,在對N元素進行替換時,三種缺陷體系的缺陷形成能均是在貧氮的條件更低,這是因為在熱力學生長平衡條件下,只有當N原子濃度較低時,其被替換的可能性更大,表明我們計算的結果是合理的。另外,由于C原子具有和N原子更加接近的原子半徑,因此是三種缺陷中形成能最小的缺陷。其受主離子化能為3.65 eV,是典型的深能級受主,意味著CN體系將很難為BN貢獻空穴載流子。在費米能級處于價帶頂附近(p型摻雜BN),CN具有相對較小的缺陷形成能,且對應的價態為+1價,說明CN缺陷將有一定可能從加大捕獲空穴或者說將失去電子到價帶中復合空穴,從而降低宿主BN的空穴導電率,類似的,當宿主為n型摻雜時(費米能級靠近導帶),CN具有-價,且具有較低的缺陷形成能,容易捕獲導帶中的價電子,從而影響n型載流子導電率。因此,實驗上欲實現n型摻雜h-BN,應盡量避免C原子的摻入。當用Si原子替換N時,如圖7所示,其受主離子化能相比CN體系變小了,但相應的缺陷形成能有較大幅度的提高,意味著Si原子很難摻入h-BN中對N原子進行替換。另外,SiN體系的最穩定價態只有+1價和-1價,也就是說,一旦通過非平衡方式(比如離子化注入)將Si原子摻入h-BN中成功替換了N原子,SiN缺陷就會帶電,從而會對摻雜BN體系載流子進行捕獲或補償,一定程度上影響其摻雜效率。如圖8所示,將Ge原子與N 原子進行替換時,其深能級特性比CN更加明顯,由于其原子半徑比N原子大很多,因此缺陷形成能在整個電子化學勢范圍內都非常大。
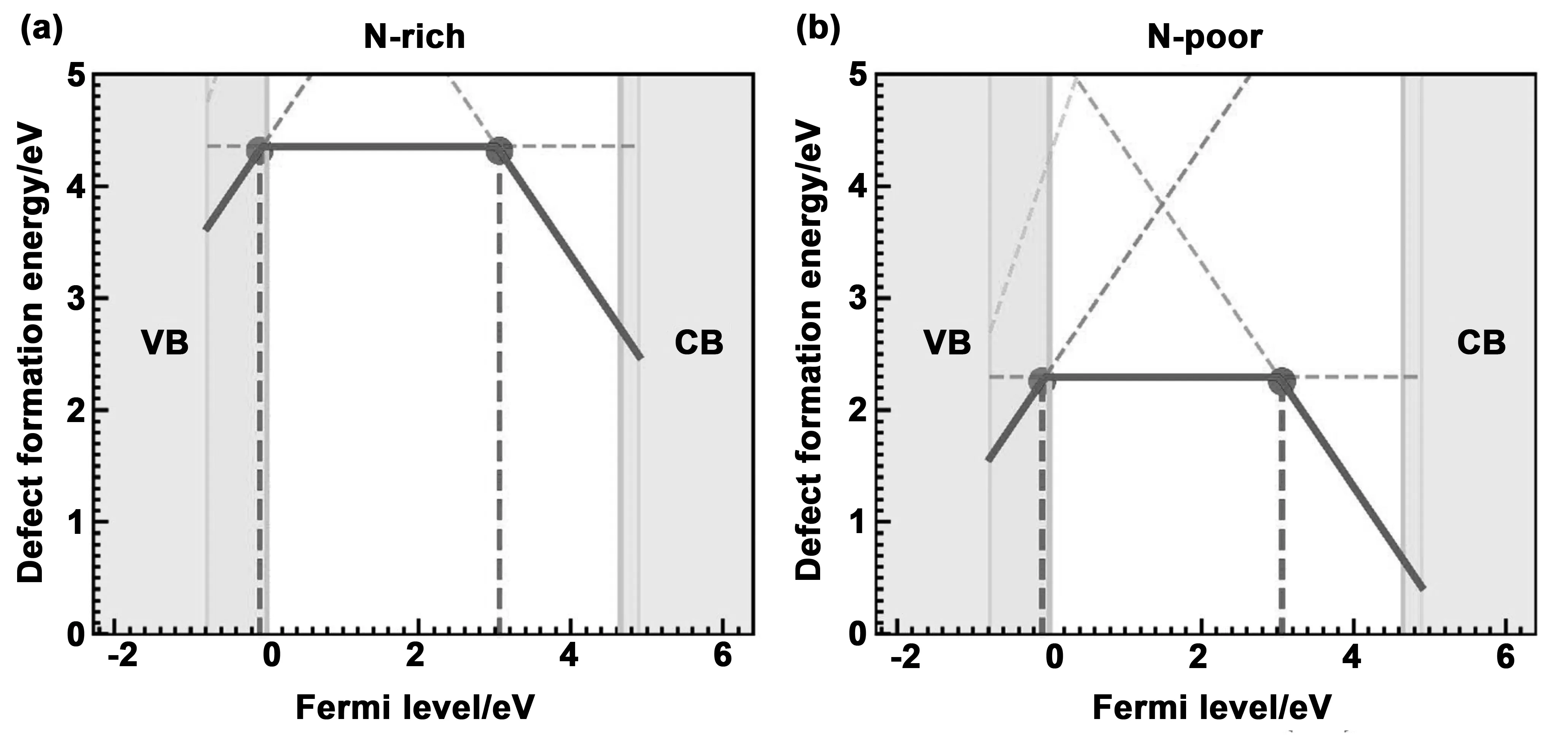
圖6 CN體系的缺陷形成能隨電子化學勢變化圖像

圖7 SiN體系的缺陷形成能隨電子化學勢變化圖像

圖8 GeN體系的缺陷形成能隨電子化學勢變化圖像
2.3 最穩定價態及電荷轉移能級
為了方便對比各體系的缺陷形成能的相對大小,圖9 對7種缺陷體系的最穩定價態缺陷形成能相對于費米能級的函數關系進行繪制,(a)對應富氮體系,(b)對應貧氮體系。總體來說,BeB體系在富氮條件下在整個電子化學勢區間具有最小的缺陷形成能,其中MgB,CaB和CN在富氮條件下具有非常類似的最穩定價態性質。在貧氮條件下,從價帶頂到費米能級為4.05 eV時,CN體系是相對容易實現的摻雜缺陷,而費米能級高于4.05 eV 時則CN和BeB具有相同的缺陷形成能,成為BN中主要的可摻雜缺陷。圖10進一步總結了本文涉及的兩類共7種潛在p型摻雜的電荷轉移能級分布規律。對于第一類(XB,X=Be,Mg,Ca,Sr),其兩個電荷轉移能級均隨替位原子半徑增大而逐漸靠近導帶底,對于第二類(YN,Y=C,Si,Ge)則規律性相對復雜。整體來說,SiN體系的受主離子化能級在PBE泛函精度下小于1 eV,可看成是準淺能級缺陷,考慮到淺能級傾向于跟隨帶邊的變化而變化[31],因此我們推測在HSE真實計算(而非等效轉換)時,SiN有可能成為淺能級受主,從而為BN提供一定的空穴。需要提醒的是SiN具有較高的缺陷形成能,需要借助于非平衡摻雜方式實現摻雜。

圖9 7種n-type缺陷體系最穩定價態對應的缺陷形成能隨電子化學勢變化圖像

圖10 7種p-type體系的電荷轉移能級分布圖
3 結 論
本文從密度泛函理論出發,借助于VASP軟件及二維帶電缺陷校正技術系統計算了二維h-BN中的兩類共7種潛在p型摻雜體系的缺陷性質。結果表明,BeB是富氮條件下缺陷形成能最低的缺陷,而CN則是貧氮條件下整個電子化學勢范圍內更容易形成的缺陷。從電荷轉移能級來看,除SiN缺陷表現出準淺能級受主外,其它缺陷均為深能級受主,因此無法為二維h-BN體系提供有效的空穴載流子。SiN由于具有較高的缺陷形成能,很難在熱力學平衡條件下摻雜到h-BN中,需要借助于非平衡摻雜方式。另外,所有缺陷在n型摻雜宿主h-BN中都表現為電子捕獲性,將抑制h-BN的n型摻雜效率,在p型摻雜宿主h-BN中表現為空穴補償中心,同樣會抑制空穴導電率。我們的研究從理論上預測了h-BN中通過單原子摻雜實現空穴導電比較困難,對相關的實驗具有非常好的理論指導價值。

