高溫溶液法生長SiC單晶的研究進展
王國賓,李 輝,盛 達,2,王文軍,2,3,陳小龍,3
(1.中國科學院物理研究所,北京 100190; 2.中國科學院大學,北京 100049;3.東莞松山湖材料實驗室,東莞 523429)
0 引 言
作為第三代半導體,碳化硅(silicon carbide, SiC)具有比硅(Si)更優越的性能,例如SiC的帶隙(4H-SiC:Eg=3.23 eV)約是Si(1.12 eV)的3倍,臨界擊穿場強(4H-SiC:~3.0 MV·cm-1)約是Si(0.3 MV·cm-1)的10倍,熱導率(4H-SiC:4.9 W·cm-1·K-1)約是Si(1.5 W·cm-1·K-1)的3倍。這些性能賦予了SiC在高溫、高頻、高功率電力電子器件和射頻微波器件中得天獨厚的應用優勢,使得其在軌道交通、新能源汽車、高壓電網、5G通信、航空航天以及國防軍事等領域具有重要的應用前景[1-3]。制備高質量、大尺寸、低成本的SiC單晶襯底是實現SiC器件大規模應用的前提。
生長SiC單晶的方法主要有:物理氣相傳輸法(physical vapor transport, PVT)、高溫化學氣相沉積(high temperature chemical vapor deposition, HTCVD)法和以頂部籽晶溶液生長(top seeded solution growth, TSSG)法作為目前主流技術的高溫溶液生長(high temperature solution growth, HTSG)法,如圖1所示。在這三種生長方法中,PVT法是現階段發展最成熟、應用最廣泛的方法,其基本原理是通過多晶SiC粉料在高溫下的分解與再結晶來實現單晶的生長,如圖1(a)所示。目前,用PVT法生長的6英寸(1英寸=2.54 cm)SiC單晶襯底已實現產業化。2016年,美國Cree公司宣稱采用PVT法已成功生長出8英寸(直徑200 mm)的SiC單晶[4]。隨著研發的深入和技術的不斷進步,PVT法生長的SiC晶體中的微管已基本消除(密度小于0.2 cm-2),但其位錯密度仍然較高,約為102~104cm-2,這對器件的性能和壽命有非常不利的影響[5]。此外,PVT法還存在擴徑難度大、成品率低、成本高等局限性[6-7]。生長SiC單晶的另外一種方法是HTCVD法。該方法是利用Si源和C源氣體在2 100 ℃左右的高溫環境下發生化學反應生成SiC的原理來實現SiC單晶的生長,該方法的一大優勢是可以實現晶體的長時間持續生長[8-9],如圖1(b)所示。通過此方法已經成功生長了4英寸和6英寸的SiC單晶,生長速率可高達2~3 mm/h[9-11]。HTCVD法不僅與PVT法一樣需要高的生長溫度,而且需要用到如SiH4、C3H8和H2等氣體,該方法的生長成本也較高。與上述兩種氣相法不同的另一種生長SiC單晶的方法是HTSG法,其基本原理是利用Si和C元素在高溫溶液中的溶解、再析出來實現SiC單晶的生長,目前廣泛采用的技術為TSSG法,如圖1(c)所示。該方法可在更低的溫度(<2 000 ℃)、近熱力學平衡的狀態下實現SiC單晶的生長,理論上更容易獲得高質量的SiC單晶[12]。此外,TSSG法還具有生長的晶體無微管、生長過程可調控性更強、易擴徑、易實現p型摻雜等優勢。目前,采用TSSG法已成功生長出4英寸的SiC單晶。該方法有望成為繼PVT法之后制備尺寸更大、結晶質量更高且成本更低的SiC單晶的方法,從而進一步促進SiC產業的快速發展。
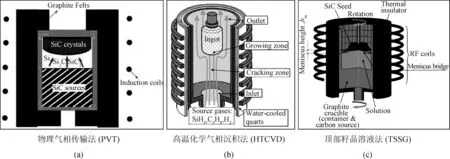
圖1 三種SiC單晶生長技術的原理示意圖:(a)PVT[13];(b)HTCVD[13];(c)TSSG[14]Fig.1 Schematic diagram of three technologies for SiC single crystal growth: (a) PVT[13]; (b) HTCVD[13]; (c) TSSG[14]
由于TSSG法具有上述獨特的優勢,近年來受到越來越多研究者的關注。在TSSG法生長SiC單晶中,高溫溶液的組成與配比、坩堝中溫場的調控、坩堝的結構設計、籽晶和坩堝的旋轉提拉工藝等都會影響晶體生長的速率和結晶質量,是目前的研究重點。本文首先總結回顧了TSSG法生長SiC單晶的發展歷程;接著簡要介紹和分析了該方法生長SiC單晶的基本原理和生長過程;然后從晶體生長熱力學和動力學兩方面總結了該方法主要的研究進展,并歸納了TSSG法生長SiC單晶的優勢;最后,提出了該技術在未來的研究重點和發展方向。
1 TSSG法生長SiC單晶的發展歷程與現狀
HTSG法生長SiC并不是一種新的嘗試,已有60多年的發展歷史。1961年,Halden等首次從溶解了C的高溫Si熔體中獲取了SiC單晶,隨后也有一些工作探索了從組成為Si+X的高溫溶液(其中X為Fe、Cr、Sc、Tb、Pr等元素的一種或幾種)中生長SiC單晶[12]。20世紀60年代,用HTSG法生長SiC單晶的研究要比PVT法的研究活躍。70年代以后,PVT法取得了快速突破,利用HTSG法生長塊體SiC單晶的研究在很長一段時間內幾乎停止,SiC液相外延(LPE)的研究比較活躍。直到20世紀90年代以后,才有少數研究組再次開始進行HTSG法生長SiC單晶的研究工作,并取得了重要研究進展,從而展示出利用HTSG法生長SiC單晶的獨特優勢:可以閉合微管,降低缺陷密度,從而獲得高質量的SiC單晶[12]。1999年,德國埃爾蘭根大學的Hofmann等[12]以純Si為自助熔劑,利用高溫高壓的TSSG法首次生長出直徑1.4 英寸、厚度約1 mm的SiC單晶。2000年,他們進一步優化工藝,在100~200 bar(1 bar=100 kPa)的高壓Ar氣氛中,在1 900~2 400 ℃下,以純Si為自助熔劑利用TSSG法生長出直徑20~30 mm、厚度可達20 mm的SiC晶體[15]。此后,以TSSG法為主流技術的HTSG法再次受到高度關注。日本、韓國、法國以及中國等國家的科研工作者先后開展TSSG法生長SiC單晶襯底的研究,使得TSSG法在近年來取得了較快發展。目前用TSSG法生長SiC單晶研究的主要單位有:日本住友金屬、豐田公司、三菱電機公司、東京大學、名古屋大學、大阪大學、新州大學等,韓國陶瓷工程技術研究所、延世大學、東義大學、慶尚大學等以及中國科學院物理研究所等。
2004年,日本住友金屬的Kusunoki等[16]報道了采用TSSG法生長SiC單晶的研究結果,他們在Si熔體中加入Ti使C在高溫溶液中的溶解度提升了10倍,同時降低了晶體生長的溫度和氣壓,獲得了尺寸為12 mm×12 mm、厚0.3 mm的自支撐6H-SiC晶體,晶體生長速率為60 μm/h。在此后的十多年里,該團隊不斷改進工藝,獲得了一系列新的階段性成果,如表1和圖2所示。

表1 日本住友金屬相關團隊采用TSSG法生長SiC晶體的發展歷程Table 1 The development of SiC single crystal grown via the TSSG method by the team from Sumitomo Metal Industries Ltd. Japan
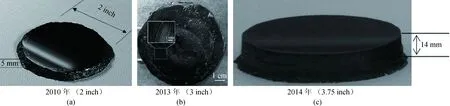
圖2 日本住友金屬相關團隊用TSSG法生長的SiC晶體的光學照片[20-22]Fig.2 Typical photo images of SiC ingots grown via the TSSG technique by the relevant team of Sumitomo Metal Industries Ltd. Japan[20-22]
2010年,豐田公司通過在Si熔體中添加Cr來提升高溫溶液對C的溶解度,將生長速率提升到300 μm/h,并在~2 000 ℃、180 kPa的Ar氣氛中生長出直徑25 mm、厚度1.65 mm的4H-SiC晶體[23]。此后的十多年里,通過開發彎月面控制技術、“凹面溶液生長”(solution growth on concave surface, SGCS)等技術和改進坩堝結構等使得晶體在生長速率、結晶質量和尺寸等方面逐步提升。2019年,該團隊采用TSSG法生長了15 mm厚的4英寸4H-SiC單晶[24]。該團隊的主要發展歷程和代表性成果如表2和圖3所示。

表2 豐田公司相關團隊用TSSG法生長SiC單晶的發展歷程Table 2 The development of SiC single crystal grown via the TSSG method by the relevant team of Toyota Corporation

圖3 豐田公司相關團隊用TSSG法生長SiC單晶的代表性成果[14,24,27]Fig.3 Representative results of SiC single crystal grown via the TSSG method by the relevant team of Toyota Corporation[14,24,27]
中國科學院物理研究所陳小龍團隊于2016年開始開展TSSG法生長SiC晶體的研究工作,成功地獲得了厚度為10 mm的2英寸4H-SiC晶體,如圖4(a)所示[28]。近期,團隊通過優化高溫溶液成分、優化溫場等措施,成功地生長出4英寸的4H-SiC晶體,晶體生長表面(0004)峰的X射線搖擺曲線的半峰全寬(FWHM)約為32.4 arcsec,如圖4(b)所示。

圖4 中國科學院物理研究所用TSSG法生長SiC單晶的代表性成果[28]Fig.4 Representative results of SiC single crystal grown via the TSSG method by the team of Institute of Physics, Chinese Academy of Science[28]
2 TSSG法生長SiC單晶的基本原理
SiC在常壓下沒有熔點,當溫度達到2 000 ℃以上會直接氣化分解。理論預測在壓強為109Pa且溫度超過3 200 ℃的極端條件下才能獲得滿足化學計量比的SiC熔體[12,29]。因此,以同成分的SiC熔體緩慢冷卻凝固,即熔體法,來實現SiC單晶生長是不可行的。
根據Si-C二元相圖,在富Si端存在“L+SiC”的二相區,這為SiC的液相法生長提供了可能。事實上,最初嘗試用液相法生長SiC單晶的一些研究中就是以純Si為自助熔劑來進行SiC的HTSG法生長[30]。但是,在2 000 ℃以下Si熔體對C的溶解度很低(不到1%),難以滿足SiC晶體生長對C元素的需求,對晶體的生長速率、結晶質量以及尺寸的提升均有很大限制,因而有效提高C元素在高溫溶液中的溶解度是更好地實現HTSG法生長SiC單晶的關鍵。雖然進一步升高溫度后,Si熔體對C的溶解度會有所提升,但會導致Si熔體大量揮發,不利于晶體生長的持續進行[31]。有兩種途徑可以克服上述局限:一種是采用高溫高壓技術,在升溫提高C的溶解度的同時利用高氣壓來抑制Si的揮發;另一種則是在Si熔體中添加對C有較高溶解度的元素(助熔劑元素),來輔助提高高溫溶液對C的溶解度。
德國埃爾蘭根大學的Hofmann等[12,15]在1999年和2000年發表的液相法生長SiC單晶生長的工作都是采用的第一種途徑。雖然這一途徑被證明是可行的,但實施起來技術難度大,生長成本高,對溶解度的提升也有限,因此沒有得到進一步的發展。相比之下,第二種途徑則更為合適,選用Si以外的其他元素(如過渡族金屬元素或稀土元素等)作助熔劑不僅可以有效提高C在高溫溶液中的溶解度,而且也可以大幅降低晶體生長的溫度和氣壓,從而降低HTSG法生長SiC單晶的技術難度和成本,因此目前被廣泛采用。
目前利用HTSG法生長SiC單晶的主流技術模式為TSSG法,圖5(a)為TSSG法生長SiC單晶的原理示意圖。通常將Si和助熔劑元素放入到高純的石墨坩堝中,將籽晶桿與冷端連接。將坩堝中的原料加熱到熔融狀態,通過控制溫場使高溫溶液在軸向上存在圖5(a)所示的溫度梯度。穩定的溫場建立后,待高溫溶液中C的濃度達到平衡時,將籽晶下推并與高溫溶液接觸,晶體生長開始。值得注意的是,高純石墨坩堝除了用于盛放高溫溶液外還為晶體生長提供C源。這主要是由于高溫溶液對C的溶解度低,為了實現大的生長量就必須在生長過程中進行C的持續補充。以高純石墨坩堝為C源,是一種簡便且有效的實現晶體生長過程中持續供C的方法。
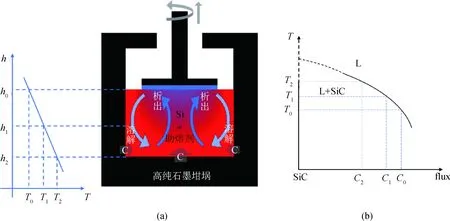
圖5 (a)TSSG法生長SiC單晶的示意圖;(b)L+SiC二相區的縱截面示意圖Fig.5 (a) Schematic diagram of SiC single crystal grown by the TSSG method; (b) schematic diagram of longitudinal section of L+SiC two-phase region
高溫溶液中可以析出單相SiC,表明在這個多元體系中存在L+SiC兩相區,將助熔劑看作整體可以定性地用圖5(b)所示的示意性相圖來描述SiC從高溫溶液中析出的熱力學過程。由L+SiC兩相區的縱截面的液相線可知,在助熔劑元素的組成和配比一定時,隨著溫度的升高,固-液平衡狀態下高溫溶液中C的平衡濃度會相應地升高。由于高溫溶液中Si的濃度遠高于C的濃度,可以近似地認為在少量SiC析出的過程中,Si和助熔劑元素的濃度保持不變,這樣高溫溶液中析出SiC晶體的驅動力f可以簡化為高溫溶液中C濃度的函數:
f∝-ΔG=RTln(C/C0)
(1)
式中:C為晶體生長界面處C的實際濃度;C0為高溫溶液在溫度為T時C的飽和濃度。當C>C0時,晶體生長的驅動力f> 0,高溫溶液處于過飽和狀態,會有SiC析出;當C≤C0時,驅動力f≤0,不會有SiC析出。晶體生長過程中,坩堝底部的高溫溶液會持續地從石墨坩堝壁溶解C,并在高溫溶液對流和溶質擴散作用下將C不斷地傳輸到溫度相對較低的晶體生長界面處,使晶體生長界面處的生長驅動力始終大于0,從而實現晶體持續生長。
理想的晶體生長狀態下,體系中主要存在以下幾個平衡:坩堝內高溫溶液中C的溶解、傳輸與消耗的平衡、坩堝中熱量輸入與耗散的平衡、晶體生長界面處溶質的傳入與單晶生長消耗的平衡,以及晶體生長界面處熱量輸入與傳出的平衡。其中溶質C的傳輸直接影響著晶體的生長,熱量傳輸所形成的溫度梯度是溶質傳輸和晶體生長的根本驅動力。高溫溶液的熱力學性質(如對C的溶解度、黏度,與SiC之間的界面能等)以及受坩堝中溫度梯度、坩堝結構和尺寸等因素影響的高溫溶液的對流形式都會直接影響整個體系對溶質C的溶解、傳輸供應和單晶生長消耗,進而影響SiC單晶的生長。一般而言,生長過程中C的供應速率越大,晶體生長界面附近的過飽和度越大,晶體的生長速率就越大。但是,過飽和度太大又會使晶體生長界面失穩,從而導致高溫溶液在晶體中的包裹和晶體表面的溝槽狀缺陷,甚至會導致SiC在高溫溶液中均勻形核,從而嚴重影響單晶的生長。因此,對高溫溶液的熱力學性質以及溶質傳輸過程和晶體生長界面處的動力學的調控以使溶質C在整個生長系統中實現良好的供需動態平衡,是更好地實現TSSG法生長SiC單晶的關鍵。
3 高溫溶液的熱力學性質
如前所述,將足夠的C溶解到高溫溶液中是實現TSSG法生長SiC單晶的核心所在,添加助熔劑元素是增加高溫溶液對C的溶解度的有效途徑。同時,助熔劑元素添加也會對高溫溶液的密度、黏度、表面張力、凝固點等與晶體生長密切相關的熱力學參數有調控作用,從而直接影響晶體生長中的熱力學和動力學過程。因而,助熔劑元素的選取是實現TSSG法生長SiC單晶中最為關鍵的一步,對晶體生長過程起著決定性作用,也是該領域的研究重點。在選取助熔劑元素時一般要遵循以下幾個原則:
(1)對C的溶解度大:提高C的溶解度是選用助熔劑元素最核心的目的,高溫溶液對C具有合適的溶解度才能夠為晶體快速、穩定、持續的生長提供充足的原料供應,選取時一般以相圖為主要參考依據。
(2)化學穩定性好:助熔劑元素在高溫下不會與Si或C直接反應形成高溫相。
(3)熱穩定性好:助熔劑元素的飽和蒸氣壓要盡可能小,不易揮發。
(4)傳質能力強:加入助熔劑元素后,高溫溶液應具有凝固點低、黏度小、流動性好等有利于溶質快速傳輸的性質。
(5)潤濕性好:高溫溶液對SiC籽晶有好的潤濕性,生長表面與高溫溶液才能夠充分、穩定地接觸。
(6)非故意摻雜少:一般來講,助熔劑元素的原子半徑越大越不容易摻雜到晶體晶格中。
(7)相組成單一:在生長溫度附近的固-液兩相區內,SiC應是高溫溶液中唯一穩定的固相。
(8)成本低、環境友好:最終要實現產業化,助熔劑元素的成本要盡可能低,且要無毒無害、可回收、易處理,最好能夠實現助熔劑元素的重復再利用。
為了探索出合適的高溫溶液組成,多年來研究者們對過渡族金屬元素和稀土元素等可能的助熔劑元素進行了探索研究,文獻中報道較多的為二元的高溫溶液體系,常見的有Li-Si[32,33]、Ti-Si[16-21,34-39]、Cr-Si[6-7,14,23-27,40-47]、Fe-Si[48-50]、Sc-Si[51]、Ni-Si[52]和Co-Si[53]等。從目前已發表的文章數量和所報道的實驗結果來看,Cr-Si、Ti-Si和Fe-Si二元體系以及Cr-Ce-Al-Si等多元體系發展得較好,并且獲得了較好的晶體生長結果。
一般而言,高溫溶液對C的溶解度越大,越有利于晶體生長速率和晶體質量的提升。2020年,日本東北大學的Kawanishi等總結了Cr-Si、Ti-Si和Fe-Si三種不同高溫溶液體系下SiC生長速率和溫度之間的關系,如圖6(a)所示。可以看到,在相同溫度下Cr-Si體系可以實現更高的晶體生長速率,且晶體生長速率會隨著Cr含量的增加而增大[6]。2018年,Hyun等為了進一步提升Si-Cr二元高溫溶液對C的溶解度,設計了組成配比為Si0.56Cr0.4M0.04(M=Sc、Ti、V、Cr、Mn、Fe、Co、Ni、Cu、Rh和Pd)的一系列高溫溶液體系,通過實驗測定、比較了這些高溫溶液中C的溶解度,結果如圖6(b)所示,其中Si0.56Cr0.4Co0.04對C的溶解度最高,為8.37%,大約是Si0.6Cr0.4的2.5倍[43]。2020年,該團隊通過向Si-Cr高溫溶液中添加少量的Co取得了很好的效果,不僅可以使晶體生長界面變得更平滑從而提高晶體的結晶質量,而且還使晶體生長速率提升了3倍之多[7]。

圖6 (a)使用不同高溫溶液體系時SiC單晶生長速率和溫度之間的關系[6];(b)1 800 ℃下組分為Si0.56Cr0.4M0.04的高溫溶液中C的溶解度(M=Al、Sc、Ti、V、Cr、Mn、Fe、Co、Ni、Cu、Rh和Pd)[43]Fig.6 (a)Relationship between SiC single crystal growth rate and temperature using different solvent systems[6]; (b) solubilities of carbon in Si0.56Cr0.4M0.04(M=Al, Sc, Ti, V, Cr, Mn, Fe, Co, Ni, Cu, Rh and Pd) solvents at 1 800 ℃[43]
除了考慮對C的溶解度外,選取助熔劑元素時也要考慮對晶體形成的非故意摻雜,摻雜濃度太高會對晶體產生非常不利的影響。Harada等通過實驗設計及測定,對B、Al、Sc、Ti、Cr、Mn、Fe、Co、Ni、Cu、Zn、Ga、Ge、Nb、Mo、Ta、W、Sn、Ag、V、Y、Zr、Mo、Hf共24種元素在作助熔劑元素時高溫溶液對C的溶解度和引起的元素在晶體中非故意摻雜量的大小進行了評估,發現并在實驗上驗證了Y-Si高溫溶液更適合用來生長高純的半絕緣SiC單晶。這為TSSG法生長高純半絕緣SiC單晶所用高溫溶液體系的設計提供了重要的參考依據[54]。
助熔劑元素添加還會對高溫溶液的密度、黏度、表面張力、凝固點等與晶體生長密切相關的熱力學參數有調控作用,會對晶體生長中的熱力學和動力學過程產生影響。2008年,日本大阪大學的Kawamura等利用Li-Si體系成功生長出塊狀的2H-SiC單晶,由于Li的加入大幅度降低高溫溶液的凝固點,生長可以在1 000 ℃以下進行,解決了2H-SiC需要在低溫環境下生長的問題,也進一步拓寬了TSSG法的應用[33]。此外,也有研究表明不同助熔劑元素的添加對晶體晶型也有影響[36,55]。2015年,Komatsu等[56]設計了組成為SiX0.05(X= B、Al、Ti、V、Cr、Ni、Ga、Ge和Sn)的高溫溶液并進行TSSG法生長SiC單晶的對照實驗,結果表明向Si熔體中添加Al、B、Sn、N和V可以使晶體生長界面更加平滑,可以抑制晶體表面溝槽狀缺陷的產生。2015年,Mitani等[57]的研究表明向Si-Cr高溫溶液中添加Al可以大幅度降低晶體生長表面生長臺階高度,有利于提高晶體的結晶質量。Komatsu等[58]于2017年發表的工作中指出,向Si-Cr中添加Al和Sn可以增大SiC與高溫溶液之間的界面能,從而有效抑制晶體生長界面處的二維形核,穩定和平滑生長界面,有利于提高晶體結晶質量。2018年,Komatsu等[44]設計了高溫溶液組成為Si0.55Cr0.4X0.05(X=B、Al、Ga、Ge、Sn、Sc、Ti、V、Mn、Fe、Co、Ni、Cu、Y、Nb、Mo、Ce和W)的晶體生長對照實驗,對各次實驗中晶體生長界面臺階的高度進行測量和統計,結果表明向Si-Cr中加入Al、Sc、Ge、Co、Sn、B和Mo可以有效地降低晶體生長臺階的高度,其中Al和Sc的效果最為明顯。2021年日本東京工業大學Daikoku等[59]用靜電懸浮法測量了Cr含量分別為18%、40%和50%(摩爾分數)的Si-Cr高溫溶液在不同溫度下的密度、表面張力和黏度。結果表明,相同溫度下隨著高溫溶液中Cr含量的升高,高溫溶液的密度、表面張力和黏度均會增大,為計算機模擬晶體生長過程提供了重要的數據支撐,對優化晶體生長工藝有重要的指導意義。
4 生長動力學
高溫溶液的組成與配比直接決定了其熱力學性質,優化高溫溶液組成可以為SiC晶體生長奠定一個好的熱力學基礎。為更好地獲得高質量的SiC單晶,還需要調控晶體析出的動力學過程。因此,TSSG法生長SiC單晶的另一個研究重點是對高溫溶液中和晶體生長界面中的動力學過程的調控。從TSSG法生長SiC單晶的原理可知,晶體生長中動力學過程的調控手段主要有:籽晶和坩堝的旋轉與提拉工藝[14,18,22,25,42,60-62]、生長系統中溫場的調控[14,26,63-64]、坩堝結構與尺寸的優化[24,26,38,61,64-67]以及外加磁場調控高溫溶液對流[68]等。動力學調控的根本目的是對高溫溶液和晶體生長界面處的溫場、流場及溶質濃度場進行調控,從而更好、更快地從高溫溶液中有序析出SiC,并長成高質量的大尺寸單晶。在調控的過程中,計算機模擬[38,64-65,67-83]有著很重要的輔助和指導意義。
Kusunoki等[18]于2006年報道的工作中采用“坩堝加速旋轉技術”(accelerated crucible rotation technique, ACRT)增強了坩堝中溶質的傳輸速率,使晶體生長速率和質量有了明顯提升。2015年,Kurashige等[61]對該技術進行了進一步的研究和優化。Kado等[26]在2013年的報道中稱,通過減小坩堝的高度來增加籽晶背向的溫度梯度,增強了生長界面處晶體生長的動力學過程,在保證晶體結晶質量的同時使晶體生長速率提高到了2 mm/h。2016年,Daikoku等[14]開發了一種 “凹面溶液生長”技術(solution growth on concave surface, SGCS),該技術通過調整彎月面高度使晶體生長表面呈凹形,這樣可以使高溫溶液的流動方向與晶體生長表面的臺階流方向相反,使溶質能夠更快地到達生長臺階處,從而使晶體生長表面更光滑,并且有效地抑制了中高溫溶液在晶體中的包裹。Kusunoki等[38]于2014年通過在坩堝內添加石墨環結構作為浸沒導向器(immersion guide, IG)來實現高溫溶液對流的調控,通過優化石墨環的尺寸和位置可以在籽晶下方的高溫溶液中建立均勻向上的溶質傳輸模式,從而使晶體生長速率和質量均有所提升,如圖7所示。2014年, Kusunoki等[22]通過對晶體生長過程中彎月面高度的精確控制,實現了晶體長時間的穩定生長。Ha等[82]通過實驗和計算機模擬研究、分析了晶體生長界面附近溫度梯度對晶體生長的影響,結果表明晶體生長界面附近小的溫度梯度更有利于SiC單晶的穩定生長。

圖7 (a)坩堝中高溫溶液流動和溫度分布的模擬結果:(a1)坩堝中沒有IG;(a2)坩堝中有IG0.77;(a3)坩堝中有IG0.51(其中“IG0.77”和“IG0.51”表示IG內徑與坩堝內徑之比分別為0.77和0.51),均勻的向上流動是通過分離IG0.77中的上角流動(U)和下角流動(L)來建立的。(b)實驗裝置示意圖及結果匯總:(b1)高溫溶液生長系統的配置;(b2)帶有IG的坩堝示意圖;(b3)生長率隨IG的變化,虛線表示實驗測得的速率,實線表示通過模擬獲得的速率[38]Fig.7 (a)Simulation of the solution flow and temperature distribution in the crucible: (a1) without IG, (a2) with IG 0.77, and (a3) with IG0.51 (“IG0.77” and “IG0.51” denote that the ratios of the inner diameter of IG to that of the crucible are 0.77 and 0.51, respectively). Note that the homogenous upward flow is established by separating the upper-corner flow (U) and the lower-corner flow(L)in IG0.77. (b) Schematic diagram of experimental device and the results summary: (b1) configuration of the solution growth system; (b2) schematic view of the crucible with IG; (b3) variation of the growth rate with IG.(Open marks show the experimentally obtained rate, whereas solid marks indicate the rate obtained by simulation)[38]
發展原位觀測技術對于了解TSSG法生長SiC單晶中晶體生長界面的動力學過程和晶體生長機理有著重要意義。2016年,日本東京大學Kawanishi等原位觀察了1 673 K下在Fe-Si高溫溶液中生長SiC單晶時生長界面的動力學過程。研究發現,SiC晶體生長初始階段的生長界面由許多臺階流組成,其產生于4H-SiC 的螺旋生長或其他晶型SiC的二維島狀生長,還觀察了兩個不同螺旋生長域的臺階相遇的過程,發現需要一定的臺階高度才能通過臺階流覆蓋螺旋中心,從而阻止螺旋生長[84]。2018年,該團隊利用同樣的技術觀察和分析了晶體生長界面處發生3C-SiC晶型轉變時SiC的形核行為,研究表明,提高生長溫度和降低生長界面處的過飽和度可以大幅減小二維島狀形核的形核密度[50]。日本東北大學的Matsumoto等于2017年發展了原位共聚焦激光掃描顯微鏡技術,對TSSG法生長SiC單晶過程中的生長界面進行了原位觀察,實現了在納米級尺度上觀察和分析TSSG法生長SiC單晶的生長動力學過程,如圖8所示。研究發現在高溫溶液中添加少量的Al可以有效抑制臺階聚并,從而降低臺階流的高度,有利于獲得結晶質量高、缺陷密度低的SiC單晶[85],該研究結果與之前的研究結果一致[58]。
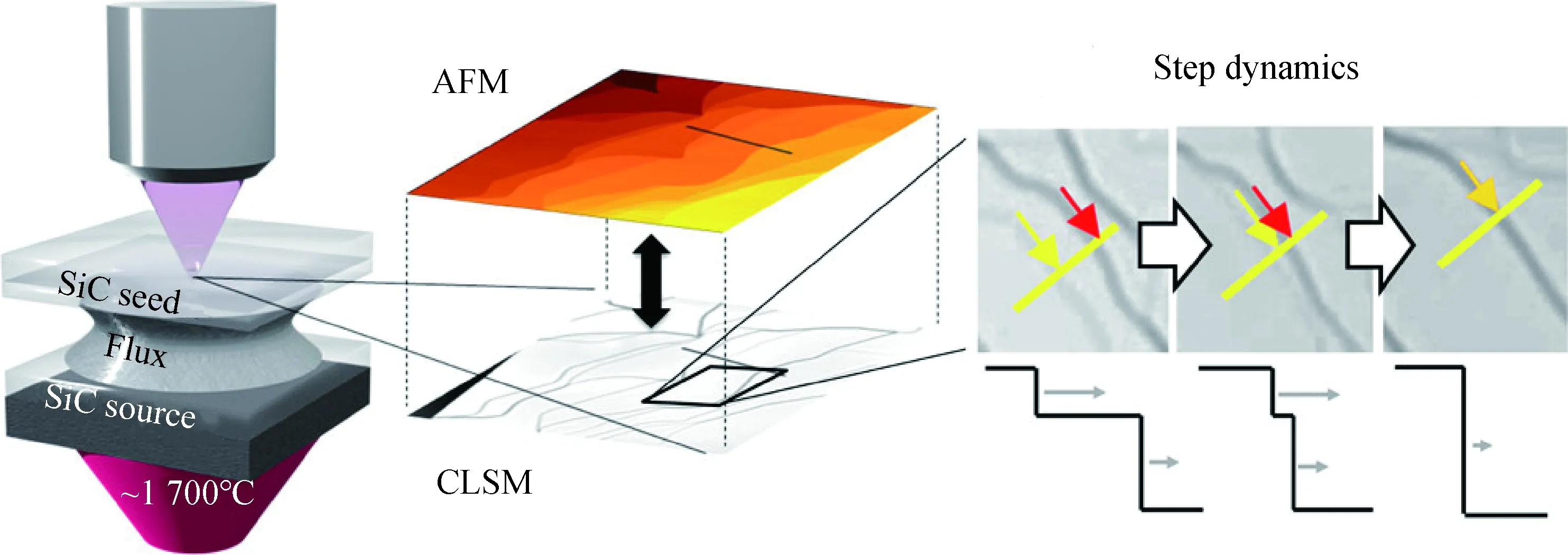
圖8 原位共聚焦激光掃描顯微鏡技術實時觀測TSSG法生長SiC單晶過程中臺階流的演變過程[85]Fig.8 In situ confocal laser scanning microscope (CLSM) technique for the observation of the step dynamics during the growth of SiC single crystal via TSSG[85]
5 TSSG法生長SiC單晶的優勢
TSSG法之所以在近些年來受到越來越多的關注,主要是由于其存在許多方面的優勢,具有很大的應用潛力,具體體現在以下幾個方面:
5.1 微管和位錯
微管及一些宏觀缺陷的存在會對SiC器件的性能產生致命性的影響。在PVT法生長的SiC單晶中非常容易形成微管,而且籽晶或襯底中的微管在PVT法生長的過程中也很容易被繼承并延伸到后續生長的晶體中。因此,獲得更高質量的SiC單晶對于PVT法來說具有很大的挑戰。大量的研究表明,TSSG法生長SiC單晶的過程中不會產生微管,并且可以有效地復合籽晶中固有的微管及一些其他宏觀缺陷,從而大幅提升晶體的質量,有利于獲得更高質量的SiC單晶。1996年,Yakimova等[86]發現液相外延SiC可以很好地覆蓋襯底中原有的微管缺陷,從而獲得無微管的高質量SiC單晶。1999年,Hofmann等[12]通過光學顯微鏡觀察并證明了TSSG法生長SiC單晶的過程中微管可以被有效覆蓋,如圖9所示。Khan等[87]借助X射線衍射、光學顯微鏡以及掃描電鏡等也證實了液相外延可以有效地修復襯底中的微管和其他宏觀缺陷,并且可以大幅地降低晶體中的位錯密度。Ujihara等[88-89]利用拉曼光譜同樣證實了液相外延生長的SiC可以有效地覆蓋襯底中的固有缺陷,使晶體質量大幅提升。因此,利用TSSG法生長SiC單晶可以完全避免微管的產生,并且可以閉合籽晶中的微管、修復籽晶中的宏觀缺陷,更容易獲得高質量的SiC單晶。
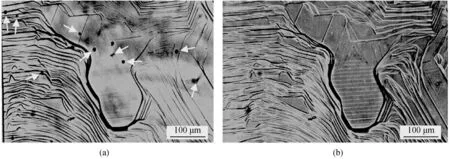
圖9 TSSG法生長SiC單晶過程中微管的消除:(a)TSSG法生長后的SiC晶體在透射模式下的光學顯微照片,可以清楚地看到位于生長層下方的微管;(b)相同區域在反射模式下的光學顯微照片,表明微管已經被全部覆蓋[12]Fig.9 Elimination of micropipes during the SiC growth by TSSG: (a) SiC crystal layer in transmission microscopy, showing a multitude of micropipes beneath the surface; (b) identical area as (a) in reflection light microscopy, showing that micropipes were eliminated[12]
大量的研究證明TSSG法生長SiC單晶的過程中位錯會發生轉變進而消失[90-101]。圖10是日本名古屋大學Harada等給出的位錯轉變機理示意圖[94],在TSSG法生長SiC過程中,臺階流會迫使籽晶中位錯線原本垂直于生長臺階流方向的螺位錯(TSDs)和刃位錯(TEDs)轉變為位錯線與臺階流相平行的堆垛層錯(SFs),SF隨著臺階流生長進行橫向擴展,并最終終止于晶體的側邊緣。這樣便可以極大地減少籽晶中位錯在后續生長中的繼承和延伸,大幅降低晶體中的位錯密度。

圖10 在偏角籽晶上用HTSG法生長SiC時晶體中位錯轉變的示意圖。(a)晶體生長前;(b)生長初期生長臺階流使位錯線方向發生轉變;(c)生長后期位錯線終止于晶體側面,晶體中的位錯密度大大降低[94]Fig.10 Schematic illustration of the dislocation conversion in the solution growth of SiC single crystal on an off-axis seed by HTSG. (a) TSDs in the seed before growth; (b) conversion of TSDs in the seed into SFs in the growth process; (c) as the growth proceeds, SFs will be excluded from the lateral face of the crystal and high quality SiC single crystal without TSDs will be obtained finally[94]
5.2 擴 徑
目前SiC襯底及器件制造成本高是限制SiC進一步推廣應用的主要因素之一,增大單晶尺寸可以有效地提高器件的生產效率,降低單個器件的制造成本,因此各國的研究者們都在研發SiC的擴徑技術和工藝,希望通過不斷擴大單晶的尺寸來達到提高產量、降低成本的目的[31]。PVT法是目前用來生長SiC單晶的主流方法,也是唯一實現了大規模商業化的方法。雖然該方法已經取得了很大的進展,但回顧其發展歷程可以發現其擴徑速率是相當緩慢的。SiC單晶生長領域中的領跑者Cree公司,30多年前就已經成功生長了2 英寸的SiC單晶,但到目前為止其8 英寸SiC單晶襯底仍未實現商業化,PVT法擴徑技術的難度之大可見一斑。TSSG法在擴徑方面則有著天然的優勢,其在生長過程中可以相對容易地通過調整提拉速度實現晶體的放肩擴徑。
豐田公司和住友公司的相關研究團隊采用了一種“彎月面高度控制”的技術成功實現了人為可調控的晶體擴徑。在TSSG法生長晶體的過程中,在表面張力的作用下,晶體與高溫溶液之間會形成具有一定高度的彎月面, 研究者通過在生長過程中調整籽晶的提拉速度來調整彎月面的高度,以調控生長角θ,如圖11(a)和(b)所示。一般而言,提拉速度越小,所形成的彎月面高度越小,晶體的生長角θ值越大,這樣可獲得的晶體的擴徑速率就越大[25]。圖11(c)~(e)是該研究團隊給出的控制不同彎月面高度獲得的晶體的形貌圖。

圖11 (a)TSSG法中彎月面控制技術示意圖;(b)生長角θ隨彎月面高度的變化圖及通過該技術獲得的SiC晶體的側視圖:(c)彎月面高度為2.5 mm下生長20 h;(d)彎月面高度為0.5 mm下生長10 h;(e)生長35 h,彎月面高度從1.5 mm逐漸增大到更大的值[25]Fig.11 (a)Schematic of the configuration of the meniscus tuning growth method by TSSG; (b) relationship between the growth angle θ and the meniscus height; side views of 4H-SiC single crystals grown by the meniscus tuning growth method: (c) growth for 20 h with a meniscus height of 2.5 mm; (d) growth for 10 h with a meniscus height of 0.5 mm; (e) growth for 35 h with changing the meniscus height from 1.5 mm to a higher value[25]
通過擴徑也可以大幅度地降低晶體中的位錯密度。圖12為該研究團隊給出的通過TSSG法擴徑生長的SiC單晶及其中心區域和邊緣擴徑區域的反射X射線形貌照片。晶體在籽晶正下方的中心區域有較高的位錯密度,而在偏離籽晶正下方的邊緣擴徑區域幾乎觀察不到位錯的存在,這主要是由于籽晶中的固有位錯在生長過程中不會延伸到擴徑區,因此擴徑區中位錯密度更低[42]。
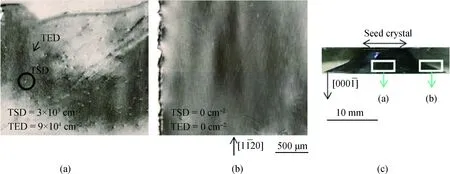
圖12 TSSG法擴徑后的晶片及其反射X射線形貌圖晶片中心區域的反射X射線形貌圖;(b)晶片邊緣擴徑區域的反射X射線形貌圖。(c)TSSG法擴徑后的晶片及反射X射線形貌表征對應的位置[42]Fig.12 Reflection X-ray topograph of 4H-SiC(0001) wafer with a diameter of 25 mm grown from a 12 mm-diameter seed. Reflection X-ray topographs were taken at (a) center and (b) periphery of the wafer; (c) the 4H-SiC(0001) wafer grown by the TSSG method and the localizations being characterized by the X-ray topography[42]
5.3 生長過程中的可調控性
晶體生長是一個動態的過程,在晶體生長過程中施加動態的調控來保證晶體生長過程中生長界面處的狀態持續穩定對于保證晶體結晶質量有重要的意義,長時間的生長過程更是如此。采用PVT法生長SiC單晶中,為了防止SiC分解后氣相物質的大量流失,坩堝必須是封閉的,晶體生長過程中坩堝內部處于一種“黑箱”狀態,晶體生長過程的動態調控受到了很大的限制。相比之下,TSSG法生長SiC單晶的生長系統更為“開放”,晶體生長過程中可實現動態調控的參數更多,對晶體生長過程進行精細化調控的空間更大。比如,通過調整籽晶和坩堝的旋轉工藝可以實現對高溫溶液中溫場、對流模式以及溶質濃度分布的調控[14,18,61];通過調整晶體生長過程中籽晶的提拉速度可以調控晶體的生長速率和生長形態[14,22];還可以借助紅外測溫及成像技術對晶體生長過程進行實時的監測與調控。隨著TSSG法生長SiC單晶相關技術的不斷突破,這方面的優勢將逐步凸顯。
5.4 p型摻雜
n型溝道的SiC絕緣柵雙極型晶體管(n-channel insulated gate bipolar transistors, SiC IGBTs)作為高壓開關有非常大的性能優勢和應用前景,該器件的制作需要用到高摻雜濃度、低電阻率的p型SiC襯底。然而,目前商用的p型SiC單晶具有晶體結晶質量差、電阻率高(約2.5 Ω·cm)等缺點[31,102],限制了n型溝道SiC IGBT的性能。采用PVT法之所以難以獲得高摻雜濃度、高質量的p型SiC單晶主要受以下兩方面因素限制:一方面,實現p型摻雜的Al源在晶體生長條件下的飽和蒸氣壓太大,在晶體生長初期Al源就會很快被耗盡,導致晶體中Al的摻雜濃度極不均勻,難以實現持續穩定的p型摻雜[103];另一方面,有研究表明PVT法生長p型SiC晶體時,晶體生長界面處高濃度的Al會嚴重影響晶體的結晶質量,導致大的缺陷密度[104]。
TSSG法則不存在上述局限,在晶體生長中只要向高溫溶液中添加一定量的Al便可以對晶體進行持續穩定的p型摻雜。這主要是由于TSSG法的生長溫度相對較低,而且將Al分散在高溫溶液中也可以進一步抑制Al的揮發。晶體生長的過程中,在溶質分凝和擴散的作用下晶體生長界面處的Al濃度會形成一個動態平衡的穩態分布,從而可以實現Al在晶體中的持續穩定的摻雜,且可以根據Al溶質在晶體中的平衡分凝系數來實現晶體中摻雜濃度的大范圍精確調控。豐田公司的Shirai等于2014年報道了其通過TSSG法生長的低電阻率p型4H-SiC晶體,如圖13所示。該團隊利用TSSG法在Si-Cr-Al 高溫溶液中生長出了厚度為5 mm的高質量p型4H-SiC晶錠,晶體生長速率高達1 mm/h,晶體中Al摻雜濃度分布也比較均勻,電阻率僅有35 mΩ·cm[40]。這充分證實了TSSG法在生長低電阻率、高結晶質量的p型SiC單晶方面的優勢。
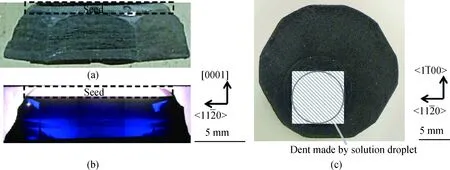
圖13 (a)TSSG法生長的p型SiC單晶的側視圖;(b)晶體縱切片的透射光學照片;(c)從Al含量為3%(原子數分數)的高溫溶液中生長的晶體的上表面形貌圖[40]Fig.13 Side view (a), transmission optical image of cross section (b), and top view (c) of p-type SiC single crystal grown from solution with an Al content of 3% (atomic number fraction)[40]
6 結語與展望
TSSG法生長SiC單晶技術,因具有生長溫度低、易擴徑、易實現p型摻雜、生長的晶體結晶質量高等優勢,近20年來受到了越來越多研究者的關注,獲得了極大的發展。少數團隊目前已經通過TSSG法生長出高質量的4 英寸SiC單晶。TSSG法生長SiC單晶技術的進一步發展還需要從以下幾個關鍵方面去重點突破:
(1)溶液熱力學性質的深入研究。由于生長溫度高,測試難度大,目前人們對TSSG法生長SiC單晶中高溫溶液的凝固點、表面張力、黏度以及相關的相圖等對晶體生長非常關鍵的熱力學參數以及這些參數受高溫溶液的組成與配比的影響尚不明確。深入研究并掌握高溫溶液的熱力學性質和調控方法,對于TSSG法生長SiC單晶技術的進一步突破有著重要的指導性意義。多元高溫溶液的熱力學性質有更大的調控空間,是將來的發展趨勢。
(2)生長速率和結晶質量的平衡。平衡好晶體生長速率和結晶質量之間的矛盾是有效提高晶體生長速率的關鍵。在TSSG法生長SiC單晶的過程中,如果生長速率太大,則非常容易產生高溫溶液包裹、表面宏觀溝槽以及多晶等嚴重影響晶體結晶質量的缺陷,嚴重時會引起晶體的開裂。深入研究產生這些缺陷的根本原因、了解晶體生長界面處的熱力學和動力學過程及其影響因素,對于平衡上述矛盾并有效提高晶體生長速率有著重要的意義。
(3)持穩性晶體生長條件的建立。目前TSSG法通常以高純石墨坩堝作為晶體生長的C源,隨著晶體生長的進行坩堝內壁會被不斷地腐蝕消耗,導致液面不斷下降、晶體生長界面處溫場不斷變化,如果生長時間太長,坩堝壁甚至會被腐蝕穿,這給晶體的長時間穩定生長帶來了一定的挑戰。探索更加合理的溶質供應途徑以提升晶體生長環境的持穩性是非常必要的。
(4)精細化動態調控技術的開發。晶體生長過程中可調控性強是利用TSSG法生長SiC單晶的一個重要優勢,充分利用并發揮好這一優勢對于將來TSSG法生長SiC單晶技術的進一步提升有著重要的意義。有效開發并利用這一技術的前提是要深刻地認識TSSG法生長SiC單晶的生長機理、生長過程、生長過程中的變量與不變量以及調控手段對晶體生長的影響,在此基礎上借助先進的原位觀測技術和精準控制技術就可以很好地發揮晶體生長過程中動態調控的優勢。動態調控的根本目的是實現晶體生長的核心參數,如晶體生長界面處的生長驅動力等,在生長過程中始終高度穩定地保持在最佳范圍,這樣對進一步提升晶體質量和晶體的均一性有重要的意義。
雖然TSSG法目前和PVT法相比還存在一定的差距,但相信在該領域研究工作者們的不斷努力下,隨著TSSG法生長SiC單晶中核心科學問題的不斷解決和生長工藝中關鍵技術的持續突破,該技術也將實現產業化,從而充分發揮TSSG法生長SiC單晶技術的潛力,并進一步促進和推動SiC產業的快速發展。

