變摻雜變組分AlxGa1-xAs/GaAs 反射式光電陰極分辨力特性*
鄧文娟 朱斌 王壯飛 彭新村 鄒繼軍
1) (東華理工大學,核技術應用教育部工程研究中心,南昌 330013)
2) (東華理工大學,江西省新能源工藝及裝備工程技術中心,南昌 330013)
根據建立的變摻雜變組分反射式AlxGa1–xAs/GaAs 光電陰極的分辨力模型以及調制傳遞函數(MTF)理論模型,仿真了材料中摻雜濃度線性變化、Al 組分線性變化,摻雜濃度均勻不變、Al 組分線性變化,摻雜濃度線性變化、Al 組分均勻不變,摻雜濃度均勻不變、Al 組分均勻不變這4 種不同結構反射式光電陰極的分辨力特性.分析了Al 組分、摻雜濃度、AlxGa1–xAs 層厚度、GaAs 層厚度和入射光波長對陰極分辨力的影響.仿真結果表明,陰極材料中摻雜濃度梯度變化以及Al 組分梯度變化都可以提高反射式AlxGa1–xAs/GaAs 光電陰極的分辨力,其中摻雜濃度線性變化的同時,Al 組分線性變化對AlxGa1–xAs/GaAs 光電陰極分辨力的影響最為明顯.仿真結果還表明:Al 組分從0.45 線性變化至0 時,陰極分辨力最好;摻雜濃度從1019—1018 cm–3 線性變化比保持1019 cm–3 不變,陰極分辨力更好;而陰極中AlxGa1–xAs、GaAs 層厚度以及入射光波長對4 種陰極分辨力的影響則有著不同的變化規律.
1 引言
負電子親和勢GaAs 基光電陰極是像增強器、光電倍增管以及低能電子顯微鏡的關鍵組件[1?4],被廣泛用于電子源和電子加速器裝置[5?8].反射式光電陰極因其量子效率高及工藝簡單的特點,越來越廣泛應用于像增強器中[9].對于光電陰極,人們主要關注其量子效率和能量分布,而較少關注其分辨力特性,尤其對于反射式光電陰極分辨力特性的研究更少[10,11].在計算像增強器、光電倍增管等的分辨力時,光電陰極分辨力對器件總分辨力的影響常被忽略.然而,光電陰極中光電子轉化時,會降低其分辨力,并將傳遞給后級像處理器.因而,研究光電陰極的分辨力特性,對于提高像增強器的分辨力是有意義的[12].前期研究顯示,材料中摻雜濃度梯度變化以及Al 組分梯度變化引起的能帶變化形成的器件內建電場,對AlxGa1–xAs/GaAs 光電陰極的量子效率有較大影響[13,14],一定程度上影響其分辨力[15,16].而且,梯度變化的Al 組分結構比梯度變化的摻雜結構引起的電場變化大得多,結構變化產生的內建電場促使光生載流子朝陰極表面移動,從而減少了其橫向擴散.如圖1(a)所示,在陰極表面,點光源照射產生的彌散圓斑,Al 組分梯度變化結構的最小,摻雜濃度梯度變化摻雜結構其次,Al 組分為0 摻雜均勻不變結構的最大.
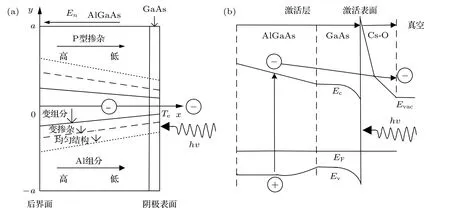
圖1 變摻雜變組分AlxGa1–xAs/GaAs 反射式光電陰極結構示意圖 (a) 結構及電場影響圖;(b) 能帶圖(Ec 為導帶底,Ev 為價帶頂,Evac 為真空能級,EF 為費米能級,Te 為激活層厚度)Fig.1.Structure diagram of varying doping and varying composition reflection-mode AlxGa1–xAs/GaAs photocathodes:(a) Structure and electric field effect diagram;(b) band structure (Ec is the conduction band minimum,Ev is the valence band peak level,Evac is the vacumm level,EF is the Fermi level,Te is the thickness of active layer).
Al 組分變化形式、摻雜變化形式對反射式光電陰極分辨力會有怎樣的影響? 根據前期研究,材料中Al 組分或摻雜濃度線性變化比指數變化結構對陰極調制傳遞函數(MTF)的影響更大[17],因此,本文討論摻雜濃度線性變化、Al 組分線性變化,摻雜濃度均勻不變、Al 組分線性變化,摻雜濃度線性變化、Al 組分均勻不變,摻雜濃度均勻不變、Al 組分均勻不變這4 種結構的MTF 值,以及有源層厚度變化,入射光波長變化等因素對反射式光電陰極分辨力的影響.為方便描述,論文中陰極材料摻雜濃度變化稱為變摻雜,Al 組分變化稱為變組分,摻雜濃度線性變化稱為線性摻雜,摻雜濃度不變化稱為均勻摻雜,Al 組分線性變化稱為線性組分,而Al 組分為0 稱為均勻組分,因此以上4 種結構分別簡稱為線性摻雜線性組分、均勻摻雜線性組分、線性摻雜均勻組分、均勻組分均勻摻雜反射式AlxGa1–xAs/GaAs 光電陰極.
2 變摻雜變組分反射式光電陰極的分辨力模型
反射式AlxGa1–xAs/GaAs 光電陰極結構圖及能帶圖如圖1 所示.光從GaAs 層入射,電子也從GaAs 面發射.變組分為從AlxGa1–xAs 層到GaAs層方向Al 組分逐漸降低,變摻雜為從AlxGa1–xAs層到GaAs 層方向摻雜濃度逐漸降低,GaAs 層均勻摻雜;均勻結構則為從AlxGa1–xAs 層到GaAs層組分為0 或者摻雜不變.
當一束強度為I(y,f)[1+cos(2πfy)] 的光從陰極表面垂直照射進入變摻雜變組分反射式光電陰極,光電子在二維變摻雜變組分材料中經過產生、漂移、擴散、復合等過程到達陰極表面并發射出去,其所遵循的二維連續方程為

式中,光電子產生函數為

邊界條件為

這里,Dn(x)為電子擴散系數,n(x,y) 為電子濃度,μn(x)為電子遷移率,E(x,y) 為內建電場強度,U(x)為載流子總復合,G(x)為光電子產生,Te為陰極厚度,α(x)為光子吸收系數,I(y,f) 為入射光強度,R(x) 為反射率.
空間頻率為f的信號在相面上的對比度Co(f)與物面上的對比度Ci(f) 的比值,即為MTF:

對于一定空間頻率的余弦光柵成像,物面上的對比度為1,反射式光電陰極像面上對比度實際為發射電流密度的對比度.仿真中用到的其他材料參數包括:電子遷移率2000 cm2·V–1·s–1,空穴遷移率150 cm2·V–1·s–1;室溫下本征電子壽命10 ns,本征空穴壽命30 ns[18?21].
3 反射式光電陰極MTF 值及其影響因素
3.1 Al 組分變化
空間頻率范圍為0—2400 lp/mm 時,不同結構AlxGa1–xAs/GaAs 光電陰極的MTF 值如圖2所示,設定空間頻率f=0 時,陰極MTF 值為1.圖2(a)中Al 組分分別從0.45,0.35,0.25,0.15 線性變化至0,而Al 組分為0 則為GaAs 結構.隨著Al 組分增加,陰極MTF 值增大,如空間頻率f=400 lp/mm,Al 組分為0.45,0.35,0.25,0.15,0 時的MTF 值分別為0.93,0.92,0.90,0.86,0.69.然而并不是Al 組分越大越好,當Al 組分超過0.45時,AlGaAs 材料變成間接帶隙,其材料特性變化較大,需要另外建模討論.此外,隨著空間頻率的增加,陰極MTF 值都減小,且Al 組分越高,其MTF 值減小越緩慢.如空間頻率f=400 lp/mm,Al 組分為0.45,0.35,0.25,0.15 和0 時的陰極分辨力與f=0 lp/mm 時相比,分別下降了7%,8%,10%,14%和31%;當f=1600 lp/mm 時,各Al 組分相對應的陰極分辨力與f=0 lp/mm 時相比,分別下降了51%,54%,57%,61%和68%.

圖2 (a)變組分及(b)變摻雜反射式AlxGa1–xAs/GaAs光電陰極的MTF 值 (a) 均勻摻雜(摻雜濃度1019 cm–3),不同Al 組分變化;(b) 變摻雜,組分從0.45—0 線性變化(結構中AlxGa1–xAs 厚度為1 μm,GaAs 厚度為10 nm,入射光波長λ 為600 nm)Fig.2.MTFs of (a) varying composition and (b) varying doping reflection-mode AlxGa1–xAs/GaAs photocathodes:(a) Uniform doping (doping concentration of 1019 cm–3),varying Al composition;(b) different doping styles,Al linearly changed from 0.45 to 0 (The thickness of AlxGa1–xAs is 1 μm,the thickness of GaAs is 10 nm,and the incident light wavelength λ is 600 nm).
3.2 摻雜濃度變化
圖2(b)仿真了摻雜濃度分別從1019—1018cm–3線性變化和保持1019cm–3不變兩種情況對陰極MTF 值的影響.隨著空間頻率增加,陰極MTF 值都減小,如空間頻率f=400 lp/mm時,以上兩種結構陰極分辨力與f=0 lp/mm 時相比,分別下降了5%和7%;當f=1600 lp/mm時,兩種結構陰極分辨力與f=0 lp/mm 時相比,分別下降了44%和51%.摻雜濃度從1019—1018cm–3線性變化時的陰極MTF 值更大,這是因為摻雜濃度梯度變化時產生的內建電場加速了載流子的定向收集,但摻雜濃度變化所產生的電場較小,因而其MTF 值變化不大.
3.3 四種不同結構的反射式光電陰極MTF 值
為了更好地討論變摻雜和變組分不同組合下的陰極MTF 值,本文基于3.1 節和3.2 節討論的Al 組分變化范圍和摻雜濃度變化范圍,對4 種不同結構反射式AlxGa1–xAs/GaAs 光電陰極進行了仿真,所采用的組分及摻雜如表1 所列.

表1 四種不同結構反射式AlxGa1–xAs/GaAs光電陰極參數Table 1.Parameters of four different reflection-mode AlxGa1–xAs/GaAs photocathodes.
圖3(a)為材料中光子的產生情況,由仿真結果可知,光從陰極表面進入體內產生的光電子濃度指數下降,主要在發射面附近.光電子產生后在材料體內經過擴散、漂移、復合最終到達陰極表面并發射.其中內建電場對光電子的輸運影響較大.表2列出了4 種結構在圖3 和表1 參數時的內建電場,在該電場作用下,光電子能較快速輸運至陰極表面,因而均勻摻雜均勻組分結構陰極MTF 值最小、線性摻雜線性組分結構陰極MTF 值最大.圖3(b)比較了4 種反射式AlxGa1–xAs/GaAs 陰極隨空間頻率變化的MTF 值.當f=400 lp/mm 時,線性摻雜線性組分、均勻摻雜線性組分、線性摻雜均勻組分以及均勻摻雜均勻組分結構陰極分辨力分別為0.95,0.93,0.78,0.69;當f=1600 lp/mm時,以上4 種結構陰極分辨力分別為0.56,0.49,0.35,0.32,其中線性摻雜線性組分結構陰極的MTF 值最高.

圖3 四種不同結構反射式AlxGa1–xAs/GaAs 光電陰極 (a) 光子產生 (f=400 lp/mm);(b) 不同空間頻率下的MTF 值(結構中AlxGa1–xAs 厚度為1 μm,GaAs 厚度為10 nm,λ=600 nm)Fig.3.Four types reflection-mode AlxGa1–xAs/GaAs photocathodes:(a) Photons generation (f=400 lp/mm);(b) MTFs with the different special frequency (The thickness of AlxGa1–xAs is 1 μm,the thickness of GaAs is 10 nm,and λ=600 nm).

表2 四種不同結構 反射式AlxGa1–xAs/GaAs光電陰極內建電場Table 2.Built-in field of four types reflection-mode AlxGa1–xAs/GaAs photocathodes.
3.4 AlxGa1–xAs 厚度及GaAs 厚度
圖4(a)顯示了AlxGa1–xAs 層厚度對反射式AlxGa1–xAs/GaAs 光電陰極MTF 值的影響.隨著AlxGa1–xAs 層厚度的增加,內建電場變弱,電子運行到陰極面的距離增大,電子的橫向擴散增加,變摻雜變組分結構陰極的MTF 值都緩慢減小,其中變組分結構的影響更明顯.以AlxGa1–xAs 層厚度從1 μm 增加到3 μm 為例,線性摻雜線性組分結構MTF 值減小了16.9%,均勻摻雜線性組分結構MTF 值減小了17.6%,線性摻雜均勻組分結構的MTF 值減小了4.4%.然而,均勻摻雜均勻組分結構陰極的MTF 值卻稍有增大,AlxGa1–xAs 層厚度從1 μm 增加到3 μm 時,其MTF 值增加了4.9%.這是因為隨著陰極厚度的增加,在后界面附近產生的光生載流子輸運到陰極表面的過程中復合增大,更少的電子能擴散到陰極表面,其橫向擴散減小,使得陰極MTF 值增大.
圖4(b)為GaAs 層厚度變化時,不同結構陰極的MTF 值.從仿真結果可知,隨著GaAs 層厚度增加,變摻雜變組分結構陰極的MTF 值都緩慢減小,其中變組分結構的影響更明顯.以GaAs 層厚度從10 nm 增加到0.6 μm 為例,線性摻雜線性組分結構MTF 值減小了40.7%,均勻摻雜線性組分結構陰極MTF 值減小了36.5%,線性摻雜均勻組分結構陰極MTF 值減小了16%;然而,均勻摻雜均勻組分結構陰極MTF 值隨著GaAs 層厚度從10 nm 增加到0.6 μm 稍有增加.分析其原因,變組分AlxGa1–xAs 層的內建電場較大[16],光生載流子在內建電場下被迅速漂移至GaAs 層,隨著GaAs 層厚度增加,在GaAs 層載流子橫向擴散增加,因而其分辨力減小.然而,均勻摻雜均勻組分結構陰極不存在內建電場,后界面復合影響使更少的電子能輸運到陰極表面,其橫向擴散減小,使得陰極MTF 值微弱增大.陰極分辨力特性與其量子效率有時是相互矛盾的特性參數,分辨力的增加可能會伴隨量子效率的減小[9],因而結構設計中需要合理設計陰極各層厚度.

圖4 變摻雜 變組分反射 式AlxGa1–xAs/GaAs光電陰極的MTF 值 (a) 將GaAs 層厚度固定為10 nm,改 變Alx Ga1–xAs厚度;(b) 將AlxGa1–xAs 厚度固定為1 μm,改 變GaAs 層厚度 (λ=600 nm,f=800 lp/mm)Fig.4.MTFs of varying doping and varying composition reflection-mode AlxGa1–xAs/GaAs photocathodes:(a) GaAs layer thickness is fixed at 10 nm,changing AlxGa1–xAs thickness;(b) AlxGa1–xAs layer thickness is fixed at 1 μm,changing GaAs thickness (λ=600 nm,f=800 lp/mm).
3.5 入射光波長變化
入射波長不同時,變摻雜變組分AlxGa1–xAs/GaAs 反射式光電陰極MTF 值如圖5 所示.由圖5可知,4 種結構陰極截止波長均約為870 nm.均勻摻雜均勻組分、線性摻雜均勻組分結構隨著波長增大,其MTF 值減小,這是因為這兩種結構中沒有內建電場或內建電場很小.波長變化為影響陰極MTF 值的主要因素,長波的吸收系數小,光子在更遠離表面的材料內部吸收,光電子輸運到電子表面的橫向擴散增大,因而其MTF 值減小.線性摻雜線性組分及均勻摻雜線性組分陰極的MTF 值變化則不一樣,波長從400 nm 增加到650 nm 時,其MTF 值都隨著波長增加而減小;但是波長從650 nm 增加至870 nm 時,其MTF 值隨著波長增大而增大.

圖5 不同波長入射時,變摻雜變組分反射式AlxGa1–xAs/GaAs 光電陰極MTF 值 (AlxGa1–xAs 層厚度為1 μm,GaAs 層厚度為10 nm,f=800 lp/mm)Fig.5.MTFs of varying doping and varying composition reflection-mode AlxGa1–xAs/GaAs photocathodes with different incident light wavelength (The thickness of AlxGa1–xAs is 1 μm,the thickness of GaAs is 10 nm,f=800 lp/mm).
AlxGa1–xAs 材料的能帶表達式為

由(5)式可知,當入射光波長較短時,光在材料中都能被吸收,此時變組分結構陰極MTF 值隨波長增加而減小的原因與均勻組分結構陰極一樣,也是受長波吸收系數小的影響.但是隨著波長增加,入射光只在越靠近發射面的低Al 組分區域吸收(如Al 組分為0.45 時,AlxGa1–xAs 材料的截止波長為625 nm;Al 組分為0.35 時,AlxGa1–xAs 材料的截止波長為666 nm).此時,光電子輸運到陰極表面距離更短,其橫向擴散更小,因而其MTF 值開始慢慢增大直至截止波長.然而,這個轉折點可能受陰極結構、Al 組分大小、摻雜濃度、AlxGa1–xAs 層以及GaAs 層厚度等因素影響,需要根據不同結構來具體分析.
4 結論
本文通過建立的變摻雜變組分AlxGa1–xAs/GaAs 反射式光電陰極分辨力模型,仿真了線性摻雜線性組分、均勻摻雜線性組分、線性摻雜均勻組分以及均勻摻雜均勻組分4 種結構MTF 值,討論了Al 組分變化、AlxGa1–xAs 層厚度、GaAs 層厚度、入射光波長等因素對上述4 種結構MTF 值的影響.仿真結果顯示:Al 組分從0.45 線性變化至0 時,陰極分辨力最好;摻雜濃度線性下降比保持均勻摻雜,陰極MTF 值越大;隨AlxGa1–xAs 層厚度或GaAs 層厚度增大,變摻雜或變組分陰極的MTF 值都減小,而均勻摻雜均勻組分結構陰極MTF 值均稍有變大;隨著入射光波長增大,組分不變結構陰極MTF 值減小,但變組分陰極MTF值則在400—650 nm 變化區間;隨著波長增大而減小,在650—870 nm 變化區間隨著波長增大而增大.

