Al界面層對Ti/n型6H-SiC(0001)接觸勢壘影響的研究
劉衍芳
(合肥工業大學 分析測試中心,安徽 合肥 230009)
0 引 言
碳化硅具有寬帶隙、高飽和電子遷移率等優點,在抗腐蝕度、耐磨性和熱穩定性以及晶體的多樣性等方面性能良好,使其在高溫、高頻、大功率、抗輻射的微電子及光電子器件方面有著巨大的應用潛力[1]。電子器件的性能在很大程度上受到金屬-半導體接觸的影響,在理想清潔的半導體表面沉積一層清潔的純金屬薄膜,形成緊密的接觸,是理想的金屬-半導體(M/S)接觸。但實際情況下,金屬不可能絕對純凈,半導體表面也不是完全理想的表面。半導體的晶型、摻雜情況、表面的重構以及金屬的功函數等因素都會影響金屬/半導體界面的性質[2-10],由于具體情況不同,M/S 接觸有不同的電流電壓特性,主要有2類:
(1)Schottky勢壘接觸。該類接觸有整流效應,可以制作肖特基勢壘二極管。此類二極管正向導通門限電壓和正向壓降都比PN結二極管低(約低0.2V),而且開關速度非常快,開關損耗也特別小,尤其適合于高頻應用。
(2)歐姆接觸。歐姆接觸不產生明顯的附加阻抗,可以減少接觸點的電能損耗,也不會使半導體內部的平衡載流子濃度發生顯著的改變。
由于Al的性質非常活潑,功函數較小,因此本文主要研究了Al界面層對Ti/n型6H-SiC(0001)接觸勢壘的影響。
1 實 驗
SiC襯底材料是從TANKEBLUE公司購買的n型6H-SiC(0001),厚度為0.43mm,飽和漂移速度為2×105m/s,帶隙為3.02eV,電子遷移率為400cm2/(V·s)。先將SiC放入10%的氫氟酸中浸泡5min以除去SiC表面的氧化層,再用去離子水沖洗,然后依次用丙酮清洗15min、酒精清洗10min,放入掃描電鏡室進行EBSD測試,取出迅速放入磁控濺射室鍍Ti,鍍Ti的條件為:裝置的本底真空為9×10-5Pa,功率為120W,氬氣流量為30mL/min,時間為0.5h。
另取一片SiC晶片,采用與以上同樣的方法處理,然后放入磁控濺射室中進行Al、Ti共濺射,Al、Ti的濺射功率均為120W,氬氣流量為30mL/min,時間為0.5h。將鍍Ti的SiC晶片傳入光電子能譜測試室進行氬離子刻蝕和XPS測試,該測試在國家同步輻射實驗室光電子能譜實驗站進行,實驗站包括進樣室、生長室和測試室,本底真空好于5×10-8Pa,開始時氬離子刻蝕的離子流約為23μA,每次刻蝕30min,每刻蝕一次測一次XPS圖,刻蝕7次時出現Si的2p峰,說明已經到達界面處,此時將離子流降到2.3μA,每次刻蝕5min,直至無Ti測出為止。
另將鍍Ti、Al的SiC晶片傳入光電子能譜測試室進行氬離子刻蝕和XPS測試,此測試在合肥工業大學分析測試中心的X射線光電子能譜儀進行,能譜儀型號為ESCALAB250Xi,能譜儀包括進樣室和測試室,本底真空好于5×10-8Pa,氬離子刻蝕的離子流約為6.2μA,每次刻蝕5min,每刻蝕一次測一次XPS圖,刻蝕8次時出現Si的2p峰,說明已經到達界面處,此時將離子流降到2.3μA,每次刻蝕0.5min,直至無 Ti測出為止。由于該能譜儀上的Ar離子槍與同步輻射實驗室的不同,此離子槍是小面積的,因此刻蝕速率要比大面積的快得多。
2 結果與討論
6H-SiC的菊池花樣如圖1所示,EBSD要求樣品表面非常干凈平整且無應變,由圖1可以看出,SiC表面非常干凈、平整。
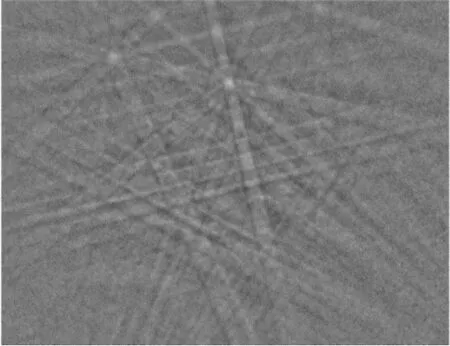
圖1 6H-SiC的菊池花樣
EBSD測得6H-SiC的極圖如圖2所示,從圖2可看到很好的六方結構的衍射花樣,有較好的取向性。

圖2 6H-SiC的極圖
Ti/n型6H-SiC(0001)不同刻蝕時間C1s的XPS圖如圖3所示。
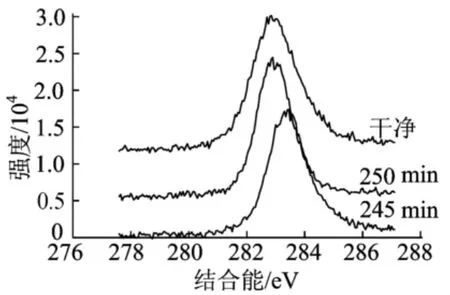
圖3 Ti/型6H-n型SiC(0001)不同刻蝕時間C1s的XPS
Ti/n-型6H-SiC(0001)接觸的勢壘高度可以采用文獻[5]提出的方法來計算,具體為:

其中,Eg為n型6H-SiC的帶隙,為3.02eV;Efi為界面處的費米能級,其表達式為:

其中,EC1s為沉積金屬后SiC中C1s結合能;(EC1s′-Ev)為干凈的SiC中C1s結合能到價帶頂的值,此值為281.26eV。
從圖3可以得出,刻蝕時間為245min時,SiC的C1s的結合能為283.39eV,從而得出Efi為2.13eV,肖特基勢壘高度為0.89eV。
XPS測得的 Ti(Al)/型6H-n型 SiC(0001)表面的Ti、Al峰的信息見表1所列,從表1可以看出,濺射的Ti、Al的相對原子百分數依次為52.53%和47.47%。

表1 Ti(Al)/n型6H-SiC(0001)表面的 Ti、Al峰的信息
Ti(Al)/n型6H-SiC(0001)不同刻蝕時間C1s的XPS圖如圖4所示,由于合肥工業大學的X射線光電子能譜儀配有磁透鏡,因此信號要比同步輻射實驗室無磁透鏡要強,但對XPS峰位沒有影響,Ti(Al)/n型6H-SiC(0001)接觸的勢壘高度也采用文獻[5]提出的方法來計算,具體與Ti/n型6H-SiC(0001)的相同。從圖4可以得出,刻蝕時間為41min時的SiC的C1s的結合能為283.57eV,從而得出Efi為2.31eV,肖特基勢壘高度為0.71eV。
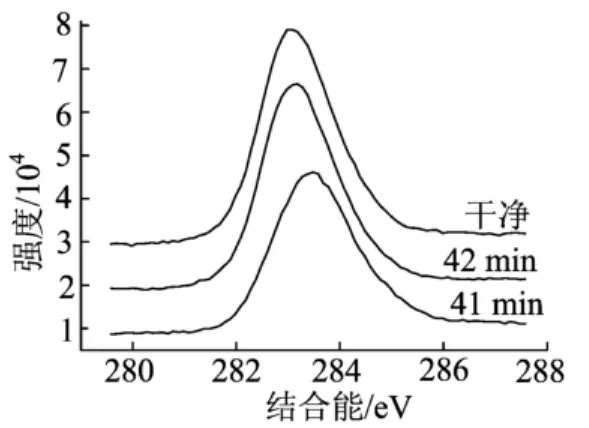
圖4 Ti(Al)/n型6H-SiC(0001)不同刻蝕時間C1s的XPS
該結果表明,相對原子百分數為47.47%的Al的存在,降低了Ti/n型6H-SiC(0001)接觸界面的勢壘高度,形成了更好的歐姆接觸,這可能是由于Al較活潑,接觸后Al表面電子向SiC轉移,從而導致勢壘高度降低。
3 結 論
由XPS測得的 Ti/n型6H-SiC(0001)和 Ti(Al)/n型6H-SiC(0001)的肖特基勢壘高度分別為0.89eV和0.71eV。結果表明,界面處摻入Al可以降低 Ti/n型6H-SiC(0001)的肖特基勢壘高度,形成更好的歐姆接觸。
[1]湯志鳴,湯文明,鄭治祥,等.SiC/M-Al金屬間化合物界面固相反應研究進展[J].合肥工業大學學報:自然科學版,2007,30(6):657-662.
[2]Kildemo M,Grossner U,Raaen S.Electronic properties of the Ce/4H-SiC interface studied by x-ray photoemission spectroscopy[J].J Appl Phys,2006,100(5):053706/6.
[3]Kennou S.An x-ray photoelectron spectroscopy and workfunction study of the Er/α-SiC(0001)interface[J].J Appl Phys,1995,78(1):587-589.
[4]Waldrop J R,Grant R W,Wang Y C,et al.Metal schottkybarrier contacts to alpha-6H-SiC [J].J Appl Phys,1992,72(10):4757-4760.
[5]Aboelfotoh M O.Schottky-barrier behavior of metals on nand p-type 6H-SiC [J].Phys Rev B,2003,67:075312/7.
[6]Waldrop J R,Grant R W.Formation and Schottky barrier height of metal contacts to beta-SiC[J].Appl Phys Lett,1990,56(6):557-559.
[7]Dontas I,Kennou S U.The interfacial properties of erbium films on the two polar faces of 6H-SiC(0001)[J].Diamond and Related Materials,2001,10:13-17.
[8]Waldrop J R.Schottky barrier height of metal contacts to ptype alpha 6H-SiC [J].J Appl Phys,1994,75(9):4548-4550.
[9]Ruffino F,Crupi I,Irrera A,et al.Room-temperature electrical characteristics of Pd/SiC diodes with embedded au nanoparticles at the interface[C]//AIP Conference Proceedings,2010,1292:103-106.
[10]趙 亮,王德君,馬繼開,等.用XPS法研究SiO2/4H/SiC界面的組成[J].半導體技術,2008,33(2):121-125.

