超高真空化學氣相沉積外延生長鍺硅材料及其應用
趙 ,張彬庭
(中國電子科技集團公司第四十八研究所,湖南長沙 410111)
元素硅半導體是半導體產業發展的基石,目前占據著統治地位,以硅為材料制作的器件被廣泛的應用于微波、微電子等領域。盡管如此,Si仍舊不能算是理想的半導體,Si的電子遷移率約只有 GaAs的 1/6,禁帶寬度只有 1.17 eV,又是間接帶隙半導體、發光效率和吸收效率較低;隨著硅集成電路晶體管尺寸的不斷減小,進一步利用尺縮效應來提高電路的性能變得越來越困難,同時將大大增加電路的制作成本。這些特性制約了硅材料在諸如高頻、高速、光電等領域的應用[1,2]。
以Si為基底的鍺硅異質結構是一種新型半導體材料,鍺硅材料的載流子遷移率高、能帶寬度隨Ge的組分變化而連續可調,如果在Si材料上生長SiGe/Si異質結構材料,則可以在Si上靈活地運用能帶工程進行能帶剪裁,制作新型Si基量子結構器件,同時又可以與成熟的Si微電子工藝相兼容,這將推動Si微電子工業跨上一個新臺階。Ge材料由于其具有比Si材料高的電子和空穴遷移率,與硅工藝兼容等優點,成為研究的熱點[3]。另外,Ge的帶隙寬度小于Si,室溫下為0.67 eV,對光通信波段1.3~1.6 μm的光具有較高的吸收系數,成為集成化光電探測器的理想材料[4]。Ge也可以作為Ⅲ-Ⅴ族光電器件與Si基集成的緩沖層[5]。在Si基上外延Ge材料對光電子集成具有重要的現實意義。因此,鍺硅材料在微電子和光電子方面有重大的應用價值,可制作高速異質結雙極型晶體管(HBT)[6],異質結場效應管(HFET)[7]、調制摻雜場效應管 (MODFET)[8],異質結紅外探測器(HIP)[9,10]、低噪聲放大器[11]等多種器件。分子束外延(MBE)和超高真空化學氣相沉積(UHVCVD)是兩種主要的低溫外延方法。由于UHVCVD成本相對較低、使用方便,易于工業化生產,是目前國際上低溫外延所采用的主要手段之一,其在鍺硅超晶格生長及硅基薄膜新材料的制備上具有良好的應用前景[12]。
1 硅基SiGe薄膜的外延生長
SiGe/Si異質結和超晶格是近年來興起的新型半導體材料,它具有許多獨特的物理性質和重要的技術應用價值,受到人們的高度重視,是“第二代硅”材料。表1列舉了Si、Ge、SiGe合金材料的一些基本性質,從表中可以看出,Si、Ge具有類似的性質和結構,使得由Si、Ge構成的SiGe合金的很多性質都與Si、Ge類似,并介于兩者之間,正是由于這些特點,使得我們可以通過改變Ge含量來影響SiGe/Si異質結構中的特性。

表 1 Si、Ge、SiGe合金材料的一些基本性質[13]
然而,由于Si和Ge的晶格失配較大,達到4.18%,在Si基上直接外延純Ge材料將引入大量的失配位錯,這將嚴重影響器件的性能。近年來,通過緩沖層技術的引入,在Si基上外延出了高質量純Ge材料。常用的一種方法是利用Ge組分漸變弛豫緩沖層技術[14,15],Ge 組分以 10%/μm 的變化速率從0變到1,將位錯壓制于緩沖層內,然后在緩沖層上外延純Ge材料作器件的有源層。Luo等人[16]采用兩層總厚度只有1.6 μm的組分躍變的SiGe層作緩沖層,1 μm厚的Ge外延層位錯密度為3×106cm-2,表面粗糙度為3.2 nm。Huang等人[17]進一步調整兩層SiGe層的組分,使得緩沖層的總厚度降低到0.5 μm,Ge晶體質量依然很好(位錯密度為7×106cm-2,表面粗糙度為 4.7 nm)。另外一種方法是采用低溫Ge作緩沖層,直接在低溫Ge上外延高溫Ge層,然后用高低溫循環退火的方法得到純Ge層[18,19]。該法將位錯壓制在低溫層內,使有源區位錯密度降低,低溫高溫兩步法的低溫緩沖層很薄(僅幾十納米),并且Ge外延層表面非常平整(粗糙度0.4~2 nm),但是位錯密度偏高(1×108cm-2),需要高溫退火進一步降低位錯密度。Nakatsuru[20]和Loh[21]等人在超薄SiGe(Ge組分0.2~0.5,SiGe層厚度5~30 nm)緩沖層上采用低溫高溫兩步法生長了高質量的Ge。此外,還有選區外延技術[18],該技術為在特定區域制備高質量的鍺硅薄膜提供了保障,也為不同材料器件間的集成提供了便利。
2 SiGe半導體薄膜外延生長設備
SiGe異質結材料的研究始于20世紀50年代中期,但由于工藝條件的原因,直到20世紀70年代初期,無論在單晶Si或單晶Ge襯底上,均未能生產出具有“器件質量”的SiGe外延層,大多出現三維島狀并產生大量的穿透位錯、堆垛位錯和裂紋。隨著近年來薄膜生長技術的長足發展,現已能生長出晶格質量優良、電光性能完美的多種SiGe/Si異質結構材料。
2.1 分子束外延
分子束外延是1970年提出的[23],在MBE中通過源分子的熱蒸發或電子束激發得到所需要的粒子,粒子到達適當加熱的襯底表面上進行生長,獲得需要的外延層,其所具有的典型低溫生長實際上排除了摻雜擴散的可能性。分子束外延系統具有超高真空(UHV,指的是比1×10-6Pa高的真空度),并配有原位監測和分析系統,能夠獲得高質量的單晶薄膜[24]。
分子束外延是首先被用來研究SiGe材料的外延工藝。在20世紀70年代中期,Kasper和其同事首先使用MBE研究在硅上生長應變SiGe層[25,26],得到Ge成分低于15%的高質量外延層薄膜,臨界厚度與理論估測相符;到20世紀80年代中期,Bean等發現在550℃條件下可以得到所有Ge成份的SiGe外延層[27,28],并研究了溫度對生長模式的影響,測量了應變SiGe的禁帶寬度[29],顯示了應變外延層器件的初步應用[30,31]。在90年代初,NEC的Hirayama等人將MBE與CVD技術相結合,形成所謂的 GSMBE[32,33],即在 MBE中采用氣體(乙硅烷、鍺烷等)作為反應源;它具有MBE的控制精度,也具有CVD的平整性的優點,生長速率和摻雜與UHVCVD的數據相接近;除此之外,GSMBE還可以進行選擇性外延。
分子束外延是制備半導體超晶格及微結構不可缺少的研究手段。但其設備復雜、價格昂貴、產量低、難于工業化,不適合于器件規模化生產,因此MBE和GSMBE主要應用于實驗室基礎研究。
2.2 超高真空化學氣相沉積
超高真空化學氣相沉積技術是20世紀80年代后期發展起來的一種新型的薄膜制備技術。人們在研究低壓CVD[34,35]的基礎上,把超高真空技術與CVD技術結合起來,發展了UHVCVD技術,其最初是由Donahue等人[36]在1986年提出的。同一年,IBM Watson研究中心的Meyerson[37]正式建立了一套UHVCVD系統,如圖1所示。系統類似于帶有裝片鎖的LPCVD爐管,其反應裝置可一次裝入35片硅片進行生長,系統的本底真空可以達到1×10-7Pa,生長壓強一般在0.1~1 Pa,反應用氣源為SiH4和GeH4,生長溫度為550~580℃,生長速率為8 nm/min。摻雜和組分控制由改變入口氣體的組成來實現。

圖1 超高真空氣相沉積系統設備圖[37]
UHVCVD外延過程屬于反應速率控制范圍,決定生長速率的是硅表面H鍵的脫附速率,而不是硅原子的表面到達率。一般而言,H鍵的脫附速率很低,這樣一方面可以在外延前利用H鍵保護,有效保證硅片表面的潔凈;另一方面限制了外延時生長速率。如同Meyerson[38]所指出:沉積速率與反應室形狀及氣流流動無關,只與硅表面H脫附的熱激活能有關,因此生長過程中表面氫的解吸速率控制著外延層的生長,從而可以很容易在整個襯底表面很均勻的生長,以及實現均勻性、可控性良好的多片生長,這可以彌補UHVCVD生長速率低的缺點,使得SiGe材料可以進行大規模生產。同時,表面氫限制生長也對溫度均勻性的控制提出了挑戰,由于H鍵脫附激活能為1.9×105J/mol,生長表面上1℃的差異可以導致沉積速率發生3%的變化,容易影響到外延的均勻性。
在SiGe外延層的生長中,典型的溫度為550~650℃,研究發現Ge的加入可以很大程度促進反應速率[39],如圖2所示。UHVCVD中硅外延速率很低,一般小于1 nm/min,如圖2中虛線所示,這是由于H原子與硅表面原子間的吸附很強;而H原子在Ge表面原子吸附較弱,很容易實現H的脫附,加上H原子可在表面自由遷移,因此表面Ge原子的存在可以有效提高硅片表面H的解附,從而提高SiGe外延的生長速率。在UHVCVD中乙硼烷是有效的P型摻雜劑,可以達到很高的摻雜程度,而N型的摻雜只能達到5×1018/cm3的程度[40],這對UHVCVD的使用產生了一些限制。

圖2 UHVCVD中外延層生長速率與Ge成分函數關系[39]
1988年,Meyerson等人[41]用此法共度生長了無缺陷的Si1-xGex(0 UHVCVD系統一般由主體部分和輔助部分組成,其中主體部分包括反應室、預處理室和進樣室;輔助部分包括真空系統、加熱及溫控系統、氣體輸送系統及計算機控制系統等。由于SiGe薄膜生長質量、膜厚均勻性、薄膜組份等對溫度均勻性、工藝氣體流量、工藝壓力控制等要求非常高。加上SiGe外延工藝環境潔凈度要求特別高,工藝過程對碳、氧污染特別敏感,要求反應室高潔凈,真空度能夠達到1×10-7~1×10-8Pa。因此用于SiGe材料外延生長的UHVCVD設備需解決的關鍵技術:超高真空度的獲取;高潔凈外延環境技術研究;高均勻性和穩定性熱場的控制;工藝氣體流量的精確控制;反應壓力的精確控制技術。其中,針對超高真空的要求,可以對設備采取如下措施:設置預真空室;真空系統的配置(預處理室可采用機械旋片泵作為前級泵,分子泵作為主抽泵,實現預備室的高真空,反應室可采用鈦升華泵);反應室密封結構的合理設計;真空管道的合理設計與加工。 超高真空化學氣相沉積系統在生長SiGe材料方面如此成功,主要歸功于以下幾點[13]: (1)UHV背景有利于保持表面干凈和生長高純材料; (2)非常低的生長壓強(<10-1Pa),保證在生長過程中潔凈的生長表面; (3)氣體流動方式介于粘滯流與分子流之間,減少氣體之間的干擾,從而減少均相成核; (4)低的粘附系數,保證多片之間的均勻生長; (5)低溫下生長外延層,自摻雜現象得到抑制; (6)相對其它生長方法,其具有生長設備簡單,產量大,易于工業化生產的特點。 SiGe/Si異質結構材料由于具有許多優于Si材料的性能,其加工工藝又與Si工藝兼容,因而成為備受矚目的硅基半導體材料。目前用Si1-xGex/Si材料制造的較成熟的高速電子器件有:Si1-xGex基區異質結雙極型晶體管(heterojunction bipolar transistor,HBT)和調制摻雜場效應晶體管(modulation-doped field-effecttransistor,MODFET)。在光電子器件領域,在(遠)紅外探測器方面有Si1-xGex/Si超晶格紅外探測器和異質結內光電發射紅外探測器(heterojunction internal photoemission infrared detectors,HIP),已實現 400×400異質結內光電發射紅外探測器陣列。Si1-xGex基區異質結雙極型晶體管HBT是應變Si1-xGex/Si材料在器件應用領域中最重要的成就,已進入商業化生產,現在正向單片集成電路發展。 提高Si基雙極型晶體管BJT運行速度的一個途徑是進一步減小器件尺寸,這要求發展更復雜的高新技術。另一個途徑是Si1-xGex基區HBT,即將SiGe能帶工程與傳統硅工藝結合,在相同的工藝條件下大幅度提高器件的特性。與采用GaAs的異質結雙極晶體管不同,SiGe HBT是通過采用減小基區的禁帶寬度來實現高的電流增益的。與硅同質結晶體管相比,SiGe HBT具有以下幾個顯著的優點[50,51]: (1)SiGe基區的禁帶寬度較窄,從而降低了導帶的勢壘高度,因而在相同的發射極-基極偏壓下,能夠顯著地提高收集極電流; (2)基區內的禁帶寬度可以是緩變的(在集電極一側帶寬較窄),從而提供了一個“內建”電場,大大提高了電子跨越基區的速度,使電子以較高的縱向的本征速度穿越過整個器件區域。 (3)HBT具有更好的低溫工作特性。 (4)由于SiGe基區與Si發射區的禁帶差別主要體現在價帶上,這相當于增加基區多數載流子渡越到發射區的勢壘高度,從而有助于器件的電流增益的提高。 表3列出了HBT的主要發展歷程,可以看到SiGe HBT的特征頻率在2003年達到了375 GHz[47],已完全具有與GaAs HBT相媲美的性能了。研究人員預計,約5年后將有室溫下500 GHz以及單位增益頻率300 GHz的SiGe器件出現。 表3 SiGe HBT的主要發展歷程[13] 圖3顯示了骨干網絡用電子器件中不同材料工藝比特率及所要求的截止頻率fT的關系,可以看到,Si雙極工藝可以滿足fT在25~50 GHz、10 Gbit/s系統的要求。對 40 Gbit/s(相應 fT在100~200 GHz)系統則必須采用SiGe、GaAs和InP器件。 圖3 骨干網絡用電子器件中不同材料工藝比特率及所要求的截止頻率fT的關系[52] 因此,就目前應用而言,SiGe HBT已經完全可以滿足高頻、高速的需求,并且在某些方面可以替代占傳統優勢地位的GaAs器件。 SiGe掩埋溝道MODFET有兩種結構,即所謂的電子和空穴量子阱MODFET,也就是N溝道和P溝道MODFET。它們是根據SiGe/Si二元體系的能帶之間的相互錯位而設計的。P型MODFET溝道為受壓應力的SiGe層與無應變的硅層相接觸時,禁帶寬度90%以上出現在價帶上,從而形成二維空穴勢阱;N型MODFET溝道則為由于張應力Si層與弛豫的SiGe層接觸時,禁帶寬度之差主要發生在導帶上,從而形成二維電子勢阱。利用這種原理制備的N-MODFET器件的最高振蕩頻率fmax已達183 GHz,模擬計算表明:柵長50nm的SiGe N-MODFET最高頻率可達300GHz;調制摻雜的SiGe溝道達到的最高空穴遷移率在296 K時為1 000 cm2/V,77 K 時達到 3 400 cm2/V[53]。 SiGe器件另外一個主要的應用是在光電子領域。目前廣泛應用的紅外凝視式成像系統中使用的是以PtSi/Si肖特基勢壘型為主的紅外探測器,其突出的優點是完全采用Si集成電路工藝;但是這種結構器件的紅外吸收區的量子效率偏低。而采用SiGe/Si異質結勢壘可以消除這一缺點。這是由于在高摻雜的SiGe合金中,空穴都集中在價帶頂到費米能級之間,摻雜濃度為1×1020/cm3時,SiGe的費米能級進入價帶的深度只有0.1~0.2 eV左右,因此被激發的光生空穴的極大部分對光生伏特效應有貢獻,從而具有很高的量子效率。目前,SiGe/Si HIP紅外焦平面陣列的集成度已達400×400單元[54]。SiGe/Si HIP的另外一個優點是對器件的截止波長可以進行調節。目前SiGe/Si HIP器件的截止波長已可以做到16 μm[55]。 Si基Ge光電探測器的研究可以追溯到1984年[56],而受到Ge外延薄膜晶體質量的制約,其快速發展開始于2000年左右。1998年,Colance等[57]采用低溫Ge緩沖層技術在UHVCVD設備上制備Ge薄膜,制作了金屬—半導體—金屬(MSM)光電探測器,器件在波長1.3 μm處的響應度為0.24 A/W,響應時間為 2 ns。2005 年,Jutzi等[58]制作了PIN同質結探測器,本征吸收區厚度為300 nm,器件的帶寬高達38.9 GHz。2009年,他們通過降低器件的串聯電阻將探測器帶寬提高到49 GHz[59]。Osmond等[60]也報道了49 GHz帶寬的探測器。Intel公司和IBM公司分別報道了波導集成PIN和MSM光電探測器,波導集成結構將探測器的量子效率—帶寬積提高了~8倍。 綜上所述,SiGe器件在通信、單芯片射頻、全球定位、信號處理等領域均有重要的應用,特別是在WLAN和GPS無線通信領域。據美國商業部預測,到2013年,全球定位系統將達到160億美元。有權威部門統計,2006年SiGe外延材料和器件市場達到了12億美元,預計到2013年SiGe IC市場規模將達到28億美元,這些都預示著鍺硅材料有著美好的應用前景。 本文綜述了Si基SiGe材料的外延生長技術、設備以及主要應用領域。通過使用UHVCVD等外延設備,綜合各種緩沖層技術,人們已經可以在Si襯底上異質外延生長出晶體質量優良的SiGe薄膜材料,并用這類材料研制出高性能雙極型異質結晶體管和調制摻雜場效應晶體管以及長波長光電探測器,并取得了重要進展。此外,近年來隨著SOI技術和SiGe技術的日漸成熟,一種基于這兩種技術的新的微電子技術應運而生-SiGe on Insulator(SiGe-OI)[61]。SiGe-OI的出現將 Si基能帶工程拓展到了SOI襯底材料上,使得器件速度、功耗等性能大為提高,應用前景非常廣闊。近年來,Si基Ge激光器也得到了很大發展,被認為是最有希望實現Si基片上集成的激光器[2]。充分發揮硅基鍺硅薄膜優良的光電特性、靈活的集成性、低廉的價格等特點,硅基光電集成將會更加快速地向前發展。 [1] L.Pavesi,G.Guillot.Optical Interconnects:The Silicon Approach[M].Berlin:Springer,2006. [2] D.Liang,J.Bowers.Recent progress in lasers on silicon[J].Nature Photon,2010,4:511-517. [3] L.L.Minjoo,A.F.Eugene,T.B.Mayank,et al.Strained Si,SiGe,and Ge channels for high-mobility metal-oxidesemiconductor field-effect transistors[J].J.Appl.Phys.,2005,97(1):011101. [4] L.Colace,G.Masini,F.Galluzzi,et al.Metal-semiconductor-metal near-infrared light detector based on epitaxia l Ge/Si[J].Appl.Phys.Lett.,1998,72(24):3175-3177. [5] G.Luo,Y.C.Hsieh,H.E.Chang,et al.High-speed GaAs metal gate semiconductor field effect transistor structure grown on a composite Ge/GexSi1-x/Si substrate[J].J Appl.Phys.,2007,101(8):084501. [6] A.Schüppen,H.Dietrich.High speed SiGe heterobipolartransistors[J].J.Crystal Growth,1995,157(1-4):207-214. [7] D.K.Nayak,J.C.S.Woo,J.S.Park,et al.Enhancementmode quantrum-well Gex/Si1-x/PMOS[J].IEEE Electron Device Lett.,1991,12(4):154-156. [8] R.People.Physics and applications of GexSi1-x/Si strained-layer heterostructures[J].IEEE J.Quantum Electronics,1986,22(9):1696-1710. [9] P.Kruck,M.Helm,T.Fromherz,et al.Medium-wavelength,normal-incidence,p-type Si/SiGe quantum well infrared photodetector with background limited performance up to 85 K[J].Appl.Phys.Lett.,1996,69(22):3372-3374. [10]W.Ruizhong,C.Peiyi and T.Peihsin.An improved nonuniformity correction algorithm for infrared focal plane arrays which is easy to implement[J].Infrared Physics and Technology,1998,39(1):15-21. [11]賈宏勇,陳培毅,錢佩信.Si1-xGexHBT技術:射頻和微波領域中的新秀[J].集成電路設計,1999(8):57. [12]葉志鎮,曹青,張侃等.UHV/CVD低溫生長硅外延層的性能研究[J].半導體學報,1998(8):6-9. [13]吳貴斌.基于UHVCVD的選擇性外延鍺硅與金屬誘導生長多晶鍺硅的研究[D].杭州:浙江大學,2006. [14]M.T.Currie,S.B.Samavedam,T.A.Langdo,et al.Controlling threading dislocation densities in Ge on Si using graded SiGe layers and chemical-mechanical polishing[J].Appl.Phys.Lett.,1998,72(14):1718-1720. [15]J.Oh,J.C.Campbell,S.G.Thomas,et al.Interdigitated Ge p-i-n photodetectors fabricated on a Si substrate using graded SiGe buffer layers[J].IEEE J.Quantum Electron.,2002,38(9):1238-1241. [16]G.Luo,T.H.Yang,E.Y.Chang,et al.Growth of highquality Ge epitaxial layers on Si(100)[J].Jpn.J.Appl.Phys.,2003,42(5B):L517-L519. [17]Z.Huang,N.Kong,X.Guo,et al.21-GHz-Bandwidth germanium-on-silicon photodiode using thin SiGe buffer layers[J].IEEE J.Selected Topics in Quantum Electron.,2006,12(6):1450-1454. [18]H.C.Luan,D.R.Lim,K.K.Lee,et al.High-quality Ge epilayers on Si with low threading-dislocation densities[J].Appl.Phys.Lett.,1999,75(19):2909-2911. [19]O.O.Olubuyide,D.T.Danielson,L.C.Kimerling,et al.Impact of seed layer on material quality of epitaxial germanium on silicon deposited by low pressure chemical vapor deposition[J].Thin Solid Films,2006,508(1-2):14-19. [20]J.Nakatsuru,H.Date,S.Mashiro,et al.Growth of high quality Ge epitaxial layer on Si(100)substrate using ultra thin Si0.5Ge0.5 buffer[J].MRS Proceedings,2005,891:EE07-24.01. [21]T.H.Loh,H.S.Nguyen,C.H.Tung,et al.Ultrathin low temperature SiGe buffer for the growth of high quality Ge epilayer on Si(100)by ultrahigh vacuum chemical vapor deposition[J].Appl.Phys.Lett.,2007,90(9):092108. [22]趙策洲,高勇.半導體硅基材料及其光波導[M],北京:電子工業出版社,1997. [23]顧培夫.薄膜技術[M],杭州:浙江大學出版社,1990. [24]鄭偉濤.薄膜材料與薄膜技術[M],北京:化學工業出版社,2003. [25]E.Kasper,H.J.Herzog and H.Kibbel.A one-dimensional SiGe superlattice grown by UHV epitaxy[J].Appl.Phys.,1975,8(3):199-205. [26]E.Kasper and H.-J.Herzog.Elastic strain and misfit dislocation density in Si0.92Ge0.08films on silicon substrates[J].Thin Solid Films,1977,44(3):357-370. [27]J.C.Bean,T.T.Sheng,L.C.Feldman,A.T.Fiory,et al.Pseudomorphic growth of GexSi1-xon silicon by molecular beam epitaxy[J].Appl.Phys.Lett.,1984,44(1):102-104. [28]J.C.Bean,L.C.Feldman,A.T.Fiory,et al.GexSi1-x/Si strained-layer superlattice grown by molecular beam epitaxy[J].J.Vac.Sci.Technol.A,1984,2(2):436-440. [29]D.V.Lang,R.People,J.C.Bean and A.M.Sergent.Measurement of the band gap of GexSi1-x/Si strained-layer heterostructures[J].Appl.Phys.Lett.,1985,47(12):1333-1335. [30]T.P.Pearsall and J.C.Bean.Enhancement-and deple-tion-mode p-channel GexSi1-xmodulation-doped FET's[J].IEEE Electron Device Lett.,1986,7(5):308-310. [31]T.P.Pearsall,H.Temkin,J.C.Bean and S.Luryi.Avalanche gain in GexSi1-x/Si infrared waveguide detectors[J].IEEE Electron Device Lett.,1986,7(5):330-332. [32]H.Hirayama,M.Hiroi,K.K.Koyama,et al.Selective heteroepitaxial growth of Si1-xGexusing gas source molecular beam epitaxy[J].Appl.Phys.Lett.,1990,56(12):1107-1109. [33]H.Hirayama,M.Hiroi,K.K.Koyama,and T.Tatsumi.Heterojunction bipolar transistor fabrication using Si1-xGexselective epitaxial growth by gas source silicon molecular beam epitaxy[J].Appl.Phys.Lett.,1990,56(26):2645-2647. [34]F.W.Smith and G.Ghidini.Reaction of oxygen with Si(111)and(100):critical conditions for the growth of SiO2[J].J.Electrochem.Soc.,1982,129(6):1300-1306. [35]G.Ghidini and F.W.Smith.Interaction of H2O with Si(111)and(100):Critical Conditions for the Growth of SiO2[J].J.Electrochem.Soc.,1984,131(12):2924-2928. [36]T.J.Donahue and R.Reif.Low Temperature Silicon Epitaxy Deposited by Very Low Pressure Chemical Vapor Deposition[J].J.Electrochem.Soc.,1986,133(8):1691-1697. [37]B.S.Meyerson.Low-temperature silicon epitaxy by ultrahigh vacuum/chemical vapor deposition[J].Appl.Phys.Lett.,1986,48(12):797-799. [38]B.S.Meyerson,F.J.Himpsel,and K.J.Uram.Bistable conditions for low-temperature silicon epitaxy[J].Appl.Phys.Lett.,1990,57(10):1034-1036. [39]B.S.Meyerson,F.K.LeGoues,T.N.Nguyen,and D.L.Harame.Nonequilibrium boron doping effects in lowtemperature epitaxial silicon films[J].Appl.Phys.Lett.,1987,50(2):113-115. [40]D.W.Greve and M.Racanelli.Growth Rate of Doped and Undoped Silicon by Ultra-High Vacuum Chemical Vapor Deposition[J].J.Electrochem.Soc.,1991,138(6):1744-1748. [41]B.S.Meyerson,K.Uram and F.LeGoues.Cooperative growth phenomena in silicon/germanium low-temperature epitaxy[J].Appl.Phys.Lett.,1988,53(25):2555-2557. [42]F.K.LeGoues,B.S.Meyerson and J.F.Morar.Anomalous strain relaxation in SiGe thin films and superlattices[J].Phys.Rev.Lett.,1991,66(22):2903-2906. [43]D.W.Rreve and M.Racaneli.Construction and operation of an ultrahigh vacuum chemical vapor deposition epitaxial reactor for growth of GexSi1-x[J].J.Vac.Sci.Technol.B,1990,8(3):511-515. [44]C.Li,S.John,E.Quinones,and S.Banerjee.Cold-wall ultrahigh vacuum chemical vapor deposition of doped and undoped Si and Si1-xGexepitaxial films using SiH4and Si2H6[J].J.Vac.Sci.Technol.A,1996,14(1):170-183. [45]E.A.Fitzgerald,Y.H.Xie,M.L.Green,et al.Totally relaxed GexSi1-xlayers with low threading dislocation densities grown on Si substrates[J].Appl.Phys.Lett.,1991,59(7):811-813. [46]S.Bozzo,J.L.Lazzari,C.Coudreau,etal.Chemical vapor deposition of silicon-germanium heterostructures[J].J.Cryst.Growth.,2000,216(1-4):171-184. [47]B.Jagannathan,H.Chen,K.Schonenberg,et al.International Conference on Indium Phosphide and Related Materials[C].New Jersey:IEEE,2003,374-377. [48]葉志鎮,曹青,張侃等.具有RHEED在線監控功能的超高真空CVD系統及3”硅片低溫外延研究[J].半導體學報,1996,17(12):932-935. [49]雷震霖,趙科新,余文斌等.UHV/CVD設備及其特性[J].真空,1997(6):14-17. [50]J.D.Cressler.Silicon Heterostructure Handbook:Materials,Fabrication,Devices,and Circuits,and Applications of SiGe and Si Strained-layer Epitaxy[M].Cleveland:CRC Press,2005. [51]Z.Jin,J.A.Johansen,J.D.Cressler,G.Freeman,et al.Proceedings of the Third SPIE International Symposium on Fluctuations and Noise,Noise in Devices and Circuit III[C].Austin:SPIE,2005,5844:101-119. [52]鄧志杰,鄭安生,俞斌才.SiGe/Si材料及其在微電子學中的應用[J].中國集成電路,2003(1):76-79. [53]K.Ismail,J.O.Chu,B.S.Meyerson.High hole mobility in SiGe alloys for device applications[J].Appl.Phys.Lett.,1994,64(23):3124-3126. [54]T.L.Lin,T.George,E.W.Jones,et al.Elemental borondoped p+-SiGe layers grown by molecular beam epitaxy for infrared detector applications[J].Appl.Phys.Lett.,1992,60(3):380-382. [55]B.Y.Tsaur,C.K.Chen and S.A.Marino.Long-wavelength GexSi1-x/Si heterojunction infrared detectors and 400*400-elementimagerarrays[J].IEEE Electron Devices Lett.,1991,12(6):293-296. [56]S.Luryi,A.Kastalsky,and J.Bean.New infrared detector on a silicon chip[J].IEEE Trans.Electron.Devices,1984,31(9):1135-1139. [57]L.Colace,G.Masini,F.Galluzzi,et al.Metal-semiconductor-metal near-infrared light detector based on epitaxial Ge/Si[J].Appl.Phys.Lett.,1998,72(24):3175-3177. [58]M.Jutzi,M.Berroth,G.W觟hl,et al.Ge-on-Si vertical incidence photodiodes with 39-GHz bandwidth[J].IEEE Photon.Technol.Lett.,2005,17(7):1510-1512. [59]S.Klinger,M.Berroth,M.Kaschel,et al.Ge-on-Si p-i-n Photodiodes With a 3-dB Bandwidth of 49 GHz[J].IEEE Photon.Technol.Lett.,2009,21(13):920-922. [60]J.Osmond,L.Vivien,J.Fédéli,et al.40 Gb/s surfaceilluminated Ge-on-Si photodetectors[J].Appl.Phys.Lett.,2009,95(15):151116. [61]F.Huang,M.Chu and M.Tanner.High-quality strainrelaxed SiGe alloy grown on implanted silicon-oninsulator substrate[J].Appl.Phys.Lett.,2000,76(19):2680-2682.3 SiGe材料的應用
3.1 SiGe基區HBT

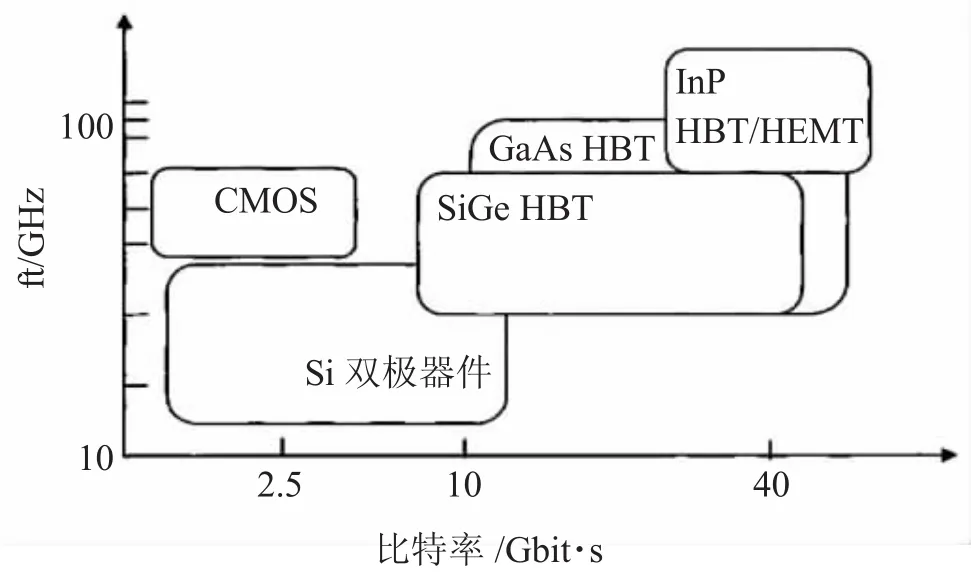
3.2 掩埋溝道MODFET(調制摻雜FET)
3.3 SiGe/Si異質結內光電發射型紅外探測器 (HIP)
4 總結與展望

