高世代平板顯示光刻機照明系統中梯形視場的設計與仿真
曹昌智+劉悠嶸+鄭繼紅
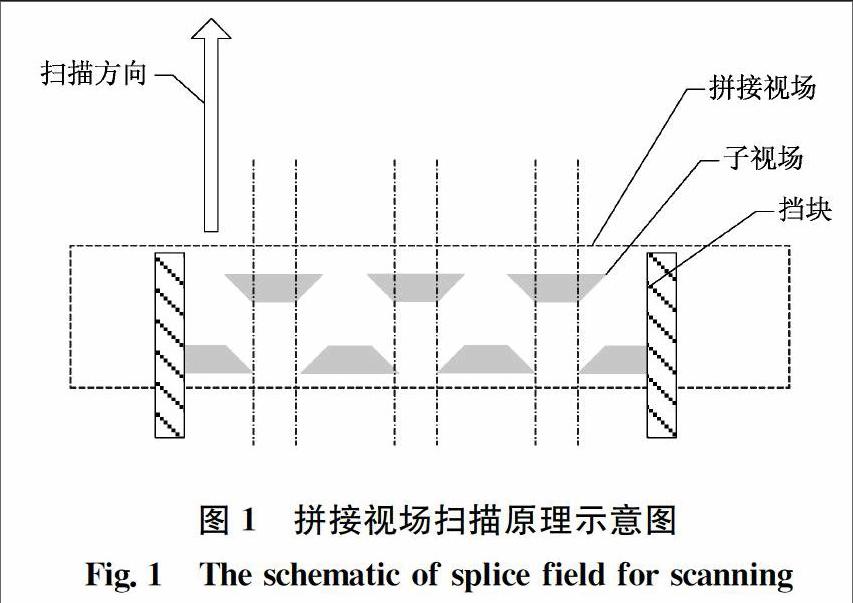

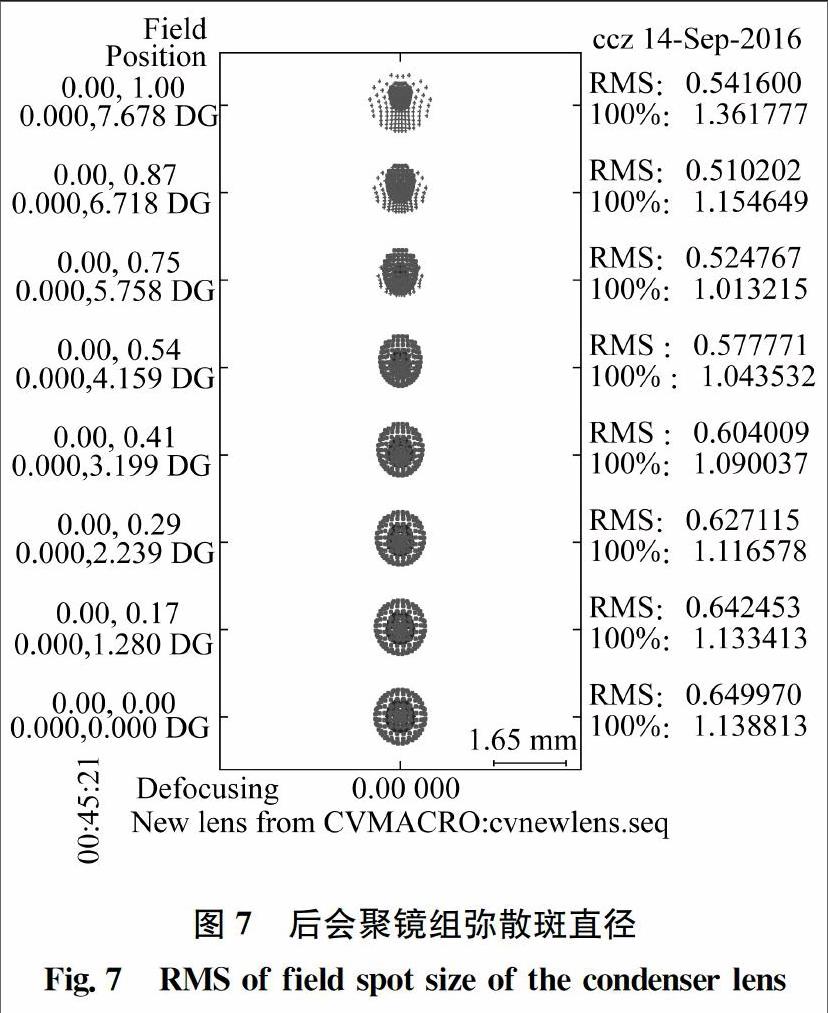
摘要:針對大面積薄膜晶體管(TFT)液晶顯示生產中的高世代光刻機(6代以上)照明系統改進,設計了一種新穎的梯形拼接照明視場方案。使用設置在微透鏡陣列入瞳處的視場光闌陣列實現了梯形拼接照明視場,同時簡化了系統設計。相較于以尼康平板液晶顯示器(FPD)光刻機為代表的現有梯形拼接視場方案,提出的設計方案能減少投影物鏡的熱負擔,同時在一定程度上提高照明系統的光能透過率。通過Lighttools建模分析,說明該設計方案能夠實現梯形照明視場并且積分均勻性在1%以內,達到了設計預期效果。
關鍵詞: 液晶顯示; 薄膜晶體管; 光刻機; 視場拼接; Lighttools模擬
中圖分類號: O 439 文獻標志碼: A doi: 10.3969/j.issn.1005-5630.2017.03.008
Design and simulation of illumination system for trapezoidal splice fields in high-generation flat pannel display lithography machine
CAO Changzhi, LIU Yourong, ZHENG Jihong
(School of Optical-Electrical and Computer Engineering, University of Shanghai for Science and Technology, Shanghai 200093, China)
Abstract: In order to satisfy the production requirement of large-area thin film transistor(TFT) liquid crystal display,a novel high-generation(above the 6th generation) optical illumination system used in the trapezoidal field stitching is proposed in this paper.By using a trapezoidal field stop array at the entrance pupil of the micro-lens array,the illumination system can be simplified and realize uniform trapezoidal illumination field.Compared with current design of Nikon flat pannel display(FPD) lithography,the proposed illumination system can not only effectively reduce projection lenses heat effect,but also improve transmittance.In the simulation with Lighttools,the result shows that the integral illumination uniformity of our proposed optical system is less than 1% and the trapezoidal illumination field is realized,which satisfies the design requirement for the illumination system.
Keywords:
liquid crystal display; thin film transistor; lithography machine; field stitching; Lighttools simulation
引 言
光刻機是現代微電子技術中的重要設備,經歷了從接觸式光刻機、接近式光刻機、全硅片掃描投影式光刻機、分布重復投影式光刻機到目前普遍采用的步進式掃描投影光刻機的發展歷程[1]。光刻機技術廣泛應用于半導體元件制造與液晶平板顯示器制造,對于薄膜晶體管(TFT)的制作尤為關鍵。隨著對大尺寸平板液晶顯示器(FPD)的需求越來越大,光刻機的曝光視場也越來越大,但是從第五代(G5)光刻機之后,單個成像物鏡的視場已無法滿足大型平板的曝光需求,從第六代起多物鏡拼接掃描曝光便成為主流。因此,與物鏡成像拼接相對應的照明視場拼接亦成為FPD光刻機光學設計的一個重要問題。
目前,以尼康公司平板顯示光刻機為代表的視場拼接多采用多物鏡梯形視場拼接作為主流方案。該方案采用微透鏡陣列作為勻光元件,能很好地解決大尺寸TFT基板曝光的均勻性問題[2-6]。微透鏡陣列出射孔徑角較大,可以實現大面積照明,其勻光基于折射的原理,能避免高階衍射造成較大的能量損耗[7-8],而且還能保持光的偏振特性,因此微透鏡陣列是光刻機照明系統中保證均勻照明的關鍵技術方案[9-14]。但是由于該方案是通過在投影物鏡中設置梯形視場光闌來實現梯形視場,所以在大劑量或者長時間曝光中,視場光闌吸收的能量會導致物鏡的熱效應加重,從而影響曝光效果[15]。
本文基于微透鏡陣列勻光系統提出改進的梯形視場實現方案,直接將梯形視場光闌陣列設置在系統微透鏡陣列入瞳處,簡化了光學系統結構。在形成符合拼接要求的梯形子視場的同時,避免視場光闌發熱對物鏡造成額外的熱效應。采用Lighttools軟件對提出的方案進行仿真模擬,結果顯示,該方案能夠滿足勻光度和梯形的曝光視場要求。
1 平板顯示TFT光刻機曝光系統基本原理
由于大面積顯示的需求,光刻機需要掃描曝光的區域很大。但是單個物鏡視場是有限的,所以在曝光掃描過程中必須采用多個彎月型或者梯形子視場拼接的方式完成大視場掃描,以梯形拼接視場掃描的TFT光刻技術如圖1所示。在典型的采用梯形視場拼接的光刻機照明系統中,均勻照明的大視場的實現流程如圖2所示,首先由2~3個大功率汞燈提供高能量紫外光源,由大口徑光纖束合成一組,再進入多個小分支光纖,向7~11個照明系統陣列提供光源,再由各個照明系統向所對應的物鏡提供均勻照明。
在照明系統中,光纖束輸入的光斑經過準直鏡組校正光斑大小和輸出角度后,進入微透鏡陣列,由微透鏡陣列將入射光斑分解成多個次級光源,各自輸入后面的會聚鏡組交疊成像形成一個均勻的矩形光斑。在會聚鏡組的像面處設置梯形光闌形成初步的梯形視場,然后經由后面的中繼鏡組將初步的梯形照明視場成像到物鏡的物面,接著經過設置在物鏡中間像上的物鏡視場光闌形成最終的梯形視場。
顯然這種方案能夠實現照明系統的梯形視場,但是系統比較復雜。光刻機長時間工作,物鏡中的視場光闌吸收雜散光發熱,會造成物鏡額外的熱負擔。為了克服原有系統的缺點,本文提出新的梯形照明方案。實現的基本流程如圖3所示,由光纖輸入的光源經過一組準直鏡組校正輸出角度與光斑大小后進入微透鏡陣列,由微透鏡陣列將入射光斑分解成多個次級光源,各個次級光源經由微透鏡陣列前的梯形光闌陣列形成梯形光斑,各自輸入后面的會聚鏡組交疊成像形成最終的梯形均勻光斑。后續均勻梯形光斑再直接照射掩模版,通過物鏡成像到光刻工作面上。對比典型的圖2系統,該照明技術方案更為精簡,直接在照明系統中形成最終的梯形光斑,有效減輕了物鏡的熱負擔,并且提高了照明系統的透過率。
2 光刻機勻光照明系統的光學設計與仿真
2.1 光刻機照明系統的整體設計及主要參數
光刻機作為半導體工業的主要設備,主要技術參數由成像物鏡的分辨率、視場大小以及設備產率需求確定。光刻機物鏡的分辨率取決于照明系統的工作波長與物鏡的數值孔徑NA;物鏡的視場范圍決定了照明部分的均勻視場大小;設備的產率需求則決定了照明系統的照度。表1所示為尼康FX86S2型光刻機的主要性能參數,其中能達到的分辨率為3.0 μm,放大率為+1,工作波長為365,405,436 nm,即g,h和i光。最大光刻基板尺寸是2 200 mm×2 500 mm,采用4次掃描曝光,每個曝光區域相當于55 inch (1 inch=2.54 cm),也就是單次照相物鏡陣列的組合視場范圍要達到1 100 mm×1 250 mm。
式中:C為光刻機的最小分辨尺寸;K為工藝因子;NA為物鏡像方數值孔徑;λ為物鏡的工作波長。若需要達到3 μm的分辨率,在365 nm單波長曝光下,物鏡的數值孔徑NA=0.1即可滿足需求。
為了實現1 100 mm大型視場的物鏡組合,系統可采用11個物鏡拼接,相對應地,也需要11個相同的照明系統。以單個照明系統的結構為例,照明系統的結構設計示意圖如圖4所示。
整個光刻機系統的光源由2個高功率燈室經過一個2進11出的分束光纖(NA=0.22)引出能量,為單個物鏡提供照明能量。單個物鏡的光照系統設計包括前組準直鏡組,微透鏡陣列,梯形光闌和后組會聚鏡組,形成系統需要的梯形均勻光照進入物鏡。
2.2 后會聚鏡組設計
由于光學系統的可逆性,從后組會聚鏡組開始到前準直鏡組設計也是可行的。根據上文所述的1 100 mm×1 250 mm的曝光區域,假設工作視場采用11個物鏡組成的物鏡陣列,每個100 mm×125 mm,則單個物鏡視場為圖5所示的梯形視場(30 mm×130 mm),光刻機倍率為1,照明視場范圍也為30 mm×130 mm。
根據上文所述的物鏡像方數值孔徑NA為 0.1,會聚鏡組的入瞳直徑(D)設為100 mm,則根據
可得出會聚鏡組的焦距(L)為500 mm。將會聚鏡組像面矩形長邊方向定義為x方向,短邊方向定義為y方向,有式中:α為入瞳角;H為像高。根據式(3)可以計算出x方向的最大視場入瞳角為7.407°;y方向的最大視場入瞳角為1.718°。
后會聚鏡組的系統設計數據如表2所示(如無特殊說明,本文提及所有鏡頭數據單位為mm),系統結構設計如圖6所示。
如圖7所示,后會聚鏡組各個視場的彌散斑直徑均方根(RMS)值小于0.65 mm,能夠保證照明視場的邊緣足夠銳利,并能將視場半影遮擋在掩模鉻邊區域內。
2.3 微透鏡陣列及梯形光闌陣列設計
微透鏡陣列設計為像方遠心光路,以減小后會聚物鏡組的光線誤差,像方最大的角度需要對應后會聚鏡組的入瞳角,否則會造成最終的照明形狀變形并出現很大的彌散區域,同時也會造成能量損失。后會聚鏡組的入瞳的視場光闌陣列大小為100 mm×100 mm,則微透鏡陣列在x方向由10個單片微透鏡組成,微透鏡截面的x方向入瞳大小定為10 mm。由上所述x方向入瞳角為7.407°,由式(2)可得微透鏡的焦距為38.46 mm,同樣根據上文所述y方向入瞳角為1.718°以及微透鏡的焦距,根據式(3)計算出y方向的入瞳口徑為2.3 mm。
微透鏡陣列中的單個透鏡設計為鼓型透鏡,具體設計數據如表3所示,其結構如圖8所示,梯形光闌位于微透鏡前。每一片透鏡單獨加工,最后貼合成一個完整的陣列,亦可整個微透鏡陣列進行整體加工成型(光刻或激光切割)。
相對應地,在本設計中為了最終形成梯形的照明視場,在每個微透鏡前方的入瞳位置設置一個梯形光闌,形成照明系統的梯形視場光闌陣列,則最終照明視場的形狀就由該光闌的形狀所決定。根據上文的計算,微透鏡x與y方向上的入瞳口徑(10 mm和2.3 mm)即為梯形視場光闌的底邊長與高,根據圖8所示梯形視場的底角為45°,即可得到單個視場光闌的形狀如圖9所示。由于光闌陣列的形狀與位置決定了最終照明視場的形狀與位置,所以光闌陣列需要較高的加工精度,可以使用激光切割或者在石英基底上光刻的方式完成。
2.4 前準直鏡組設計
同樣,光照系統的前準直鏡組設計也為像方遠心系統,以保證微透鏡陣列的入瞳角度。光纖出射端光束經過前組準直后,要保證照射到對應微透鏡的數值孔徑范圍之內并照亮后會聚鏡組的入瞳口徑。照射到微透鏡NA以外的光線會在傳遞過程中損耗,或者落到設計視場以外的區域,造成照明視場的變形與邊緣彌散區域的擴大。微透鏡的截面是長方形,因此經過光纖傳輸整形后的入射光束也是與之相匹配的長方形。微透鏡陣列的尺寸正是前準直鏡組的像高,為50 mm。而光纖的NA為0.22(石英光纖典型數值孔徑),根據式(2)前準直鏡組的焦距為221.704 mm。根據后會聚鏡組x方向入瞳角為7.407°,y方向入瞳角為1.718°,再根據式(3)則計算得出前準直鏡組的物方尺寸(即光纖出射端尺寸)為57.643 mm×13.302 mm。所設計的具體光路圖和數據如圖10和表4所示。
2.5 系統設計性能仿真
將整個光學系統在Lighttools中建模仿真(圖11)。總追跡光線為10 000 000條,為有效消除隨機噪聲對追跡結果造成的干擾,對追跡結果進行三階平滑處理。
考慮到梯形視場難以進行積分均勻性的計算,而且視場光闌只會影響照明視場的形狀而不會對照明均勻性有影響,所以視場能量均勻性仿真是基于不設置光闌陣列條件進行的。結果顯示,積分均勻性為0.884%。
由系統仿真圖12和圖13的結果可以看出,視場光闌陣列的確發揮了作用,系統形成了標準梯形照明視場。而視場周圍的彌散是由后會聚鏡組造成的,考慮到實際工作情況下,在掩模圖形區域的周圍存在鉻邊進行遮擋,所以這種程度的彌散不會影響實際工作。
3 結 論
提出的視場形成方案較現有的方案在照明系統中省去了整個中繼鏡組結構,很大程度上節省了系統的成本并降低了系統的復雜程度。同時將額外的熱負擔最大程度地留在照明系統的前半部分(梯形光闌陣列位置),從而緩解了物鏡的熱負擔,降低了物鏡熱效應。從最終的系統仿真結果可以看出,使用視場光闌陣列配合微透鏡陣列勻光,在理論上完全可以實現梯形的均勻照明視場。
但是作者在實際工作中發現,雖然微透鏡陣列應用于均勻照明領域的情況非常普遍,但是微透鏡本身的像差(主要是畸變)也會對最終的照明視場均勻性和視場形狀造成影響,尤其是在大焦距后會聚鏡組的情況下。考慮如何消除或補償微透鏡本身的像差所導致的照明視場均勻性惡化,在工程應用上有較大的意義。
參考文獻:
[1] 彭袆帆,袁波,曹向群.光刻機技術現狀及發展趨勢[J].光學儀器,2010,32(4):8085.
[2] 肖艷芬,朱箐,楊寶喜,等.用于光刻機照明均勻化的微柱面鏡陣列設計[J].中國激光,2013,40(2):0216001.
[3] 王旻,宋立維,喬彥峰,等.外視場拼接測量技術及其實現[J].光學 精密工程,2010,18(9):20692076.
[4] 高天元,董正超,趙宇,等.視場拼接復眼成像系統結構及裝調方法[J].光子學報,2014,43(11):1122001.
[5] 馮桂蘭,田維堅,屈有山,等.實時視場拼接系統的設計與實現[J].光電工程,2007,34(4):124127.
[6] 付躍剛,趙宇,劉智穎,等.基于視場拼接方法的仿生復眼光學系統設計[J].儀器儀表學報,2015,36(2):422429.
[7] MLLER S,FORREST S R.Improved light out-coupling in organic light emitting diodes employing ordered microlens arrays[J].Journal of Applied Physics,2002,91(5):33243327.
[8] BIZJAK T,MITRA T,ASCHKE L.Novel high-throughput micro-optical beam shapers reduce the complexity of macro-optics in hyper-NA illumination systems[C]∥Proceedings of SPIE,Optical Microlithography XX.San Jose,CA:SPIE,2007,6520:65202X.
[9] WEI L D,LI Y Q.Hybrid approach for the design of mirror array to produce freeform illumination sources in immersion lithography[J].OptikInternational Journal for Light and Electron Optics,2014,125(20):61666171.
[10] GANSER T,DARSCHT M,MIKLYAEV Y,et al.High-throughput homogenizers for hyper-NA illumination systems[C]∥Proceedings of SPIE,Optical Microlithography XIX.San Jose,CA:SPIE,2008,6154:61542N.
[11] KOYAMA M,KATO M,SHIBANO H.Optical apparatus,exposure apparatus,and exposure method:US6750951[P].20040615.
[12] TANAKA M,KUMAZAWA M,KATO K,et al.Exposure apparatus,optical projection apparatus and a method for adjusting the optical projection apparatus:US7372544[P].20080513.
[13] 劉志輝,楊歡,石振東,等.衍射微透鏡陣列用于半導體激光光束勻化[J].紅外與激光工程,2014,43(7):20922096.
[14] 閆觀勇,李思坤,王向朝.基于二次規劃的光刻機光源優化方法[J].光學學報,2014,34(10):1022004.
[15] 陳成,梁靜秋,梁中翥,等.微小型靜態傅里葉變換紅外光譜儀中復眼縮束系統的光學設計及仿真研究[J].光學學報,2015,35(11):1122002.

