熱處理溫度及摻硼對富硅氧化硅發光的影響
,,,,
(浙江大學硅材料國家重點實驗室,浙江 杭州 310027)
1 前 言
體硅晶體是目前微電子行業中應用最廣泛的材料,但由于體硅是間接帶隙半導體,其發光效率低下。為了克服這個問題,過去的數十年來研究人員嘗試了各種方法來改善其發光性能。L. Canham[1]利用電化學腐蝕的方法制備了在室溫下具有可見光致發光的多孔硅材料,開啟了低維硅材料發光性能的研究。在低維硅材料中,富硅氧化硅即硅納米晶鑲嵌二氧化硅體系具有良好的發光性能,并且能夠與大規模集成電路制造工藝相兼容,使得富硅氧化硅比其他納米材料更具有優勢[2]。特別是在發現了富硅氧化硅的光增益現象[3]之后,研究人員對富硅氧化硅發光性能的研究表現出極大的關注[4-7]。
但是,目前關于富硅氧化硅薄膜的發光機理仍存在很大爭議。一方面,由于硅納米晶的尺寸在納米級別,量子限制效應使硅納米晶表現出良好的發光性能[8];另一方面,富硅氧化硅薄膜基體二氧化硅和界面中的發光中心對其光致發光也起到了重要的作用[9-11]。L. Pavesi等人[12]指出硅納米晶與基體二氧化硅之間的過渡層即界面,成份為SiOx(0 本文中利用PECVD法制備了未摻雜與摻硼富硅氧化硅薄膜,研究了在不同熱處理條件下,富硅氧化硅薄膜光致發光來源的演變過程,并研究了摻硼對硅納米晶發光和薄膜中發光中心的影響。 未摻雜與摻硼富硅氧化硅薄膜采用等離子體增強化學氣相沉積法制備,其襯底為經過標準RCA溶液清洗的p型輕摻Si(100)襯底片。沉積氣氛為(SiH4、Ar)混合氣、N2O、(B2H6、H2)混合氣。在沉積過程中,(SiH4、Ar)混合氣、N2O兩路氣體的流量都保持在100sccm,而(B2H6、H2)混合氣的流量依次為0、100sccm,背底真空度4.0×10-3Pa,襯底溫度為300℃,沉積時間為30min。隨后,對上述樣品分別進行了600、800和1100℃的高溫熱處理,保護氣氛為高純氮氣。樣品的光致發光譜利用光電倍增管(PMT)測試,He-Cd 325nm激光器作為激發光源。利用盧瑟福背散射(RBS)和X射線光電子能譜(XPS)分別定量和半定量地測試了樣品的Si/O比和B元素的摻雜含量。因為未摻雜樣品與摻硼樣品在制備過程中(SiH4,Ar)混合氣與N2O的流量保持恒定不變,兩組樣品的Si/O比都為0.85,摻硼量分別為0和0.05 at%。利用透射電子顯微鏡(TEM)觀察了樣品的微觀顯微結構;而電子自旋共振譜(ESR)用來表征薄膜中具有未成對電子的缺陷。 圖1 未摻雜(a)與摻硼(b)富硅氧化硅薄膜在不同溫度熱處理后的光致發光譜Fig.1 PL spectra of undoped (a) and B-doped (b) films with different temperature post-annealing treatment 圖2 經1100℃熱處理后的未摻雜樣品(a)與摻硼樣品(b)中硅納米晶尺寸分布統計圖。其中插圖為硅納米晶的高分辨電子顯微鏡照片Fig.2 Diameter distributions of the Si-NCs embedded in undoped (a) and B-doped (b) films under 1100℃ post-annealing treatment. The insets are HRTEM images of Si-NC 圖1為未摻雜樣品與摻硼樣品在經過不同溫度熱處理后的光致發光譜。由圖可見,隨著熱處理溫度的升高光致發光譜出現了明顯的紅移。經過1100℃熱處理的樣品的發光峰波長達到最大;未摻雜樣品的發光峰位于650nm,摻硼樣品的發光峰則位于720nm,而此時未摻雜樣品與摻硼樣品發光譜中其他發光峰的強度可以忽略不計。眾所周知,經過1100℃熱處理后在富硅氧化硅薄膜中會形成硅納米晶,650與720nm兩個發光峰很有可能來源于硅納米晶。圖2所示為未摻雜樣品與摻硼樣品在經過1100℃熱處理后薄膜中硅納米晶的尺寸分布圖,其中插圖為樣品的硅納米晶的HRTEM圖片。可見,未摻雜樣品與摻硼樣品中都有硅納米晶的形成,晶格間距為0.314nm,未摻雜樣品的硅納米晶尺寸為2.2nm左右,摻硼樣品的硅納米晶的尺寸為2.8nm。這表明摻硼促進了硅納米晶的生長,與我們之前的研究結果相吻合[20]。根據硅納米晶尺寸與其光致發光波長關系的經驗公式[21]式(1),計算得到650和720nm的發光峰來源于硅納米晶: Eg=E0+Ad-2+Bd-1 (1) 其中:Eg為硅納米晶的禁帶寬度,E0為體硅的禁帶寬度,d為硅納米晶的尺寸,A、B為常量(硅納米晶尺寸為2~10nm時,A、B分別為2.56與0.83)。 在未經熱處理和經600℃熱處理的未摻雜樣品與摻硼樣品中由于沒有硅納米晶的形成,因此樣品的光致發光來源為薄膜中的發光中心。如圖1(a)所示,未經熱處理的未摻雜樣品的發光峰位于415nm左右,而經600℃熱處理之后光致發光譜中的主峰紅移至480nm,同時出現了380nm的發光峰。根據相關文獻,415nm的發光峰來源于弱氧鍵(—O—O—),470nm的發光峰來源于雙折硅(—Si—Si—,屬于缺氧中心)[22-24],380nm的發光峰來源目前不詳。已知PECVD制備的沉積薄膜中的Eδ’ centers (≡Si·)會被氫自由基鈍化為—SiH。經過600℃熱處理脫氫之后,會引入—Si—Si—和Eδ’ centers,從而引起470nm的發光峰,這可能是由于Eδ’ centers的濃度較低沒有出現明顯的520nm的發光峰[25-26]。而經過800℃熱處理之后,除了470nm發光峰之外,還出現了600nm處的發光峰。因為經過800℃熱處理的富硅氧化硅薄膜中會形成非晶硅團簇,因此600nm的發光峰來自于非晶硅團簇。經過1100℃熱處理后,前文已證明了發光峰來源于硅納米晶。如圖1(b)所示,未經熱處理的摻硼樣品的發光峰位于470nm,即來自于缺氧中心-Si-Si-。已有研究工作中,發現大部分的B原子主要存在于富硅氧化硅中的界面和基體二氧化硅中,且B原子主要與O原子結合[20],這就造成了Si原子的缺氧環境,因此摻硼有利于缺氧中心的形成。經過600℃熱處理去氫后,引入了大量的Eδ’ centers,發光峰,變為一個半高寬很大的寬峰。經過800℃熱處理后,樣品發光峰有了微小的紅移,這是由非晶硅團簇的形成引起的。經過1100℃熱處理后,同樣前文已證明樣品的發光來源于硅納米晶。由此可知:隨著熱處理溫度的升高富硅氧化硅薄膜的光致發光來源逐漸由薄膜中的發光中心演變為硅納米晶;摻硼有利于薄膜中缺氧中心的形成。 為研究摻B對1100℃熱處理樣品即硅納米晶鑲嵌二氧化硅薄膜的影響,將未摻雜樣品與摻硼樣品的硅納米晶的發光強度和發光壽命分別做了對比,如圖3所示。從圖3(a)中可見,摻硼樣品的發光強度明顯減弱,并且發光峰有了明顯的紅移。硅納米晶發光的紅移是因為B原子的摻雜有利于硅納米晶的生長,尺寸較大的硅納米晶,量子限制效應較弱,發光紅移。同時,摻硼不利于硅納米晶的光致發光:一方面,由于硅原子的摻雜會引入多余的載流子,由此引起的俄歇復合效應導致硅納米晶發光強度的減弱;另一方面,B原子主要的摻雜位置為硅納米晶的表面或者亞表面,并且B原子的半徑比硅原子小21%,所以會引入應變缺陷,也會導致硅納米晶發光強度的減弱。從圖3(b)中可見,B的摻雜使硅納米晶的發光壽命明顯降低。 圖3 經1100℃熱處理的未摻雜樣品與摻硼樣品的光致發光譜(a)和熒光壽命譜(b)Fig.3 PL spectra (a) and time-resolved PL spectra (b) of undoped and B-doped films under 1100℃ post-annealing treatment 前文已證明了摻硼有利于缺氧中心的形成,但在1100℃熱處理的摻硼樣品的光致發光譜中未出現明顯的470nm和520nm的發光峰。為研究摻硼對1100℃熱處理樣品中發光中心的影響,測試了ESR譜。在Eδ’ centers的結構中,有一個未成對電子,因此ESR是有力的佐證工具[27]。圖4所示為經過1100℃熱處理的未摻雜樣品與摻硼樣品的ESR測試譜。g因子的值為2.0020,這是Eδ’ centers的特征g值,說明摻硼樣品中存在Eδ’ centers[25-26],而在未摻雜樣品中并沒有出現任何信號。因為界面的成份為SiOx,氧含量低,這說明B原子的摻雜可以在硅納米晶與基體二氧化硅之間的界面中引入Eδ’ centers。但在摻硼樣品的發光譜中未出現520nm的發光峰,這表明硅納米晶與發光中心之間可能存在競爭關系,在有硅納米晶存在或者硅納米晶的發光未被猝滅時,硅納米晶占主導地位而發光中心占支配地位。 圖4 經過1100℃熱處理的未摻雜樣品與摻硼樣品的ESR測試譜Fig.4 ESR spectra of undoped and B-doped films under 1100℃ post-annealing treatment 采用PECVD法制備了未摻雜與摻硼富硅氧化硅薄膜。在高純N2氣氛中經過600℃、800℃和1100℃高溫熱處理后,研究了富硅氧化硅薄膜經不同溫度熱處理后的光致發光來源以及B原子摻雜的影響。隨著熱處理溫度的升高,富硅氧化硅薄膜的光致發光來源逐漸由薄膜中的發光中心演變為硅納米晶。硼的摻雜有利于薄膜中缺氧中心的形成,并會在硅納米晶與基體二氧化硅之間的界面中引入發光中心,但同時也會引入多余載流子和非輻射復合中心,從而降低硅納米晶的發光強度。2 實 驗
3 結果分析與討論

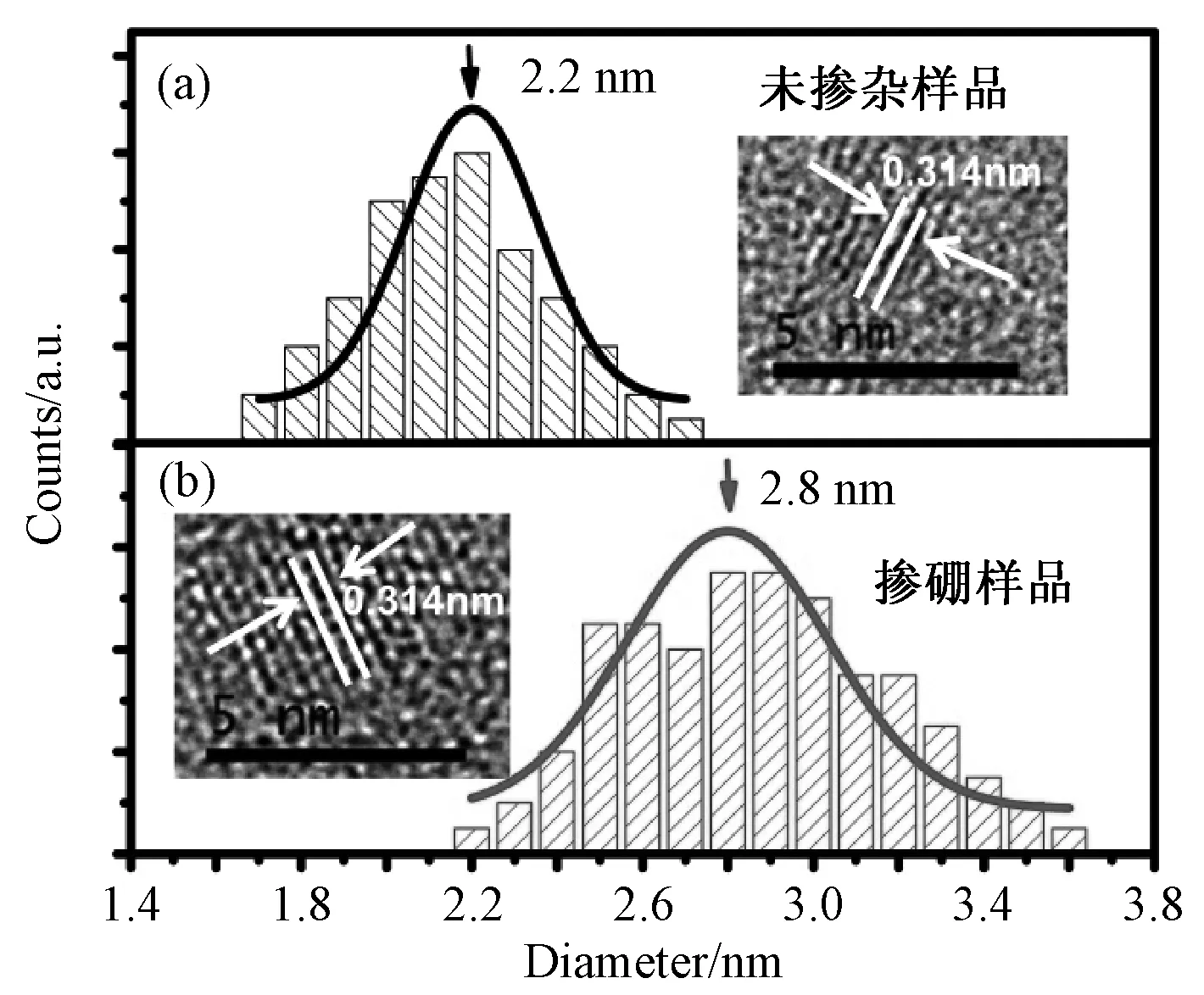
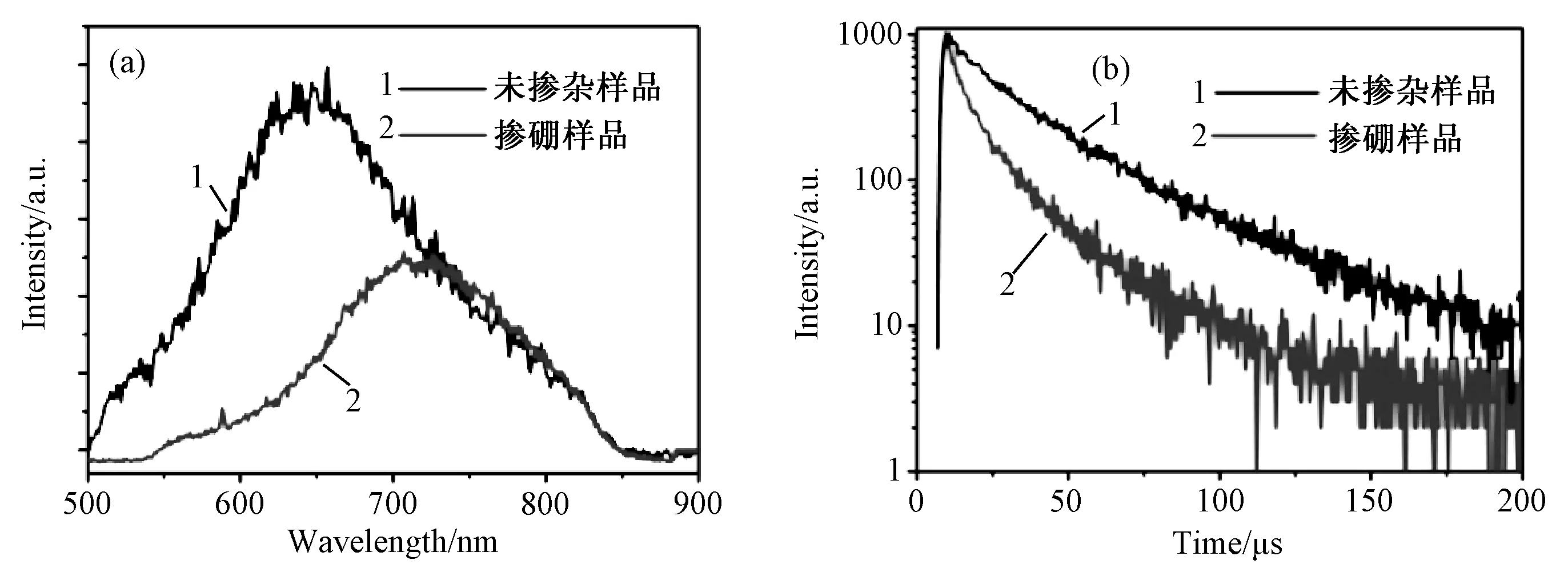

4 結 論

