壓強對GaSb/GaAs量子點形貌各向異性的影響
徐德前, 徐佳新, 莊仕偉, 李國興, 張寶林
(集成光電子學國家重點實驗室 吉林大學電子科學與工程學院, 吉林 長春 130012)
1 引 言
Ⅲ-Ⅴ族Sb化物半導體由于其獨特能帶結構、有效質量小、電子遷移率高的特性,在超高速低功耗器件和紅外光電器件等領域有著重要應用[1-4]。GaSb/GaAs量子點(QDs)系統,其Ⅱ型異質能帶結構可有效抑制俄歇復合效應,提高器件性能,因而引起了研究者的廣泛關注;而且GaSb量子點與InGaAs/GaAs量子阱結合,器件波長可達1.7 μm[5],因而在近紅外波段具有重要應用。GaSb/GaAs量子點的生長通常采用層-島(S-K)模式,量子點界面處以60°位錯為主導,容易導致外延層中產生大的穿透位錯密度[6-7],而穿透位錯以非輻射復合中心的形式降低器件性能。IMF生長模式以90°位錯為主導,與傳統的S-K生長模式相比,應變只在界面處釋放并且位錯有很強的局域性[8],可以實現密集的量子點疊層生長,從而顯著增強光子吸收。同時有文獻表明,與S-K生長模式相比,IMF模式生長GaSb/GaAs界面穿透位錯密度降低了兩個數量級(~5×105cm-2)[9],生長的GaSb/GaAs量子點穿透位錯密度更低,有利于器件性能的改善。相關研究表明,界面失配(IMF)生長模式主要由溫度和晶格失配主導,溫度為520 ℃時,為純凈的90°失配位錯,溫度大于560 ℃時為60°位錯[7,10];襯底與外延層低應變(<2%)時產生60°位錯,中等應變(3%~4%)產生90°和60°混合位錯,大應變(>6%)形成90°位錯[11-12]。
通過改變生長參數,GaSb/GaAs量子點可以實現S-K或IMF模式無應力生長[13]。采用MOCVD工藝實現以90°位錯主導的IMF模式進行外延生長時,要求生長溫度低(約520 ℃),晶格失配大(>6%),以及氣相Ⅴ/Ⅲ比高。對于銻化物的MOCVD生長,由于Sb的飽和蒸汽壓低而具有特殊性,Ⅴ/Ⅲ比的選取相對較低(1<Ⅴ/Ⅲ<3)。由于IMF生長模式為準二維生長模式,相比S-K三維生長模式,<110>晶向的各向異性對GaSb量子點生長的影響被放大,導致GaSb量子點沿[110]方向被拉長[14]。Hiroyuki Sakaki等研究發現低的Ⅴ/Ⅲ比可以抑制GaSb/GaAs量子點的各向異性[15-16],但與IMF生長模式高Ⅴ/Ⅲ比的要求相矛盾。我們通過實驗也發現增大源輸入流量可以在一定程度上抑制GaSb/GaAs量子點的各向異性,但高的生長速率導致量子點的生長過程難以調控,并且容易引入堆垛形貌而降低器件性能。
本文采用低壓金屬有機物化學氣相沉積(LP-MOCVD)技術制備了GaSb/GaAs量子點樣品,通過Sb表面處理改變表面自由能來實現準二維的IMF生長模式。通過不同壓強下樣品表面形貌的對比,研究了反應室壓強對IMF模式生長的GaSb/GaAs量子點各向異性的影響。
2 實 驗
采用水平反應室的LP-MOCVD在GaAs襯底上基于IMF生長模式制備了GaSb量子點結構,GaAs襯底為(001)偏(110)方向2°的斜切半絕緣單晶片。三甲基鎵(TMGa)為Ⅲ族源(輸入流量為4.9 μmol/min),三乙基銻(TESb)為V族源(輸入流量為3.6 μmol/min),載氣為H2。對應上述IMF模式的MOCVD生長條件要求,本實驗生長溫度設為500 ℃,晶格失配(7.8%)滿足IMF生長模式要求,氣相Ⅴ/Ⅲ比為0.7,生長前采用Sb表面處理方法在界面處形成Sb原子富集,進而使生長初期的Ⅴ/Ⅲ比高,有利于形成IMF生長模式。反應壓強分別為10,7,5,4,3 kPa,樣品依次標記為S1、S2、S3、S4和S5。GaSb量子點臨界厚度約為2.5 ML(monolayer),由于壓強的變化GaSb在不同壓強下的生長速度(約為0.036~0.5 ML·s-1)發生改變。500 ℃通入Sb源(輸入流量為1.8 μmol/min),進行5 s的Sb表面處理,通過Sb表面處理形成富Sb(2×8)重構表面[17-18],在界面處誘導產生周期性90°失配位錯,實現準二維的IMF模式的GaSb/GaAs量子點生長。降溫時通入Sb源(輸入流量為1 μmol/min),抑制外延GaSb材料中Sb的解吸附效應。
實驗采用布魯克公司的原子力顯微鏡(AFM) (ICON-PT,Veeco)表征各樣品表面形貌。采用輕敲模式進行測試,SiC探針的共振頻率約為300 kHz。
3 結果與討論



圖1 (a)不同壓強下制備的GaSb/GaAs量子點AFM形貌圖。S1:10 kPa,S2:7 kPa,S3:5 kPa,S4:4 kPa,S5:3 kPa。 (b)隨壓強變化的GaSb量子點密度和各向異性島的長寬比。
Fig.1 (a) Atomic force microscopy images of GaSb/GaAs QDs formed at different reaction chamber pressure. S1: 10 kPa, S2:7 kPa, S3: 5 kPa, S4: 4 kPa, S5:3 kPa. (b) The density of GaSb quantum dots and the aspect ratio of anisotropic islands as functions of reaction chamber pressure.
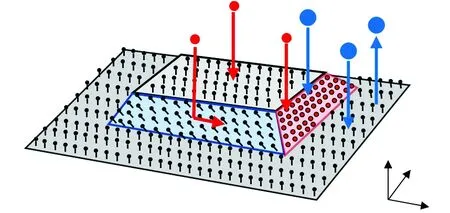
圖2 GaSb各向異性島不同{111}面的生長機制[18],其中藍色面為{111}B面,紅色面為{111}A面。
Fig.2 Schematic illustration of the growth mechanism of different {111} planes on anisotropic islands of GaSb quantum dots, blue planes represent the {111}B facets and red ones are {111}A facets.

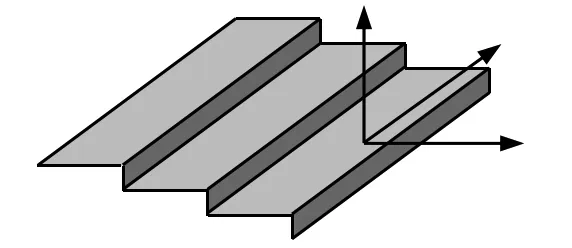
圖3 GaAs襯底(001)偏[110]方向2°時的表面臺階
Fig.3 Surface steps of GaAs(001) substrate with 2° offcut towards [110]


圖4 GaAs襯底表面富Sb的2×8表面重構[17]
Fig.4 (2×8) reconstruction of Sb on GaAs(001) surfaces[17]
4 結 論
本文采用LP-MOCVD技術與Sb界面處理方法,基于IMF生長模式制備了GaSb/GaAs量子點。實驗結果表明:(1)采用IMF生長模式生長的量子點形貌存在明顯的各向異性,量子點的形貌近似為長方體,生長模式為準二維(2D)模式。(2)降低壓強可以有效抑制GaSb量子點沿<110>方向的各向異性,壓強為4 kPa時量子點密度最大,量子點長寬比從10 kPa時的3.5降低至1。(3)反應室壓強變化對量子點生長機制有著重要影響。通過降低壓強,一方面增大{111}A面Ga原子的解吸附作用,可以降低沿[110]方向的生長速率而抑制各向異性生長;另一方面降低了吸附原子的擴散激活能,增大擴散長度,從而抑制襯底臺階取向和表面重構帶來的各向異性生長。

