六角氮化硼(h-BN)對單層硒化銦(InSe)的調制效應及這一新結構的電子性質
謝子鋒, 張智慧, 李 赫, 鄭 丹, 段 理
(1.長安大學材料科學與工程學院,西安 710064; 2.長安大學環境科學與工程學院,西安 710064)
1 引 言
自石墨烯從石墨中分離出來以后,二維材料由于其獨特的光電性質,越來越受到人們的重視[1]. 但是本征石墨烯帶隙為零,不具備半導體性質,這限制了其在納電子學器件中的應用[2]. 作為替代方案,已經出現了其他二維材料的研究. 如二維硫族化合物,其帶隙介于1-3 eV,這意味著可制造出較高開關比的器件[3, 4]. 黒磷,從塊體到單層有0.3-2.0 eV的直接帶隙以及較高的載流子遷移率,然而進一步研究發現,單層或幾層BP在大氣環境中不穩定,受空氣中的水分和氧氣的嚴重降解[5,6]. 具有類似石墨層狀結構的六角氮化硼(h-BN),帶隙理論計算值為4.8 eV左右,實驗值為5.9 eV左右,是一種寬禁帶半導體[7]. 直接的寬帶隙可用于遠紫外光發射,同時具有良好的化學穩定性和力學性能. 比起常用的SiO2表面,h-BN片是原子級的薄片且沒有電荷雜質以及懸掛鍵,h-BN作為一種良好的電介質材料而受到人們親睞[8].
最近Geim等人成功制備出只有幾個原子厚度的二維硒化銦(InSe)材料,它擁有比石墨烯、黒磷及其他過渡金屬二硫屬元素更好的半導體屬性[9]. InSe,六方晶系結構,每層都有一個蜂窩狀晶格. 層與層之間通過范德華力連接起來,層間距約為0.8 nm. 超薄InSe電子遷移率高,室溫下超過1000 cm2V-1s-1,遠遠超過了硅,液氮溫度下載流子遷移率可以達到104cm2V-1s-1[10, 11]. 這些研究表明二維InSe在超快電子領域和光電子領域有很大的應用潛力.
幾年前,范德華(vdW)異質結構的概念由Geim和Grigorieva提出[12]. 這種vdW異質結通過層疊二維結晶原子層合成,層與層之間沒有化學鍵,依靠范德華力結合在一起. 目前,用不同二維材料堆垛成三維空間里具有原子層精度的異質結成為研究的熱點. 最近有一些人開始制備硒化銦基異質結器件. Chen等人制造了硒化銦/石墨烯異質結光電探測器,該器件光響應性和外部量子效率比單純二維硒化銦高四個數量級[13];Ding、Padilha等人研究了硒化銦/黒磷范德華異質結的結構和電子特性,其載流子遷移率有了很大的提升[14, 15];Alharbi等人制備了硒化銦/氮化硼異質結,通過透射率,反射率和吸收光譜的光學分析揭示了設計一種新型光通信傳感器的可能性[16].
因此,考慮到單層硒化銦和六方氮化硼的優異性質,在本文的研究中,我們將單層InSe堆疊于h-BN片層上構建出新型InSe/h-BN異質結構,研究該異質結的穩定性和能帶結構.
2 理論方法和模型
采用基于密度泛函理論(DFT)的第一性原理計算程序包CASTEP模塊計算InSe/h-BN體系的結構和電子性質[17]. 廣義梯度近似(GGA)下的PBE泛函用來估計電子交換關聯作用,用超軟贗勢(USPP)來描述離子實和電子之間的相互作用[18]. 通過使用Grimme提出的經驗校正方案消除vdW相互作用的影響. Monkhorst-Pack網格布里淵區K點取樣為5*5*1[19]. 為了避免相鄰兩個超胞間的相互影響,我們設置真空層厚度為15 ?,此時層間作用可以忽略不計. 經過收斂性測試,平面波函數截斷能值取為400 eV,在結構優化時,能量收斂標準為每個單胞能量為10-5eV,力的收斂判據為0.03 eV/?.
首先優化孤立狀態的單層InSe和h-BN,優化后單層InSe晶格常數為a=b=4.084 ?,單層h-BN晶格常數為a=b=2.510 ?,兩者晶格失配率為超過38%. 為了降低失配率,我們選用超胞匹配,在本文的研究中選用3*3*1的硒化銦超胞和5*5*1的h-BN超胞進行匹配,超胞的晶格參數分別為a=b=12.25 ?和a=b=12.55 ?,此時晶格失配率小于2.4%,在計算中認為是合理的[20]. 為此,我們建立三個不同模型來研究InSe/h-BN異質結的結構性質,結構A固定六方氮化硼,建立晶格常數為a=b=12.55 ?的模型,結構B取兩種物質晶格常數的平均數a=b=12.40 ?構建模型,結構C固定硒化銦,建立晶格常數為a=b=12.25 ?的模型.異質結結構如圖1所示.
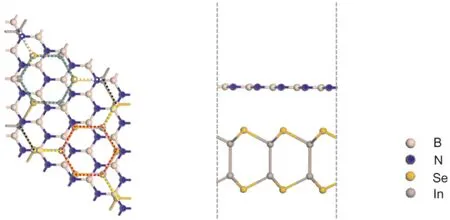
圖1 優化后InSe/h-BN異質結的俯視圖(左)和側視圖(右)Fig. 1 Top view (made) and side view (right) of the InSe/h-BN heterojunction after optimization.
3 結果和討論
形成能是反映異質結形成難易程度和穩定性的一個重要參數[14]. 為了考察異質結形成的合理性,我們計算了單層InSe和單層h-BN的能量以及三種異質結的總能量,本文中形成能Ef的計算采用以下公式:
Ef=EInSe/h-BN-(EInSe+Eh-BN)
這里EInSe/h-BN為異質結構的總能量,EInSe為單層硒化銦的能量,Eh-BN為單層六角氮化硼的能量. 計算得出結構A、B、C的結合能如表1所示.
表1 三種硒化銦/六角氮化硼異質結的形成能
Table 1 Binding energies of InSe/h-BN heterostructure with three stacking conformations.

StructureABCEf(eV)-0.2712-0.2345-0.0023
由表中形成能數值可以看出均為負值,表明體系為放熱過程,三種異質結構均能穩定存在. 三種結構相比,結構A能量最小為-0.2712 eV,說明結構A最穩定.
為了便于比較,我們首先計算了單層InSe和h-BN的能帶結構,如圖2所示. 從能帶圖中可以看出單層InSe帶隙為1.44 eV,導帶底位于Γ點,而價帶頂位于Γ和K點之間靠近K點處,是間接帶隙半導體. h-BN帶隙為4.68 eV,導帶底位于Γ點而價帶頂于K點,也為間接帶隙,與文獻中報道一致[21-23],說明我們選取的計算參數是合理的.

圖2 單層硒化銦(a)和六方氮化硼(b)的能帶結構圖(圖中虛線表示費米能級位置)Fig. 2 Band structures of monolayer InSe (a) and h-BN (b). (The dotted line indicates the Fermi level position)
接著,我們研究了將單層h-BN放在單層InSe層上的三種特殊情況,堆疊結構如圖1所示. 差分電荷密度可以判斷體系中的電荷轉移情況,如圖3(d)所示(由于三種結構差分電荷密度基本一致,所以本文只給出了一幅圖),其中藍色區域表示差分電荷密度為負值,意味著電子的損失,相反黃色區域意味著電子的聚集,由圖中可以看出電子的轉移都在層內發生,層與層之間未發現電荷轉移. 由鮑林標度[24]可知N原子比B原子電負性大1.0,Se原子比In原子電負性大0.77,因此N原子和Se原子周圍區域均為黃色,意味著得到電子,而且氮原子周圍黃色更深. 從圖中電荷轉移可以看出h-BN由B-N共價鍵連接起來,InSe是由四個通過共價鍵(Se-In-In-Se)連接起來的原子平面組成(中間是較弱的In-In鍵). 層與層之間沒有電荷交換,進一步證實層間是弱的范德華力結合.
所以InSe/h-BN異質結可以視為單層InSe和單層h-BN的疊加 .相應的能帶結構如圖3(a)-(c)所示,結構A、B、C的帶隙分別為0.952 eV、1.105 eV、1.211 eV. 異質結的價帶頂位于G和K點之間靠近K點位置,導帶低位于G點,所以異質結也為間接帶隙半導體. 與單層硒化銦相比,三種異質結構的帶隙均有所減小. 為了獲得更多細節信息,我們研究了每個體系和單層InSe的分波態密度,如圖3(e)-(h)所示. 很明顯,三種結構VBM主要由In原子和Se原子的p態所貢獻,而CBM則由In原子的s態和Se原子的p態之間的雜化態組成,和單層硒化銦能量分布類似,即異質結的VBM與CBM電子貢獻都來源于InSe. h-BN中的N原子和B原子在能量為-1.1 eV,-2.3 eV,-3.5 eV和-15.0 eV(圖中未畫出)處存在一個尖峰,在費米能級以上沒有貢獻. 三種結構的分態密度只有帶隙寬度和費米能級附近有所不同. 三種結構帶隙的變化的不同,我們認為是六方氮化硼對硒化銦層的調控作用.
為了更好的理解帶隙的變化,我們計算探討了異質結InSe/h-BN中h-BN層對InSe層的具體晶格調控. 我們發現經過優化以后,InSe/h-BN異質結中由于原子之間的相互作用,共價鍵Se-In、In-In和B-N的鍵長等物理參數均發生了變化,如下表所示:
表中dSe-Inn、dIn-Inn、dB-N、dc-c分別表示優化后Se-In鍵、In-In鍵、B-N鍵以及InSe和h-BN層的層間距的大小. 由于六方氮化硼中硼原子和氮原子在硒化銦上方所處的位置不同,所以它對硒化銦中Se-In鍵、In-In鍵的調控會有不同. dSe-In1表示B原子正好位于硒化銦六元環的中心位置時Se-In鍵的長度(圖1中紅色線條表示),這六個Se-In鍵所處環境相同,具有相同的鍵長. dSe-In2表示N原子正好位于硒化銦六元環的中心位置時Se-In鍵的長度(圖1中綠色線條表示);dSe-In3表示B原子位于Se-In鍵橋位上方時Se-In鍵的鍵長(圖1中黃色線條表示);dSe-In4表示N原子位于Se-In鍵橋位上方時Se-In鍵的鍵長(圖1中白色線條表示);dSe-In5為Se-In鍵垂直方向上沒有B、N原子時Se-In鍵的鍵長(圖1中黑色線條表示);同樣地,共價鍵In-In鍵處于三種不同的環境,鍵長數據如表中dIn-Inn所示. 由表中數據可以看出,與單層硒化銦和氮化硼相比異質結價鍵參均發生了變化. 不同原子之間由于電子云的漲落,正負電荷重心發生瞬時的不重合從而產生瞬時偶極,產生色散力,色散力越大引起的變形性越大. 我們用Se-In鍵鍵長和In-In鍵鍵長的方差(分別為σ1和σ2)來分析鍵長的變化情況,我們發現σ1A>σ1B>σ1C,同時σ2A>σ2B>σ2C,這說明結構A中硒化銦中處于不同位置的Se-In鍵和In-In鍵的鍵長波動變化最為顯著,結構B次之,結構C中鍵長基本趨于穩定. 同時鍵長波動最明顯的A結構帶隙值變化也最為顯著(為0.952 eV),B結構次之,鍵長趨于穩定的C結構帶隙變化相對較弱(為1.211 eV). 說明在固定六方氮化硼的結構A中,調控作用最明顯.


圖3 (a)-(c)依次為結構A、B、C的能帶結構(圖中虛線表示費米能級位置);(d)為異質結的差分電荷密度圖,(e)-(h)依次為結構A、B、C和InSe的分波態密度圖.Fig. 3 (a)-(c) Band structures of structures A, B, and C, respectively (the dotted line indicates the Fermi level position). (d) Differential charge density of the heterojunction. (e)-(h) partial DOSs of structures A, B, C, and InSe, respectively.

StructuredSe-In1dSe-In2dSe-In3dSe-In4dSe-In5σ1dIn-In1dIn-In2dIn-In3σ2dB-Ndc-cPristine2.687—2.879—1.449—A2.6872.6792.6742.7132.7073.0×10-42.8012.7972.8364.6×10-41.4493.874B2.6692.6642.6572.6962.6872.7×10-42.7882.7872.8185.5×10-41.4323.886C2.6742.6722.6732.6732.6735.0×10-42.8382.8372.8383.4×10-41.4143.888
接著,研究了經過h-BN調控后的單層InSe的能帶結構,也就是晶格參數變化如表2中所示的單層InSe的結構. 圖4給出了三種情況下的能帶圖. 我們發現此時三種結構任為間接帶隙,帶隙分別為0.953 eV、1.126 eV和1.301 eV,此時的帶隙與InSe/h-BN異質結體系的帶隙差別甚微,分別為0.001 eV,0.021 eV,0.090 eV,不同于無應變的單層InSe的能帶結構(帶隙為1.444 eV). 這說明在異質結構中,帶隙的變化為h-BN的調控作用所致. 結構中h-BN和InSe片層之間的相互作用導致在InSe片層中存在較大的應變,從而導致InSe能帶的變化. 三種結構中h-BN的調控作用依次減弱,這是因為在相同的晶格失配度下結構A中固定了h-BN,而結構C中固定了InSe,六方氮化硼的結構發生了輕微的改變,所以三種結構其對硒化銦的調控作用依次減弱.

圖4 優化好的InSe/h-BN異質結中去掉h-BN后InSe層的能帶結構(圖中虛線條表示費米能級位置)Fig. 4 Band structures of InSe in the optimized InSe /h-BN system without h-BN substrate. (the dotted line indicates the Fermi level position)
4 結 論
總之,我們采用基于密度泛函理論的第一性原理成功地預測了三種InSe/h-BN異質結構的穩定構型. 二維InSe/h-BN異質結和單層InSe一樣都是間接帶隙. 通過差分電荷密度,態密度,能帶結構的研究發現異質結層與層之間沒有電荷轉移,帶隙的變化是由InSe和h-BN之間的相互作用而誘導的晶格應變引起的. 三種結構的對比發現,固定h-BN后對體系的調控作用最明顯,改變h-BNd的結構,其對體系帶隙的調控作用有所減弱. 我們的研究結果表明,單層InSe沉積或生長在不同h-BN片上可以獲得不同的晶格應變,實現對單層InSe能帶結構的有效調控. 這一發現可以實現在原子精度定向改變系統的帶隙,對實際實驗具有一定的指導意義.

