基于兩步退火法提升Al/n+Ge歐姆接觸及Gen+/p結二極管性能*
王塵 許怡紅 李成 林海軍 趙銘杰
1) (廈門理工學院光電與通信工程學院,福建省光電信息材料與器件重點實驗室,廈門 361024)
2) (廈門工學院電子信息工程系,廈門 361024)
3) (廈門大學物理學系,半導體光子學研究中心,廈門 361005)
1 引 言
隨著COMS工藝尺寸的不斷減小,Ge材料由于具有比硅更高的電子和空穴遷移率、在光纖通信波段具有更大的吸收系數以及更低的工藝處理溫度,成為極具應用前景的材料之一,受到人們的廣泛關注[1,2].目前,高性能Ge p-MOSFET的研究已經取得了不錯的進展,然而Ge n-MOSFET性能的提升仍存在許多問題[3-5],如隨著器件的源/漏接觸面積不斷縮小,源/漏的接觸電阻增大,器件性能下降[6-8].此外,金屬與鍺低比接觸電阻率的歐姆接觸較難實現,這主要是由兩方面決定的: 一方面,金屬與鍺的接觸存在強烈的費米釘扎效應,導致大的電子勢壘高度[9]; 另一方面,由于n型雜質在Ge中具有較大的擴散系數(與摻雜濃度正相關)以及較低的雜質固溶度,使得在Ge中實現高摻雜濃度、界面陡峭以及低擴散深度的n型摻雜十分困難.結合離子注入和后退火工藝是實現Ge中n型摻雜的常用手段,然而要在Ge中獲得高激活濃度n型摻雜的同時,雜質的擴散深度也要盡可能小,此時就需要一種退火時間短(減小雜質擴散)以及退火溫度高(激活雜質離子)的退火技術.相比于其他退火技術,如常規熱退火[10]、快速熱退火[11]、快閃燈照退火[12]、微波退火[13]等,脈沖激光退火技術擁有獨特的優勢[14]: 首先,退火時間極短,只有幾十納秒,使得雜質的擴散深度減小,雜質的損失也減小; 其次,脈沖激光退火過程是一個亞穩態的熱處理過程,故允許摻雜濃度超過雜質在半導體中的固溶度極限; 再次,退火溫度很高,一般可以達到半導體材料的熔點,有利于雜質的激活; 最后,可對特定區域進行退火處理,忽略對周圍區域的影響.這些優勢使得脈沖激光退火技術成為一種實現Ge中高激活濃度n型摻雜、低擴散深度以及雜質損失少的有效退火方法[15].
目前,結合離子注入和激光退火技術在Ge中實現激活濃度大于1020cm-3的n型摻雜,已有許多文獻報道[16,17],且激光退火還可有效修復離子注入損傷,減小器件的暗電流.但是,實現高性能Ge n+/p結二極管以及高激活濃度的n+Ge,通常需要較大的離子注入劑量以及激光退火能量,而較大的激光退火能量將導致雜質在Ge中擴散深度加大,不利于Ge中n型淺結的制備,限制了其在器件中的應用[18-20].
本文采用低溫預退火處理注磷鍺樣品,在保證雜質幾乎不發生擴散的同時,初步修復注入損傷,而后再脈沖激光退火.采用低溫預退火與脈沖激光退火的兩步退火工藝,降低了雜質在Ge中的擴散深度,提高了Ge中雜質激活濃度,并提升了金屬與鍺的歐姆接觸以及Ge n+/p結二極管的性能.結合離子注入和兩步退火工藝,Al/n+Ge歐姆接觸的比接觸電阻率降至2.61×10-6Ω·cm2,Ge n+/p結二極管在±1 V的整流比提高到8.3×107.
2 實 驗
本實驗采用電阻率為0.088 Ω·cm,厚度為500 μm的p-Ge(100)晶片作為襯底材料,其過程可分為三個步驟.第一步,首先對襯底依次進行丙酮和乙醇超聲清洗,冷去離子水沖洗干凈后再用冷去離子水超聲清洗3遍,然后浸泡HF∶H2O=1∶50約15 s,去除Ge表面氧化物,接著冷去離子水沖洗干凈,氮氣吹干; 而后,用PECVD在清洗后的襯底表面沉積15 nm SiO2,再在注入能量為30 keV,注入劑量為5×1014cm-2條件下注入磷離子(P+),離子注入后用濃度適中的氫氟酸去除樣品表面的SiO2.第二步,對注磷p-Ge樣品進行不同條件的退火處理,形成n+-Ge層; 低溫預退火采用的是N2氣環境下快速熱退火工藝,而脈沖激光退火(ELA)是用248 nm波長KrF準分子激光器以不同能量密度的脈沖激光對注磷Ge樣品在N2氣環境下進行掃描退火,脈沖激光光斑為面積4 mm×3 mm的矩形光斑,激光分別沿著X軸和Y軸對樣品進行單脈沖掃描.第三步,將不同條件退火后的樣品經圖1所示工藝制備得到Ge n+/p結二極管,二極管的金相顯微鏡俯視圖如圖1最后一步所示,并通過測試它們的I-V特性曲線,分析p-n結特性; 同時,采用光刻、濺射以及腐蝕等工藝,制備Al/n+-Ge的歐姆接觸,并采用了圓點傳輸線模型(CTLM)來計算得到歐姆接觸的比接觸電阻率.
3 結果與分析
首先固定脈沖激光退火能量密度為150 mJ/cm2,改變低溫預退火的溫度和退火時間,制備不同退火條件下的Ge n+/p結二極管,并測試二極管的I-V特性曲線.預退火溫度的選擇依據是在保證雜質不發生明顯擴散的情況下能夠一定程度修復離子注入損傷,根據文獻報道[21-23],選擇的溫度范圍為從350 ℃變化至450 ℃,具體退火條件及相應的樣品編號如表1所示.樣品R1至R4的p-n結二極管I-V特性測試曲線如圖2所示,從圖2中抽取得到它們的理想因子和整流比如表1所示.測試結果表明: 4種樣品中,樣品R2二極管的理想因子最小、反向漏電最小以及整流比最大,這說明400 ℃-10 min條件下的低溫預退火效果最好.對比樣品R2和R3,僅低溫預退火的時間不同,樣品R2二極管的性能明顯更好,說明在相同預退火溫度下,退火時間不能太長,盡管低溫退火雜質擴散非常小,但是由于離子注入深度很淺,雜質離子主要分布在靠近表面很薄的一層Ge中,長時間的低溫退火仍然會有較多雜質向外擴散[23],造成較大的雜質損失,影響二極管的性能.此外,對比樣品R1和R2二極管的I-V曲線,2種二極管正向電流相差不大,但是在-1 V時R2樣品的反向漏電流比R1樣品約小了一個數量級,說明低溫預退火溫度越高越有利于注入損傷的修復,從而減小二極管的反向漏電.但是低溫預退火溫度又不能太高,如樣品R4,當低溫預退火溫度達到450 ℃時,盡管有利于離子注入損傷的修復,但這個溫度下退火可能造成的雜質外擴散損失比樣品R3還要多[23],故二極管的性能最差.

表1 不同退火條件下Ge n+/p結二極管的整流比和理想因子Table 1.Rectification ratio and ideality factor of Ge n+/p junction diodes under different annealing conditions.
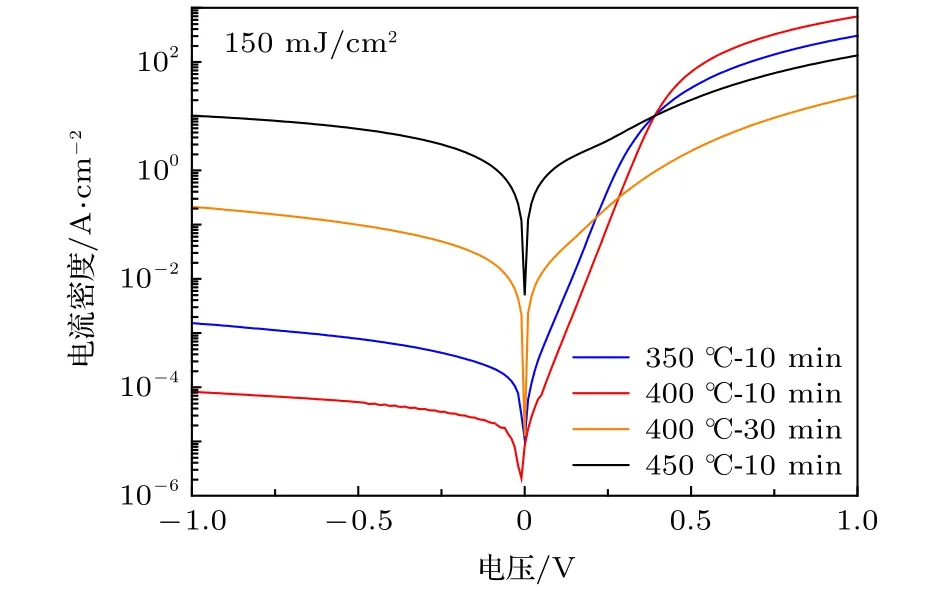
圖2 150 mJ/cm2激光能量密度不同預退火條件下p-n結二極管的I-V特性曲線Fig.2.Room temperature I-V characteristics of Ge n+/p junction diode formed by ELA with one pulse at 150 mJ/cm2 with different pre-annealing conditions.
而后改變脈沖激光退火能量密度(100,150,200,250 mJ/cm2),分別基于兩步退火法和單獨激光退火制備了兩組Al/n+-Ge的歐姆接觸,兩步退火法中的低溫預退火溫度和時間定為400 ℃-10 min.本文采用圓形傳輸線模型(CTLM),通過測試不同圓環間距的I-V特性,擬合計算得到Al/n+-Ge歐姆接觸的比接觸電阻率隨退火條件的變化情況(圖3).從圖3中可以看到,樣品單獨在100 mJ/cm2激光退火后,由于其測得的I-V特性曲線不是直線(未在此處顯示),表明該條件下無法得到Al與Ge的歐姆接觸,說明此退火條件下不能很好地修復離子注入損傷以及激活雜質離子; 而結合了低溫預退火后,可得到Al/n+-Ge歐姆接觸的比接觸電阻率為3.44×10-4Ω·cm2.結合低溫預退火,提高激光退火能量為150 mJ/cm2時,得到的Al/n+-Ge接觸的比接觸電阻率最低,約為2.61×10-6Ω·cm2,比單獨采用脈沖激光退火樣品的比接觸電阻率(4.48×10-5Ω·cm2)降低了一個多數量級.此外,從圖3中還可以看到,兩步退火法可得到比單獨激光退火更低的比接觸電阻率,而低的比接觸電阻率對應高的摻雜濃度.為了得到雜質的擴散深度以及激活濃度,對樣品進行二次離子質譜(SIMS)以及擴展電阻探針(SRP)測試[17],結果發現,離子注入樣品經過兩步退火后,磷在Ge中的擴散深度明顯比單獨采用脈沖激光退火后要小很多,說明低溫預退火可降低脈沖激光退火時雜質在Ge中的擴散系數,更容易在Ge中獲得更小雜質擴散深度的n型摻雜.擴展電阻探針測試可以得到磷的最大激活濃度為6×1019cm-3[17],比采用傳統退火方式獲得的雜質激活濃度高好幾倍[10],這說明控制調整離子注入條件以及激光退火能量密度,結合低溫預退火和激光退火的兩步退火法是實現鍺中實現高激活濃度、低擴散深度的n型摻雜的一種有效途徑.
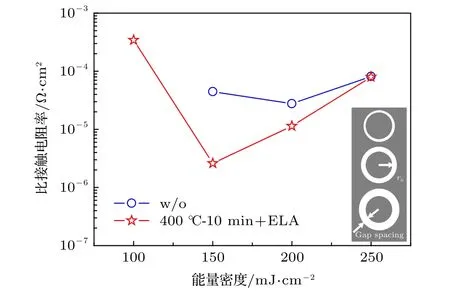
圖3 Al/n+-Ge接觸的比接觸電阻率隨不同退火條件的變化曲線,內插圖是CTLM結構的俯視圖Fig.3.Change of specific contact resistivity of Al/n+-Ge extracted by CTLM with different annealing conditions.The inset shows the CTLM schematic structure (top view).

圖4 (a) 不同退火條件下Ge n+/p結二極管的I-V特性曲線; (b) Ge n+/p結二極管的整流比隨退火條件變化曲線Fig.4.(a) Room temperature I-V characteristics of Ge n+/p junction diode; (b) rectification ratio of Ge n+/p junction diodes formed by ELA with or without pre-annealing at 400 ℃-10 min.
圖4(a)所示為不同退火條件下的Ge n+/p結二極管的I-V特性曲線,計算抽取得到它們的整流比(@±1 V),如圖4(b)所示.結果表明,當脈沖激光能量密度小于等于150 mJ/cm2時,低溫預退火對I-V特性的影響作用十分明顯,經過兩步退火法制備得到的二極管性能比單獨激光退火后制備的二極管性能要好得多; 而當脈沖激光能量密度大于等于200 mJ/cm2時,低溫預退火對二極管I-V特性的影響減弱.這是因為Ge中注入的雜質離子在兩步退火過程中的擴散主要發生在脈沖激光退火過程中,擴散深度由Ge層熔化深度決定,Ge中低能量離子注入后,損傷區域非常薄,低溫預退火可部分修復離子注入損傷,提高Ge的晶體質量,在低能量密度激光退火時,Ge層熔化深度較淺,低溫預退火對熔化深度的影響較為明顯,而當激光退火能量密度較大時,Ge層熔化深度較深,此時低溫預退火作用可以忽略不計.此外,在400 ℃-10 min的低溫預退火外加150 mJ/cm2的脈沖激光退火的退火條件下,制備得到超高性能的Ge n+/p結二極管,整流比高達8.35×106,相比于未經低溫預退火處理得到的PN結二極管,整流比提高了約兩個數量級,且二極管的理想因子僅為1.07,說明正向電流以擴散電流為主,PN結勢壘區中產生復合中心很少,缺陷很少,離子注入損傷得到有效修復.通過高分辨投射電鏡測試分析[17],發現p-Ge經過磷離子注入后形成了約15 nm左右的注入損傷區,經400 ℃-10 min的低溫預退火后,注入損傷區的損傷得到了初步修復,但仍然存在一些殘余的注入損傷,再經過150 mJ/cm2激光退火后,殘余注入損傷得到了良好的修復,樣品中幾乎看不到明顯缺陷的存在,這更直觀說明結合低溫預退火和激光退火的兩步退火法可有效修復Ge中的離子注入損傷.
4 結 論
本文進行了p-Ge襯底中磷離子注入后,采用兩步退火工藝對其退火處理的研究,即先低溫預退火,初步修復注入損傷,而后再經過脈沖激光退火,進一步修復注入損傷以及激活雜質離子,在此基礎上制備了Al/n+Ge的歐姆接觸以及Ge n+/p結二極管.I-V特性和SIMS,SRP,TEM等測試的結果表明: 樣品先低溫預退火,可降低脈沖激光退火時鍺中雜質的擴散深度,提高雜質激活濃度,Al/n+Ge歐姆接觸的比接觸電阻率降至2.61×10-6Ω·cm2,Ge n+/p結二極管在±1 V的整流比提高到8.35×106,歐姆接觸及二極管性能均得到了顯著提升.結合低溫預退火和脈沖激光退火的兩步退火法有望運用在高性能Ge n-MOSFET以及其他Ge器件中.

