熱退火處理對AuGeNi/n-AlGaInP歐姆接觸性能的影響*
王蘇杰 李樹強 吳小明 陳芳 江風益
(南昌大學, 國家硅基LED工程技術研究中心, 南昌 330047)
本文在n?(Al0.27Ga0.73)0.5In0.5P表面通過電子束蒸發Ni/Au/Ge/Ni/Au疊層金屬并優化退火工藝成功制備了具有較低接觸電阻的歐姆接觸, 其比接觸電阻率在445 ℃退火600 s時達到1.4 × 10—4 Ω·cm2.二次離子質譜儀測試表明, 疊層金屬Ni/Au/Ge/Ni/Au與n?AlGaInP界面發生固相反應, Ga, In原子由于熱分解發生外擴散并在晶格中留下Ⅲ族空位.本文把歐姆接觸形成的原因歸結為Ge原子內擴散占據Ga空位和In空位作為施主提高N型摻雜濃度.優化退火工藝對低摻雜濃度n?(Al0.27Ga0.73)0.5In0.5P的歐姆接觸性能有顯著改善效果, 但隨著n?(Al0.27Ga0.73)0.5In0.5P摻雜濃度提高, 比接觸電阻率與退火工藝沒有明顯關系.本文為n面出光的AlGaInP薄膜發光二極管芯片的n電極制備提供了一種新的方法, 有望大幅簡化制備工藝, 降低制造成本.
1 引 言
目前, 與GaAs襯底晶格匹配的(AlxGa1—x)0.5In0.5P材料是制備590—660 nm譜段發光二極管(LED)性能最好的化合物半導體材料[1].
AlGaInP LED的研制可以追溯到上世紀80年代[2], 初期都是在GaAs襯底上晶格匹配生長AlGaInP材料后制備p面朝上的LED芯片, 這種結構的LED芯片存在襯底光吸收和表面全反射損耗, 其功率轉換效率通常只有10%左右[3].此后,業界通過晶片鍵合[4]、襯底剝離和表面粗化等[5]芯片工藝開發出了n面朝上的AlGaInP薄膜LED芯片, 其消除了襯底光吸收, 減少了出光面的全反射損耗, 大幅度提升了AlGaInP LED的功率轉換效率[6], 比如峰值波長630 nm的AlGaInP薄膜LED芯片封裝器件后的功率轉換效率已達到60%左右[7], 使AlGaInP LED應用領域得到拓展,目前已廣泛應用于汽車燈具、戶外全彩顯示、舞臺投光燈、植物生長照明、多基色混合白光照明、城市亮化等諸多領域.
常規n面出光的AlGaInP薄膜LED芯片是在n+?GaAs層上制備N型歐姆接觸.這種n面電極制備方案存在如下幾個問題: 第一, 影響光效,由于n+?GaAs對可見光完全吸收, 因此n電極存在光吸收問題, 影響LED的功率轉換效率; 第二,制程復雜, 成本高[8], 在GaAs上制備n型歐姆接觸, 在芯片表面粗化時, 需要增加一道光刻工藝,保留與n電極進行接觸的GaAs, 在需要進行p面電極和n面電極對位時, 由于n+?GaAs層不透光,還需要增加一道光刻, 以得到一個可以看到p電極圖形的透明窗口進行定位.
如果能在n?AlGaInP層上直接制備n型歐姆接觸, 就可以消除業界普遍采用的n+?GaAs層上制備n型歐姆接觸時存在的上述問題, 在提高AlGaInP薄膜LED芯片光電性能的同時簡化其制備工藝, 并降低其制備成本.但由于n?AlGaInP材料中Al原子易與O原子結合形成Al元素的氧化物[9], 較難做到性能優異的歐姆接觸[10].這一難題的存在, 使n?AlGaInP材料上直接制備歐姆接觸鮮有系統的研究.因此, 研究在n?AlGaInP粗化層上直接制備n型歐姆接觸, 具有重要意義.
Au/Ge/Ni是傳統Ⅲ?Ⅴ族半導體制作歐姆接觸的合金材料[11], 例如GaAs[12], InP[13]等.合金化過程中的互擴散和相變反應被認為是Au/Ge/Ni與n?GaAs形成良好歐姆接觸的主要原因[14].本文通過電子束蒸發在n?(Al0.27Ga0.73)0.5In0.5P材料表面蒸鍍 Ni/Au/Ge/Ni/Au電極, 通過研究 n?(Al0.27Ga0.73)0.5In0.5P表面接觸層的摻雜濃度以及退火工藝, 包括退火溫度和退火時間對歐姆接觸的影響, 獲得了具有較低比接觸電阻率的歐姆接觸,并討論分析其歐姆接觸的形成機理.
2 實驗過程
本實驗使用的外延材料由山東華光光電子股份有限公司提供, 采用LP?MOCVD設備生長,Ⅲ族MO源使用TMGa, TMAl, TMIn, Ⅴ族源使用PH3, AsH3, n型摻雜劑為Si2H6, p型摻雜劑為CP2Mg, AlGaInP材料層生長溫度為690 ± 5 ℃,生長室壓力為50 mbar.外延結構如圖1所示, 自GaAs襯底開始依次生長n?Ga0.5In0.5P腐蝕阻擋層, n+?GaAs, n?(Al0.27Ga0.73)0.5In0.5P 粗化層, n?Al0.5In0.5P下限制層, 非摻雜 MQW有源區、p?Al0.5In0.5P上限制層和p?GaP窗口層.
為研究摻雜濃度對歐姆接觸性能的影響, 本實驗生長了n?(Al0.27Ga0.73)0.5In0.5P粗化層摻雜濃度分別為 7 × 1017, 1 × 1018, 2 × 1018, 3 × 1018cm—3的四批樣品, 依次標記為A, B, C, D.
本文樣品制備依照常規n面出光的AlGaInP薄膜LED芯片加工工藝流程, 其基本步驟包括:生長SiO2全方向反射鏡(ODR)、p電極制備、新支撐基板制備及金屬熱壓鍵合, 依次去除襯底、腐蝕截止層, 制備n電極, 得到常規AlGaInP薄膜LED芯片, 如圖2(a)所示.圖2(b)為去除 n+?GaAs歐姆接觸層后得到以n?(Al0.27Ga0.73)0.5In0.5P層為n面歐姆接觸層的樣品.在蒸發n電極金屬前, 將樣品置于摩爾濃度為0.01 mol/L的稀鹽酸溶液中浸泡4 min, 沖水吹干后, 通過電子束蒸發的方法在 n?(Al0.27Ga0.73)0.5In0.5P層表面蒸鍍Ni/Au/Ge/Ni/Au作為n電極, 金屬厚度依次為100/500/200/100/5000 ?, 最先沉積的金屬為Ni.將A, B, C, D各自平均分為6小份并進行標號:A1, A2, ··, A6, 詳細樣品標號及退火條件見表1.
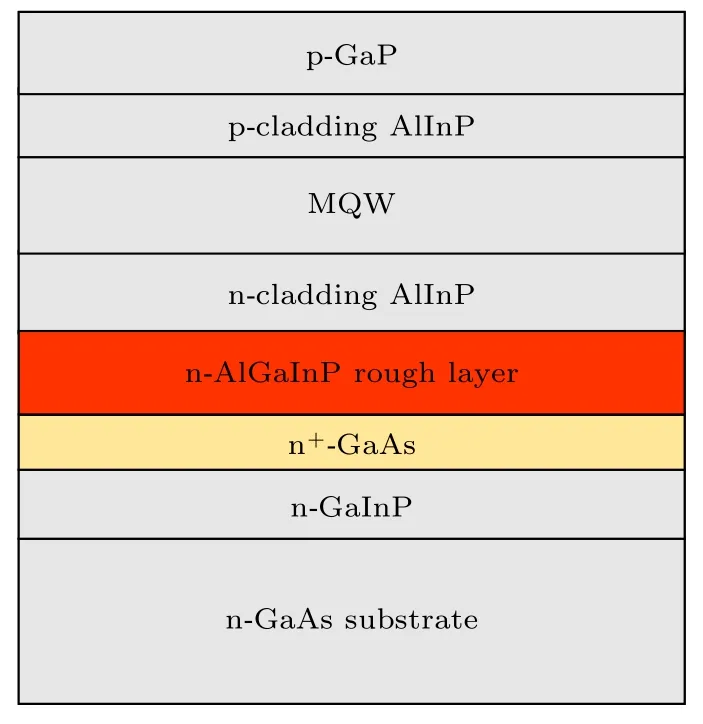
圖1 AlGaInP LED基本外延結構Fig.1.Schematic diagrams of AlGaInP?base LED epitaxial structure.

圖2 n面出光AlGaInP LED (a)常規結構薄膜芯片; (b)基于n?AlGaInP歐姆接觸的芯片結構Fig.2.Schematic diagrams of (a) conventional n?side?up AlGaInP LED structure and (b) n?AlGaInP contact LED.

表1 樣品退火分組信息及比接觸電阻率(ρc)測試結果Table 1.Grouping information of samples annealing and specific contact resistivity (ρc) results.
用圓環傳輸線法(CTLM)測試退火后樣品的I?V特性曲線, 并計算其比接觸電阻率(ρc).圓環間隔從小到大依次為2.5, 5, 10, 15, 20, 25, 30和35 μm, 考慮光刻誤差以及電流擴展帶來的差異,只測試圓環間隔為10—35 μm區域的I?V特性曲線[15].本文選取n?(Al0.27Ga0.73)0.5In0.5P層摻雜濃度為3 × 1018cm—3的樣品, 在退火前后進行二次離子質譜測試(secondary ion mass spectrometry,SIMS), 觀察 n電極與 n?(Al0.27Ga0.73)0.5In0.5P 界面原子的擴散情況.
3 結果與分析
表1列出了各樣品的n?(Al0.27Ga0.73)0.5In0.5P層摻雜濃度 (ND)、退火溫度 (T)、退火時間(Time)以及 NiAuGeNiAu/n?(Al0.27Ga0.73)0.5In0.5P在退火后測試得到的比接觸電阻率ρc.圖3為計算 D5樣品 ρc所需要測試的 I?V曲線, 插圖為CTLM的測試圖形.根據CTLM測試結果可知,當摻雜濃度為3 × 1018cm—3時, 在n?(Al0.27Ga0.73)0.5In0.5P層上直接制備歐姆接觸最優退火溫度為445 ℃, 退火時間為 600 s, 對應的 ρc值為 1.4 ×10—4Ω·cm2.這一數值已接近 AuGeNi/n?GaAs上制備歐姆接觸的結果[16].
A1, A2, A3, B1, B2五個樣品沒有形成歐姆接觸, 因此沒有在表1中列出ρc值.圖4為385 ℃退火25 s時, 4種摻雜濃度樣品的I?V特性.其中插圖為相鄰電極測量接觸特性示意圖.摻雜濃度為7 × 1017和1 × 1018cm—3的樣品退火后的I?V 曲線為非直線, 而摻雜濃度為2 × 1018和3 × 1018cm—3的樣品退火后的I?V曲線為直線.在此退火條件下, 當摻雜濃度達到2 × 1018cm—3時, NiAuGeNiAu/n?(Al0.27Ga0.73)0.5In0.5P接觸由肖特基接觸轉變為歐姆接觸.隨著n?(Al0.27Ga0.73)0.5In0.5P摻雜濃度的提高, ρc值呈現降低趨勢, 這與歐姆接觸的理論相符合[17].
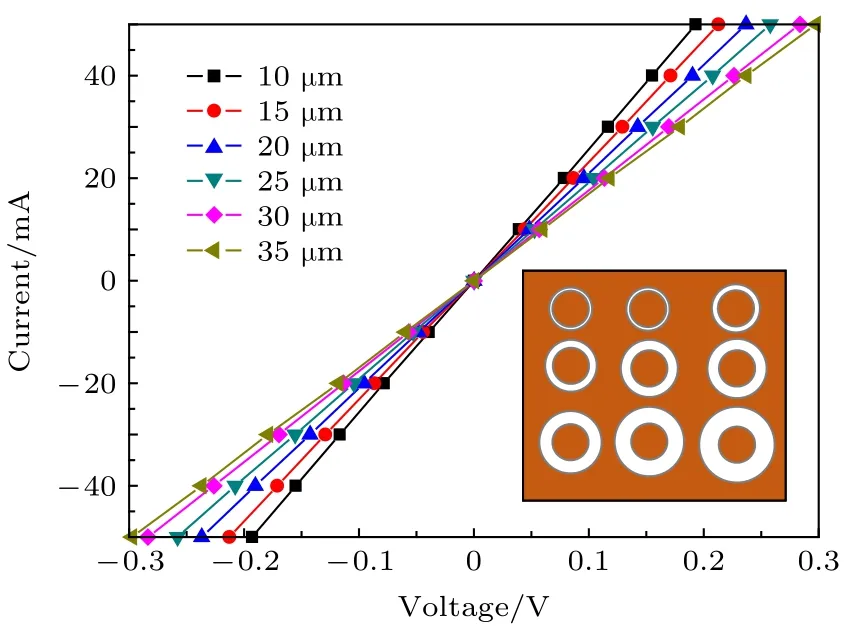
圖3 D5樣品的 I?V 曲線, 圓環間距為 10?35 μmFig.3.I?V behaviors of Sample D5, ring intervals are 10?35 μm.
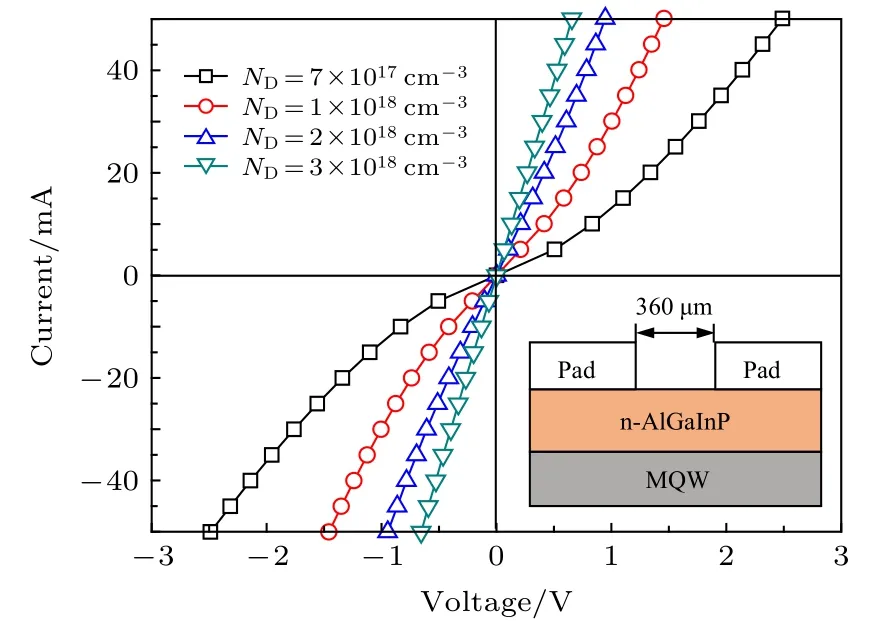
圖4 385 ℃退火25 s時, A1, B1, C1和D1樣品I?V曲線Fig.4.I?V behaviors of Sample A1, B1, C1 and D1 after an?nealing at 385 ℃ for 25 s.
圖5為幾組不同退火條件下ρc與摻雜濃度的關系.隨著退火溫度與時間的增加, 低摻雜濃度樣品 的 NiAuGeNiAu/n?(Al0.27Ga0.73)0.5In0.5P 接 觸也轉變為歐姆接觸.在形成歐姆接觸的相同退火條件下, ρc隨著摻雜濃度的提高逐漸減小.摻雜濃度從 7 × 1017cm—3增大到 1 × 1018cm—3時, ρc值迅速降低, 繼續提高摻雜濃度后, 其變化趨于平緩.
為研究退火過程中Ni/Au/Ge/Ni/Au與n?(Al0.27Ga0.73)0.5In0.5P層之間的界面反應, 本文對n?(Al0.27Ga0.73)0.5In0.5P層摻雜濃度為3 × 1018cm—3退火前后的樣品進行SIMS測試表征, 結果如圖6所示.首先對未退火樣品表面進行SIMS深度剖析, 疊層金屬與粗化層之間區分明顯, 在距離n電極表面深度約為600 nm處, 已經幾乎檢測不到n電極中的金屬元素, 這與蒸鍍n電極的厚度(590 nm)相符.對比分析385 ℃退火25 s后樣品表面SIMS測試結果, 與未退火時存在明顯不同.在n電極一側, 除了Ni, Au, Ge三種元素外, 還檢測到了Ga, In, Al元素.這表明, 在退火過程中, n?(Al0.27Ga0.73)0.5In0.5P發生了分解, 部分Ga, In,Al元素向外擴散.
研究表明[18], 在成熟的 Au/Ge/Ni與 n?GaAs歐姆接觸體系中, 歐姆接觸形成的機理, 是合金過程中的互擴散.GaAs材料會在300 ℃左右發生分解, 而由于合金層Au的存在會加速Ga的外擴散.相變過程如下[14]:
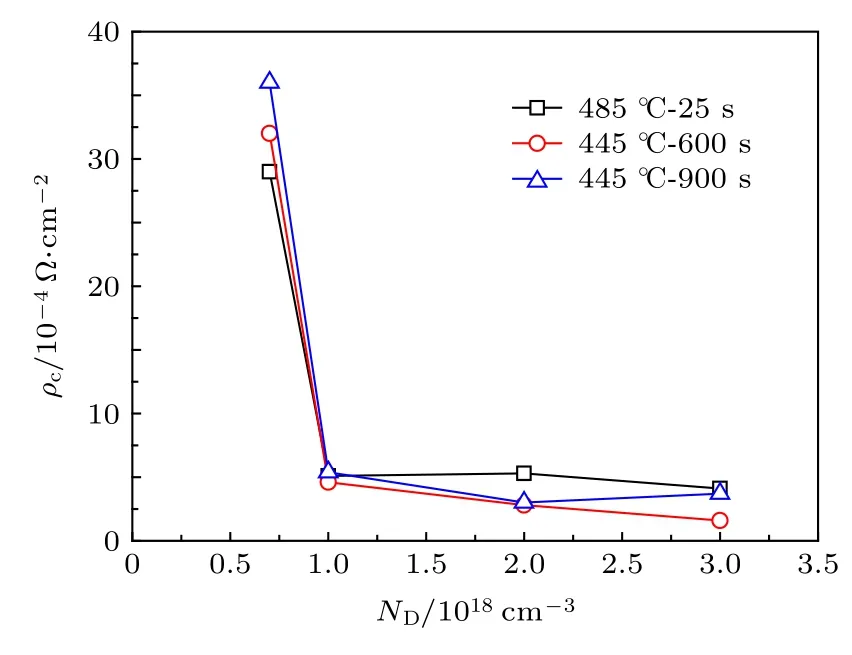
圖5 不同退火條件下, ρc與ND關系Fig.5.Contact resistivity as a function of doping concen?tration for different annealing conditions.
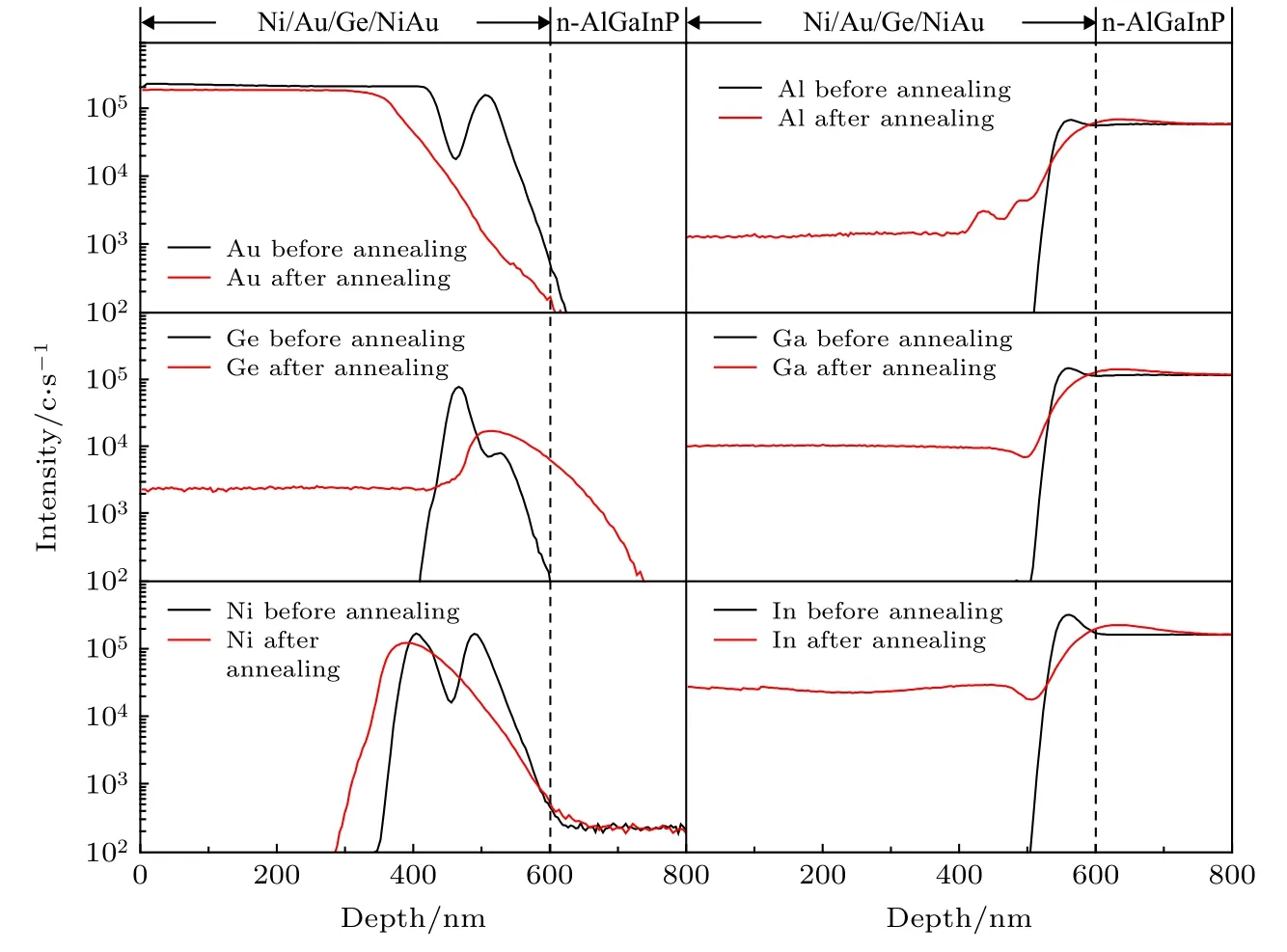
圖6 SIMS深度剖析Ni/Au/Ge/Ni/Au與n?(Al0.27Ga0.73)0.5In0.5P接觸性能Fig.6.SIMS depth profiles of Ni/Au/Ge/Ni/Au contact on n?(Al0.27Ga0.73)0.5In0.5P before annealing and after annealing.

GaAs中由于Ga的外擴散在晶格中留下大量Ga空位.當溫度升高到400 ℃時, Ge會向晶體內擴散占據Ga空位成為施主雜質提供電子, 因此在電極下方可以得到一層n+?GaAs.此外, 也有研究者利用擴散理論在Au/Ge/Pd與n?Al0.5In0.5P界面得到低接觸電阻率的歐姆接觸[19].n?Al0.5In0.5P中In向外擴散, Au/Ge/Pb中的Ge向內擴散, 形成低接觸電阻.
參考前文所述的幾種歐姆接觸機理, 本文認為互 擴 散 是 NiAuGeNiAu/n?(Al0.27Ga0.73)0.5In0.5P形成歐姆接觸的關鍵.AlGaInP材料中Al, Ga,In三種原子按照一定比例占據Ⅲ族位[20], 在退火過程中由于熱分解Ga, In發生外擴散, 在材料中會留下Ga空位與In空位.Au不僅會加速Ga的外擴散, 高溫下還能與In強烈反應形成Au?In化合物, 類似于AuGe/n?InP形成歐姆接觸過程形成的Au10In3[21].同時Ge向界面內擴散占據Ga空位與In空位, 這才是較低摻雜濃度n?(Al0.27Ga0.73)0.5In0.5P也能形成歐姆接觸的原因.足夠的Ge內擴散導致合金層下n?(Al0.27Ga0.73)0.5In0.5P轉變為n+?(Al0.27Ga0.73)0.5In0.5P, 肖特基勢壘消失, 形成歐姆接觸[22].對比可以發現, In外擴散的含量最多,而Al元素擴散較少, 這主要是因為Al易與O元素結合形成較難分解的氧化物.在n?(Al0.27Ga0.73)0.5In0.5P一側, 有部分Ge向內擴散進入晶格中, 占據Ga, In外擴散留下的Ⅲ族空位, 成為施主雜質提高n型摻雜濃度.此外, n?AlGaInP層中檢測到大量的Ni元素, 本文認為Ni在合金化的過程中有助于改善金屬與半導體的界面粗糙度, 提高金屬電極與半導體材料的黏附性, 但過多的Ni內擴散作為深能級受主雜質可能是阻礙比接觸電阻率降低的主要原因.
成功在n?(Al0.27Ga0.73)0.5In0.5P上制備歐姆接觸后, 本文在此基礎上進行了系列優化退火工藝的工作.在相同摻雜濃度、相同退火時間下, 分析NiAuGeNiAu/n?AlGaInP 接觸的 ρc與退火溫度的關系, 結果如圖7(a)所示.從曲線中可以看出,兩種摻雜濃度下的ρc值都隨退火溫度的升高呈現先降低后升高的趨勢, 當退火溫度為445 ℃時,NiAuGeNiAu/n?AlGaInP接觸具有最低的 ρc值.繼續升高退火溫度至485 ℃, 其接觸性能都略有退化.對此, 本文解釋如下: 隨著退火溫度的升高, n?(Al0.27Ga0.73)0.5In0.5P與合金層之間的互擴散加劇,有足夠的Ge占據Ga, In空位, 合金層下方的載流子濃度逐漸趨于飽和, 更高溫度下的接觸性能退化可能與接觸界面Au?Ge合金的“球聚”有關.當Au?Ge與接觸材料浸潤性較差時, 容易在合金化過程中出現“球聚”的現象[23], 收縮成不同大小的孤立小島.“球聚”會使接觸界面粗糙, 提高接觸電阻, 同時降低歐姆接觸性能的穩定性.

圖7 相同摻雜濃度時 (a)退火時間25 s, ρc與退火溫度關系; (b) 退火溫度445 ℃, ρc與退火時間關系Fig.7.At the same ND (a) ρc as a function of annealing temperature when the annealing time is 25 s; (b) ρc as a function of annealing temperature when the annealing tem?perature is 445 ℃.
本文利用SIMS測試中的二次離子轟擊, “剝離”n?(Al0.27Ga0.73)0.5In0.5P表面的疊層金屬, 再通過SEM測試了不同退火溫度下Au?Ge合金在接觸界面的形貌, 結果如圖8所示.圖8(a)與圖8(b)對應的退火溫度分別為445 ℃, 485 ℃, 退火時間都為25 s.在退火溫度達到445 ℃時, Au?Ge合金開始熔化形成較小尺寸的小島, 隨著退火溫度的升高, “球聚”變得愈發嚴重, 接觸界面不再保持光滑,歐姆接觸電阻也隨之升高.
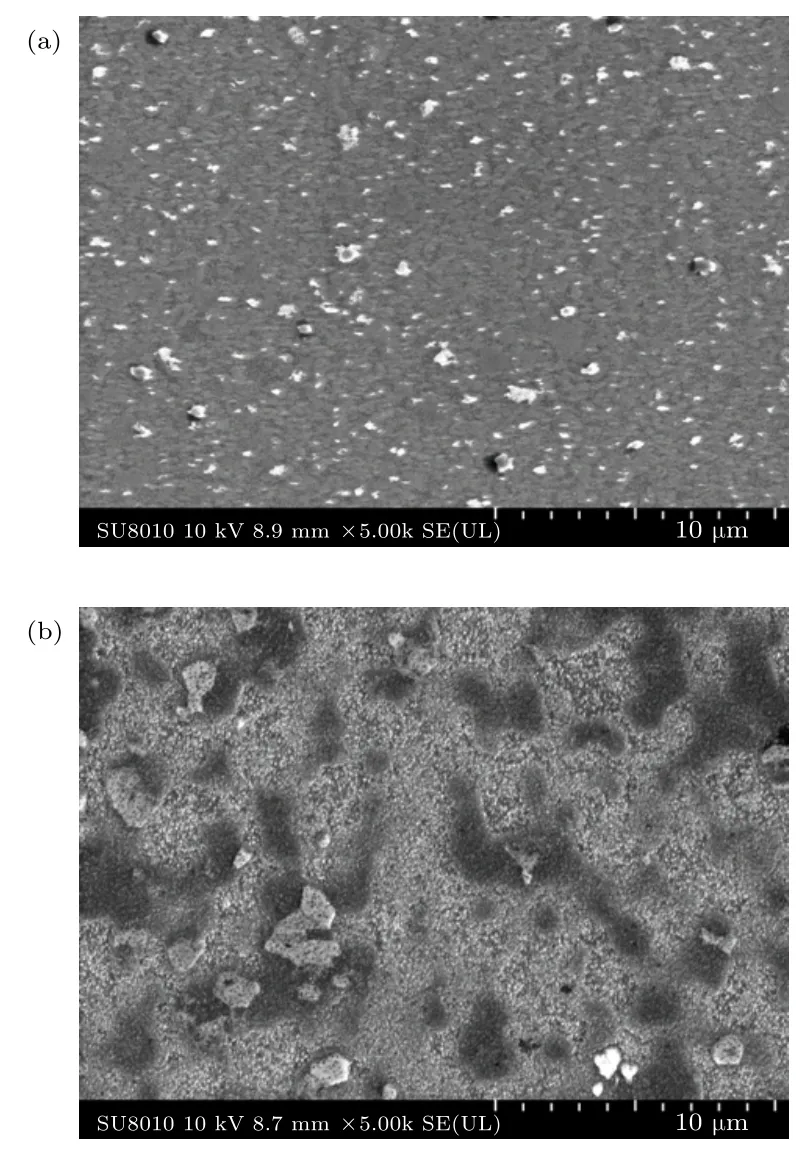
圖8 SEM測試不同退火溫度下接觸界面形貌 (a) 445 ℃退火25 s; (b) 485 ℃退火25 sFig.8.SEM micrographs showing the surface morphologies of ohmic contact (a) 445 ℃ for 25 s (b) 485 ℃ for 25 s.
圖7(b)為不同摻雜濃度樣品的比接觸電阻率隨退火時間的變化曲線.從圖中可以看出, 摻雜濃度大于 1 × 1018cm—3時, 其 ρc值隨退火時間增大無明顯變化.摻雜濃度較低時, 其接觸性能隨退火時間增大有明顯改善.結合圖7與表1數據, 低摻雜濃度樣品(≤ 1 × 1018cm—3)對退火溫度和時間都非常敏感, 而高摻雜濃度樣品并未表現出相同性質.摻雜濃度較低時, 肖特基勢壘較高, 合金過程中的互擴散可顯著提高n?(Al0.27Ga0.73)0.5In0.5P表面摻雜濃度, 降低肖特基勢壘高度; 而高摻雜濃度樣品其本身肖特基勢壘較低, 互擴散帶來的變化并不明顯.退火時間的增加與升高退火溫度類似, 都是加劇互擴散的過程, 有利于更多的Ga, In外擴散和Ge的內擴散.退火溫度較低或時間較短時,界面原子間的相變反應不完全, n?(Al0.27Ga0.73)0.5In0.5P表面的摻雜濃度較低, 勢壘高度較高, 無法形成歐姆接觸.而經過高溫退火或長時間退火后,合金層下的載流子濃度迅速升高, 達到與高摻雜濃度樣品(> 1 × 1018cm—3)低溫退火條件下相同的歐姆接觸性能.此外, 可能受材料表面態影響, n?(Al0.27Ga0.73)0.5In0.5P的摻雜濃度到達2 × 1018cm—3后接觸界面的費米能級釘扎效應(pinning effect)明顯, 合金層下方的載流子濃度趨于飽和, 歐姆接觸性能逐漸穩定.
目前, 本研究在n?(Al0.27Ga0.73)0.5In0.5P上制備的歐姆接觸比接觸電阻率ρc最低為1.4 × 10—4Ω·cm2, 將其導入AlGaInP薄膜LED芯片工藝時,27 mil規格芯片在350 mA電流下電壓比常規工藝高0.3 V左右, 尚不能應用于批量化生產工藝.后期需優化n?AlGaInP組份、厚度、摻雜、表面處理工藝和金屬組合, 使比接觸電阻率進一步降低.
4 結 論
本文成功在n?(Al0.27Ga0.73)0.5In0.5P材料上直接制備歐姆接觸, 研究了熱退火工藝對NiAuGeNiAu/n?(Al0.27Ga0.73)0.5In0.5P 歐姆接觸性能的影響并分析其形成機理.結果表明, 當n?(Al0.27Ga0.73)0.5In0.5P摻雜濃度為 3 × 1018cm—3,退火溫度為445 ℃, 退火600 s時, Ni/Au/Ge/Ni/Au與n?(Al0.27Ga0.73)0.5In0.5P比接觸電阻率達到1.4 × 10—4Ω·cm2.在退火過程中, Ga, In 外擴散在晶格中留下Ⅲ族空位, 合金層中Ge內擴散占據Ga空位和In空位成為施主提供電子.摻雜濃度較低的條件下, 升高退火溫度或增加退火時間均有利于互擴散的進行, 能明顯改善接觸性能.隨著摻雜濃度的提高, 改變退火條件對接觸性能沒有明顯影響.本文在n?(Al0.27Ga0.73)0.5In0.5P層上成功制備了歐姆接觸, 簡化了AlGaInP薄膜LED芯片制備工藝.但本文仍存在不足, 不足之處在于過高的n型AlGaInP摻雜濃度會影響晶體質量, 導致LED的發光效率降低, 因此, 為了在低摻雜濃度的n?AlGaInP材料上制備性能優異的歐姆接觸,優化電極設計與半導體材料的表面處理是后續研究的關鍵.

