自旋發光二極管研究進展*
梁世恒 陸沅 韓秀峰
1) (中國科學院物理研究所, 北京 100190)
2) (湖北大學物理與電子科學學院, 武漢 430062)
3) (法國國家科學研究中心 Jean Lamour 研究所, 南希 54011)
4) (中國科學院大學材料科學與光電技術學院, 北京 100049)
1 引 言
伴隨著自旋電子學發展歷程中一系列豐富物理效應的不斷發現、以及材料結構和器件制備工藝的優化進步, 自旋電子器件應用取得了顯著的進步. 例如, 以磁性隧道結 (magnetic tunnel junction, MTJ)為核心結構的各類磁性傳感器、磁性隨機存儲器(MRAM)已經在高科技產品應用中大放異彩. 同時, 關于半導體材料中自旋極化電子的注入和輸運機制研究及半導體自旋電子器件的應用開發, 吸引了大量研究者的廣泛關注. 自旋發光二極管 (spin light emitting diode, spin LED)[1]正是這一類重要的半導體自旋電子器件, 其將電子自旋極化信息轉換為圓偏振光信息予以表達. 雖然spin LED在光信息傳輸[2]、量子密碼通信[3]和三維顯示[4]等融合了自旋電子和半導體技術中具有較大的應用潛力, 但相比MTJ和磁性金屬多層膜等體系, 基于半導體自旋電子的spin LED中的物理材料研究和器件應用還有待進一步發展和探索.
在1999年spin LED概念已被提出[5,6], 在GaAs基半導體異質結中利用順磁半導體[5]或者磁性半導體[6]作為自旋注入端, 低溫下通過自旋極化的載流子注入到半導體中, 自旋極化載流子在半導體激活區與空穴(或電子)復合產生左旋或右旋的圓偏振光, 以偏振光信息表達自旋量子信息. Spin LED為讀取半導體和量子阱(點)中自旋相干態的信息提供了可能. 但由于自旋注入效率及工作溫度等問題, 在較長時間內困擾著spin LED的進一步發展. 為此, 半導體自旋電子學領域針對 spin LED的研究歷程也主要圍繞著自旋注入端而開展, 以達到在零磁場下和室溫條件下能夠有效進行自旋注入來實現較大圓偏振光極化率. 為此, 本文將回顧spin LED 的研究歷程, 總結 spin LED 中自旋、電學和光學性質及其之間的物理關系; 介紹spin LED研究過程中所涉及的自旋注入端材料、結構和物理; 最后進一步對未來研究趨勢進行展望.
2 自旋發光二極管
Spin LED核心結構由兩部分構成: 載流子復合發光區 (有源區, active region)和自旋注入端(spin-injector)組成, 如圖 1 所示. 通過自旋注入端將自旋極化的電子(或空穴)注入到半導體LED有源區, 根據光學選擇定則與空穴(電子)復合產生左旋或者右旋的圓偏振光, 所發射的圓偏振光的極化率與注入的電子(空穴)的自旋極化率相關.
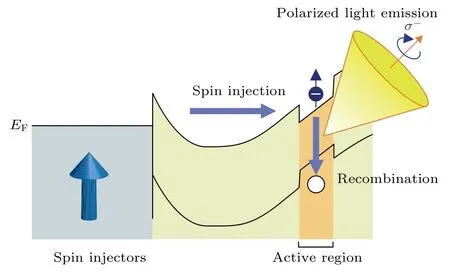
圖 1 Spin LED 能帶結構示意圖[7]Fig. 1. Schematic of band diagram of spin LED[7].
Spin LED中圓偏振光可以通過電學注入以電致發光方式進行檢測, 其測量系統如圖2所示, 自旋極化電子注入所產生的圓偏振光通過聚焦準直后經過1/4玻片, 經線偏振片后進入單色儀, 然后在CCD上進行成像. 通過測量產生的左旋及右旋圓偏振發光強度(I(σ+) 及I(σ?)) , 即可得到電致發光圓偏振光極化率Pc[8]:

LED中的載流子復合壽命和自旋弛豫時間則可通過偏振的時間分辨光致發光光譜進行檢測. 在時間分辨光致發光光譜測量中, 通過將左旋(右旋)圓偏振激光照射到樣品上, 根據光學選擇定則可將電子和空穴分別激發到導帶和價帶, 形成激發態的自旋極化電子. 切斷激發光源后, 激發態的極化電子會與空穴復合產生圓偏振光, 其測量系統如圖3所示, 與電致發光測量系統不同在于, 其利用一超快激光通過偏振片后進行極化電子的激發. 利用該光致發光方法, 可以測量半導體中載流子壽命τ、自旋弛豫時間τs, 關系式如下[8]:

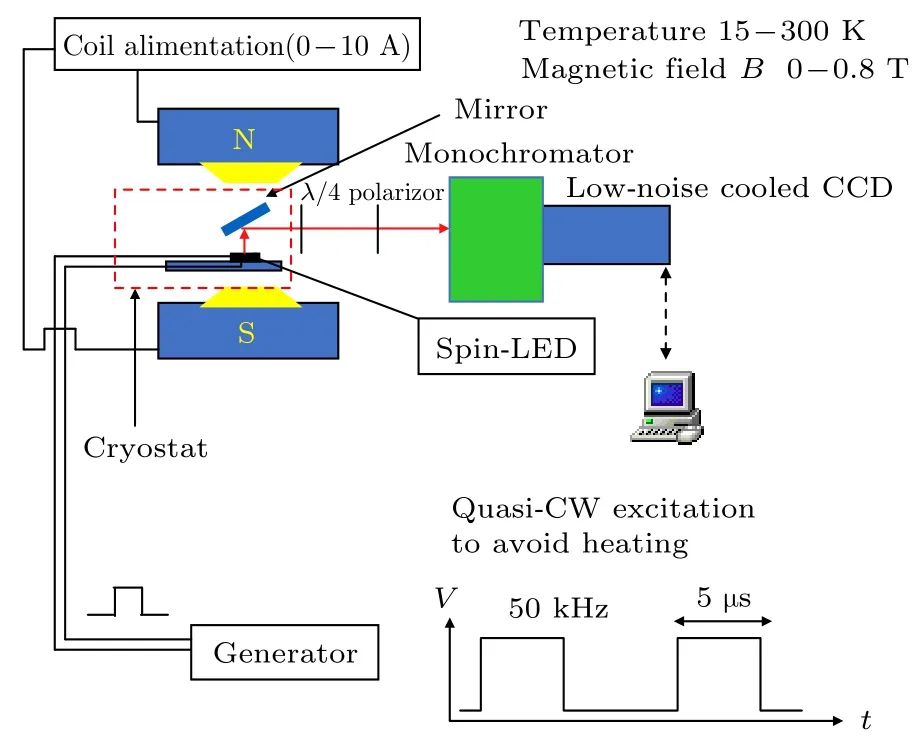
圖 2 自旋發光二極管的電致發光中偏振光測量系統原理示意圖Fig. 2. Schematic diagram of electroluminescence measurement system for spin LED.
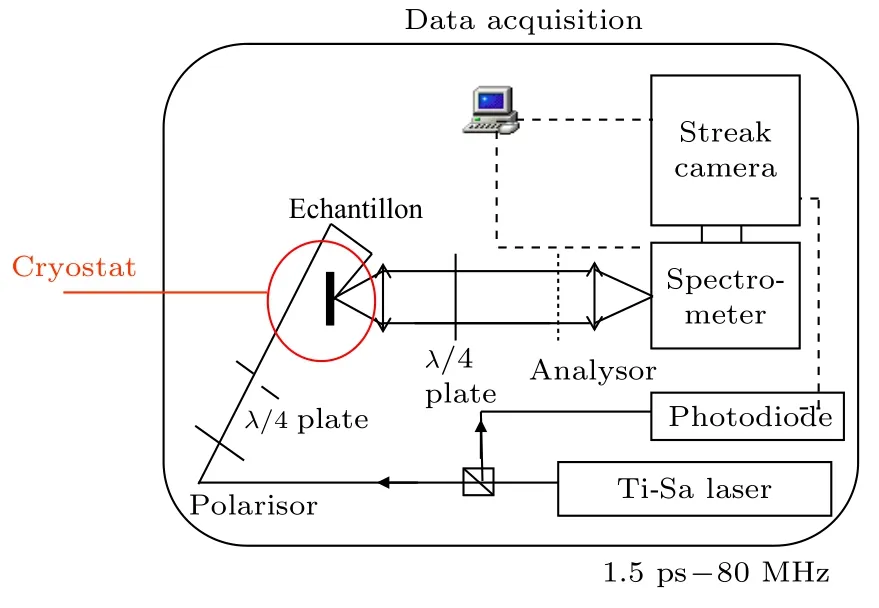
圖 3 Spin LED 中時間分辨光致發光系統原理示意圖Fig. 3. Schematic diagram of time-resolved photoluminescence system.
3 自旋發光二極管中自旋相關物理
Spin LED自旋相關物理主要涉及自旋注入、自旋輸運和自旋探測, 理解這3個方面的物理機制和過程對于Spin LED的結構優化和器件設計至關重要.
3.1 自旋注入
自旋注入是指將自旋極化電流注入到非磁性金屬或者半導體中. 首先要考慮怎樣產生自旋極化電流, 目前主要有電學注入、光學注入及自旋霍爾效應等方法. 對于spin LED中的電致發光研究用到的是電學注入. 利用鐵磁材料層作為自旋注入端, 電子在鐵磁層內會進行自旋極化, 利用電學方法將自旋極化的電子從鐵磁層注入到半導體中. 其次, 自旋注入中主要考慮的問題是自旋注入的效率, 自旋注入效率定義為注入的電子極化率與鐵磁體自旋極化率的比值. 自旋注入層/半導體的界面質量、缺陷雜質和能帶結構等因素都會對自旋進行散射從而影響到自旋的注入效率. 另外, 鐵磁體與半導體的電導不匹配也會影響到自旋的注入效率.
最早研究的自旋發光二極管是基于“磁性半導體/半導體”結構, 如以 GaMnAs和 ZnMnSe等磁性半導體作為自旋注入端[5,6], 該結構的優點是能夠避免電導不匹配的問題, 但是由于磁性半導體的居里溫度較低, 其在室溫下不能進行有效的自旋注入. 后來人們用到居里溫度較高的鐵磁體作為自旋注入端, 如“鐵磁體/半導體”結構, 但由于存在嚴重的電導不匹配而不能實現較高的自旋注入效率.為此Rashba提出[9]用隧穿勢壘層的方法, 即在鐵磁體及半導體間插入勢壘層構成“鐵磁體/勢壘層/半導體”結構, 從而解決了電導不匹配的問題, 因此在后續研究中自旋的注入效率得以顯著提高.
3.2 自旋輸運
自旋輸運過程主要涉及電子在輸運過程自旋弛豫等物理問題. 在 spin LED中, 影響自旋輸運過程的自旋弛豫機制主要有三種: Elliott-Yafet(EY)機制、Dyakonov-Perel (DP)機制和 Bir-Aronov-Pikus (BAP)機制.
1954年Elliott[10]研究表明, 材料中自旋軌道耦合可以將電子的波函數分為空間和時間反演對稱的兩個簡并態: 一個為自旋向上態, 另一個為自旋向下態. 這種混合態會導致電子在動量散射過程中發生自旋翻轉, 如電子-雜質散射和電子-聲子散射等, 如圖4(a)所示. EY機制中對于III-V半導體G點附近的自旋弛豫可以表述為[1]

其中,A為散射常數,?為材料中自旋軌道耦合的分裂能,Eg為帶隙,tp(E)是能量E上的電子動量散射時間. 在EY自旋弛豫機制中, 自旋弛豫率與電子的動能平方成正比, 與能隙平方成反比. 電子在G點時, 當其波矢K越大、價帶和導帶間的耦合越強時, 自旋翻轉的幾率越大. 所以對于能隙較大的半導體(如GaN, GaAs), EY機制則不是自旋弛豫的主導機制.
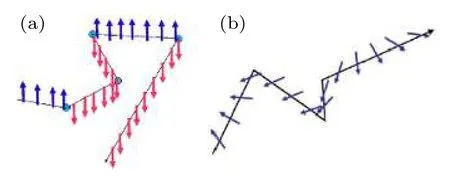
圖 4 (a) EY 和 (b) DP 自旋弛豫機制示意圖[11]Fig. 4. Spin relaxation by scattering in (a) EY and (b) DP mechanisms[11].
DP機制主要來源于半導體材料晶格結構的非對稱中心反演特性, 它在III-V族半導體(如GaAs)及II-VI族半導體中的自旋弛豫過程起主導作用[1].在非對稱中心反演半導體材料中的電子會受到一個有效磁場的作用, 從而繞著該有效場進行Larmor 進動. 該有效場的強度和方向依賴于電子的波矢K, 具有較強的各向異性. 當電子發生動量散射時, 電子的進動頻率及有效磁場也會發生改變, 從而導致電子自旋相位退相干, 如圖4(b)所示.DP機制的自旋弛豫率可以表述為[1]

其中,Q是散射因子,α是依賴于自旋軌道相互作用強度的系數.
Soldat等[12]研究了室溫下電子在spin LED中的自旋弛豫長度, 通過FeTb/MgO自旋注入端將自旋極化電子注入到GaAs有源區, 他們發現圓偏振光極化率隨自旋注入層到有源發光區之間長度的增加而呈指數衰減. 為此可以通過擬合得到自旋弛豫長度(如圖5所示). 通過該實驗得到的室溫下GaAs中電子自旋弛豫長度為26 nm, 這與Saikin等[13]基于DP自旋弛豫機制計算得到的GaAs中25—50 nm的自旋弛豫長度理論值一致.

圖 5 圓偏振光極化率隨自旋注入層到有源發光區之間長度關系[12]Fig. 5. Calculated circular polarization for fully perpendicular magnetization in remanence over injection path length[12].
此外, 比較 (4)式和 (5)式, 可以發現 DP機制中自旋弛豫率正比于電子動量散射時間τp(E) , 而 EY 機制中反比于τp(E) . 因此, EY機制中電子散射次數越多, 自旋弛豫率就越大; 而DP機制中, 電子散射不會導致自旋弛豫率的增大, 但散射會導致隨波矢K相關的進動頻率更加隨機化, 而發生在碰撞間隙的自旋退相位相干性會隨著頻繁的碰撞而減弱.
BAP機制來源于電子空穴的相互作用, 該機制在p型半導體中對于電子自旋的弛豫占主導作用. 當電子與空穴即將進行復合時, 電子和空穴間的散射會形成自旋交換作用, 因此當電子把自旋轉移給空穴時, 會引起電子的自旋弛豫.
3.3 自旋探測
關于自旋探測有一系列方法, 包括磁電阻方法、自旋霍爾效應和Hanle效應的電探測方法、光致發光及電致發光的光探測等方法. Spin LED正是利用了光探測以表達自旋信息. 根據光學選擇定則, 當電子與空穴復合后所產生圓偏振光的極化率與電子(空穴)的自旋極化率直接相關, 如圖6所示. 如對于GaAs半導體體材料, 由于重空穴是三重簡并態, 輕空穴是單態, 所以電子與重空穴的復合幾率是其與輕空穴復合幾率的3倍, 電子空穴復合發光的圓偏振極化率為[1]

其中,I(σ+) 和I(σ?) 分別是圓偏振光σ+與σ?的強度;n↑以及及n↓為注入電子的自旋向上及自旋向下的態密度;為注入電子的自旋極化率.
對于量子阱結構如In1–xGaxAs/GaAs 量子阱,由于結構限制及應變等約束作用, 其輕空穴能級下移與重空穴能級解除簡并, 所以電子與輕空穴的復合被大大抑制. 此時, 電子空穴復合發光的圓偏振極化率為[1]


圖 6 在閃鋅礦GaAs直接帶隙能帶中的光選擇定則 (a)體材料及(b)量子阱中的電子空穴復合選擇定則. 上邊藍色球代表電子, 下邊的紅色球代表空穴, 箭頭代表自旋方向.其中CB代表導帶, HH代表重空穴帶, LH代表輕空穴帶,HH 是三重簡并態, LH 是單態. σ ? 和 σ + 分別代表左旋光與右旋光. 在量子阱結構中由于晶格應變和結構限制, 電子與LH態空穴的復合幾率被大大抑制[1]Fig. 6. Electric dipole allowed radiative inter-band transitions and corresponding optical polarization for the cases of(a) bulk material with degenerate heavy- and light-hole bands and (b) a quantum well in which epitaxial strain and quantum confinement have lifted the heavy- and light-hole band degeneracy[1].
因此在基于 In1–xGaxAs/GaAs量子阱結構的Spin LED中, 理論上如果注入100%自旋極化電子, 將可以得到100%的圓偏光極化率.
上述(6)式和(7)式中考慮到的是理想情況,實際電致發光的極化率Pc并不直接等于注入電子的極化率PE,PE與Pc之間的關系為[8]

其中,F因子反映了半導體對注入到其中的電子自旋的影響, 它可由半導體中載流子壽命τ和電子自旋弛豫時間τs表示為[8]

這里以基于GaAs量子阱的自旋發光二極管[8]為例來進一步介紹自旋探測中圓偏振光極化率Pc與電學注入自旋極化率PE的關系. 圖7(a)顯示了以CoFeB/MgO為自旋注入端制備的兩個spin LED器件Pc隨溫度的變化關系. 它們有一共同的顯著特征: 在 10 K 到 60 K 溫度區間, 隨著溫度升高PC先下降, 在60 KPC達到最小值; 在60 K 到110 K溫度區間, 隨著溫度升高PC增加. 通過時間分辨光致發光(TRPL)測量可以得到ts和t, 如圖7(b)中插圖所示. 根據(9)式可以得到F因子. 進一步通過比較溫度依賴的F因子和溫度依賴的PC特性,發現在 GaAs量子阱 spin LED 中,PE在10—100 K區間并不隨溫度發生變化. 因此通過自旋探測PC隨溫度依賴特性, 可以研究半導體有源區對自旋弛豫的影響.

圖 7 GaAs 量子阱自旋發光 二極管中 (a)溫度依賴的PC特性和(b)溫度依賴的ts, t及F因子特性[8]Fig. 7. (a) Temperature dependence of PC, (b) temperature dependence of ts, t, and the F factor in GaAs quantum well spin LED[8].
4 自旋注入端研究概況
4.1 面內磁各向異性自旋注入端
Spin LED中自旋注入端有磁性半導體、鐵磁性材料及磁性半金屬等類型. 在較早的spin LED研究中, 主要使用的是磁性半導體 (如GaMnAs, ZnMnSe, CdCr2Se4等)[5,6,14], 磁性半導體能夠避免自旋注入層與發光區層的電導失配問題, 但由于磁性半導體的居里溫度較低, 室溫下則不能進行有效的自旋注入. 為此, 居里溫度較高的鐵磁金屬被研究用于自旋注入端, 但是由于金屬與半導體之間的電導失配, 自旋注入效率也較低. 在此之后, 人們發現在鐵磁金屬和半導體間插入勢壘層構成“鐵磁體/勢壘層/半導體”結構, 可以解決電導不匹配的問題, 從而大大提高自旋注入效率. 目前在CoFe/MgO/GaAs半導體量子阱結構中, 在室溫下已經觀測到了32%的圓偏振光極化率[15].這里, 我們將重點介紹以鐵磁金屬材料為自旋注入端的spin LED研究進展.
2001年, Zhu等[16]在以Fe為自旋注入端、In-GaAs量子阱為發光區的結構中, 在室溫300 K下觀測到2%的電致發光極化率. 2005年, Jiang等[15]在基于CoFe/MgO為自旋注入端, 通過利用MgO勢壘及CoFe的高自旋極化率實現較高自旋極化率的電子注入, 他們在以GaAs量子阱為發光區的結構中低溫下觀測到高達52%的電致發光極化率.2008年Ikeda等[17]于室溫在CoFeB/MgO/CoFeB磁性隧道結中觀測到高達600%的TMR, 這說明CoFeB/MgO可以提供具有更高的隧穿電子自旋極化率, 同年Lu等[8]在基于面內磁各向異性CoFeB/MgO自旋注入端、以GaAs 量子阱為發光區的結構中, 低溫下觀測到了32%的電致發光極化率. 此后, Barate等[18]通過對比磁控濺射和分子束外延制備的不同界面質量自旋注入端, 證明了CoFeB/MgO界面對于自旋電子注入起到關鍵的影響作用. 表1給出了基于面內磁各向異性自旋注入端的spin LED研究的主要歷程中自旋注入端材料結構及對應的圓偏振光極化率結果.
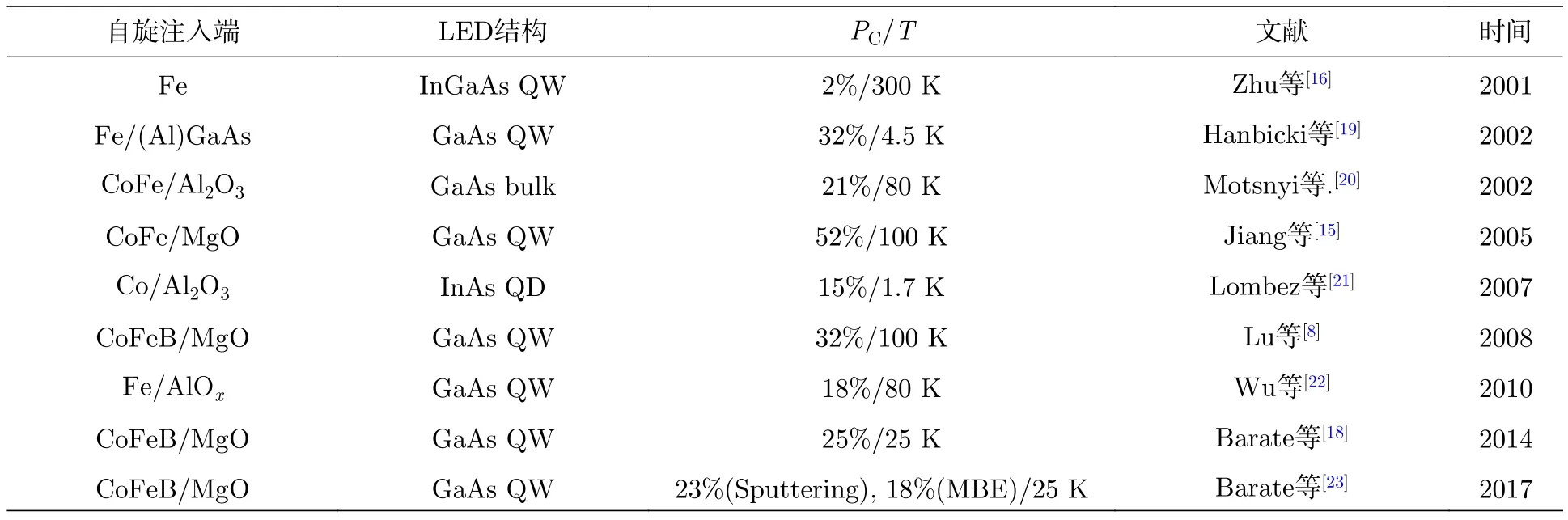
表 1 基于面內磁各向異性自旋注入端的自旋發光二極管Table 1. Spin LED based on spin injector with in-plane magnetic anisotropic.
4.2 垂直磁各向異性自旋注入端
如果自旋注入端磁矩位于面內方向, 根據光選擇定則, 需要在沿薄膜法線方向施加磁場使自旋注入端的磁矩位于垂直膜面方向, 才可以在法向方向測量所產生光的圓偏振極化率, 如圖8所示.
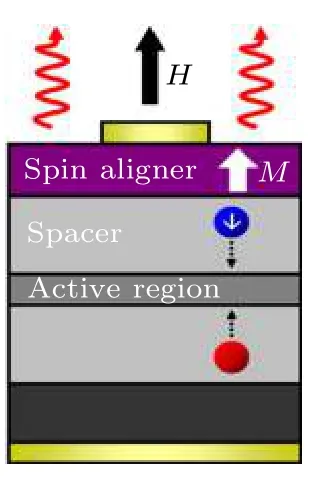
圖 8 自旋發光二極管的Faraday測試方法示意圖[1]Fig. 8. Schematic representation of a spin LED under the Faraday geometries[1].
由于需要外加磁場設備提供垂直膜面方向的磁場, 這在實際應用中十分不便. 為此更加突顯具有垂直磁各向異性的自旋注入端的優勢, 即在不施加垂直磁場的情況下, 自旋注入端的磁矩就垂直于薄膜膜面. 2005 年, Gerhardt等[24]利用具有垂直磁各向異性的FeTb作為自旋注入端, 他們在零磁場90 K下得到了0.7%的圓偏振光極化率, 如圖9所示. 此后Adelmann 等[25]、H?vel等[26]、Grenet等[27]及Zarpellon等[28]等分別利用具有垂直磁各向異性的 MnGa, FeTb, CoPt等作為自旋注入端, 成功制備了具有垂直磁各向異性自旋特性的spin LED(圓偏振光極化率見表2).
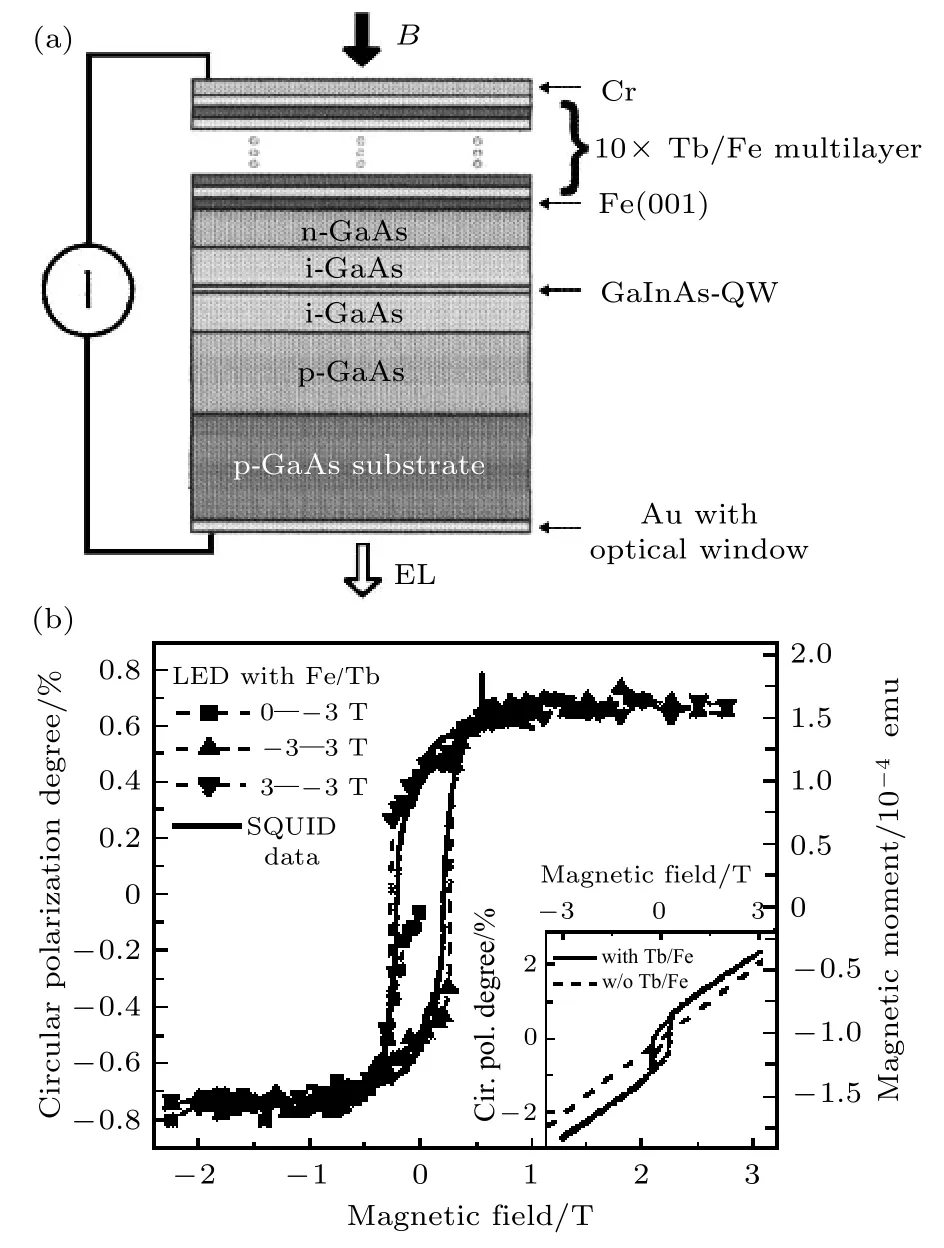
圖 9 Gerhardt等[24]利用具有垂直磁各向異性的 FeTb 作為自旋注入端的自旋發光二極管 (a)結構示意圖; (b)電致發光與磁場的關系, 他們在未加磁場剩余磁態下, 在90 K下得到了0.7%的圓偏振光極化率Fig. 9. Schematic Spin LED device structure of the LED with Tb/Fe multilayer (a) reported by Gerhardt et al.[24],Circular polarization as a function of the applied magnetic field at 90 K (b), they observed PC of 0.7%.
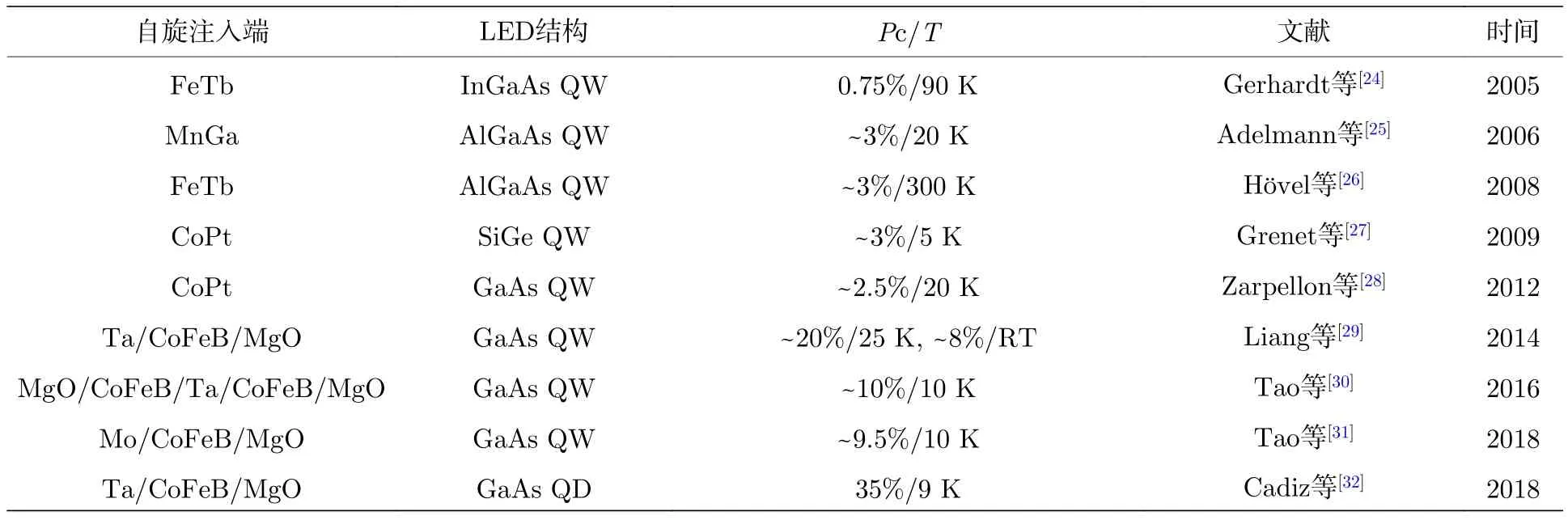
表 2 基于垂直磁各向異性的自旋注入端的自旋發光二極管Table 2. Spin LED based on spin injector with out-plane magnetic anisotropic.
雖然上述報道實現了基于垂直磁各向異性自旋注入端的自旋極化電子注入, 但是自旋注入效率較低(圓偏振率小于3%). 研究人員思考和設計更加優化的垂直磁各向異性自旋注入端: 自旋極化率越高越好、厚度越薄越好. 自旋極化率高可以使得注入到二極管半導體中的電子自旋極化率較高; 薄膜自身厚度越薄其對發出光的吸收就越少, 這樣spin LED發出光的強度就越強, 同時由于鐵磁金屬引起的磁圓二色性也會越小. 2014年, Liang等[29]報道了采用界面誘導的垂直磁各向異性Ta/CoFeB/MgO自旋注入端的自旋發光二極管(如圖10所示). 相比于先前的結果, 由于CoFeB具有較高的自旋極化率, 并且所用到的CoFeB厚度也較薄(約 1.2 nm), 在零磁場下測量到低溫 (10 K)13%和室溫下8%的圓偏振光極化率. 他們同時研究了溫度依賴PC特性, 發現在溫度小于 100 K 時,PC隨著溫度的增加而顯著降低, 而當溫度大于100 K 后,PC基本趨于穩定. 通過利用時間分辨的光致發光測量得到的GaAs半導體量子阱中載流子壽命τS以及及電子自旋弛豫時間τ, 如圖10 (c)所示, 發現F因子與電致發光極化率PC隨溫度變化的趨勢較為一致. 由PE=PC/F計算的零磁場下注入電子的自旋極化率PE與溫度T的關系, 從圖10 (b)可以看到, 注入電子的PE隨著溫度變化基本保持穩定, 其自旋極化率約為 1 6% . 這說明PC隨溫度的變化主要是來自于GaAs半導體量子阱性質隨溫度的變化, 而自旋注入端在低溫25 K到室溫范圍內注入到GaAs半導體量子阱的電子自旋極化率基本不變.
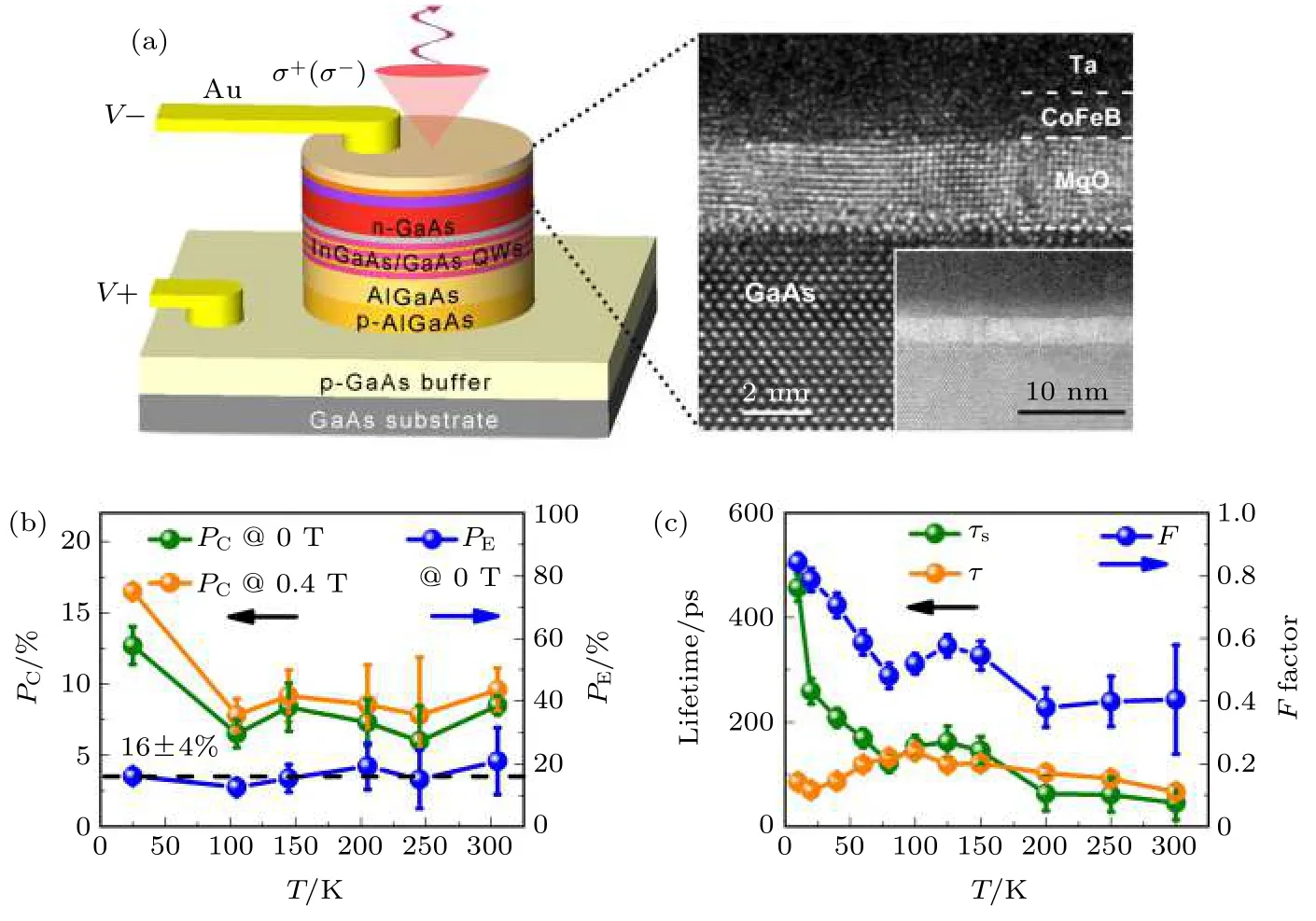
圖 10 (a) 基于垂直磁各向異性Ta/CoFeB/MgO為自旋注入端的自旋發光二極管結構示意圖, 虛線選定區對應的TEM照片,其中插圖為縮小后的TEM照片; (b)溫度依賴的圓偏振極化率及注入電子極化率; (c)溫度依賴的F因子及載流子壽命 τ 、電子自旋弛豫時間τsFig. 10. (a) Schematic device structure of Spin LED and HR-TEM image of CoFeB/MgO PMA injector; (b) temperature dependence of PC without magnetic field and with 0.4 T field. Temperature dependence of PE is calculated by PE = PC/F from the data without field; (c) temperature dependence of tS, t, and F factor deduced from the TRPL measurements.
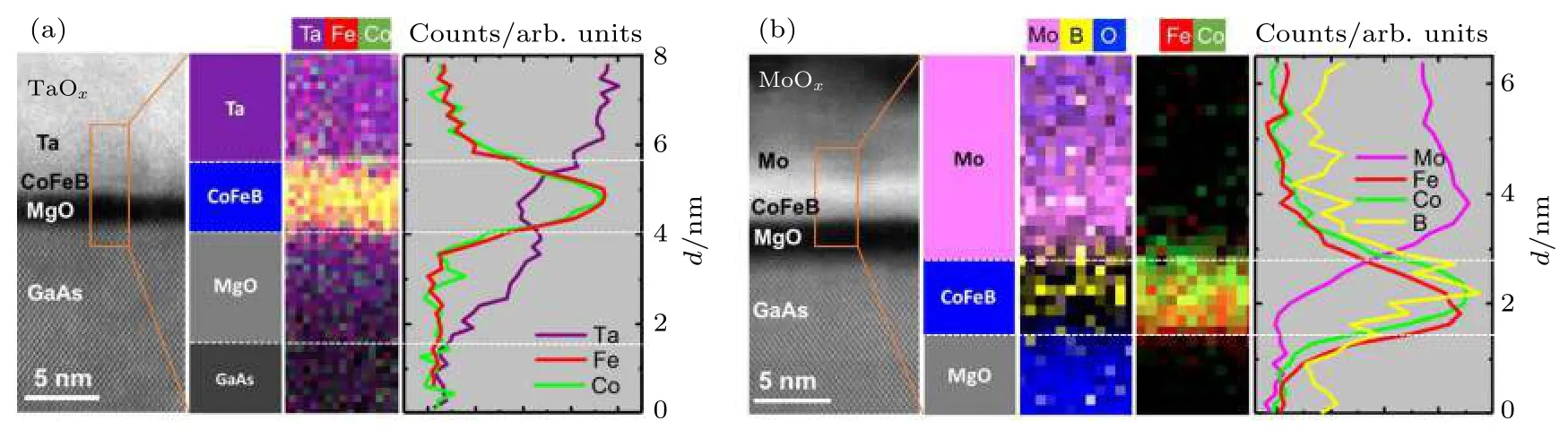
圖 11 退 火 400 °C 后 , 具 有 垂 直 磁 各 向 異 性 的 Ta/CoFeB/MgO (a)和 Mo/CoFeB/MgO (b)自 旋 注 入 端 中 由 HR-STEMEELS測量的空間元素分布[31]Fig. 11. Chemical characterization of spin-injectors annealed at 400 °C. Dark field HR-STEM images and corresponding EELS mappings and profiles for (a) Ta and (b) Mo injectors annealed at 400 °C[31].

圖 12 (a), (b)基于垂直各向異性的Ta/CoFeB/MgO作為自旋注入端InGaAs/GaAs量子點spin LED 的TEM及其結構示意圖;(c) InGaAs/GaAs量子點AFM圖; (d)零磁場下9 K觀測到了約35%電致發光圓偏振光極化率[32]Fig. 12. Spin LED device with p-doped InAs/GaAs quantum dots and polarization resolved electroluminescence of an ensemble of quantum dots: (a) High resolution-transmission electron microscope image of the injector Ta/CoFeB/MgO/GaAs; (b) schematic structure of the spin LED device. A single layer of InAs QDs is embedded in the intrinsic region of the p-i-n junction of the LED;(c) AFM image of InAs QDs; (d) strongly polarized single dot emission at zero applied field[32].
2018年, Tao等[31]利用具有垂直各向異性的Mo/CoFeB/MgO作為自旋注入端, 通過利用高分辨掃描透射電鏡(HR-STEM)及電子能量損失譜(EELS), 從原子尺度分析了利用Ta和Mo作為覆蓋層的垂直磁各向異性自旋注入層的結構和化學性質. 相比較Ta/CoFeB/MgO 自旋注入端, Mo/CoFeB/MgO中CoFeB層元素與Mo元素不會相互擴散(如圖11所示), 因此其磁學性能具有耐高溫退火穩定性(400 °C以內), 并且注入的電子可以保持較高的自旋極化狀態. 2018 年, Cadiz 等[32]利用具有垂直磁各向異性的Ta/CoFeB/MgO作為自旋注入端, 同時優化了spin LED有源區的結構設計,采用p型InGaAs量子點, 在零磁場下觀測到單量子點~35%圓偏振光極化率(如圖12所示), 這是迄今為止采用垂直各向異性自旋二極管觀測到的最好的結果. 表2給出了基于垂直磁各向異性自旋注入端的spin LED研究歷程中主要的自旋注入端材料、結構及對應的圓偏振光極化率結果.
5 總結及展望
自旋電子注入效率的提高使得spin LED的圓偏振光極化率得到了提升, 這對于spin LED的器件未來應用至關重要. Spin LED的未來研究仍將包括物理、材料和器件結構等幾個方面. 實現室溫零磁場下自旋注入仍將是spin LED重點研究內容之一. 在基于垂直磁各向異性的自旋注入端研究中, 未來探索在保證較高自旋注入效率和圓偏振光極化率的基礎上, 若在spin LED自旋注入端中能夠利用自旋軌道轉矩驅動垂直磁各向異性磁化強度(磁矩)的翻轉, 則有望進一步提升spin LED的工作性能. 另外采用新材料(如:具有豐富半導體性質的低維材料及其異質結構)應用到spin LED有源區, 則可以調制發光頻率區間以進一步拓展spin LED的應用范圍.
伴隨著自旋電子學發展的同時, spin LED的研究范圍也不斷地在拓展, 尤其是第三代半導體材料和低維半導體材料可以在其中發揮重要作用. 其中GaN不但具有較大的能隙(室溫下約3.4 eV), 而且具有較弱的自旋軌道耦合 (Dso≈ 15 meV)[33],因此GaN中的自旋弛豫時間(5 K溫度下約20 ns;室溫下約幾百ns)[34]比GaAs中的自旋弛豫時間大3個數量級(10 K溫度下約500 ps)[8,35]. 較長的自旋相干時間也為GaN在半導體自旋電子器件中的應用提供了優勢. 最近基于GaN基的可見光spin LED和自旋激光器(spin lasers)已被研究報道[36?42].在該類spin LED和自旋激光器中, 室溫下已分別實現 6%[40]及 25%[41]圓偏振光極化率. 此外, 二維材料由于新奇的物理性質也受到了廣泛關注, 2016年Ye等[43]利用電學注入方式實現了從具有垂直磁各向異性的GaMnAs中將自旋極化的空穴注入到WS2中, 實現了基于二維材料的 spin LED, 如圖 13所示. 同年Sanchez等[44]實現了基于MoS2/WeS2異質結構為有源區的spin LED.
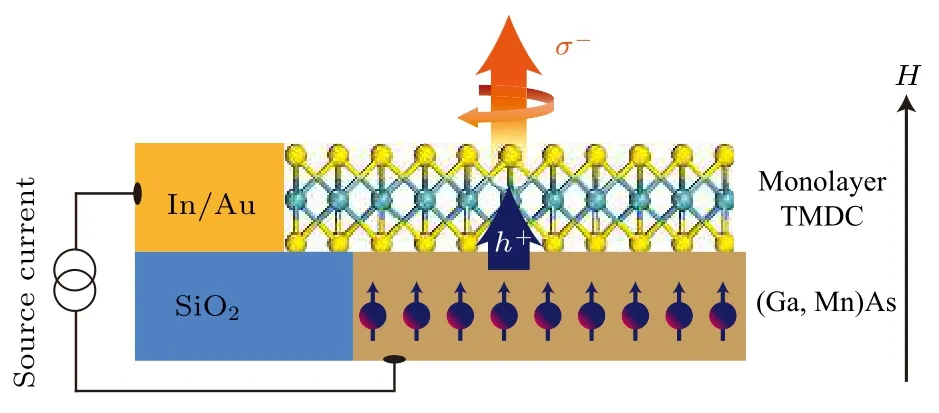
圖 13 基于 (Ga, Mn)As自旋注入端、MoS2/WeS2 有源區的自旋發光二極管結構示意圖[43]Fig. 13. Schematic of the monolayer TMDC/(Ga, Mn)As heterojunction for electrical valley polarization devices. (Ga,Mn)As was used as a spin aligner under an external magnetic field[43].
綜上所述, 未來通過對spin LED器件自旋注入端及其有源區的進一步深入系統研究和優化, 自旋發光二級管的器件功能特性將在自旋?光信息傳輸與顯示方面展現出巨大的應用價值和發展前景.

