高擊穿電壓復合介質結構垂直GaN 基PN 二極管優化設計
趙智源,杜江鋒,劉 勇,于 奇
(電子科技大學電子薄膜與集成器件國家重點實驗室,四川成都 610054)
隨著硅基功率二極管的研究逐漸成熟,其性能幾乎接近硅的理論極限。第三代寬禁帶半導體氮化鎵(GaN)材料和器件具有高擊穿電場、低導通電阻和高開關速度等明顯優勢,在未來大功率器件和高頻功率電子系統中具有巨大的發展潛力。特別是隨著高質量自支撐襯底GaN 外延材料技術的快速發展,GaN 垂直結構耐壓功率器件的研究獲得了廣泛關注[1-6]。然而在垂直GaN 基PN 二極管高耐壓器件工作時,PN 結邊緣處不可避免地會產生電場擁擠現象,明顯限制了器件擊穿電壓的提升。目前主流的解決方案是采用浮空場限環(FLR)、結終端擴展(JTE)等技術來緩解PN 結邊緣的電場擁擠現象[7-13],但工藝版圖復雜、Mg 摻雜激活率低從而導致p-GaN 實現困難,限制了上述技術的應用。基于以上背景,本文提出了一種新型復合介質結構的垂直GaN 基高耐壓梯形二極管,該新結構器件的特點是通過在PN 結的外側引入復合介質層,從而在二極管的漂移區內部產生一個新的電場峰值來調制器件的電場分布。相比其他結終端的結構,該結構優勢在于可以在提升器件耐壓的同時,不影響器件的正向導通特性。
1 器件結構與仿真
具有雙層復合介質結構的垂直GaN 基梯形二極管的橫向截面圖如圖1 所示。該復合介質結構由一層高介電常數的材料(Si3N4)和一層低介電常數的材料(SiO2)組成并縱向排列于有源區的兩側。二極管中p型摻雜區厚度為0.5 μm,摻雜濃度為3 ×1017cm-3。n型摻雜區的厚度為15.5 μm,摻雜濃度定義為Nnc。圖1 中的關鍵參數含義闡述如下:T為PN 結界面與復合介質層界面之間的高度差,L為復合介質層的長度,n型摻雜區的橫截面形狀為梯形,其上底和下底的長度分別定義為Lpn(up)和Lpn(down),大小分別為7 μm 和10 μm,Tpn是外延層的總厚度,梯形的底角定義為θ。在工藝上考慮采用光電化學(PEC)刻蝕的辦法實現深槽刻蝕[23],PEC 刻蝕利用帶隙紫外線照射GaN 材料產生載流子,同時外加電壓驅動光生空穴至GaN 表面,從而氧化GaN 并將其溶解在酸性或堿性溶液中實現刻蝕。該方法具有刻蝕損傷小,界面質量好,可以實現高深寬比的深槽刻蝕等優點。完成PEC 刻蝕后,再通過PECVD 在深槽中填充介質實現復合介質結構[24],具備一定的可行性。
根據高斯定律,在介質常數K 不同的介質界面處,電場強度滿足Maxwell 方程:

式中:εSi3N4和εSiO2分別為Si3N4和SiO2的相對介電常數,ESi3N4和ESiO2分別為Si3N4和SiO2介質內部在界面處的電場強度大小。由式(1)可知,由于介電常數在界面處的突變,電場強度在介質界面處不連續且比值與介質的介電常數大小比值成反比。在介質-半導體界面附近,半導體內部電場強度與介質層內部電場強度同樣滿足式(1),因此在低介電常數介質附近的半導體內部電場強度較高,而在高介電常數介質附近的半導體內部電場強度較低。又因在半導體的內部電場分布是連續的,因此在復合介質層的界面附近,半導體的內部電場存在由低到高的陡升現象,表現為一個新的電場峰值出現在漂移區的內部靠近Si3N4和SiO2介質界面的附近,從而達到調節PN 二極管漂移區內部電場分布使其更加均勻的目的。
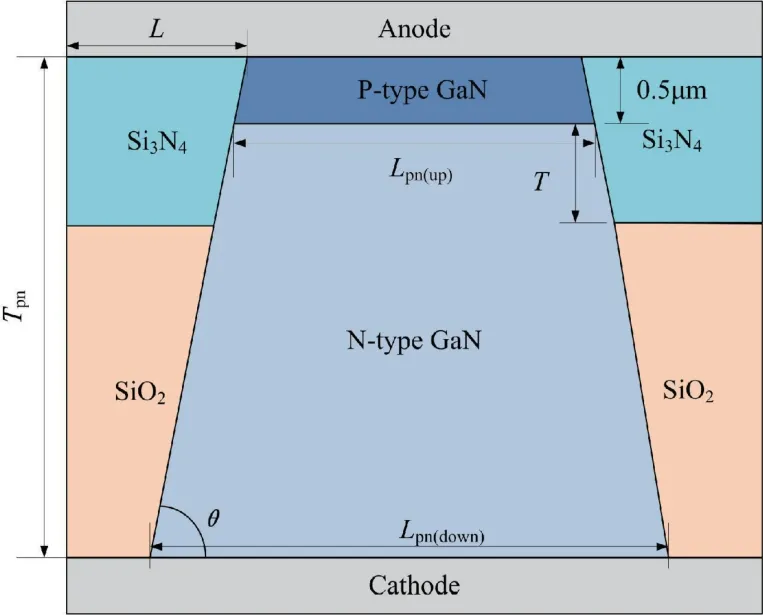
圖1 復合介質GaN 基梯形二極管橫截圖Fig.1 Schematic cross-section of trapezoidal GaN PN diode with a compound dielectric
圖2 為利用Silvaco TCAD 仿真工具仿真得到的器件內部電場分布圖,圖2(a)、(b)、(c)分別為普通GaN 基PN 二極管、GaN 基梯形二極管以及復合介質結構GaN 基梯形二極管在發生雪崩擊穿的瞬間器件內部的電場分布。可以發現相比于圖2(a)、(b)中沒有復合介質層的二極管結構,圖2(c)中具有高/低K 介質層的二極管的漂移區內部存在一個新的電場峰值,與之前理論分析的結果符合,說明了該復合介質層調節電場分布的有效性。
上述三種結構在PN 結邊緣處沿垂直方向的電場分布曲線如圖3 所示。相比于普通結構的垂直二極管和梯形二極管,該復合介質結構梯形二極管在Si3N4和SiO2介質界面處存在一個新的電場峰值。漂移區內部的電場分布曲線從整體上被拉高且器件的漂移區內部電場分布相比沒有復合介質層結構的二極管更加均勻。

圖2 (a) GaN 基的垂直二極管;(b) 梯形二極管;(c) 復合介質梯形二極管在擊穿時的內部電場分布圖像Fig.2 Electric field distribution of (a) GaN vertical diode,(b) trapezoidal diode and (c) trapezoidal diode with a compound dielectric
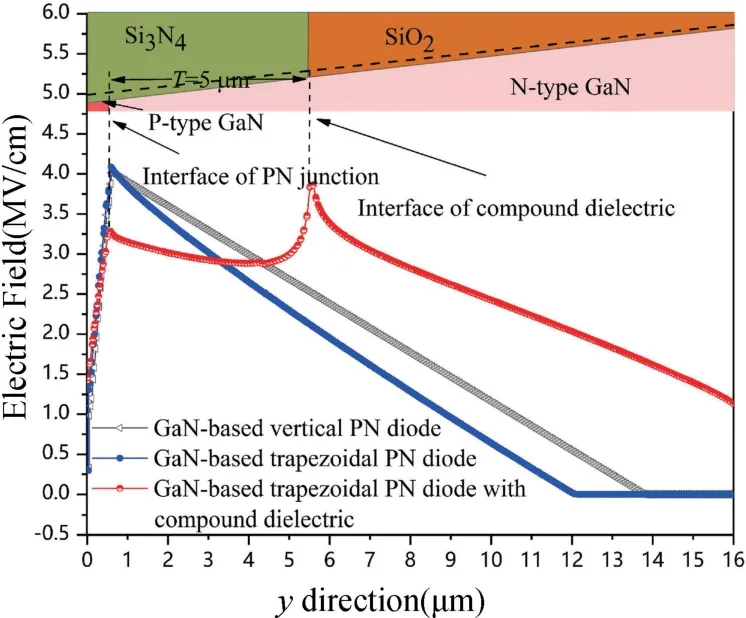
圖3 三種不同結構二極管的內部電場分布曲線Fig.3 Electric field profiles of three different structures of diodes
2 優化與結果分析
為了探究該復合介質結構GaN 基梯形二極管的極限耐壓性能,關鍵結構參數如PN 結界面與復合介質層界面之間的高度差T、復合介質層的長度L、n 型摻雜區的濃度Nnc以及梯形的底角θ等通過仿真得到了優化,并根據優化結果給出了器件的耐壓最優值。為了進一步提升該復合介質層結構提升耐壓的作用,具備三層介質的復合介質結構的垂直GaN 基梯形二極管結構被提出并給出了部分參數的優化結果。
圖4 為基于擊穿電壓對結構參數中的L和T進行仿真優化的結果。在L為10 μm 時,擊穿電壓BV 隨著T的增加而增加,在T=5 μm 時BV 達到最大值,之后再隨著T的增加而減少。因此取5 μm 為T的優值。從插圖中可以看出,在T為5 μm 時,擊穿電壓BV 隨著L的增加而增加,且在L增加到10 μm 后達到了飽和區。因此取L=10 μm 為優值。最終該復合結構在T=5 μm,L=10 μm 時二極管的耐壓達到最大值。
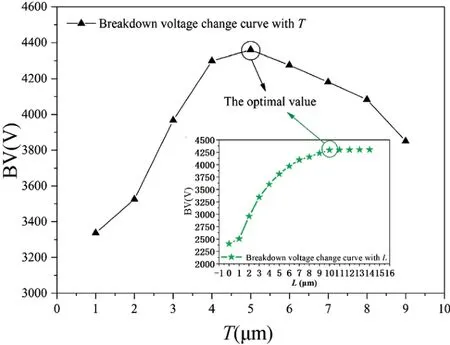
圖4 擊穿電壓(BV)隨著L 和T 的變化曲線Fig.4 Breakdown voltage change curves with L and T
圖5 為保持L和T不變對底角θ和漂移區摻雜濃度Nnc的優化結果。圖5(a)為梯形的底角θ與器件的擊穿電壓(BV)的關系曲線,從圖中可以看出,擊穿電壓隨著角度θ的增加先增加后減小,且在θ為87°時達到最大值。圖5(b)為漂移區摻雜濃度Nnc與器件的導通電阻Ron、擊穿電阻BV 的關系曲線,插圖為器件的BFOM 與Nnc的關系曲線。由圖可知,器件的BV 和Ron隨著Nnc的增大而減小,體現了二極管器件中的Ron和BV 之間存在的Trade-off 關系。而BFOM 則隨著Nnc的增大先增大后減小,因此取BFOM 在最高點時的Nnc為最優值。

圖5 (a)擊穿電壓隨著θ 的變化曲線。(b)導通電阻Ron和BV 隨著漂移區摻雜濃度Nnc的變化曲線,插圖為BFOM 優值隨Nnc的變化Fig.5 (a)Dependence of breakdown voltage and θ.(b)BV and Ronas functions of GaN n-type drift layer's doping concentration (Nnc).The inset of Fig.5 (b) shows the dependence of BFOM and Nnc
基于上述關鍵參數的優化結果,圖6 給出了GaN基的普通PN 二極管、梯形二極管以及復合介質結構梯形二極管的反向特性對比圖,插圖為三種結構的正向特性曲線。三種結構的有源區均具有相同的外延層結構,其中p 型摻雜區厚度為0.5 μm,摻雜濃度為3×1017cm-3,n 型摻雜區的厚度為15.5 μm,摻雜濃度為1.5 ×1016cm-3。θ、L和T的取值分別為87°,10 μm 和5 μm。普通PN 二極管、梯形二極管以及復合介質結構梯形二極管的BV 分別為2780,2300 和4360 V。從插圖可以看出,三種結構具有相似的正向特性曲線和導通電阻大小。通過正向特性曲線計算出該復合介質結構梯形二極管的導通電阻為1.53 mΩ·cm2。
相比具有兩層介質的復合介質結構,具有三層介質的復合介質結構具備更好的調節二極管漂移區內部的電場分布的能力,從而可以進一步提高器件的耐壓。基于上述對具有兩層介質的復合介質結構梯形二極管優化結果,具有Al2O3、Si3N4和SiO2三層介質的復合介質結構GaN 梯形二極管被提出并進行了仿真優化。圖7 為三層復合介質結構GaN 基梯形二極管的橫向截面圖,其中p型摻雜區厚度為0.5 μm,摻雜濃度為3×1017cm-3,n 型摻雜區的厚度為15.5 μm,摻雜濃度為1.5 ×1016cm-3。T1為Al2O3和Si3N4介質層界面與PN 結界面之間的距離。T2為Si3N4與SiO2介質層界面與PN 結界面之間的距離。L與θ分別取為10 μm 和87°。

圖6 GaN 基普通PN 二極管、梯形二極管以及復合介質結構梯形二極管的反向特性曲線,插圖為正向特性曲線Fig.6 Reverse I-V characteristics of regular PN diode,trapezoidal diode and trapezoidal diode with compound dielectric.The inset of Fig.6 shows the forward I-V characteristics of three different structures of diodes
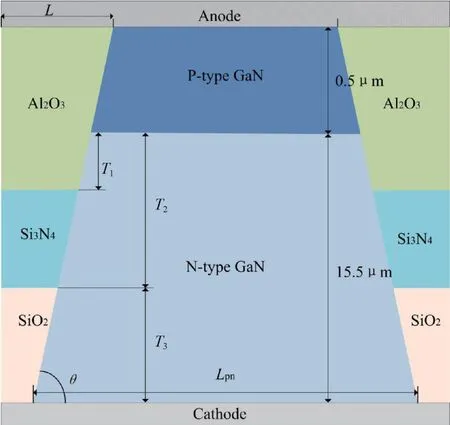
圖7 三層復合介質結構GaN 基梯形二極管的橫截圖Fig.7 GaN trapezoidal PN diodes with compound dielectric of three layers
圖8 為GaN 基的普通PN 二極管、梯形二極管、雙層復合介質結構梯形二極管以及三層復合介質結構梯形二極管的沿垂直方向的電場分布曲線。相比具有雙層復合介質結構的梯形二極管,三層復合介質結構的梯形二極管多了一個電場的峰值,漂移區內部的電場分布更加均勻。說明通過增加介質層的數量可以起到進一步調節漂移區內部的電場分布的作用,從而提高器件的耐壓。
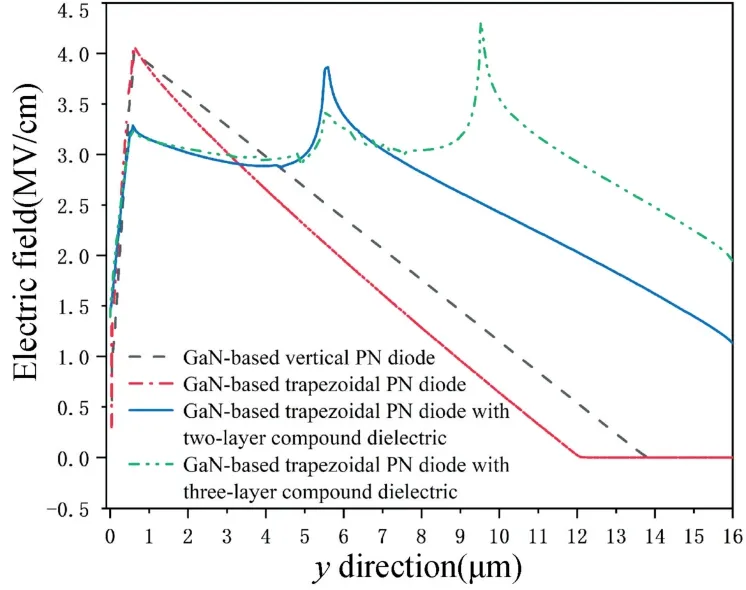
圖8 GaN 基普通PN 二極管、梯形二極管、雙層復合介質結構梯形二極管以及三層復合介質結構梯形二極管的垂直方向電場分布曲線Fig.8 The electric field distributions corresponding to GaN regular PN diode,trapezoidal diode,trapezoidal diode with compound dielectric of two layers and trapezoidal diode with compound dielectric of three layers
圖9 為插圖所示結構的BV 與T1的關系曲線。插圖為具有Al2O3和Si3N4兩層介質層的GaN 基梯形二極管的截面圖,其外延層結構與前文結構相同,其中p型摻雜區的厚度為0.5 μm,摻雜濃度為3 ×1017cm-3,n 型摻雜區厚度為15.5 μm,摻雜濃度為1.5 ×1016cm-3。梯形底角為87°,復合介質層的長度L為10 μm。從圖中可以看出,BV 隨著T1的增加先增大后減小,當T1取值在3~6 μm 之間時,擊穿電壓為4530~4570 V 之間,穩定在相對高的范圍內,之后再隨著T1的增加而減小。在T1從2 μm 增加到3 μm 以及從6 μm 增加到7 μm 的過程中,BV 的數值均存在跳變。因此取3~6 μm 為T1的優值范圍。
圖10 為T1取1~10 μm 時圖9 中二極管內部的縱向電場分布曲線。隨著T1的增大,PN 結界面處的電場峰值穩定在3.5 MV/cm 左右,復合介質層界面處的電場峰值則隨著T1的增大先增大后減小。通過對T1取4~10 μm 時介質層界面的電場峰值的大小進行擬合,可以發現電場峰值的下降趨勢符合指數函數的下降規律。在T1為3~6 μm 時,介質層界面處的電場峰值處于相對高點,約為3.9 MV/cm 左右,說明此時復合介質層對電場的調節作用達到最大。
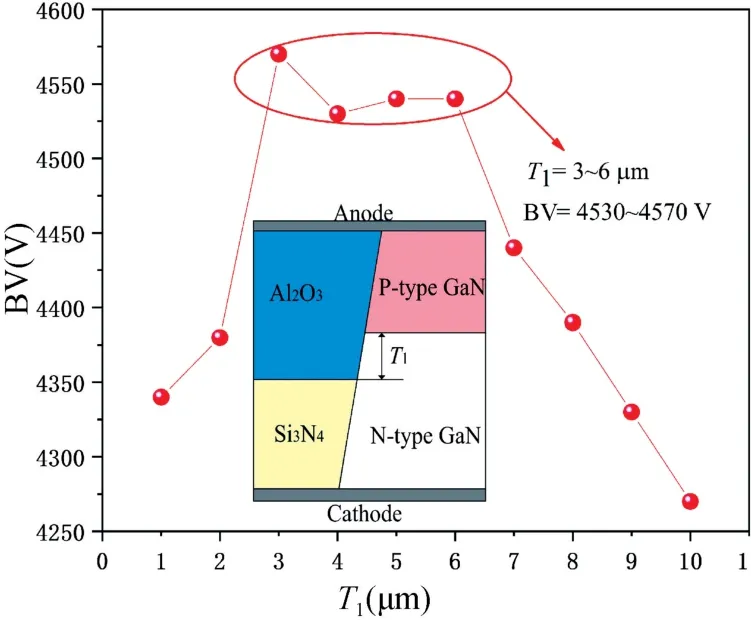
圖9 擊穿電壓BV 隨著T1的變化曲線,插圖為具有Al2O3和Si3N4兩層介質層的GaN 基梯形二極管器件橫截圖Fig.9 Breakdown voltage change curves with T1.Inset:Schematic cross-section of trapezoidal GaN PN diode with Al2O3/Si3N4compound dielectric
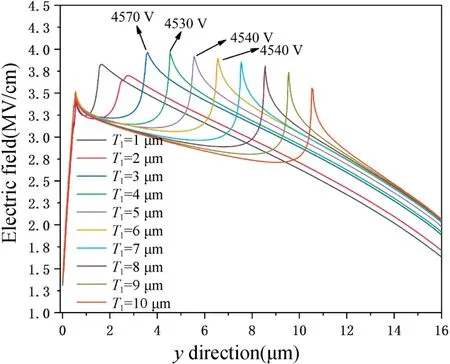
圖10 T1取1~10 μm 時二極管內部縱向電場分布Fig.10 The electric field distributions of PN diodes when T1=1-10 μm
圖11 為T1=5 μm 時插圖所示結構的擊穿電壓隨著T2的增加而變化的曲線。插圖為具有Al2O3、Si3N4和SiO2三層介質層的GaN 基梯形二極管截面圖,其中p 型摻雜區的厚度為0.5 μm,摻雜濃度為3×1017cm-3,n 型摻雜區厚度為15.5 μm,摻雜濃度為1.5×1016cm-3。梯形底角為87°,復合介質層的長度L為10 μm。可以發現器件的擊穿電壓隨著T2的增加而逐漸減小,T2取6 μm 時BV 最大為5360 V。這是由于復合介質界面與PN結界面之間距離為3~5 μm 時,復合介質層對電場的調節作用最大,而離PN 結界面距離為5 μm 的位置已經被Al2O3/Si3N4的介質層界面占據,因此Si3N4/SiO2的介質層界面只能占據距離PN 結界面大于5 μm 的位置。這導致Si3N4/SiO2的介質層界面在逐漸遠離PN 結界面過程中,對漂移區內部電場的調節作用逐漸減小,反映為器件的BV 隨著T2增加而單調下降。
圖12 為不同結構二極管的正向特性曲線和反向特性曲線。圖12(a)為經過優化后的普通PN 二極管、梯形二極管、雙層復合介質結構梯形二極管以及三層復合介質結構梯形二極管的反向特性曲線對比,圖12(b)則為四種結構的正向特性曲線。普通PN 二極管、梯形二極管、雙層復合介質結構梯形二極管以及三層復合介質結構梯形二極管的擊穿電壓分別為2300,2780,4360 和5360 V。相比于具有雙層復合介質結構的梯形二極管,具備三層復合介質結構的梯形二極管的耐壓提升了22.9%。四種結構具有相似的正向特性曲線,開啟電壓Von均在3 V 左右。其中普通PN 二極管導通的電流略大于其他三種結構。這是因為相比梯形的二極管,在底邊長度相同的情況下,底角為直角的二極管有源區面積要略大于梯形的二極管。正向特性曲線高度相似說明復合介質層結構對二極管的正向特性幾乎沒有影響。通過計算可得雙層復合介質結構梯形二極管和三層復合介質結構梯形二極管的導通電阻為1.53 mΩ·cm2,對應的BFOM,即(BV)2/Ron大小分別為12.4 GW/cm2和18.78 GW/cm2。
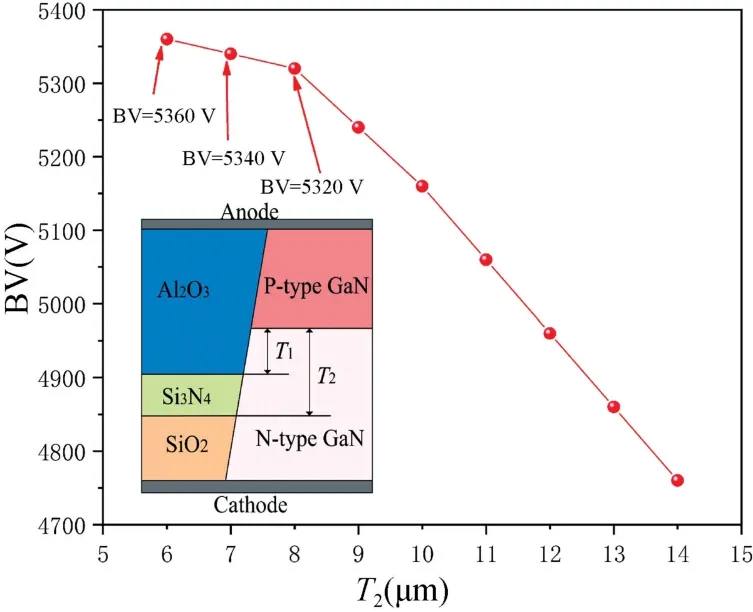
圖11 T1=5 μm 時擊穿電壓隨著T2的變化曲線,插圖為具有Al2O3、Si3N4和SiO2三層介質層的GaN 基梯形二極管截面圖Fig.11 Breakdown voltage change curves with T2when T1=5 μm.Inset:Schematic cross-section of trapezoidal GaN PN diode with Al2O3/Si3N4/SiO2compound dielectric
圖13 為具有雙層復合介質結構和三層復合介質結構梯形二極管的導通電阻和擊穿電壓與其他垂直功率二極管的文獻比較圖[14-22]。文獻[21]為具有場限環結構的GaN 基垂直PN 二極管結構,通過在主PN 結區域和場限環區域之間插入一個電阻器件來抑制結邊緣處電場擁擠現象,從而提升器件耐壓;文獻[1]為具有場板結構的GaN 垂直PN 二極管,該結構通過場板結構抑制結邊緣的電場擁擠,同時通過優化具有多層不同摻雜濃度n 型摻雜區的穿通結來降低器件的導通電阻。從對比圖中可以看出,本文中復合介質結構GaN 基梯形二極管的性能已經接近GaN 材料的理論極限。而且相比于文獻中具有相似性能的其他結構,該結構無需在有源區外構造額外器件來調制電場,同時有源區也沒有復雜的外延層結構,具備較好的面積利用效率和進一步提升的潛力。

圖12 GaN 基普通PN 二極管、梯形二極管、雙層復合介質結構梯形二極管以及三層復合介質結構梯形二極管的(a) 反向特性曲線和(b) 正向導通曲線Fig.12 (a) Reverse I-V characteristics and (b) positive I-V characteristics of regular PN diode,trapezoidal diode,trapezoidal diode with double compound dielectric and trapezoidal diode with treble compound dielectric

圖13 二極管的導通電阻和擊穿電壓文獻對比圖Fig.13 Benchmark of Ronvs BV of the vertical power diodes
3 結論
本文提出了一種高擊穿電壓復合介質結構垂直GaN 基PN 二極管,利用Silvaco TCAD 對結構的關鍵參數進行了優化設計和分析。得出了器件的擊穿電壓隨著結構中的各個關鍵參數的變化規律,經過優化后具有雙層復合介質結構GaN 基梯形二極管的擊穿電壓為4360 V,相比普通GaN 基PN 二極管耐壓提升了56.8%,正向導通電阻為1.53 mΩ·cm2,BFOM 為12.4 GW/cm2;具有三層復合介質結構的GaN 基梯形二極管的擊穿電壓為5360 V,相比沒有復合介質層的GaN 基普通PN 二極管提高了92.8%,正向導通電阻為1.53 mΩ·cm2,BFOM 為18.78 GW/cm2。具有三層復合介質結構的GaN 基梯形二極管的平均擊穿電場為3.35 MV/cm,接近GaN 材料的理論極限。證明了復合介質結構具備對漂移區電場的調制作用,具有該結構的二極管可以在不犧牲正向導通性能的情況下顯著提升耐壓,為設計高耐壓的GaN 基垂直二極管器件提供了新的思路和方向。

