基于AFM的振幅反饋電路設計
王萍,戴斐
(合肥職業技術學院,機電工程學院,安徽 合肥 238010)
AFM全稱是Atomic Force Microscope,即原子力顯微鏡,它是一種原子級高分辨的新型的測量儀器。AFM適用于導體和半導體材料,可以在液體中對物體進行測量,與被測試樣可以有接觸、非接觸和輕敲三種工作模式,具有測量精度高、可達到納米級等顯著的優點。在納米材料、精密制造、生物等領域中應用十分廣泛。但是,原子力顯微鏡在測量樣品形貌的時候也存在掃描速度慢、耗時長等不足,本文針對AFM測量的這一缺陷,設計了一種PID反饋控制硬件電路,通過硬件電路對掃描速度有了有效的提高。
1 AFM的工作原理
原子力顯微鏡檢測是利用其極小的原子量級的探針針尖與被測物體表面原子的作用力,此作用力與距離有關,如圖1所示,橫坐標r為距離,縱坐標為原子間作用力f。當探針慢慢接近被測物體時,即r慢慢減小,原子間的合力先為排斥力,隨著距離r逐漸減小,排斥力緩慢增加,r減小到r’時,排斥力快速增加達到最大值,然后,快速減小到0,隨著r繼續減小,兩原子間的作用力表現為吸引力,吸引力隨著距離的減小極具增加。通過圖1可知,當距離r小于r’后,作用力f隨距離r的變化十分明顯,即r很小的變化引起f的巨大變化,且基本為線性關系。原子力顯微鏡在檢測物體時,正是利用兩者的這一線性關系和高靈敏度。
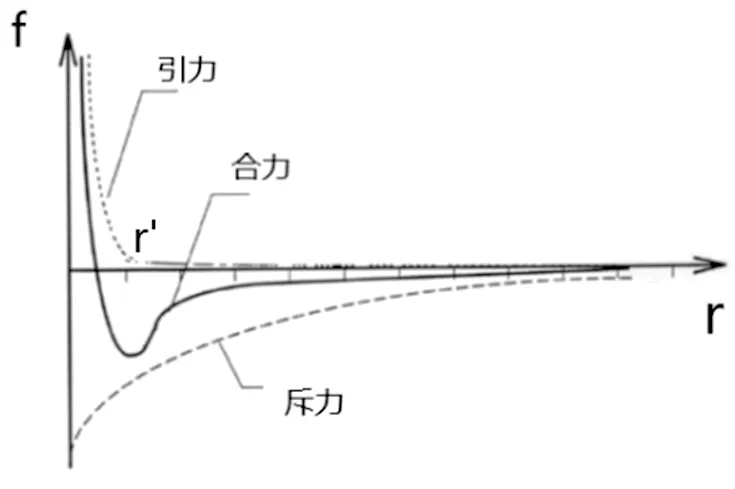
圖1 兩原子間的作用力與距離的關系曲線
2 AFM結構與測量原理
原子力顯微鏡是綜合運用了精密機械光電檢測信號處理信號采集圖像處理等技術的高精度精密儀器,其結構如圖2所示,是由物料檢測臺、微懸臂探頭、激光放大機構、光電檢測電路及反饋控制系統和等部分組成。其中,物理檢測臺主要是由一個或多個壓電陶瓷構成,壓電陶瓷是一種具有壓電效應和逆壓電效應的材料,即給壓電陶瓷施加拉力或壓力,材料會產生電場,力消失電場消失,電場方向隨著力的方向變化而變化;同樣,當給壓電材料施加電場,其會發生形變,出現拉伸或收縮的現象,形變方向與施加電場方向有關。測量時,將被測物體放在檢測臺上,由于被測物形貌的關系,其各點與微懸臂探針距離不同,探針所受作用力不同,導致探針的振動幅度不同;通過放大機構和光電檢測電路將檢測探針的振幅或相位的偏移量進行放大并測量,最終轉換成電信號,即將物體形貌的變化轉換成電信號的變化,并通過檢測臺水平方向移動被測物體,即可得到被測物各點形貌的電信號。為了使測量更精確,需要將檢測的電信號通過反饋控制系統進行調節,最后,再通過計算機控制整個掃描過程,計算處理相關數據,并顯示被測物體的形貌。一般在測量時,將探針與測量點的距離設成恒定值,當形貌變化,被測點與探針距離變化,反饋控制系統將這一變化與恒定值比較,從而調節控制壓電陶瓷的電壓,調節探針與被測點的距離,直至達到恒定值。反饋控制系統有軟件反饋和硬件反饋兩種方式,其中軟件反饋通過各種PID算法,優點是修改方便、不增加成本,缺點是計算復雜,在反饋調節過程中,需要多次調節多次計算才能達到設定值,導致執行速度慢,掃描時間長;硬件反饋與此相反,掃描速度快,但硬件電路不易修改反饋參數。反饋控制信號可以是振幅、相位及頻率等,本文在保持探針與被測點距離不變的情況下,采用振幅作為反饋信號。

圖2 原子力顯微鏡的結構組成
3 AFM的振幅反饋電路設計
本文設計了具有PID的硬件振幅反饋電路,在檢測物體過程中,保持AFM的探針針尖與物體的距離為設定值,即探針受力是恒定的值,此作用力由AFM轉換成恒定的電壓量輸出。AFM的振幅反饋電路設計框圖如圖3所示。當檢測被測物的不同點時,由于物體形貌的變化,探針與檢測點的距離發生變化,探針受力發生變化,AFM輸出的反應被測點形貌的電壓量與設定值不同。將此電壓值與設定值進行比較作差,再將差值進行PID運算,再通過求和、放大后差值反饋電壓送給Z向壓電陶瓷,壓電陶瓷的電壓變化,發生相應的形變,改變被測點與探針的距離,使此距離最終保持恒定,記錄此時加在壓電陶瓷上的電壓大小即為被測點的形貌,對被測物體多點進行檢測,最終得到被測物體的形貌。AFM的振幅反饋電路原理圖如圖4所示。

圖3 AFM的振幅反饋電路設計框圖

圖4 AFM的振幅反饋硬件原理圖
4 結語
本文通過分析原子力顯微鏡測量的原理,提出其存在的問題,并設計了硬件PID反饋控制后,使其測量時掃描速度得到有效提高。

