基于InGaAs/GaAs 量子阱結構的輻射標定因子實驗研究
王 偉, 楊舒婷, 汪雅欣, 王宇軒, 王 茹, 于慶南
(無錫學院 江蘇省集成電路可靠性技術及檢測系統工程研究中心, 江蘇 無錫 214105)
1 引 言
InGaAs/GaAs 半導體激光器由于其優良特性,已經廣泛應用于通信傳輸、醫療衛生、空間探測等領域[1-8]。輻射標定因子作為揭示半導體激光器件工作機制和特性的重要參數,是設計和評估半導體激光器的重要指標,它表征了載流子分布、光學增益、自發輻射速率、自發輻射等參數之間的內在聯系[9],是關于電子和空穴復合產生有效發光的程度描述。該參數統一概括了自發輻射強度在任意單位和不同光場模式下的轉換關系,可以將從端面收集到的自發輻射(任意單位)轉換為真實的輻射強度[10]。然而,現階段國內外關于輻射標定因子的報道較少,大都只給出了以上物理量和輻射標定因子的理論公式,并未給出具體的測量方法,也未提及該因子的具體數值[11-12]。因此,本文提出一種新的測量方法來探究輻射標定因子的數值大小和分布。雖然該參數可以通過理論仿真獲得,但在計算中有些特殊參數的具體數值難以獲得,不得不進行近似處理。同時,理論計算還忽略了器件制備和工藝處理過程中可能引入的結構缺陷,因此理論仿真僅是一種理想情況下的計算結果,無法真實地反映激光器的實際輻射特性。InGaAs/GaAs 量子阱結構具有極其優良的光學特性,在超寬調諧激光器以及同步雙頻激光器等領域已經展現出了巨大應用潛力[13-14]。因此,如何通過有效的實驗方法來獲得該量子阱結構的輻射標定因子對探究其輻射特性意義重大。本文通過測量InGaAs/GaAs 量子阱外延結構芯片兩側輻射的光致發光光譜(PL),計算獲得了不同光注入濃度下的輻射標定因子,對探究和評估半導體激光器的性能具有較大參考價值。
本文首先利用金屬有機化學氣相沉積系統(MOCVD)生長獲得InGaAs/GaAs 量子阱結構,利用808 nm 光纖耦合光源作為泵浦能源,通過光泵技術測量和分析了由該量子阱結構產生的PL 光譜。通過對其中一個端面進行增透處理,結合該結構兩端輻射的PL 光譜,測量并獲得了在不同載流子注入濃度下的輻射標定因子。最后,利用固體模型理論對該參數進行了分析和討論。
2 InGaAs/GaAs 量子阱結構及測量裝置
2.1 材料結構
本文設計InGaAs/GaAs/GaAsP 材料體系作為量子阱結構的有源區,基本材料組成及波導微觀結構如圖1 所示。所采用的InxGa1-xAs 勢阱的銦含量x=0.17,層厚為10 nm。InGaAs 材料被嵌入在兩個厚度為2 nm 的GaAs 應變緩沖層之間,緩沖層外側分布有8 nm 厚的GaAs0.92P0.08勢壘,用以吸收泵浦光。In0.17Ga0.83As 和GaAs 材料的晶格常數ɑ分別為0.572,0.565 nm,GaAsP 的晶格常數利用插值法[15]求得,即ɑ(GaAs0.92P0.08)=0.92×ɑ(GaAs)+0.08×ɑ(GaP)=0.563 nm。因此,GaAs 層的作用是為了緩解和補償In0.17Ga0.83As 勢阱和GaAs0.92P0.08勢壘之間的高晶格失配和應變,以減少在材料生長過程中由應力導致的缺陷。該量子阱結構在660 ℃和104Pa 的生長環境下以0.7 μm/h 的速率進行沉積,V 族源和Ⅲ族源的量比V/Ⅲ為40[16]。
2.2 測量裝置
為了測量獲得InGaAs/GaAs 量子阱結構的輻射標定因子,本文對樣品的端面進行了特殊處理。一端鍍有增透膜,透過率為99.9%;另一端為自然解理面,反射率R=30%。由于量子阱層厚度(10 nm)遠小于波導層厚度(2 μm),所以端面反射率R主要取決于波導層AlGaAs 材料。端面反射率可由以下公式確定[17]
其中nair和nAlGaAs分別表示空氣和波導層材料折射率。
本文建立了如圖2(a)所示的實驗測量系統。使用808 nm 光纖耦合激光器(公司:北京鐳志威光電技術有限公司,型號:LWIRL808-40W-F)作為泵浦能源,利用光纖耦合系統對InGaAs/GaAs量子阱外延結構雙側輻射的PL 光譜進行收集測量。注入光功率P與載流子濃度N的轉換關系為[18]:
其中ηabs為泵浦吸收效率,hν為光子能量,Ap為泵浦光斑面積,τ為載流子壽命,Nω和Lω分別為增益介質中量子阱的個數和厚度。
為了規避熱效應對測量結果的影響,提高測量精度,利用信號發生器將泵浦光源調制為脈沖工作方式,脈寬為20 ms。在室溫300 K 下,利用上述實驗裝置測量獲得了InGaAs 量子阱樣品在不同載流子注入濃度下材料兩側輻射的PL 光譜,測量結果如圖2(b)所示。其注入載流子濃度分別為9.0×1017(紅),9.2×1017(藍),9.4×1017(綠),9.6×1017cm-3(黑),其中實線和虛線分別表示從端面1(T=99.9%)和端面2(R=30%)采集的PL 光譜IPL1和IPL2。
圖2(b)中的PL 光譜呈現出特殊的雙峰特征,這是由于在生長高應變InGaAs/GaAs 材料時的富銦島效應導致的。銦原子遷移將導致材料內部包含兩種不同組分的有源區,其光譜疊加導致了光譜的雙峰現象[19]。
3 測量原理
為了建立InGaAs/GaAs 量子阱結構輻射標定因子和雙側PL 光譜強度的公式關系,本文首先建立InGaAs 材料PL 光譜強度和模式增益G之間的關系為[20]:
其中L表示InGaAs 量子阱外延結構長度,Isp表示自發輻射強度,IPL1和IPL2是分別從材料兩個端面(T=99.9%和R=30%)測量的PL 光譜強度。通過公式(3)和(4)可以獲得模式增益G的表達式為:
將公式(5)代入公式(4),即可獲得自發輻射強度的表達式為:
為了通過實驗獲得量子阱結構的輻射因子,我們引入反轉因子PF[21]:
其中,ΔEf表示電子和空穴的準費米間距,該參數可由材料增益零點確定;T為溫度;kB表示玻爾茲曼常數;hν代表光子能量。輻射標定因子C的表達式為[21]:
其中c表示真空中的光速;n代表有源層的折射率,值約為1.5;Γ表示光限制因子,與波導層厚度有關,大小約為0.002 49。
將公式(5)、(6)、(7)代入公式(8)可獲得輻射標定因子C的表達式為:
由公式(9)可知,只要確定了費米間距ΔEf,就可以通過InGaAs 外延結構兩端輻射的PL 光譜求得該材料的輻射標定因子。
4 結果與分析
由公式(9)可知,要想獲得輻射標定因子,除了PL 光譜,還需求得電子和空穴的準費米間距ΔEf,其大小可由材料增益零點確定。為了獲得InGaAs 結構電子和空穴的費米間距ΔEf,首先建立材料增益g與模式增益G的關系為g=(G+ɑ)/Γ[22],其中ɑ表示InGaAs 材料內部損耗,主要來源于材料內部散射和吸收,可由模式增益評估產生[23-24]。因此,將圖2(b)中測量的PL 光譜帶入公式(5),計算獲得不同光注入濃度下的模式增益G,結果如圖3(a)所示,內部損耗評估約為ɑ=5.0 cm-1。同理,利用損耗系數ɑ和圖3(a)中的模式增益G,可計算獲得該結構的材料增益g,結果如圖 3(b)所示。
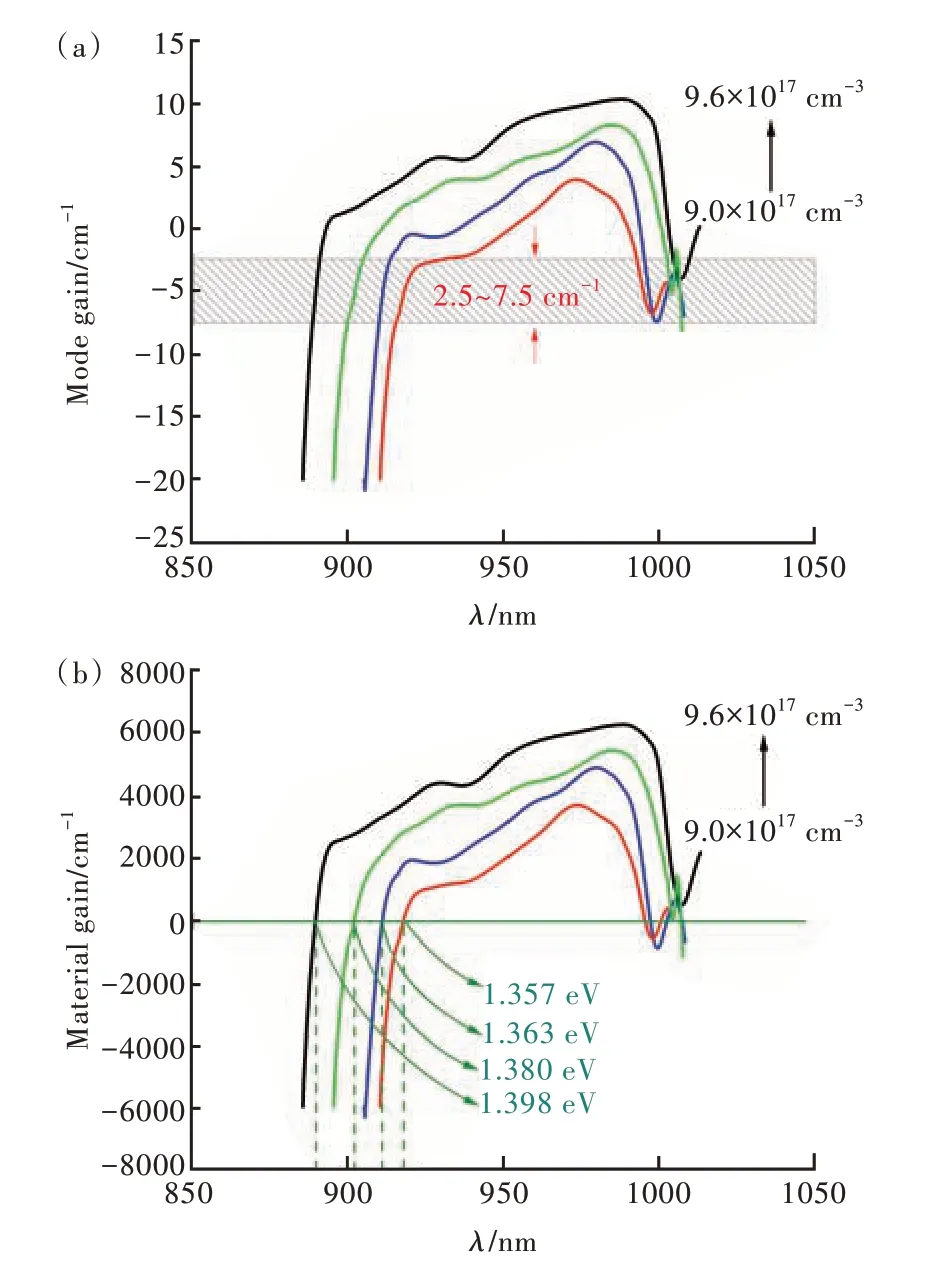
圖3 不同光注入濃度下的模式增益G(a)和材料增益g(b)Fig.3 The mode gain G(a) and material gain g(b) with different carrier densities
根據圖3(b)材料增益零點對應的光子能量可獲得電子和空穴在不同載流子注入濃度下的費米間距ΔEf[22]。室溫300 K 下,載流子注入濃度為9.0×1017,9.2×1017,9.4×1017,9.6×1017cm-3時對應的準費米間距分別為1.357,1.363,1.380,1.398 eV。將圖2(b)中的光譜數據帶入公式(9),結合上述準費米間距,可計算獲得InGaAs 量子阱結構的輻射標定因子C,結果如圖4 所示。
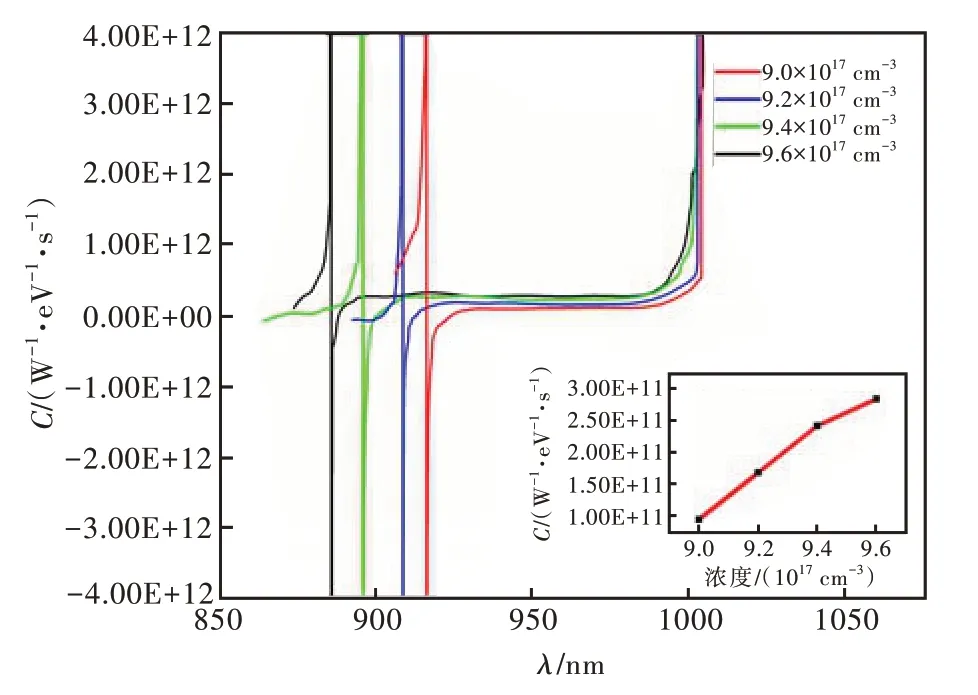
圖4 不同光注入濃度下的輻射標定因子曲線及其變化趨勢Fig.4 The curves of emission scaling factor under different carrier densities and their variations
由圖4 分析可知,在同一熱平衡狀態下(相同的載流子注入濃度和工作溫度),該InGaAs 量子阱結構具有統一的輻射標定因子,該參數隨不同工作條件下的變化趨勢如圖4 中插圖所示。該曲線清晰地反映出輻射標定因子C隨注入濃度的增加逐漸增大,這是由于隨著光泵浦功率的增加,注入的非平衡載流子濃度逐步增大,使得電子-空穴對的復合幾率增大所致。同時,隨著載流子注入濃度增大,輻射標定因子增加的幅度逐漸變緩,這是由載流子的填充逐漸飽和引起的。
此外,圖4 還反映了輻射標定因子在費米間距處發生轉折,隨能量的增大逐漸降低,在數值上由正轉負,這是由于粒子數反轉在準費米能級發生突變所致。輻射標定因子表征電子和空穴的有效復合程度,該因子依賴于載流子反轉分布程度以及能帶填充水平。當對半導體材料施加光照時,光生載流子首先占據低能級并實現粒子數反轉,可以實現電子和空穴的有效輻射復合,光子的產生率大于吸收率,產生正的輻射標定因子。而對于未能實現載流子反轉分布的高能級,無法獲得電子和空穴的有效輻射,光子的產生率小于吸收率,產生負的輻射標定因子。本文利用載流子的填充規律對其進行了闡述,具體如圖5 所示。非平衡載流子的注入將導致電子和空穴的準費米能級EFn和EFp分開并逐漸向高能級移動。費米能級代表了量子狀態基本被載流子填充或者基本空余的分界線,因此準費米間距以內的能級基本被載流子填充,大于準費米間距的能級狀態基本為空。因此,輻射標定因子在準費米能級處逐漸減小,該結論與圖4 中的變化規律一致,驗證了該測量方法的準確性,同時揭示了該結構在不同熱平衡狀態下的非平衡載流子填充水平。
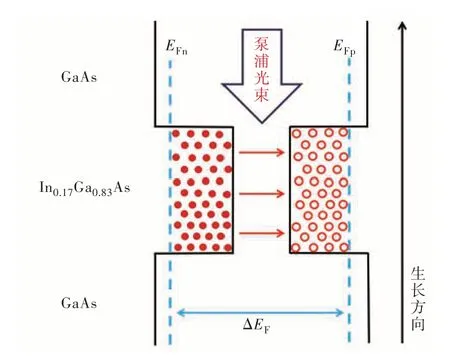
圖5 載流子填充規律Fig.5 The band-filling rules of electrons and holes
5 結 論
本文提出了一種測量輻射標定因子的實驗方法,通過實驗裝置收集樣品兩端輻射的光致發光(PL)光譜,計算獲得了InGaAs 量子阱結構在不同載流子注入濃度下的輻射標定因子,其結果分別為7.98×1010,1.68×1011,2.65×1011,3.36×1011W-1·eV-1·s-1。最后利用能帶結構對該結果進行了討論和分析,揭示了該結構在不同熱平衡狀態下電子和空穴的準費米能級變化規律和非平衡載流子填充水平的關系。該項研究不僅提出了一種測量輻射標定因子的新方法,也對揭示發光材料輻射機制和推動激光器發展具有重要研究價值。
本文專家審稿意見及作者回復內容的下載地址:http://cjl. lightpublishing. cn/thesisDetails#10.37188/CJL.20230249.

