室溫下不同偏壓與摻雜濃度對非對稱量子阱隧穿系數的影響
趙瑞娟, 安盼龍, 許麗萍, 楊 艷
(1.中北大學電子測試技術國家重點實驗室,山西太原030051;2.中北大學儀器科學與動態測試教育部重點實驗室,山西 太原030051;3.中北大學理學院,山西 太原030051)
近十幾年,國內外關于對稱雙勢壘共振隧穿結構的研究已經比較成熟,報道較多[1-4],但兩個及以上多個非對稱勢壘的研究,實驗和理論較少。理論預測非對稱多勢壘構成的不同阱寬、壘寬的共振隧穿,理論上可導致更大的隧穿電流和峰谷比,具有設計高頻量子器件等優勢[5]。非對稱雙勢阱三勢壘結構,起初阱中電子的量子化能級并沒有對齊,當電場方向由窄阱指向寬阱,錯開的兩阱的量子化能級可以處于同一高度,形成量子隧道,構成比雙勢壘對稱結構更大的隧穿電流;而當電場反向時,兩個量子阱量子化能級高度差增大,此時隧穿電流小到可以忽略不計,由此可以設計效果很好的非對稱量子器件、量子開關等[6]。
1 建立基本模型
選用GaAs為勢阱材料,勢壘材料選用匹配AlxGa1-xAs,x=0.3,T=300 K,B 為勢壘,W 為勢阱。B1、B2、B3分別為 5 nm、6 nm、10 nm,W1、W2分別為4 nm、9 nm。
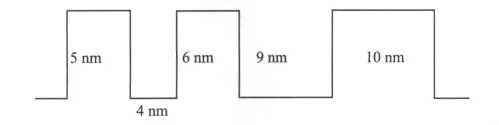
圖1 非對稱三勢壘模型Fig.1 Asymmetric three-barrier model
2 理論推導
量子隧穿問題實際為求解一維定態薛定諤方程[7-10],下面使用傳遞矩陣方法求解。
多勢壘結構圖簡化分為3個區,選z方向為縱向且垂直勢壘。

圖2 任意非對稱勢壘曲線Fig.2 Curve of arbitrary shape barrier
則多勢壘結構中電子滿足薛定諤方程

式(1)中,m和U代表有效質量和勢能,E為總能。令波函數Ψ為

式(1)代入式(2)可得

式(3)中,電子橫向動能E//為

電子的總能量

據電子總能量守恒,有

式(6)中 mE分別為發射區電子質量、總動能。
式(6)代入式(3)得

設1、2、3區的波函數Φ(z)分別為:

以上式中

Ai和Bi分別為入射波振幅和反射波的振幅;m、EEz分別為電子有效質量、能量,Ueff(k//,z)=Vi為勢壘高度。設勢壘高度、寬度分別為V0、Lb,勢阱寬度為LW,則透射系數Tn為

式(12)中

Yn為迭代函數。波函數及導數邊界連續,可得Ai+1,Bi+1與Ai和Bi有

式(14)中

顯然,式(12)為遞推公式,可求得

N+1個2×2矩陣乘積得M=M0M1…Mi…MN為傳遞矩陣。這樣,就可以得到穿過任意勢壘UX的透射系數近似值為

任意勢壘的隧穿實際仍為解決單勢壘的隧穿問題。
3 室溫條件不同偏壓濃度下所對應的不同隧穿系數曲線圖
以下給出外加偏壓1~4 V,摻雜濃度為(1017~1020)/cm3所對應的不同隧穿系數模擬曲線圖。
3.1 外加偏壓1 V,摻雜濃度為(1017~1020)/cm3
如圖3所示。
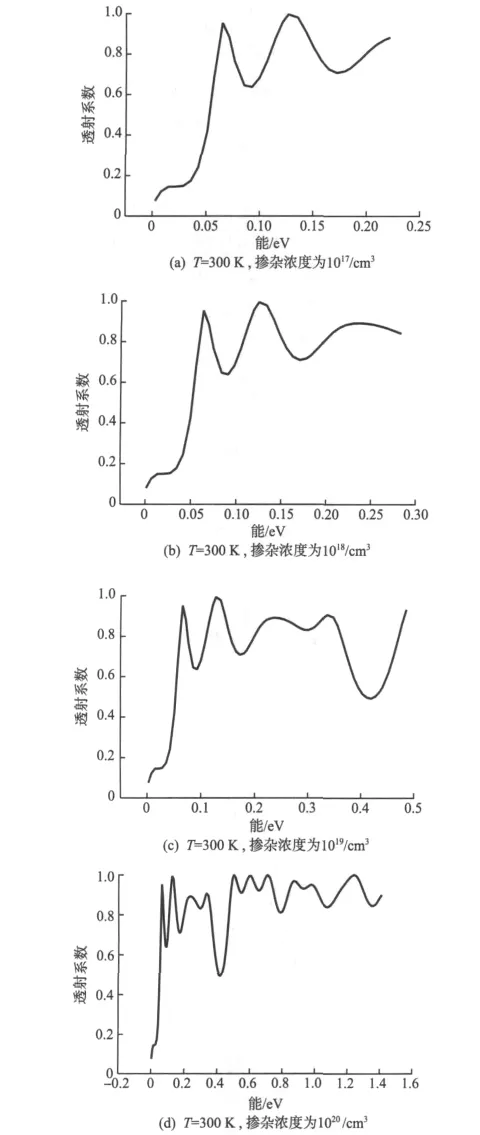
圖3 T=300 K,偏壓為1 V時,不同摻雜濃度對透射系數的影響曲線Fig.3 T=300 K,Bias is equal to 1 V,Transmission coefficient curves with different doping
3.2 外加偏壓2 V,摻雜濃度為(1017~1020)/cm3
如圖4所示。
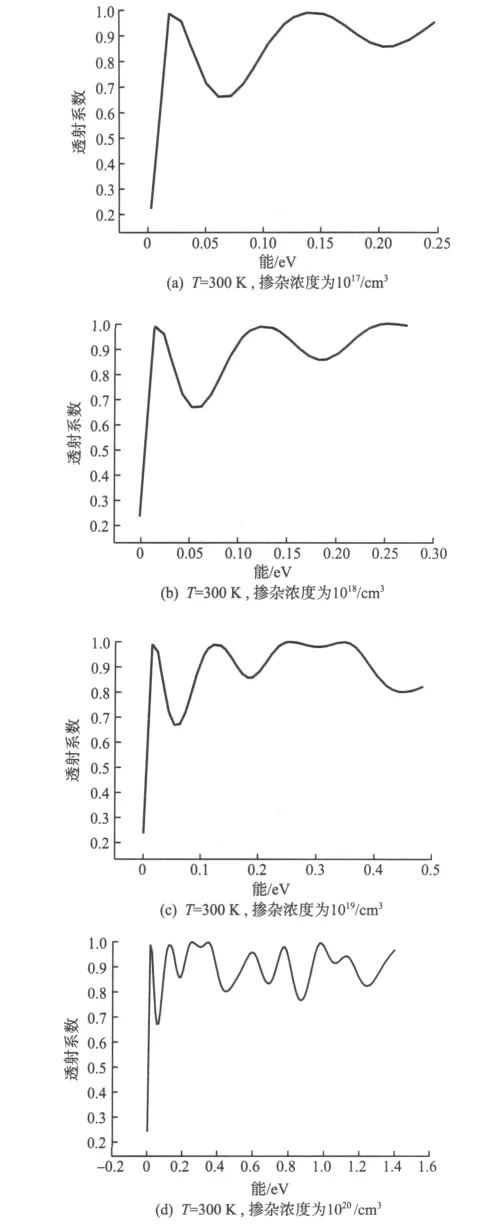
圖4 T=300 K,偏壓為2 V時,不同摻雜濃度對透射系數的影響曲線Fig.4 T=300 K,Bias is equal to 2 V,Transmission coefficient curves with different doping
3.3 外加偏壓3 V,摻雜濃度為(1017~1020)/cm3
如圖5所示。
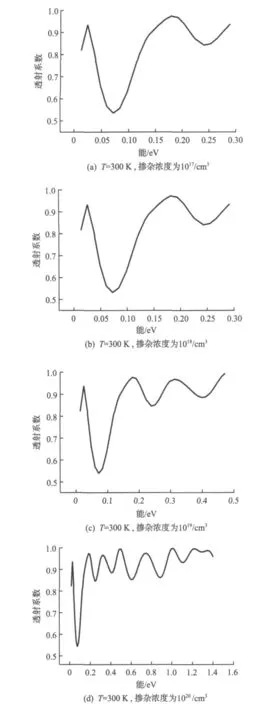
圖5 T=300 K,偏壓為3 V時,不同摻雜濃度對透射系數的影響曲線Fig.5 T=300 K,Bias is equal to 3 V,Transmission coefficient curves with different doping
3.4 外加偏壓4 V,摻雜濃度為(1017~1020)/cm3
如圖6所示。
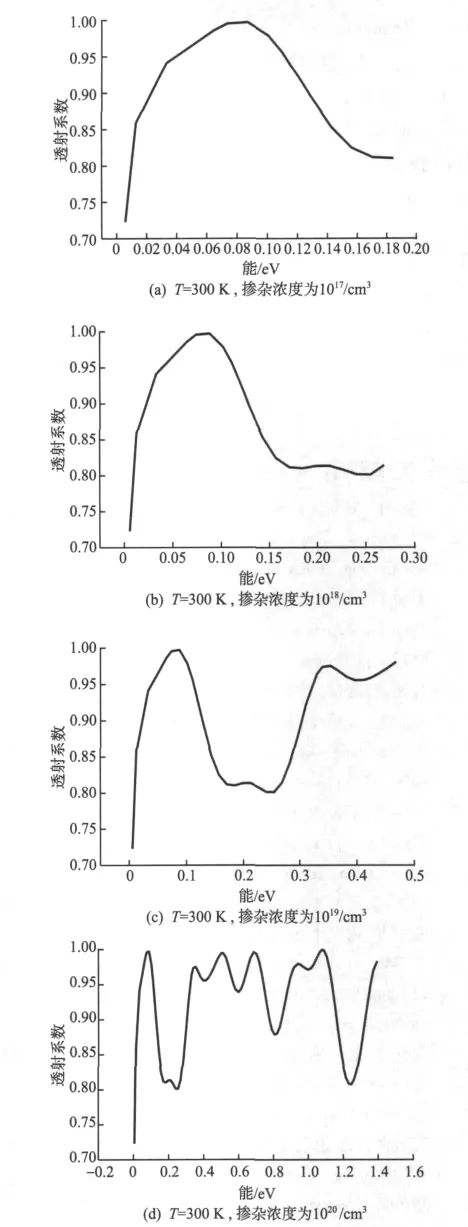
圖6 T=300 K,偏壓為4 V時,不同摻雜濃度對透射系數的影響曲線Fig.6 T = 300 K, Biasis equalto 4 V,Transmission coefficient curves with different doping
4 模擬結果分析
以上通過對1~4 V外加偏壓下,半導體材料發射區和集電區摻雜濃度分別為1017~1020/cm3的T—E(Transmission coefficient—Energy)曲線比較。偏壓小于3 V,摻雜濃度小于1020/cm3時,T—E曲線峰谷比較好;任何偏壓下一旦摻雜濃度大于1020/cm3時,T—E曲線失真明顯。可見制造量子器件時摻雜濃度不是越大越好,摻雜濃度控制在1018/cm3和1019/cm3兩個值較合適。
5 結語
據以上模擬,針對器件室溫保持不變,加置不同偏壓(1~4 V偏壓),不同摻雜濃度(1017~1020/cm3)下非對稱納結構量子阱透射系數的研究,發現偏壓3 V以下,由于摻雜濃度所造成的半導體器件內建電場形成的影響較小[7-11],適合隧穿條件。具體的量子器件需要的摻雜濃度、溫度,以及偏壓條件,必須考慮內建電場對其產生的影響而對隧穿過程進行調制。得到了內建電場變化實際,從側面反映了非平衡載流子對摻雜濃度的影響。平衡條件下載流子由于材料自身特點受到外界電場、磁場、溫度、極化、壓電諸多因素的影響[12],在其內部發生了隨機動態漂移,材料表面形成諸多因素的空間電荷,內建電場隨之形成,會使材料的非平衡態又逐漸趨于相對穩定的動態平衡態,材料的費米能級在能級圖上也會達到新的平衡高度。
[1]虞麗生.半導體異質結物理[M].北京:科學出版社 ,2006:112-147.
[2]XU Li-ping.The resonant tunneling in Si1-xGex/Si superlattices[J].Solid State Phenomena,2006,42:2721.
[3]XU Li-ping,WEN Ting-dun,YANG Xiao-feng.Mesopiezoresistive effects in double-barrier resonant tunneling structures[J].Appl Phys Lett,2008,92:043-508.
[4]Jogai B,WANG K L.Dependence of tnuneling current on structural variations of superiattice devices[J].Appl Phys Lett,1985,46(2):167-168.
[5]杜磊,莊弈琪.納米電子學[M].北京:電子工業出版社,2004.
[6]安盼龍,許麗萍,溫銀萍.Zn1-xCdxSe/ZnS量子阱材料的共振遂穿特性研究[J].紅外,2009,30(3):35-38.AN Pan-long,XU Li-ping,WEN Yin-ping.Study on resonant tunneling effects in Zn1-xCdxSe/ZnS quantum well[J].Infrared,2009,30(3):35-38.(in Chinese)
[7]趙瑞娟,安盼龍,許麗萍,等.不同偏壓溫度下非對稱三勢壘透射系數的模擬計算[J].半導體光電,2012,33(4):540-543.ZHAO Rui-juan,AN Pan-long,XU Li-ping,et al.Simulations on asymmetric three-barrier transmission coefficients under different bias and temperatures[J].Semiconductor Optoelectronics,2012,33(4):540-543.(in Chinese)
[8]王輝.靜壓對Ⅲ—Ⅴ族量子阱共振隧穿的影響[D].太原:中北大學,2007.
[9]安盼龍.內建電場對納結構半導體材料功函數調制研究[D].太原:中北大學,2009.
[10]李春雷,肖景林.勢壘的非對稱性對隧穿幾率的影響[J].內蒙古民族大學學報,2006,21(3):253-256.LI Chun-lei,XIAO Jing-lin.The effect of asymmetric barriers on tunneling probability[J].Journal of Inner Mongolia University for Nationalities,2006,21(3):253-256.(in Chinese)
[11]安盼龍,趙瑞娟,許麗萍.內建電場對納構半導體功函數的調制[J].武漢工程大學學報,2011,33(4):50-53.AN Pan-long,ZHAO Rui-juan,XU Li-ping.Modulation on work function of nano semiconductor materialby builtin electric field[J].J Wuhan Inst Tech,2011,33(4):50-53.(in Chinese)
[12]安盼龍,趙瑞娟.小偏壓下阱中阱結構的量子隧穿特性及其實現[J].量子電子學報,2011,28(5):629-634.AN Pan-long,ZHAO Rui-juan.Quantum tunneling properties and realization in low-biased well of wells structures[J].Chinese Journal of Quantum Electronics,2011,28(5):629-634.(in Chinese)

