Cu-Ni交互作用對Cu/Sn/Ni焊點液-固界面反應的影響
黃明亮,陳雷達,趙 寧
(1.大連理工大學 材料科學與工程學院,大連 116024;2.大連理工大學 遼寧省先進連接技術重點實驗室,大連 116024)
電子封裝技術中Cu作為倒裝芯片凸點下金屬層(UBM)被廣泛使用,但是,大量的研究表明,釬料凸點與Cu基UBM的反應速率很快,在釬焊過程中會形成一層較厚的金屬間化合物(IMC),嚴重影響微小焊點的可靠性[1-2]。Ni與釬料凸點的反應速率遠遠低于Cu和釬料凸點的反應速率,因此,Ni作為UBM也廣泛應用在電子封裝芯片互連技術中[3]。目前,Cu/solder/Ni焊點結構已取代Cu/solder/Cu焊點結構成為常見的芯片互連形式。近年來,隨著高密度封裝的不斷發展,凸點的尺寸持續減小。當凸點的尺寸減小到微米級時,凸點兩側的界面不再是相對獨立的體系,而是相互聯系、相互影響,這主要體現在微小焊點中一側的Ni或Cu金屬層原子會擴散越過釬料到達對面一側界面,并在界面處發生Cu-Ni交互作用[4-6]。
近年來,國內外對Cu、Ni在界面反應過程中的作用進行了大量研究[7-9]。HO等[7]研究發現,Sn-Ag-xCu釬料與Ni基板在250℃條件下液-固界面反應時,界面IMC的類型與釬料中Cu濃度有很大關系:當釬料中Cu含量低于0.2%(質量分數)時,在界面處生成(Ni,Cu)3Sn4;當釬料中Cu含量高于0.6%時,在界面處生成(Cu,Ni)6Sn5;當釬料中Cu含量介于0.4%到0.5%之間時,界面處既生成(Ni,Cu)3Sn4,又生成(Cu,Ni)6Sn5。TSAI等[8]研究發現,Sn-3.5Ag釬料中添加不同含量的Ni會對Sn-3.5Ag-xNi/Cu界面反應產生影響,Ni的添加雖然不能改變界面IMC的類型,但會改變其厚度及形貌。Sn-3.5Ag/Cu界面處的IMC為致密的層狀結構,當釬料中加入Ni元素后,界面IMC轉變為疏松的多孔狀結構,而且厚度大于未添加 Ni時的厚度。此外,本課題組的前期研究結果表明,基體中Cu、Ni的溶解、擴散及交互作用對界面反應具有顯著的影響[10-12]。由此可見,Cu和Ni作為參與凸點界面反應中的重要元素,即使含量很微小也會顯著影響界面反應的進程。
對于Cu/solder/Ni焊點結構,在封裝工藝過程中,UBM中的Cu和Ni原子會溶解并擴散越過釬料參與對面一側的界面反應,進而對微小焊點的可靠性產生影響。在Cu/solder/Ni焊點中,Cu和Ni作為無限的擴散源對界面反應的影響必然不同于微量的Cu和Ni對界面反應的影響。因此,本文作者采用Cu/Sn/Ni線性焊點(即采用目前業界常見的焊點間距)研究液-固界面反應過程中Cu與Ni交互作用及其對界面反應產物及生長動力學的影響。
1 實驗
采用浸焊的方法來制備Cu/Sn/Ni線性焊點。先將Cu塊和Ni塊(5 mm×7 mm×12 mm)的端面(5 mm×7 mm)進行預磨、拋光,然后電鍍一層3 μm厚的Sn,以增加潤濕性并避免釬焊孔洞出現。在Cu塊和Ni塊之間放置兩根直徑為200 μm的不銹鋼絲以控制焊點間距,將固定好的試樣浸入300 g液態純Sn中進行釬焊,釬焊溫度為260 °C、時間為10 s。然后,將試樣立即取出并水冷至室溫。將釬焊后的試樣線切割加工制成橫截面尺寸約為600 μm×600 μm的條狀試樣,最后再將這些條狀試樣的4個側面分別進行預磨拋光處理制備成橫截面尺寸為300 μm×300 μm的線性焊點。圖1所示為Cu/Sn/Ni線性焊點的液-固界面反應裝置示意圖。液-固界面反應實驗在油浴中進行,將線性焊點水平放置在矩形玻璃上,用密封膠將試樣固定在載玻片上,然后用特制的金屬夾具進行固定,最后將整個裝置放入溫度為250℃的油浴中進行液-固界面反應,反應時間分別為10 min、30 min、1 h、2 h、4 h和6 h。
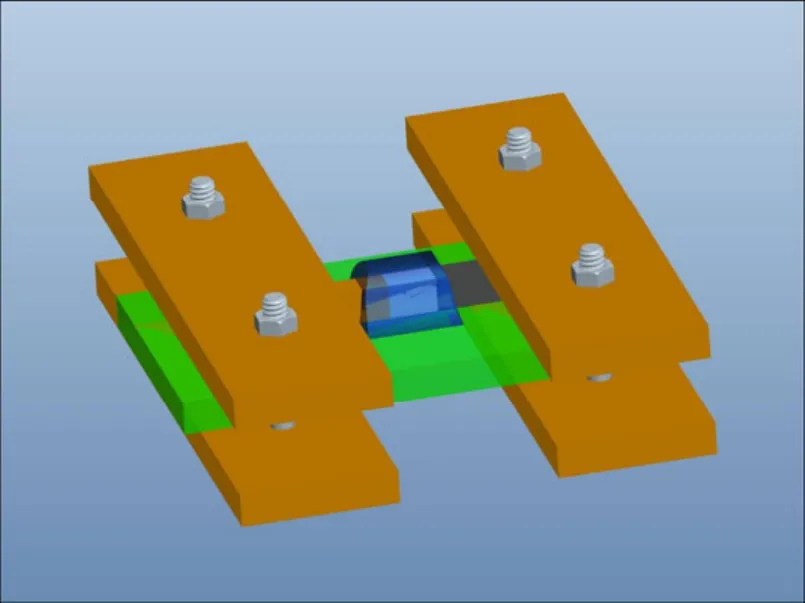
圖1 Cu/Sn/Ni線性焊點液-固界面反應示意圖Fig.1 Schematic diagram of liquid-solid interfacial reaction of line-type Cu/Sn/Ni interconnect
液-固界面反應后的線性焊點首先進行預磨,然后再依次用直徑分別為1.5和0.5 μm的金剛石拋光膏進行拋光。拋光后再用92%酒精-5%硝酸-3%鹽酸(體積分數)的腐蝕液進行腐蝕,腐蝕時間為10 s。采用JSM-5600LV型掃描電子顯微鏡和EPMA-1600型電子探針分別對界面金屬間化合物的形貌與成分進行觀察與分析。采用Q500IW 型圖像分析軟件測定 SEM照片中界面IMC層的面積,然后除以測量區域的總長度,得到界面IMC層的平均厚度。為了結果更加準確,每個界面取3張照片,每張照片測量3次,最后取平均值。
2 結果與分析
圖2所示為Cu/Sn/Ni焊點在260 °C下浸焊反應10 s后的微觀組織。浸焊后Cu基板和Ni基板之間形成了良好的連接,Cu和Ni的實際間距為(210±5) μm。在焊點兩側的Sn/Ni和Sn/Cu界面上均生成了扇貝狀的IMC。EPMA分析得Sn/Ni界面IMC為Ni3Sn4,Sn/Cu界面IMC為Cu6Sn5,由此可見,在短時浸焊反應后并沒有發生 Cu-Ni交互作用。測量得到Ni3Sn4層和Cu6Sn5層的厚度分別為0.25 μm和0.30 μm。在釬料基體中觀察到細小的共晶組織。WANG和LIU[13]研究了Cu/Sn/Ni焊點在250℃條件下的液-固界面反應,發現當反應時間小于1 min時,Sn/Ni界面IMC的生長速率小于Sn/Cu界面IMC的生長速率,這與本實驗的結果相吻合。
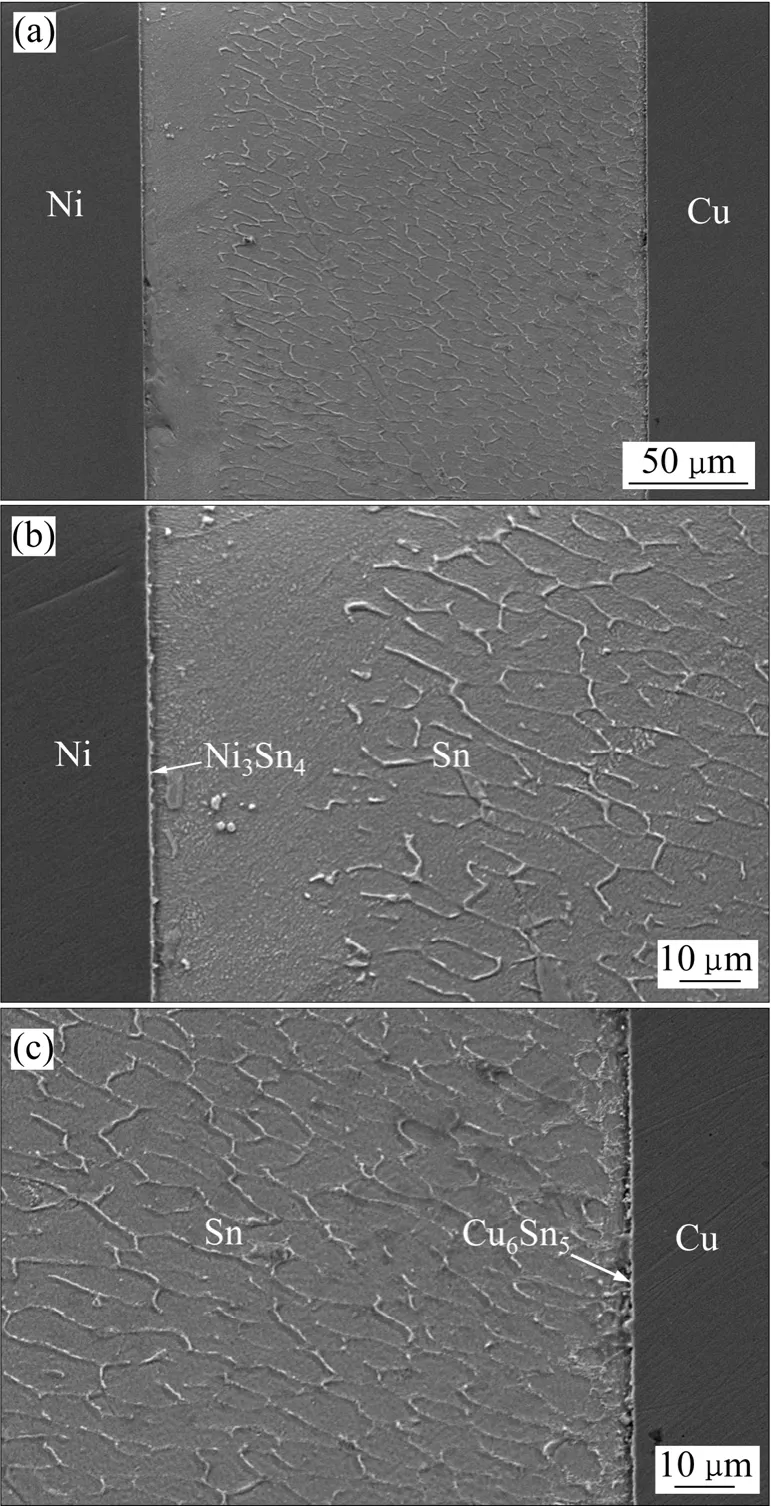
圖2 浸焊后Cu/Sn/Ni焊點的微觀組織Fig.2 Microstructures of Cu/Sn/Ni interconnect after immersing soldering: (a) Entire micrograph; (b) Sn/Ni interface;(c) Sn/Cu interface
圖3所示為Cu/Sn/Ni焊點在250℃液-固界面反應不同時間后界面微觀組織演變。圖3(a)、(c)、(e)、(g)為Sn/Ni界面,圖3(b)、(d)、(f)、(h)為Sn/Cu 界面。由圖3(a)可知,液-固界面反應10 min后,Sn/Ni界面IMC已由初始的Ni3Sn4轉變為Cu6Sn5類型,EPMA分析顯示其具體成分為(Cu0.83Ni0.17)6Sn5。在釬焊過程中,從Sn/Cu界面處溶解到液態釬料中的大量Cu原子會在化學勢梯度的驅動下擴散到Sn/Ni界面并參與界面反應,由于Cu6Sn5具有更低的吉布斯自由能[14],促使界面IMC由Ni3Sn4轉變為(Cu0.83Ni0.17)6Sn5。同樣,Sn/Ni界面處的Ni原子溶解到液態釬料中后,也會在化學勢梯度的驅動下擴散到Sn/Cu界面并參與界面反應,但界面IMC仍為Cu6Sn5類型,如圖3(b)所示。同時,由于Ni的溶解速率較低,Sn/Cu界面IMC為(Cu0.92Ni0.08)6Sn5,僅含有少量的Ni原子。此外,Sn/Ni和Sn/Cu界面IMCs形貌均由初始的扇貝狀轉變為短棒狀,厚度分別為2.59 μm和4.88 μm。在釬料基體中均勻分布著顆粒狀的IMC,EPMA分析表明這些顆粒狀的IMC為(Cu,Ni)6Sn5。WANG和LIU[13]的研究同樣發現,經過1 min后,在Sn/Cu和Sn/Ni界面上均生成了(Cu,Ni)6Sn5IMC,但界面 IMC的形貌卻有所不同,這主要是由于焊點兩側界面的間距有所不同(本研究中焊點的間距為200 μm,而文獻[13]中焊點的間距為100 μm),從而導致焊點中元素的擴散行為及界面處 Cu、Ni元素的原子濃度有所不同。可見,焊點間距對Cu-Ni交互作用及界面反應有重要影響。
Cu原子和Ni原子在液態Sn中的擴散速率均為10-5cm2/s數量級[15],其擴散距離可表示為

式中:S為擴散距離,D為擴散速率,t為擴散時間。
根據式(1)計算可知,在本研究條件下,Cu原子和Ni原子僅需要40 s就可以擴散到焊點對面一側,可見液-固界面反應10 min后,Cu-Ni必將發生交互作用,并導致Sn/Ni界面IMC類型發生轉變(由Ni3Sn4轉變成Cu6Sn5類型),兩側界面處的IMC形貌也發生轉變。
如圖3(c)和(d)所示,液-固界面反應 30 min后,釬料中的顆粒狀IMC越來越多。Sn/Cu和Sn/Ni界面IMC厚度進一步增加,分別達到6.17和4.93 μm。界面 IMC仍然為(Cu,Ni)6Sn5類型,EPMA分析可知 Sn/Cu和Sn/Ni界面 IMC的成分分別為(Cu0.90Ni0.10)6Sn5和(Cu0.83Ni0.17)6Sn5。Sn/Ni界面處的(Cu,Ni)6Sn5由短棒狀逐漸轉變為長棒狀。在Sn/Cu界面處并未發現有Cu3Sn生成,這是由于Ni的存在抑制了 Cu3Sn的生長。WATANABE等[16]研究了 Ni對Sn-Ag-Cu/Cu液-固界面反應的影響,發現當釬料中加入微量 Ni元素時,能夠明顯抑制 Cu6Sn5/Cu界面處Cu3Sn層的生長,這與本實驗結果相吻合。

圖3 Cu/Sn/Ni焊點在250℃液-固界面反應過程中界面組織演變Fig.3 Microstructures evolutions of Cu/Sn/Ni interconnects during liquid-solid interfacial reaction at 250℃: (a), (c), (e), (g)Sn/Ni interfaces; (b), (d), (f), (h) Sn/Cu interfaces
如圖3(e)和(f)所示,液-固界面反應2 h后,Sn/Ni和Sn/Cu界面 IMC繼續增厚,分別達到了 11.31和10.33 μm。此時,Sn/Ni界面上IMC的厚度要比Sn/Cu界面上IMC的厚。由此可見,Cu/Sn/Ni焊點在液-固界面反應過程中,Sn/Cu和Sn/Ni界面處的IMC雖然均為(Cu,Ni)6Sn5類型,并且均隨液-固界面反應時間的增加而增厚,但是其具有不同的生長速率。在液-固界面反應初期,Sn/Cu界面 IMC的生長速率要大于Sn/Ni界面IMC的生長速率,而經過一段時間后,Sn/Ni界面IMC的生長速率要大于Sn/Cu界面處IMC的生長速率。EPMA分析可知,Sn/Cu和Sn/Ni界面IMC的成分分別為(Cu0.92Ni0.08)6Sn5和(Cu0.87Ni0.13)6Sn5。液-固界面反應2 h后,Sn/Ni界面(Cu,Ni)6Sn5由短棒狀轉變為長棒狀。
如圖3(g)和(h)所示,液-固界面反應6 h后,Sn/Cu和Sn/Ni界面IMC的厚度分別達到15.78和23.44 μm。即使液-固界面反應進行了6 h,Sn/Ni界面IMC仍然為(Cu,Ni)6Sn5,在(Cu,Ni)6Sn5/Ni的界面處并沒有生成(Ni,Cu)3Sn4;Sn/Cu界面 IMC也為(Cu,Ni)6Sn5,并未發現Cu3Sn層的生成。EPMA分析顯示,Sn/Ni和Sn/Cu界面 IMC 的成分分別為(Cu0.89Ni0.11)6Sn5(圖3(g))和(Cu0.90Ni0.10)6Sn5(圖3(h))。與液-固界面反應2 h后的焊點相比,Sn/Cu界面IMC的厚度僅增加了4.47 μm,而Sn/Ni界面IMC的厚度則增加了13.11 μm。由此可見,隨著液-固界面反應時間的延長,Sn/Cu界面IMC的增長越來越緩慢,而Sn/Ni界面IMC的增長卻越來越快。
圖4所示為250℃時Sn-Cu-Ni三元相圖的等溫截面圖[13]。由圖4可知,Cu在Sn中的飽和溶解度約為1.2%(質量分數),當Sn中含有0.2%的Ni時,Cu在Sn中的飽和溶解度就會下降到0.6%。Ni在Sn中的飽和溶解度約為0.2%,但當Sn中溶解有少量的Cu時(低于0.6%),Ni在Sn中的溶解度變化并不大,只有當Cu含量高于0.6%時,Ni在Sn中的飽和溶解度才會下降。對Cu/Sn/Ni焊點而言,Sn/Cu界面附近釬料中的Cu濃度要大于Sn/Ni界面附近釬料中的Cu濃度,因此,Cu原子在釬料中存在一個濃度梯度,在該濃度梯度的作用下,Cu原子會不斷地從Cu端擴散到Ni端;而Sn/Ni界面附近釬料中的Ni原子濃度雖然比Sn/Cu界面附近釬料中的Ni原子濃度大,但是與Cu原子在釬料中的濃度梯度相比要小很多,所以,Ni原子在釬料中的擴散通量要明顯小于Cu原子在釬料中的擴散通量。

圖4 250℃下Sn-Cu-Ni等溫相圖富Sn角處放大示意圖[13]Fig.4 Enlarged Sn corner of isothermal section of Sn-Cu-Ni ternary phase diagram at 250℃[13]
液-固界面反應過程中界面IMC的厚度與反應時間的關系可用以下經驗公式表示:

式中:ht為經液-固界面反應時間t后界面IMC層的厚度,h0為界面 IMC層的初始厚度(t=0),K為IMC層生長速率系數,n為IMC層生長速率指數。
式(2)中的K可用Arrhenius方程來表示:

式中:K0為生成常數,Q為生長激活能,T為絕對溫度,R為摩爾氣體常數。
將式(3)代入式(2)并對兩邊取對數得


圖5 Cu/Sn/Ni焊點液-固界面反應過程中界面 IMC的lg(ht-h0)—lgt關系曲線Fig.5 lg(ht-h0)—lgt plots of growth kinetics of IMC layers in Cu/Sn/Ni interconnect during liquid-solid reaction
焊點中界面 IMC的厚度及形貌會顯著影響焊點的力學性能,通過液-固反應過程中交互作用對界面IMC的成分變化規律、金屬間化合物類型以及生長動力學的影響可知,焊點中的Cu-Ni交互作用通過影響界面反應,進而會對焊點的力學性能產生重要影響。在交互作用下,一方面,Sn/Ni界面IMC的類型發生轉變且具有更大的生長速率,界面IMC過快生長將使焊點的可靠性下降;另一方面,由于被溶解的Cu原子參與Sn/Ni界面反應,將使液態釬料中的Cu濃度降低,這會促使 Cu基板的加速溶解,從而降低焊點的可靠性。因此,焊點中的交互作用將對焊點的可靠性產生不利影響,在焊點設計及封裝工藝過程中應予以避免。
3 結論
1) 250℃短時浸焊后(10 s),Cu/Sn/Ni焊點中沒有發生Cu-Ni交互作用,Cu6Sn5和Ni3Sn4IMCs分別在Sn/Cu及Sn/Ni界面處生成。
2) 在250℃下液-固界面反應10 min后,Cu-Ni交互作用明顯。Cu原子和Ni原子均溶解并擴散到對面基體的界面上參與界面反應,Sn/Ni及Sn/Cu界面的IMCs均轉變為(Cu,Ni)6Sn5。
3) Sn/Cu與Sn/Ni界面IMCs的厚度均隨著液-固界面反應時間的延長而增加,其生長指數分別為0.32和0.61。在液-固界面反應的初始階段,Sn/Cu界面IMC的厚度要大于Sn/Ni界面IMC的厚度;液-固界面反應2 h后,由于Cu與Ni之間的交互作用,Sn/Cu界面IMC的厚度要小于Sn/Ni界面IMC的厚度,并隨著界面反應時間的延長一直保持;液-固界面反應6 h后,Sn/Cu與Sn/Ni界面IMCs厚度分別達到15.78和23.44 μm。
4) 交互作用的存在會加速Sn/Ni界面 IMC的生長和Cu基板的溶解,降低焊點的可靠性,應通過焊點設計及封裝工藝優化予以避免。
[1]ZENG K J, STIERMAN R, CHIU T C, EDWARDS D, ANO K,TU K N.Kirkendall void formation in eutectic SnPb solder joints on bare Cu and its effect on joint reliability[J].Journal of Applied Physics, 2005, 97(2): 024508.
[2]CHANG C C, LIN Y W, WANG Y W, KAO C R.The effect of solder volume and Cu concentration on the consumption rate of Cu pad during reflow soldering[J].Journal of Alloys and Compounds, 2010, 492(1/2): 99-104.
[3]ZHANG F, LI M, CHUM C C, TUNG C H.Effects of substrate metallizations on solder/underbump metallization interfacial reactions in flip-chip packages during thermal aging[J].Journal of Materials Research, 2003, 18(6): 1333-1341.
[4]HONG K K, RYU J B, PARK C Y, HUH J Y.Effect of cross-interaction between Ni and Cu on growth kinetics of intermetallic compounds in Ni/Sn/Cu diffusion couples during aging[J].Journal Electronic Materials, 2008, 37(1): 61-72.
[5]CHANG C W, YANG S C, TU C T, KAO C R.Cross-interaction between Ni and Cu across Sn layers with different thickness[J].Journal Electronic Materials, 2007, 36(11): 1455-1461.
[6]WANG S J, LIU C Y.Study of interaction between Cu-Sn and Ni-Sn interfacial reactions by Ni-Sn3.5Ag-Cu sandwich structure[J].Journal Electronic Materials, 2003, 32(11):1303-1309.
[7]HO C E, TSAI R Y, LIN Y L, KAO C R.Effect of Cu concentration on the reactions between Sn-Ag-Cu solders and Ni[J].Journal of Electronic Materials, 2002, 31(6): 584-590.
[8]TSAI J Y, HU Y C, TSAI C M, KAO C R.A study on the reaction between Cu and Sn3.5Ag solder doped with small amounts of Ni[J].Journal of Electronic Materials, 2003, 32(11):1203-1208.
[9]YOON J W, NOH B I, JUNG S B.Effects of third element and surface finish on interfacial reactions of Sn-Ag-xCu (or Ni)/(Cu or ENIG) solder joints[J].Journal of Alloys and compounds,2010, 506(1): 331-337.
[10]陳雷達, 周少明, 黃明亮.電遷移對Ni/Sn/Ni-P焊點界面反應的影響[J].稀有金屬材料與工程, 2012, 41(10): 1785-1789.CHEN Lei-da, ZHOU Shao-ming, HUANG Ming-liang.Effect of electromigration on interfacial reaction in Ni/Sn/Ni-P solder joint[J].Rare Metal Materials and Engineering, 2012, 41(10):1785-1789.
[11]黃明亮, 陳雷達, 周少明.電遷移對Ni/Sn3.0Ag0.5Cu/Cu焊點界面反應的影響[J].金屬學報, 2012, 48(3): 321-328.HUANG Ming-liang, CHEN Lei-da, ZHOU Shao-ming.Effect of electromigration on interfacial reaction in Ni/Sn3.0Ag0.5Cu/Cu flip chip solder joint[J].Acta Metallurgica Sinica, 2012, 48(3):321-328.
[12]黃明亮, 陳雷達, 周少明, 趙 寧.電遷移對Ni/Sn3.0Ag0.5Cu/Au/Pd/Ni-P倒裝無鉛焊點界面反應的影響[J].物理學報, 2012, 61(19): 198104.HUANG Ming-liang, CHEN Lei-da, ZHOU Shao-ming, ZHAO Ning.Effect of electromigration on interfacial reaction in Ni/Sn3.0Ag0.5Cu/Au/Pd/Ni-P flip chip solder joints[J].Acta Physica Sinica, 2012, 61(19): 198104.
[13]WANG S J, LIU C Y.Kinetic analysis of the interfacial reactions in Ni/Sn/Cu sandwich structures[J].Journal Electronic Materials,2006, 35(11): 1955-1960.
[14]LAURILA T, VUORINEN V, KIVILAHTI J K.Interfacial reactions between lead-free solders and common base materials[J].Mater Sci Eng R, 2005, 49: 1-60.
[15]ROY A K, CHABRA R P.Prediction of solute diffusion coefficients in liquid metals[J].Metallurgical Transactions A,1988, 19(2): 273-279.
[16]WATANABE H, SHIMODA M, HIDAKA N, SHOHJI I.Effect of interfacial reaction in Sn-Ag-Cu solder alloy with Ni addition[J].Key Engineering Materials, 2011, 462/463:247-252.

