磁控濺射功率對β-Ga2O3薄膜特性的影響
冉景楊,高燦燦,馬 奎,2,3,楊發順,2,3
(1.貴州大學 電子科學系,貴陽 550025; 2.貴州省微納電子與軟件技術重點實驗室,貴陽 550025;3.半導體功率器件可靠性教育部工程研究中心,貴陽 550025)
1 引 言
β-Ga2O3屬于第三代超寬禁帶半導體材料,是一種白色透明的、單斜結構的氧化物半導體[1,2].β-Ga2O3是目前已經確定的五種氧化鎵結構中最穩定的一種,其禁帶寬度約為4.8 eV -4.9 eV,具有優秀的結構性質、電學性質、光學性質和氣敏性質[3-7],在半導體功率器件、高壓高頻電路、氣敏傳感器、日盲紫光探測器[8,9]等方面都受到了廣泛的研究與應用.
目前,MOCVD、PLD、磁控濺射是制備β -Ga2O3薄膜最主要的幾種常用方法.相比于MOCVD 和PLD,磁控濺射制備β -Ga2O3薄膜具有成本低、操作簡單、沉積速度快、粘附性強等優勢,但磁控濺射制膜通常需要進行后退火處理來釋放薄膜與襯底之間的應力,使薄膜結構更穩定[10,11].美國德克薩斯大學Ranmana 等[12]采用磁控濺射方法基于Si( 100) 襯底,在不同襯底溫度(25 -600 ℃) 下制備β -Ga2O3薄膜得出,襯底溫度對薄膜結晶狀態影響較大.沙特阿拉伯薩克拉大學Hassanien 等[13]用磁控濺射方法基于石英( SiO2) 為襯底制備β-Ga2O3薄膜并進行了退火處理得出,退火溫度能有效改善薄膜光學和微觀結構質量.國內魯東大學張義軍等[14]采用射頻磁控濺射方法,基于Si 和石英( SiO2) 襯底制備β -Ga2O3薄膜,改變氨分比條件并進行熱處理后得出,隨著氨分比增加,薄膜的結晶性能提升,光學間隙增加.北京工業大學張浩等[15]采用射頻磁控濺射方法,基于Si 和石英( SiO2) 襯底進行了本征摻Nb 的β-Ga2O3薄膜制備得出,Nb 摻雜對β-Ga2O3薄膜結構和光學性質有影響,薄膜的晶格常數增大、晶體質量提高、帶隙變窄.然而,專門針對射頻磁控濺射功率這一參數對β -Ga2O3薄膜特性的研究很少,具有一定的研究意義.
本文通過射頻磁控濺射方法在C 面藍寶石( Al2O3) 襯底上進行β -Ga2O3薄膜制備,在保證其他條件如靶間距、工作壓強、濺射時間、襯底溫度等不變的情況下,只改變濺射功率( Sputtering power,以下簡稱Sp) ,研究濺射功率對射頻磁控濺射制備的β-Ga2O3薄膜特性的影響.濺射沉積完成,經過相同條件的退火處理后,使用XRD、AFM 和SEM 對薄膜進行表征,研究濺射功率參數對β-Ga2O3薄膜特性的影響,使用積分球式分光光度計研究了濺射功率對β -Ga2O3薄膜光學特性的影響.
2 實 驗
實驗基于沈科儀JGP280 雙靶磁控濺射系統進行薄膜制備.襯底材料選用1 ×1cm 的C 面藍寶石( Al2O3) 方片,靶材選用氧化鎵陶瓷靶( 純度99.99%) ,濺射時工作氣體選用高純氬氣(99.999%) 、反應氣體選用高純氧氣(99.999%).在其他條件都保持一致的情況下,僅改變濺射功率( Sputtering power,以下簡稱Sp) ,觀察薄膜特性變化情況.
首先,清洗襯底.將C 面藍寶石方片依次在無水乙醇、丙酮、無水乙醇中分別進行超聲清洗15 min,用去離子水清洗10 min,使用氮氣吹干,用作磁控濺射的襯底.
其次,進行薄膜制備.薄膜制備各工藝參數分別為: 本底真空9.0 ×10-4Pa,靶基距6.0 cm,工作壓強1.0 Pa,沉積時間90 min,襯底溫度500 ℃,氧氣流量2.3 sccm,氬氣流量46.2 sccm,氧氬比1: 20,濺射功率分別為90 W、110 W、130 W、150 W、170 W.
最后,退火觀察.將不同濺射功率下制備的β-Ga2O3薄膜樣品進行氮氣退火處理,退火條件完全一致( 退火溫度900 ℃,退火時間90 min,氮氣流量1 L/min).
完成后,使用XRD、AFM 和SEM 對薄膜進行表征,研究分析濺射功率對β -Ga2O3薄膜結構特性的影響,并使用積分球式分光光度計測量研究分析濺射功率對β-Ga2O3薄膜光學特性影響.
3 濺射功率對薄膜結構特性的影響
圖1 為改變濺射功率沉積并經后退火處理的β-Ga2O3薄膜XRD 圖譜,掃描范圍10° -70°.可以看出在隨濺射功率增大,90 W -170 W,薄膜β( -201) 晶向的衍射峰峰強整體呈現增大的變化趨勢.除襯底峰外,不同濺射功率的薄膜均存在三個特征峰,分別對應β( -201) 、β( -402) 和β( -603) 取向,同屬<-201 >晶面族,薄膜有良好的擇優取向性.此外,濺射功率為130W 時,出現了微弱的β( -401) 取向的衍射峰,改變濺射功率沉積并經過相同退火處理后得到β -Ga2O3多晶薄膜.

圖1 不同濺射功率薄膜的XRD 圖譜Fig.1 XRD patterns of β -Ga2O3 thin films with different sputtering powers
利用ORIGIN 軟件繪制不同濺射功率與薄膜β( -201) 衍射峰半峰寬和晶粒尺寸關系,如圖2所示,是薄膜β( -201) 半峰寬和晶粒尺寸與濺射功率的關系.從圖中看出,隨著濺射功率增大,半峰寬呈現先增大后減小再增大的趨勢,晶粒尺寸的變化則與之相反.當濺射功率為150 W 時,半峰寬最小,晶粒尺寸最大,在此條件下的薄膜結晶性能較好.
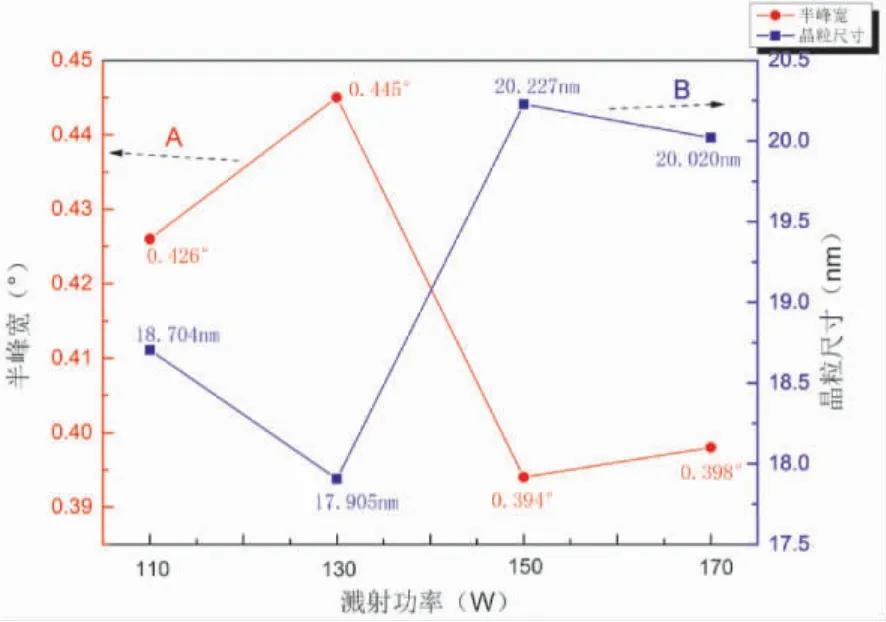
圖2 β( -201) 衍射峰的濺射功率與半峰寬和晶粒尺寸關系圖Fig.2 The relationships between the sputtering power of the β( -201) diffraction peak and the half-width,the grain size
圖3 為不同濺射功率β -Ga2O3薄膜的原子力圖片,掃描范圍是10 ×10 μm.當濺射功率150 W時,薄膜表面晶粒分布均勻,均方根粗糙度較大,為2.07 nm,與表2.1 對薄膜晶粒尺寸的計算相符.整體來看,濺射功率增大,薄膜表面形貌趨于平整且晶粒分布均勻.較高的濺射功率導致更多離化的Ar 原子轟擊靶材,更多帶有高能量的靶材原子能夠運動到合適晶面位置與相鄰原子結合成鍵,并且高轟擊能量在濺射過程中會提高襯底溫度,這些都有利于靶材原子的成核與生長.因此,隨著濺射功率的增大,晶粒尺寸隨之增大.但隨著濺射功率的進一步增大,高能量的靶材原子在襯底成核生長可能會出現競爭效應,導致薄膜表面顆粒破壞,薄膜損耗,從而晶粒尺寸又隨之變小.
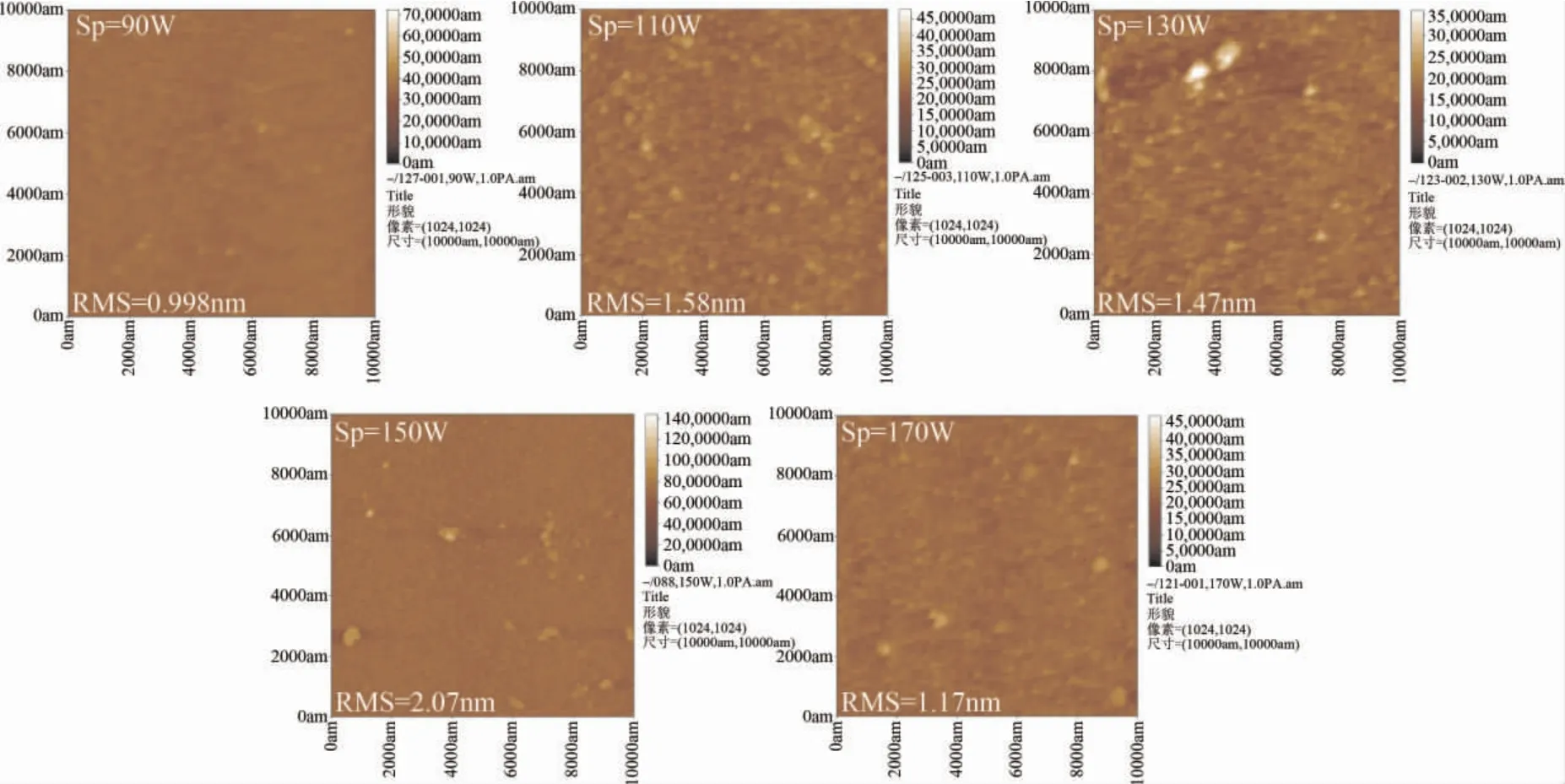
圖3 不同濺射功率薄膜的原子力圖片Fig.3 AFM images of β-Ga2O3 thin films with different sputtering powers
為了研究濺射功率對薄膜厚度的影響,利用掃描電子顯微鏡對不同濺射功率制備的β -Ga2O3薄膜進行了截面掃描,如圖4 所示是β -Ga2O3薄膜的SEM 截面圖及不同濺射功率制得的薄膜厚度曲線.通過與比例尺的對比,可以確定不同濺射功率條件薄膜的厚度,分別為238 nm、241 nm、347 nm、404 nm 和430 nm,隨著濺射功率增大,轟擊靶材表面的離子數量增多,有更多的靶材原子被轟出,薄膜沉積速率變高,薄膜的厚度也隨之增加,基本呈現線性變化的趨勢.此現象與前文XRD 圖譜的分析一致,最大的薄膜厚度對應最高的衍射峰峰強.
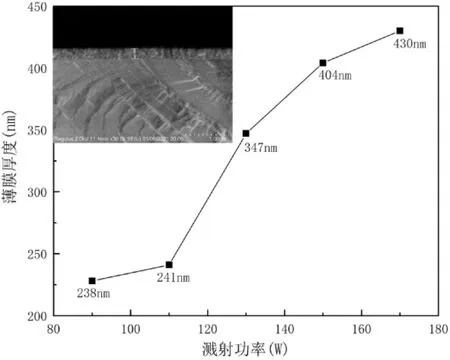
圖4 β-Ga2O3薄膜的SEM 截面圖及不同濺射功率制得的薄膜厚度曲線Fig.4 SEM cross section of β -Ga2O3 film and film thickness curve prepared by different sputtering powers
4 濺射功率對薄膜光學特性的影響
利用積分球式分光光度計對不同濺射功率沉積并經相同后退火處理的β -Ga2O3薄膜進行吸收光譜測試,研究濺射功率對β -Ga2O3薄膜光學性質的影響,如圖5 所示.分析可知,濺射功率對薄膜的吸收光譜有較大影響.整體來看,薄膜吸光度A 隨著波長增加,呈現升高、下降、再升高、再下降的趨勢,吸收邊在700 nm 附近截止.不同濺射功率制備的β-Ga2O3薄膜吸收光譜都存在兩個吸收峰,這一現象的出現可能是因為,隨著濺射壓強的增大,晶粒尺寸不斷減小,而表面原子占比變大、數量變多,使得結合時鍵長和鍵角產生不同程度的畸變,對薄膜光學特性分析的影響不大.隨著濺射壓強增加,β -Ga2O3薄膜的吸光度在不斷增加,并且紫外吸收邊向短波方向移動.這是因為,隨著濺射功率的進一步增加,晶粒尺寸減小,當晶粒尺寸減小到一定程度會產生量子尺寸效應,使β-Ga2O3禁帶寬帶變大,且由于高能靶材原子沉積,襯底成核生長出現競爭效應,薄膜表面損耗,導致薄膜散射能力變弱,紫外光吸收能力也變弱,故而紫外吸收邊向短波方向移動.
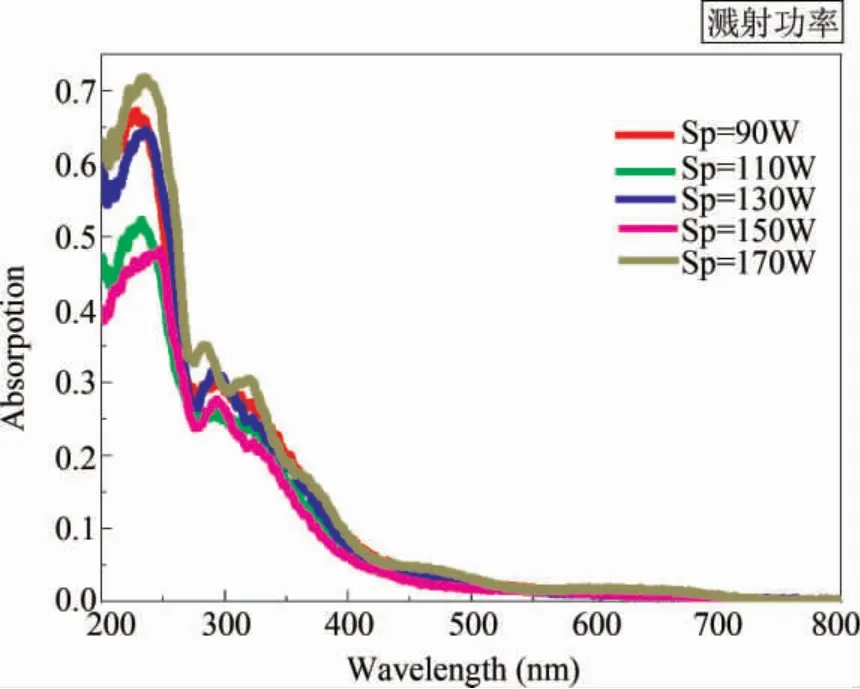
圖5 不同濺射功率薄膜的吸收光譜Fig.5 Absorption spectra of films with different sputtering powers
5 結 論
針對基于射頻磁控濺射在C 面藍寶石襯底上制備的β-Ga2O3薄膜材料,在相同的后退火處理條件下研究了不同濺射功率的影響.整體來看,在結構特性方面,隨著濺射功率增大,薄膜的表面平整且晶粒尺寸分布均勻.濺射功率越高,離化的Ar 粒子越多,對靶材的轟擊越強,產生了更多的帶有高能量的靶材原子運動到合適的晶面位置與相鄰原子結合成鍵,與此同時,高濺射功率下的轟擊下,靶材原子帶有高能量,在濺射過程中會相應提高襯底溫度,這些都有利于靶材原子的結晶與生長.在光學特性方面,不同濺射功率制備的β - Ga2O3薄膜吸收光譜都存在兩個吸收峰,薄膜吸光度A 隨著波長的增加,呈現升高、下降、再升高、在下降的趨勢,吸收邊在700 nm附近截止,但隨著濺射壓強增加,β -Ga2O3薄膜的吸光度在不斷增加,并且紫外吸收邊向短波方向移動.
總的來說,隨著濺射功率的增加,轟擊粒子增加,沉積速度變快,相同時間沉積薄膜越厚,所制備β-Ga2O3薄膜表面光滑、均勻、致密,能得到結構特性和光學特性較好的薄膜.但隨著濺射功率進一步增大,轟擊粒子數進一步增加,在襯底成核生長時可能產生競爭效應,高能量的粒子可能造成薄膜表面損耗以及表面顆粒的破壞,使得半峰寬增大、晶粒尺寸變小.當晶粒尺寸變小到一定程度會產生量子尺寸效應,紫外吸收能力變差,紫外吸收邊向短波方向移動.綜合考量得出,濺射功率為150 W 時,制備的β-Ga2O3薄膜效果較好.

