1.3μm GaAsSb/GaAs單量子阱垂直腔面發射激光器的仿真研究
何斌太,劉國軍,魏志鵬,安寧,劉鵬程,劉超,王旭
(長春理工大學 高功率半導體激光國家重點實驗室,長春 130022)
如今光纖通信已經成為當代通信的主流,是信息社會的主要支柱之一。垂直腔面發射激光器(VCSEL)以其光束質量好、閾值電流低、易于集成和制造成本低廉等優點成為光纖通信系統中重要的光源[1]。與石英光纖第二低損窗口相對應的1.3μm VCSEL能夠滿足當前城域網的需求,在中遠距離高速數據通信、光互聯和光識別等方面有著廣闊的應用前景[2]。鑒于AlGaAs材料可以構成高性能的分布布拉格反射鏡(DBR),因此多采用與GaAs基材料晶格相匹配的有源材料。已經證實InGaNAs/GaAs材料系可以實現1.3μm波長激射[3,4],然而N組分對材料增益峰值波長影響明顯且生長不易控制,導致器件的光學特性及可靠性受到很大的影響[5]。高質量的應變GaAsSb三元化合物可用分子束外延法(MBE)生長在GaAs上,且不易產生三維成核,并在相當大的近紅外范圍內能產生很強的發光。為了研制能滿足光纖通信應用要求的高性能1.3μm VCSEL,我們以GaAsSb/GaAs作為有源材料,基于PICS3D軟件建立激光器仿真模型,對材料增益、器件的閾值電流和輸出功率等性能參數進行了分析。
1 理論分析
VCSEL核心結構主要包括DBR和有源區。良好的器件特性往往是由材料性質及其結構所決定的,下面分別介紹DBR與有源區的設計。
1.1 DBR的設計
由于VCSEL的有源層很薄,只有亞微米量級,比起邊發射激光器的有源層諧振腔要小兩個數量級,因此就要求DBR具有很高的光反射率。
DBR一般是由多周期的高低反射膜堆疊而成,每個周期高低折射率層的厚度要嚴格遵循λ/4光學厚度。半導體化合物材料的折射率主要受材料的禁帶寬度和入射光的波長這兩個因素影響,計算公式為:

式中,

其中,Eg(x,y)為材料的禁帶寬度;ω為入射光的頻率;A(x,y)為Eg(x,y)與Eg(x,y)+Δ(x,y)之間的躍遷幾率;B(x,y)為非色散項;Δ(x,y)為分裂能量。GaAs和AlAs二元材料參數如表1所示。
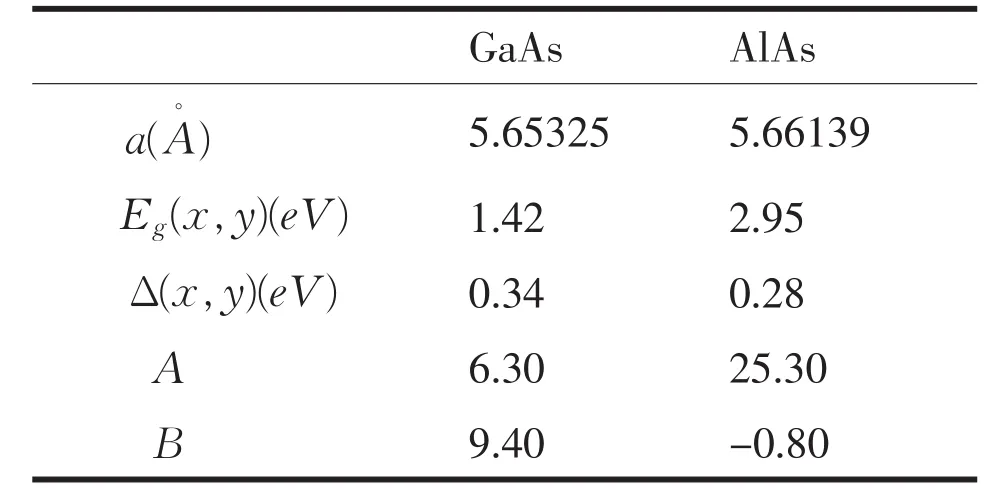
表1 300K時GaAs和AlAs材料參數
利用表1參數計算出,1.3μm條件下,GaAs的折射率為3.451,AlAs的折射率為2.930。由于VCSEL有源區厚度較小,為了滿足激射,DBR反射率要達到99.5%。采用GaAs/Al0.9Ga0.1As材料系構成DBR,上、下DBR對數分別為26和36.5。上DBR反射率達到99.5%,下DBR反射率達到99.9%。圖1(a)和圖1(b)分別為模擬的上DBR和下DBR的反射光譜。
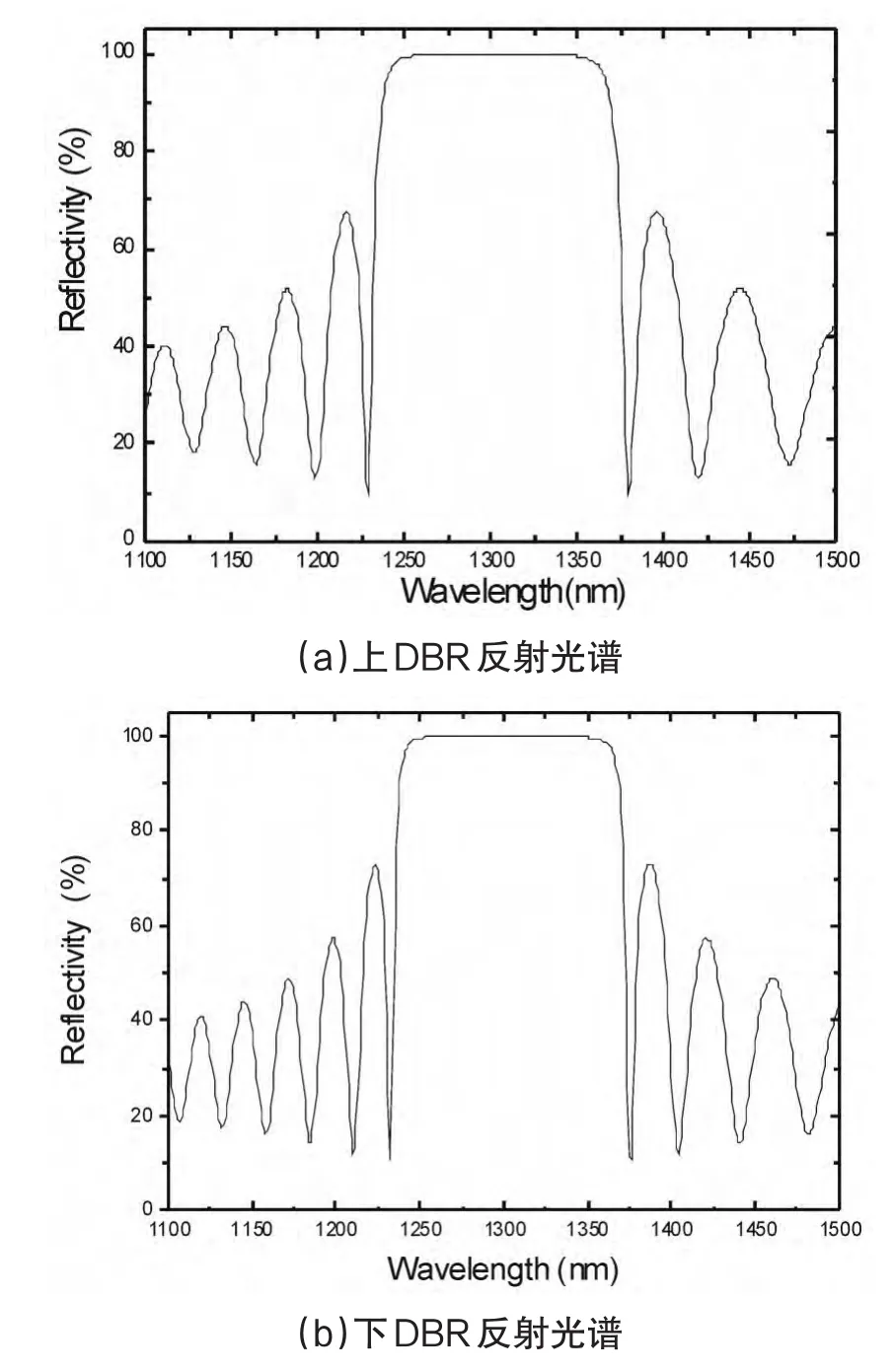
圖1 模擬的上DBR和下DBR的反射光譜
1.2 有源區的設計
有源區作為VCSEL載流子復合區域,采用量子阱結構。基于量子阱應變理論與固體模型理論,數值上求解一維有限深方勢阱薛定諤方程,從而確定量子阱結構中材料的組分及厚度。經實驗驗證[6-9]與理論分析,GaAsSb/GaAs材料的能帶呈II型排列。
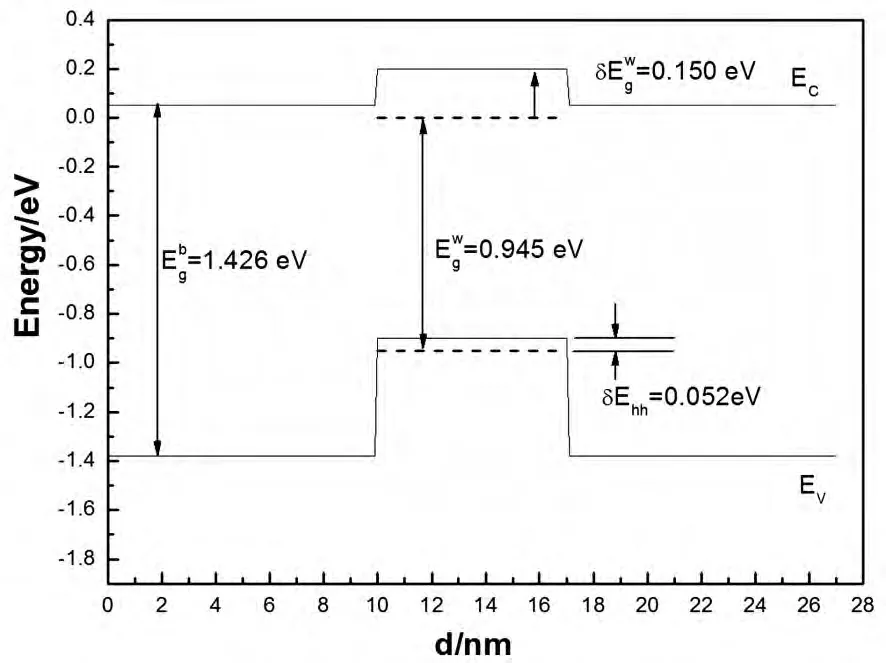
圖2 GaAs0.64Sb0.36/GaAs量子阱的能帶圖
量子阱材料的選擇主要考慮材料的晶格匹配和能帶帶隙。經過對比不同組分GaAsxSb1-x及阱寬對器件發光波長的影響,最終采用GaAs0.64Sb0.36/GaAs材料,量子阱寬度為7nm。根據上述理論計算出GaAs0.64Sb0.36/GaAs量子阱的能帶圖如圖2所示。在量子阱的個數選擇上,隨著量子阱個數增加,量子阱增益區所提供的光增益會不斷地增加。但是量子阱個數增加到一定的數值時,將對器件的閾值電流密度產生影響[10]。另外考慮到材料的臨界厚度,本文采用單量子阱結構。
1.3 器件結構參數
根據上述理論分析,本文設計的1.3μm GaAs-Sb/GaAs量子阱垂直腔面發射激光器詳細結構參數如表2所示。

表2 1.3μm GaAsSb/GaAs VCSEL結構參數
2 器件仿真與結果分析
根據表2所示的結構參數,采用PICS3D軟件模擬了氧化孔徑為7μm器件特性,圖3是器件結構的剖面圖,仿真結果如圖4至圖7所示。

圖3 器件結構的剖面圖
圖4為沿生長方向材料折射率和樣品內駐波之間的分布圖示。從圖中可以看出中間駐波剛好位于量子阱的阱區,二者形成最大的重疊,這時增益可以達到最大值。

圖4 生長方向材料的折射率與駐波
圖5為注入不同濃度載流子時,量子阱材料的增益圖。從下到上載流子濃度由0.5×1018cm-3變到5×1018cm-3,間隔為0.5×1018cm-3。從圖中可以看出在不同注入濃度時,在1.3μm處均達到最大值。
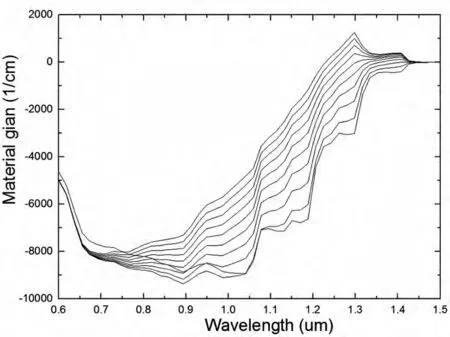
圖5 不同載流子濃度下材料增益曲線
圖6為器件整體往返增益隨波長的變化圖。從圖中可以看出,在相當大波長范圍內增益是均勻的,這是器件在所需的工作波長穩定運行的基本要求。

圖6 往返增益隨波長變化圖
圖7為器件輸出功率與輸入電流關系曲線圖。從圖中可以看出,閾值電流為0.8mA,斜率效率為0.017W/A,當輸入電流為8mA時,輸出功率達到0.12mW。

圖7 器件P-I曲線
3 結論
本文從理論上計算AlGaAs材料的折射率,模擬了DBR反射特性,得到符合器件要求的DBR。基于PICS3D軟件設計了氧化孔徑為7μm的VCSEL器件仿真模型,對GaAsSb/GaAs材料增益及器件光電特性進行仿真,得到閾值電流為0.8mA,斜率效率為0.017W/A,當輸入電流為8mA時,輸出功率為0.12mW的仿真結果。該設計具有較好的輸出特性,能夠滿足光纖通訊技術對半導體激光器光源的性能要求。
[1]李林,鐘景昌,蘇偉,等.垂直腔面發射半導體激光器[J].長春理工大學學報:自然科學版,2003,26(2):68-72.
[2]Hugues Salas E,Giddings RP,Jin XQ,et al.Real-time experimental demonstration of low-cost VCSEL intensity-modulated 11.25Gb/s optical OFDM signaltransmissionover25km PON systems[J].Optics Express,2011,19(4):2979-2988.
[3]Coldren CW,Larson MC,Spruytte SG,et al.1200nm GaAs-based vertical cavity lasers employing GaIn-NAs multiquantum well active regions[J].Electronics Letters,2000,36(11):951-952.
[4]岳愛文.1.3μm GaInNAs/GaAs垂直腔面發射激光器的優化設計與制作[D].武漢:武漢大學,2004.
[5]Mair RA,Lin JY,Jiang HX,et al.Time-resolved photoluminescence studies of InxGa1-xAs1-yNy[J].Appl Phys Lett,2000,76(2):188-190.
[6]Wang TS,Tsai JT,Lin KI,et al.Characterization of band gap in GaAsSb/GaAs heterojunction and band alignment in GaAsSb/GaAs multiple quantum wells[J].Materials Science and Engineering:B,2008,147(2):131-135.
[7]Liu G,Chuang SL,Park SH.Opticalgain of strained GaAsSb/GaAs quantum-well lasers:A self-consistent approach[J].Journal of Applied Physics,2000,88(10):5554-5561.
[8]Johnson SR,Guo CZ,Chaparro S,et al.GaAsSb/GaAs band alignmentevaluation for long-wave photonic applications[J].Journal of crystal growth,2003,251(1):521-525.
[9]Sitarek P,Hsu HP,Huang YS,et al.Optical studies of type-I GaAs1-xSbx/GaAs multiple quantum well structures[J].Journal of Applied Physics,2009,105(12):123523-1-123523-5.
[10]吳文光,范廣涵,沈為民,等.多量子阱VCSEL速率方程的數值模擬分析[J].半導體光電,2007,28(5):651-654.

